PCB Prozess Chip Verpackung Technologie detaillierte Erklärung
1.BGA (Ball Grid Array) wird auch CPAC (Globe Top Pad Array Carrier) genannt. Eine Anzeige von sphärischen Kontakten, eines der Oberflächenmontagepakete. Auf der Rückseite der Leiterplatte werden sphärische Stöße im Anzeigemodus produziert, um die Stifte zu ersetzen, und der LSI-Chip wird auf der Vorderseite der Leiterplatte montiert und dann durch Formharz oder Vergießen versiegelt. Auch bekannt als Bump Display Carrier (PAC). Der Stift kann 200 überschreiten, was ein Paket für Multi-Pin LSI ist. Der Gehäusekörper kann auch kleiner als QFP (Quad Flat Package) gemacht werden. Zum Beispiel ist ein 360-poliger BGA mit einem Stiftmittelabstand von 1,5mm nur 31mm Quadrat, während ein 304-poliger QFP mit einem Stiftmittelabstand von 0,5mm 40mm Quadrat ist. Und BGA muss sich keine Sorgen um Pin Deformation wie QFP machen.
Dieses Paket wurde von Motorola Company aus den Vereinigten Staaten entwickelt und wurde zuerst in tragbaren Telefonen und anderen Geräten angenommen und dann in PCs populär gemacht. Anfangs betrug der BGA-Pin (Bump) Mittelabstand 1,5mm und die Anzahl der Pins war 225. Es gibt auch einige LSI-Hersteller, die 500-polige BGAs entwickeln. Das Problem bei BGA ist die Sichtprüfung nach dem Reflow-Löten. American Motorola Company bezeichnet das mit gegossenem Harz versiegelte Paket als OMPAC, während das mit Vergussverfahren versiegelte Paket GPAC genannt wird.
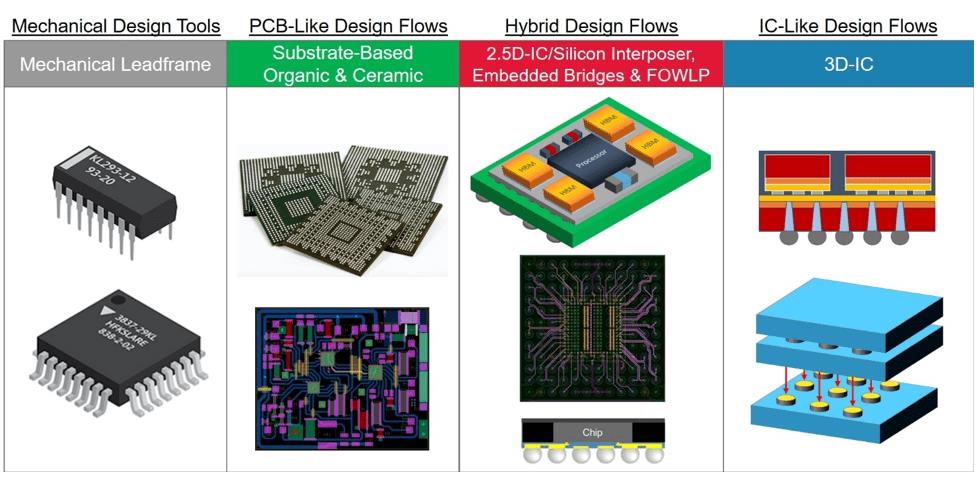
2.Cï¼(Keramik) stellt das Zeichen der keramischen Verpackung dar. CDIP steht zum Beispiel für keramisches DIP. Es ist eine Marke, die in der Praxis häufig verwendet wird.
3.COB (Chip an Bord) Chip an Bord Verpackung ist eine der nackten Chip Befestigungstechnologien. Der Halbleiterchip wird übergeben und auf der Leiterplatte montiert. Die elektrische Verbindung zwischen dem Chip und dem Substrat wird durch Drahtnähte realisiert und mit Harz bedeckt, um Zuverlässigkeit zu gewährleisten. Obwohl COB die einfachste Bare-Chip-Montagetechnologie ist, ist seine Packungsdichte der TAB- und Flip-Chip-Klebetechnik weit unterlegen.
4.DIP (duales Inline-Paket) Dual Inline-Paket. Eines der Plug-in-Pakete, die Stifte werden von beiden Seiten der Verpackung gezogen, und die Verpackungsmaterialien sind Kunststoff und Keramik. Die europäischen Halbleiterhersteller verwenden hauptsächlich DIL. DIP ist das beliebteste Plug-in-Paket und sein Anwendungsbereich umfasst Standard-Logik-ICs, Speicher-LSIs und Mikrocomputer-Schaltungen. Der Stiftmittelabstand beträgt 2.54mm, und die Anzahl der Stifte ist von 6 bis 64. Die Paketbreite beträgt normalerweise 15,2mm. Einige Pakete mit Breiten von 7,52mm und 10,16mm werden SK-DIP (Skinny Dual In-Line Paket) und SL-DIP (Slim Dual In-Line Paket) Schmalkörper DIP genannt. Aber in den meisten Fällen wird kein Unterschied gemacht, und sie werden einfach kollektiv als DIP bezeichnet. Darüber hinaus wird keramisches DIP, das mit niedrig schmelzendem Glas versiegelt ist, auch Cerdip genannt (siehe 4.2).
4.1DIC (duales inline keramisches Paket) Ein anderer Name für DIP (einschließlich Glasdichtung) des keramischen Pakets.
4.2Cordip: Keramisches Dual-in-Line-Paket versiegelt mit Glas, verwendet für ECL RAM, DSP (digitaler Signalprozessor) und andere Schaltungen. Cerdip mit Glasfenster wird für ultraviolett löschbare EPROM und Mikrocomputerschaltung mit EPROM innen verwendet. Der Stiftmittelabstand ist 2.54mm, und die Anzahl der Stifte ist von 8 bis 42. In Japan wird dieses Paket als DIP-G ausgedrückt (G bedeutet Glasdichtung).
4.3SDIP (Schrumpfen duales Inline-Paket) Schrumpfen DIP. Eines der Plug-in-Pakete, die Form ist die gleiche wie das DIP, aber der Stiftmittelabstand (1.778mm) ist kleiner als das DIP (2.54mm), so wird es genannt. Die Anzahl der Pins reicht von 14 bis 90. Es gibt zwei Arten von Keramik und Kunststoff. Auch bekannt als SH-DIP (Shrink Dual Inline Package)
5.Flip-ChipFlip-Löten des Chips. Eine der Bare-Chip-Verpackungstechnologien besteht darin, Metallstöße im Elektrodenbereich des LSI-Chips zu machen und dann die Metallstöße durch Druckschweißen mit dem Elektrodenbereich auf dem gedruckten Substrat zu verbinden. Der Footprint der Verpackung ist im Grunde der gleiche wie die Chipgröße. Es ist die kleinste und dünnste aller Verpackungstechnologien. Wenn sich der Wärmeausdehnungskoeffizient des Substrats jedoch von dem des LSI-Chips unterscheidet, tritt an der Verbindung eine Reaktion auf, die die Zuverlässigkeit der Verbindung beeinträchtigt. Daher ist es notwendig, Harz zu verwenden, um den LSI-Chip zu verstärken, und ein Substratmaterial mit im Wesentlichen dem gleichen Wärmeausdehnungskoeffizienten zu verwenden.
6.FP (flaches Paket)Flaches Paket. Eines der Aufputzpakete. Ein anderer Name für QFP oder SOP (siehe QFP und SOP). Einige Halbleiterhersteller verwenden diesen Namen.
7.H-(mit Kühlkörper)Zeigt eine Markierung mit einem Heizkörper an. HSOP bedeutet zum Beispiel SOP mit Kühlkörper.
8.MCM (Multi-Chip Modul)Multi-Chip Komponenten. Ein Paket, in dem mehrere Halbleiterchips auf einem Verdrahtungssubstrat montiert sind. Entsprechend dem Substratmaterial kann es in drei Kategorien unterteilt werden: MCM-L, MCM-C und MCM-D. MCM-L ist eine Komponente, die eine gemeinsame Glas-Epoxid-Mehrschicht-Leiterplatte verwendet. Die Verdrahtungsdichte ist nicht sehr hoch und die Kosten sind niedrig. MCM-C verwendet Dickschichttechnologie, um Mehrschichtverdrahtung zu bilden, und verwendet Keramik (Aluminiumoxid oder Glaskeramik) als Substratkomponente, die einem Dickschichthybrid IC unter Verwendung eines mehrschichtigen Keramiksubstrats ähnlich ist. Es gibt keinen offensichtlichen Unterschied zwischen den beiden. Die Verdrahtungsdichte ist höher als MCM-L. MCM-D ist die Verwendung von Dünnschichttechnologie zur Bildung von mehrschichtigen Verdrahtungen mit Keramik (Aluminiumoxid oder Aluminiumnitrid) oder Si, Al als Substratkomponente. Das Verdrahtungsschema ist das höchste unter den drei Komponenten, aber die Kosten sind auch hoch.