Le multi - Chip Packaging (MCP) répond depuis longtemps au besoin d'encapsuler plus de performances et de fonctionnalités dans des espaces de plus en plus petits (PCB). Il est naturel de souhaiter que le MCP de la mémoire soit étendu pour inclure un ASIC tel qu'un processeur en bande de base ou multimédia. Mais cela a aussi des difficultés, à savoir des coûts de développement élevés et des coûts de propriété / réduction. Comment résoudre ces problèmes? Le concept d'encapsulation IC en cascade (POP) est largement accepté dans l'industrie.
POP (Packaging on Packaging), également connu sous le nom de composant empilé, également connu sous le nom de couche d'emballage. POP est un boîtier composé de deux ou plusieurs BGA (Ball Grid Array Packaging) empilés ensemble. Typiquement, la structure d'encapsulation empilée du pop utilise une structure de bille de soudure BGA, qui intègre un dispositif logique numérique ou à signal mixte à haute densité au fond du boîtier pop pour répondre aux caractéristiques du dispositif logique à plusieurs broches. POP en tant que nouvelle forme d'emballage hautement intégrée, principalement utilisée dans les smartphones modernes, les appareils photo numériques et autres produits électroniques portables, joue un rôle très large.

Le MCP est une technologie hybride qui empile verticalement différents types de puces mémoire ou non de différentes tailles dans un boîtier en plastique. Cela permet d'économiser de l'espace pour les petits circuits imprimés PCB.
D'un point de vue architectural, le SIP est l'intégration de plusieurs puces fonctionnelles, y compris le processeur, la mémoire et d'autres puces fonctionnelles, dans un seul boîtier, permettant ainsi une fonctionnalité complète de base. Du point de vue de l'électronique du terminal, SIP se concentre non seulement sur la performance / consommation d'énergie de la puce elle - même, mais réalise également l'ensemble de l'électronique du terminal court, mince, multifonctionnel, faible consommation d'énergie. Avec la montée en puissance des produits légers tels que les appareils mobiles et les dispositifs portables, le besoin de SIP devient de plus en plus évident.
Le concept de base d'un soc est d'intégrer plus d'appareils sur la même puce en métal nu pour atteindre les objectifs de réduction de la taille, d'amélioration des performances et de réduction des coûts. Cependant, dans un marché de la téléphonie mobile où les cycles de vie des projets sont courts et les coûts exigeants, les solutions SOC présentent de grandes limites. Du point de vue de la configuration de la mémoire, différents types de mémoire nécessitent beaucoup de logique et la maîtrise de différentes règles de conception et techniques peut être très difficile, ce qui peut affecter le temps de développement et la flexibilité requise par les applications.
SOC et sip
SOC est très similaire à sip, car les deux combinent des systèmes contenant des composants logiques, des composants de mémoire et même des composants passifs en une seule unité. Du point de vue de la conception, un soc est un haut niveau d'intégration des composants nécessaires à un système sur une puce. Du point de vue de l'encapsulation, SIP est une méthode d'encapsulation côte à côte ou superposée pour différentes puces. Il s'agit d'un boîtier standard unique qui intègre plusieurs composants électroniques actifs avec des fonctions différentes, des dispositifs passifs optionnels et d'autres dispositifs tels que des MEMS ou des optiques pour réaliser certaines fonctions.
En termes d'intégration, généralement SOC n'intègre que des systèmes logiques tels que AP, tandis que SIP intègre AP + mobiledr. Dans une certaine mesure, SIP = SOC + DDR. Avec des niveaux d'intégration de plus en plus élevés à l'avenir, emmc sera probablement intégré dans sip. Du point de vue du développement de l'emballage, le SOC s'est imposé comme l'objectif et la direction de développement de la conception des futurs produits électroniques en raison des exigences de l'électronique en termes de volume, de vitesse de traitement ou de caractéristiques électriques. Cependant, avec l'augmentation des coûts de production des SOC et l'apparition fréquente d'obstacles techniques au cours des dernières années, le développement des SOC est confronté à des goulots d'étranglement, ce qui rend le développement des SIP de plus en plus préoccupant pour l'industrie.
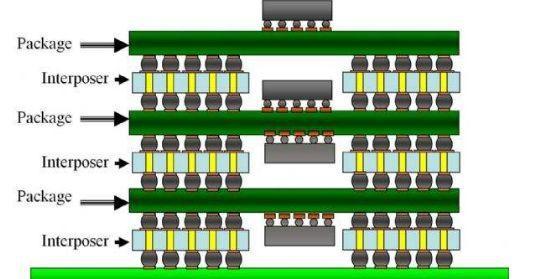
Le chemin du MCP vers le pop
Les produits de mémoire combinée (flash + RAM) qui intègrent plusieurs Flash NOR, NAND et Ram dans un seul boîtier sont largement utilisés dans les applications de téléphonie mobile. Ces solutions d'encapsulation unique comprennent l'encapsulation Multi - puces (MCP), l'encapsulation au niveau du système (SIP) et les modules Multi - puces (MCM).
La nécessité de fournir plus de fonctionnalités dans des téléphones de plus en plus petits est le principal moteur de la croissance de MCP, cependant, développer des solutions qui améliorent les performances tout en restant de petite taille est un défi difficile. Non seulement la taille est un problème, mais les performances sont également un problème, par exemple lors de l'utilisation d'un chipset en bande de base ou d'un coprocesseur multimédia dans un téléphone avec une mémoire MCP avec des interfaces SDRAM et DDR.
L'Encapsulation d'empilement POP est un excellent moyen d'atteindre une miniaturisation hautement intégrée. Dans les boîtiers empilés, les boîtiers hors boîtier (POP) deviennent de plus en plus importants dans l'industrie de l'encapsulation, en particulier dans les applications mobiles, grâce à la possibilité d'empiler des cellules logiques à haute densité.
Avantages de l'encapsulation pop
1. L'équipement de stockage et l'équipement logique peuvent être testés ou remplacés individuellement pour assurer le rendement;
2. L'encapsulation POP à double couche économise la surface du substrat et un plus grand espace longitudinal permet plus de couches d'encapsulation;
3. Mélanger DRAM, ddramsram, flash et microprocesseur le long de la carte PCB longitudinale;
4. Pour les puces de différents fabricants, offrant une flexibilité de conception, peut être simplement mélangé pour répondre aux besoins des clients, réduire la complexité et le coût de la conception;
5. Actuellement, cette technologie peut être utilisée pour couvrir et assembler les puces de couche dans la direction verticale;
6. La connexion électrique des dispositifs supérieurs et inférieurs empilés ensemble permet un taux de transfert de données plus rapide, peut faire face à l'interconnexion à grande vitesse entre les dispositifs logiques et les dispositifs de mémoire