Nouveau processus de placage de substrats IC: trous borgnes, trous traversants et remplissage de rainures encastrées
Résumé
À l'ère de la miniaturisation de l'électronique, les substrats de circuits intégrés à haut rendement et à faible coût offrent un moyen fiable de réaliser des interconnexions à haute densité entre les puces et les PCB. Afin de maximiser l'espace de porteurs disponible, la distance entre les motifs en cuivre - la largeur du motif et l'espacement des motifs (L / s) - doit être minimisée. Dans la technologie PCB commune, les largeurs de motif et les distances de motif sont supérieures à 40 angströms, tandis que la technologie au niveau de la plaquette plus avancée peut atteindre des largeurs de motif et des distances allant jusqu'à 2 angströms. Au cours de la dernière décennie, la taille des puces a considérablement diminué avec l'avènement du L / s embarqué, ce qui pose des défis uniques aux industries des circuits imprimés et des semi - conducteurs.
L'Encapsulation au niveau du panneau de sortie de secteur (foplp) est une nouvelle technologie de fabrication conçue pour combler le fossé entre les domaines des circuits imprimés et des circuits intégrés / semi - conducteurs. Bien que le foplp reste une technologie émergente, il est favorisé par le marché en raison de sa capacité à améliorer l'utilisation de l'empreinte et de la capacité et à augmenter l'avantage concurrentiel en réduisant les coûts. Sur ce marché, la clé de la performance des circuits fins est l'uniformité ou la planéité du revêtement. L'uniformité du revêtement, la planéité au Sommet du fil / trou borgne (mesure de la planéité au Sommet du fil) et le trou borgne caractérisent ses propriétés. Ceci est particulièrement important dans l'usinage de PCB multicouches, car l'hétérogénéité de la couche inférieure peut affecter les revêtements ultérieurs, perturber la conception du dispositif et entraîner des conséquences catastrophiques telles que les courts - circuits. De plus, les surfaces inégales déforment les points de connexion (c. - à - d. Les trous borgnes et le câblage) et entraînent une perte de signal. Les solutions de placage permettent ainsi d'obtenir un profil uniforme et plat sans post - traitement particulier, ce que l'industrie attend.
Cet article présente un additif Composite innovant pour revêtement de cuivre CC pour substrats IC. Le remplissage des rainures encastrées peut être réalisé par un placage graphique amélioré, et le remplissage des trous traversants et borgnes peut être effectué simultanément. Ces nouveaux produits offrent non seulement un meilleur profil de motif, mais peuvent également être remplis de trous borgnes et de trous métallisés. Nous présentons également deux procédés de cuivrage électrolytique qui peuvent être choisis en fonction de la taille du trou borgne et des exigences concaves de l'application spécifique: le procédé I permet un bon remplissage des trous borgnes profonds de 80 à 120 µm de diamètre et de 50 à 100 µm de profondeur (Figure 1); Le procédé II est plus adapté aux petits trous borgnes peu profonds d'un diamètre de 50 à 75 îles et d'une profondeur de 30 à 50 îles.
Ces deux procédés permettent d'obtenir une excellente uniformité de surface et un profil de ligne (Figure 2). Cet article décrit les propriétés de remplissage de trous borgnes et de placage de trous traversants pour un paramètre donné dans la plage de contrôle. Il décrit également comment optimiser la dissipation thermique et les caractéristiques physiques de la métallisation galvanique
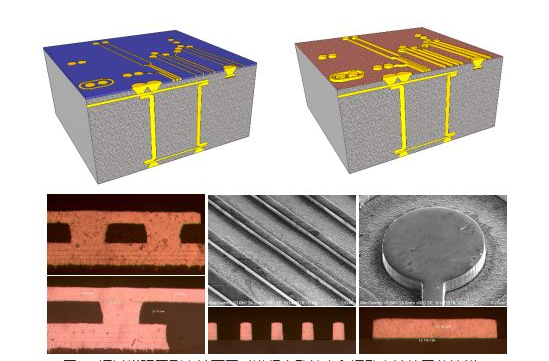
Figure 1 les caractéristiques du procédé de remplissage des trous borgnes et de placage des trous traversants peuvent être réalisées simultanément par un placage graphique renforcé

La figure 2 montre les performances de remplissage de rainures encastrées avec une grande cohérence entre les Plots et les fils
Introduction
Le substrat IC est le plus haut niveau de la technologie de miniaturisation de PCB, fournissant une connexion entre la puce IC et le PCB via un réseau électrique de fils de cuivre conducteurs et de vias. La densité des fils est un facteur clé dans la miniaturisation, la vitesse et la portabilité de l'électronique grand public. La densité de fil a considérablement augmenté au cours des dernières décennies et le développement de l'encapsulation au niveau du panneau de ventilation (foplp) est devenu un sujet brûlant dans le domaine de la microélectronique pour répondre aux exigences de conception des circuits imprimés d'aujourd'hui, y compris les matériaux de noyau mince, la largeur de motif précise et les trous traversants et borgnes de plus petit diamètre.
Les principaux facteurs qui alimentent le développement de cette nouvelle technologie sont les coûts et la productivité. L'Encapsulation classique au niveau de la tranche de sortie (fowlp) utilise des plaquettes de 300 mm comme unité de production, car il est difficile d'obtenir des plaquettes plus grandes, ce qui augmente les étapes d'usinage, la main - d'œuvre et les coûts, et les rendements sont faibles. L'avantage d'utiliser un chargeur de type PCB par rapport à une plaquette réside dans la flexibilité de conception du fabricant, qui peut utiliser une plus grande surface de panneau. Par exemple, un panneau de 610 mm x 457 mm a une surface presque quatre fois supérieure à celle d'une plaquette de 300 mm, ce qui réduit considérablement les coûts, les délais et les étapes d'usinage, ce qui constitue un avantage considérable pour la production de masse.
Cependant, l'application de la technologie foplp sur les substrats nécessite plus de recherche et de développement et fait face à des défis tels que la résolution et les problèmes de gauchissement. Si elle est mise en œuvre avec succès, des volumes plus élevés, des coûts inférieurs et des tailles de boîtier plus minces peuvent être atteints, rendant l'électronique grand public plus rapide et plus légère.
Remplissage de trou borgne en cuivre acide
Le processus de placage est l'un des maillons clés de la production de circuits imprimés. Grâce à la distribution de courant, le câblage, les trous borgnes et le placage des trous traversants sur la carte PCB peuvent être réalisés. Le cuivre, en tant que choix de métal conducteur, se caractérise par son faible coût et sa conductivité élevée. Au cours des dernières décennies, avec le développement de la technologie de placage du cuivre, l'utilisation du cuivre comme métal de placage a considérablement augmenté. La conception avancée de carte de circuit imprimé professionnelle nécessite des équipements de placage de pointe et des solutions de placage innovantes, de sorte que les équipements de placage par jet ont été largement utilisés au cours des dernières décennies.
La solution de remplissage galvanique est généralement une concentration élevée en cuivre (200 g / l à 250 g / L de sulfate de cuivre) et une faible concentration en acide (environ 50 g / l d'acide sulfurique) pour faciliter un remplissage rapide. Les additifs organiques sont utilisés pour contrôler le taux de placage et obtenir des propriétés physiques acceptables. Ces additifs doivent être soigneusement conçus pour répondre aux exigences du client en ce qui concerne la taille de remplissage du trou de guidage, le rendement, l'épaisseur de cuivre de surface, les tolérances de distribution de cuivre de la plaque et la forme du trou borgne après le placage. Les formules de placage typiques comprennent des inhibiteurs, des agents brillants et des agents de nivellement. En théorie, il est possible de remplir les pores borgnes uniquement avec un système à deux composants contenant un inhibiteur et un agent blanchissant, mais il existe des problèmes pratiques avec les systèmes à deux composants tels que de grandes dépressions, un remplissage de forme et le processus est difficile à contrôler analytiquement.
Les inhibiteurs et les niveleurs agissent comme des inhibiteurs, mais de différentes manières. Les inhibiteurs de type I tels que les inhibiteurs peuvent être désactivés par des agents éclaircissants, alors que les inhibiteurs de type II tels que les agents nivelants ne le peuvent pas, et le support est généralement un composé polyoxyalkylé de haut poids moléculaire. En général, ils s'adsorbent à la surface de la cathode et forment une couche mince en interagissant avec les ions chlorure, de sorte que le support diminue la vitesse de placage en augmentant l'épaisseur effective de la couche de diffusion. Les niveaux d'énergie à la surface de la cathode sont égalisés (il est possible d'utiliser localement le même nombre d'électrons pour le placage de tous les points de la surface de la cathode), ce qui conduit à une répartition plus uniforme de l'épaisseur du placage résultant.
D'autre part, les agents éclaircissants augmentent la vitesse de placage en réduisant l'effet inhibiteur. Il s'agit généralement de composés soufrés de faible poids moléculaire, également appelés affineurs de grains. Les agents nivelants sont généralement constitués de polymères azotés / ramifiés linéaires et de composés aromatiques hétérocycliques ou hétérocycliques, généralement de structure quaternaire (atome chargé positivement au centre et quatre substituants) qui sont susceptibles d'être adsorbés sélectivement à haute densité de courant, tels que des bords, des angles et un gonflement local, Évitez le cuivrage excessif dans les zones à haute densité de courant.
Méthode d'essai
Testé dans un bain de placage de 8L et un bain de test de 200l. Les anodes insolubles sont utilisées pour des densités de courant applicables plus élevées, un entretien facile et une distribution uniforme de la surface du cuivre. Après avoir configuré la solution de placage, la solution de placage est pseudo - plaquée à 1ah / L, analysée, ajustée à la concentration correcte d'additif, puis testée pour le placage. Chaque plaque d'essai est lavée à l'acide pendant 1 minute, à l'eau pendant 1 minute et marinée à l'acide sulfurique à 10% pendant 1 minute avant le placage.
Conditions de fonctionnement et composition du placage
La figure 1 montre les conditions opératoires et la concentration optimale en additif pour les deux formulations. Habituellement, la solution de placage de remplissage de trous borgnes a une teneur élevée en cuivre et une faible teneur en acide pour atteindre le remplissage de fond de trou souhaité.
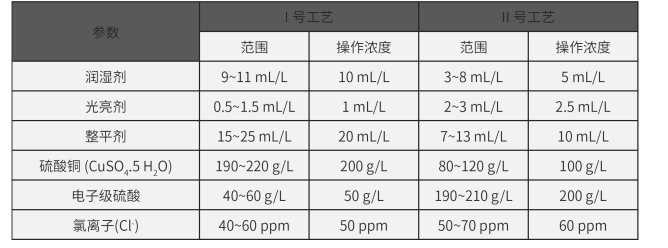
Figure 1 Composition du bain de placage et conditions de placage
Mécanisme de remplissage de trou borgne
Le taux de croissance du cuivre dans les trous borgnes et sur les plaques est contrôlé par des additifs. La figure 3 montre une représentation schématique de la croissance du cuivre à pores borgnes montrant les différents rôles joués par chaque additif. Lors du placage, des adsorptions sélectives et non sélectives peuvent se produire même lorsque l'adsorption se dilate localement. Les additifs doivent être contrôlés dans les limites de réglage indiquées dans le tableau 1 pour obtenir le « remplissage ascendant» souhaité. L'analyse peut être effectuée à l'aide d'outils d'analyse couramment utilisés dans l'industrie, tels que la Voltampérométrie cyclique (CVS) et les essais en chambre de Hall.
Sur la figure 3, le vert représente l'inhibiteur, le rouge l'agent nivelant et le jaune l'agent éclaircissant. Les molécules d'agent mouillant sont principalement adsorbées sur la surface, inhibant le placage dans celle - ci, tandis que l'agent de nivellement est sélectivement adsorbé dans la zone chargée négativement en raison du sel d'amine quaternaire chargé positivement, ce qui peut empêcher le placage excessif des bords et éviter la fermeture prématurée du trou borgne, entraînant la formation d'un trou au Centre. Un agent éclaircissant est une petite molécule contenant du soufre qui peut diffuser plus rapidement dans les trous borgnes pour accélérer le placage. Comme la géométrie des trous borgnes change constamment au cours du processus de placage, les agents brillants sont concentrés dans les trous traversants, ce qui entraîne un placage rapide des trous borgnes. C'est ce qu'on appelle le mécanisme de recouvrement accélérateur renforcé par courbure (CEAC).

Figure 3 Schéma du mécanisme CEAC
Enfin, lorsque le revêtement de cuivre dans le trou borgne est presque coplanaire avec la surface, les taux de revêtement dans le trou borgne et sur la surface deviennent égaux et le remplissage ascendant s'arrête. En fonction de l'intensité d'adsorption et de désorption de l'additif, l'agent lumineux peut ne pas diffuser comme prévu et des concentrations élevées d'agent lumineux continueront à accélérer le placage, entraînant un placage excessif connu sous le nom de « choc pulsé».
Mesure de contour de motif de précision
La figure 4 illustre le calcul du taux de profil, défini comme le rapport, exprimé en pourcentage, entre la différence de hauteur entre le point le plus bas et le point le plus haut et la valeur de R, qui est la différence de hauteur entre la zone de Plot et la ligne fine, en prenant la plus petite des deux valeurs.
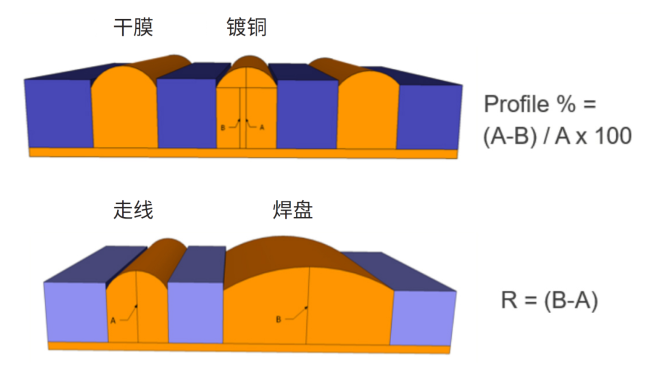
Figure 4 calcul du rapport de profil et de la valeur r
Comme le montre la figure 5, la conception de procédé No.1 est conçue pour remplir les trous borgnes, ce qui donne une surface plane et un meilleur profil de ligne, et les conditions de placage sont optimisées. Pour obtenir la capacité de remplissage des pores borgnes requise, une concentration plus élevée de CuSO4 (200 g / l) est combinée à une concentration plus faible d'acide sulfurique (50 g / l).
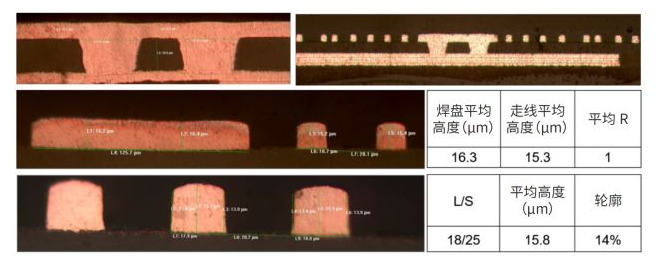
Figure 5 propriétés de placage typiques
Les caractéristiques typiques du procédé n°1 sont illustrées sur la figure 5 où les pores borgnes remplis ont une taille de 60 µm * 35 µm et une épaisseur de cuivre de 15 µm. Parce que le processus No.1 peut remplir les trous borgnes avec la plus petite concavité, aucune étape supplémentaire d'aplatissement n'est nécessaire. Le rapport de profil est généralement de l'ordre de 10 à 15%, cependant, dans certains cas, on observe que la situation réelle est comprise entre 15 et 20%, l'épaisseur cuivrée du fil étant de 15 µm à 16 µm et la valeur r comprise entre 1 et 2. Les Plots ont une forme plus carrée avec une surface plane et un câblage montrant un léger dôme.
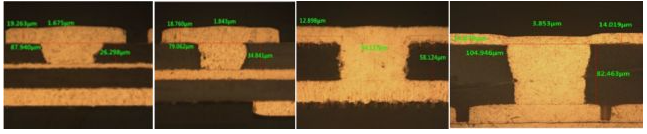
Figure 6 remplissage de trous borgnes de différentes tailles 90 îles x 25 îles, 80 îles x 35 îles, 90 îles x 60 îles et 100 îles x 80 îles
La capacité de remplissage de cette formule pour les trous borgnes de différentes tailles a été évaluée davantage. Quatre tailles différentes de trous borgnes ont été testées: 90 angströms x 25 angströms, 80 angströms x 35 angströms, 90 angströms x 60 angströms et 100 angströms x 80 angströms. Les résultats des tests sont présentés à la figure 6. Pour le remplissage de trous borgnes inférieurs à 90 ° m * 60 ° M, aucune concavité n'est observée, tandis que les plus grands trous borgnes de 100 ° m * 80 ° M ont une concavité de 4 ° m.
Étude de la durée de vie du liquide de placage
Après évaluation initiale des performances, le placage est vieilli à 150 AH / l avec un volume de cuve de 8 L. chaque cycle de placage est de 15 ASF pendant 45 minutes et les concentrations en additifs sont indiquées dans le tableau 1.
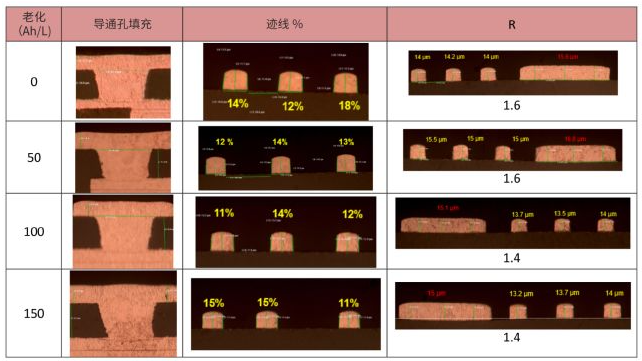
Durée de vie de la solution de placage
Au cours de l'essai de vieillissement en bain, les plaques d'essai sont galvanisées à des intervalles de 50 AH / L et des échantillons tranchés sont préparés et évalués au microscope. La plaque de test est composée de trous borgnes de 60 µm x 35 îlots m et de différentes voies L / S. Les conditions de placage sont ajustées pour obtenir une épaisseur d'environ 15 µm en surface. Tout au long du vieillissement, le profil du fil est compris entre 10 et 15% et occasionnellement entre 15 et 20%, ce qui est conforme aux résultats des tests de performance initiaux, avec des valeurs de R comprises entre 1 et 2 pour le placage de Plots plats.
La capacité de remplissage des trous traversants a été testée avec des plaques de 40 angströms et 60 angströms d'épaisseur. Les ouvertures des deux cartes sont respectivement de 40 et 50. Les résultats sont présentés à la figure 7. Le cycle de placage est 1.24asd et dure 60 minutes
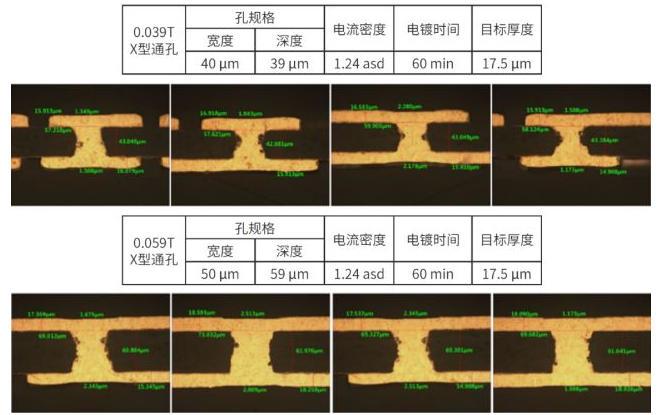
Capacité de remplissage des trous en forme de X
Résistance à la traction et allongement
Les deux caractéristiques physiques les plus importantes dans la fabrication de PCB sont la résistance à la traction et l'allongement des conducteurs en cuivre galvanisé, car ces caractéristiques indiquent les contraintes thermiques auxquelles le métal en cuivre peut résister lors de l'assemblage et de l'utilisation finale. Les propriétés physiques sont le résultat d'une combinaison d'additifs, y compris des inhibiteurs, des affineurs de grains et des agents de nivellement. Ces caractéristiques dépendent également de la vitesse de placage ou de la densité de courant, de la température de placage et de la morphologie cristalline. Par example, les dépôts denses de différentes directions cristallines présentent de meilleures propriétés physiques que les dépôts colonnaires.
Les propriétés physiques sont mesurées selon la méthode d'essai IPC TM - 650 standard 2.4.18.1, puis l'échantillon est coupé en bandes et cuit au four à 125 degrés Celsius pendant 4 à 6 heures. La bande d'échantillon est testée avec un testeur mécanique industriel et la résistance à la traction et l'allongement sont calculés avec les mesures de cet instrument. La figure 8 montre les résultats obtenus pour deux solutions de bain de vieillissement différentes: un bain de néoplaquage et un bain de vieillissement d'environ 100 AH / L. Les résultats montrent que ses caractéristiques ne changent pas beaucoup avec l'augmentation du temps de placage et qu'elles répondent aux exigences de la classe III de la norme IPC.
