Technologie d'encapsulation de puce de niveau Wafer
Wlcsp, également connu en anglais sous le nom de Wafer level Chip Packaging Technology, diffère des méthodes traditionnelles d'encapsulation de puces (scellé après découpe, augmentant le volume de la puce d'origine d'au moins 20% après Encapsulation). Cette dernière technologie consiste à encapsuler et à tester d'abord l'ensemble de la plaquette, puis à la découper en particules IC une par une, de sorte que le volume après Encapsulation est égal à la taille originale du cristal nu IC. Il est salué comme le courant dominant de la technologie d'emballage du futur. Parmi les fabricants qui ont déjà investi dans la recherche et le développement figurent FCT, aptos, Casio, epic, Fujitsu, Mitsubishi Electronics, etc.
Il effectue directement toutes les opérations sur la plaquette, mettant ainsi fin au processus de fabrication de la plaquette frontale. Lors de l'encapsulation de la puce, la puce est séparée de la plaquette, ce qui permet au wlcsp d'atteindre un volume d'encapsulation minimal avec la même taille de puce, ce qui est presque la technologie ultime de miniaturisation de l'encapsulation.
La technologie d'encapsulation au niveau de la puce au niveau de la plaquette, qui intègre la technologie des dispositifs passifs à couche mince et la technologie de fabrication de spécifications de grande surface, offre non seulement une solution économique, mais également un facteur de forme cohérent avec les processus d'assemblage en surface existants. La technologie d'encapsulation au niveau de la puce fournit non seulement une feuille de route pour l'amélioration des performances, mais réduit également la taille des dispositifs passifs intégrés.
Depuis l'annonce de la faisabilité de la technologie wlcsp en 1998, divers types de wlcsp sont apparus sur le marché ces dernières années. Cette technologie a été appliquée aux appareils électroniques mobiles, tels que les puces d'alimentation des téléphones portables, et s'est étendue aux applications de produits logiques.
Wlcsp est une variante de la technologie d'interconnexion par puce inversée. Avec l'aide de la technologie wlcsp, la surface active de la puce nue est inversée et fixée au PCB avec des billes de soudure. La taille de ces billes de soudure est généralement suffisamment grande (300 au pas de 0,5 mm et au pré - reflux) pour que le procédé de remplissage par le bas nécessaire à l'interconnexion des puces inversées puisse être omis.
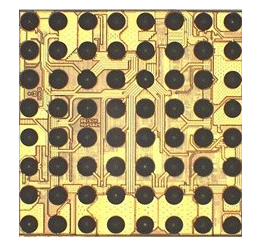
Encapsulation wlcsp
Le wlcsp peut être divisé en deux types de structure: les bosses directes et les couches redistribuées (RDL)
Ventilation directe
Le Plot direct wlcsp contient une couche organique optionnelle (polyimide) qui sert de tampon de contrainte sur la surface du noyau actif. Le Polyimide couvre toute la zone de la puce nue, à l'exception de la zone de la fenêtre autour des plots de connexion. Sur cette zone de fenêtre, une couche métallique de sous - Plots (UBM) est pulvérisée ou plaquée. L'UBM est un empilement de différentes couches métalliques comprenant une couche diffusante, une couche barrière, une couche mouillante et une couche antioxydante. Les billes de soudure tombent sur l'UBM (c'est - à - dire les billes dites de chute), puis les billes de soudure sont formées par soudage à reflux.
Couche de redistribution (RDL)
Redistribued layer (RDL) wlcsp cette technologie peut convertir des puces nues conçues pour les lignes de jonction (Les Plots de jonction sont disposés autour) en wlcsp. Contrairement au point convexe direct, ce wlcsp utilise deux couches de Polyimide. Une première couche de Polyimide est déposée sur la puce nue et maintient les plots de collage à l'état de fenêtre. La couche RDL transforme la matrice périphérique en matrice de zones par pulvérisation ou placage. La structure suivante est similaire à celle des plots directs et comprend une deuxième couche de Polyimide, UBM et des billes tombantes.
Avantages du wlcsp:
La manière dont le wlcsp est encapsulé réduit non seulement efficacement la taille du module de stockage, mais répond également aux exigences de densité élevée des appareils mobiles pour l'espace du fuselage; D'autre part, en termes de performances, il améliore la vitesse et la stabilité de la transmission de données. L'équipement d'assemblage SMT standard peut être utilisé sans processus de remplissage par le bas.
1. Taille minimale de la méthode d'emballage de puce originale:
La plus grande caractéristique de l'encapsulation de puce au niveau de la plaquette wlcsp est la réduction efficace du volume d'encapsulation, ce qui rend la forme d'encapsulation plus légère et plus mince. Il peut donc être adapté à un appareil mobile pour répondre aux exigences des caractéristiques des produits légers et courts.
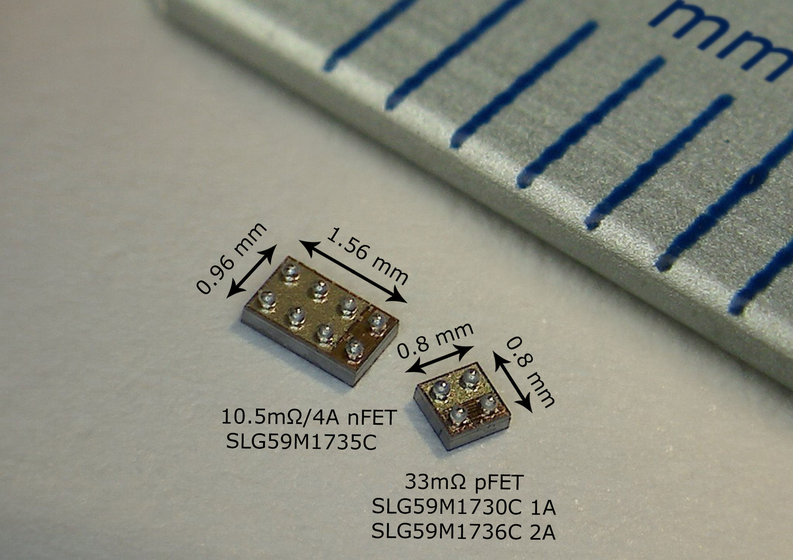
Emballage de taille minimale
2. Chemin de transmission de données court et haute stabilité:
Lors de l'utilisation de l'encapsulation wlcsp, il peut augmenter efficacement la fréquence de transmission des données, réduire la consommation de courant et améliorer la stabilité de la transmission de données en raison du câblage court et épais du circuit (lignes jaunes marquées a à b). Le taux de finition de l'assemblage est élevé en raison des caractéristiques d'auto - calibrage des feuilles nues légères lors du soudage.
3. Bonne dissipation de chaleur
Étant donné que le wlcsp a moins de boîtiers en plastique ou en céramique scellés traditionnels, il peut dissiper efficacement l'énergie thermique pendant le fonctionnement de la puce IC sans augmenter la température du corps. Cette fonctionnalité est d'une grande aide pour la dissipation de chaleur des appareils mobiles. Il peut réduire l'inductance et améliorer les performances électriques.
Wlcsp peut non seulement mettre en œuvre des technologies importantes de haute densité, d'encapsulation haute performance et de sip, mais joue également un rôle clé dans la technologie PCB embarquée du dispositif. Bien que le processus de collage de fil soit très mature et flexible, les circuits multicouches de la technologie wlcsp, les graphiques de fil fin et la combinaison avec le collage de fil suggèrent qu'il aura une application plus large et de nouvelles opportunités.
Inconvénients du wlcsp: le coût du wlcsp provient de l'usinage de la plaquette ou de l'encapsulation. Si la production de masse est nécessaire, il faut augmenter la main - d'œuvre. Cela augmentera les coûts de production en conséquence.
L'avenir de la technologie wlcsp
Le wlcsp a été utilisé dans les téléphones portables, les cartes mémoire, les navigateurs automobiles et les appareils numériques depuis son application aux montres électroniques en 2000. Dans les années à venir, il y aura plus de puces utilisant la technologie wlcsp sur les marchés mobiles haute performance tels que les téléphones mobiles.
La technologie wlcsp, combinée au processus PCB embarqué sur puce, peut garantir la stabilité de la qualité de l'assemblage du PCB. Cela est dû au fait que le wlcsp est non seulement facile à installer avec un PCB, mais possède également les caractéristiques d'une « bonne puce connue».
La technologie wlcsp offre encore plus de possibilités pour produire des appareils électroniques légers et compacts. Wlcsp a été appliqué à l'assemblage de cartes. Ces dernières années, il est également devenu un élément important du sip. Le MCP, qui combine le wlcsp et la technologie traditionnelle de liaison par fil, est également entré en production en série.
Tout au long de l'évolution du wlcsp au cours des dernières années, nous pouvons être sûrs que le wlcsp continuera à évoluer et à s'étendre à d'autres domaines dans un proche avenir.