Substrat d'encapsulation IC - PCB background Technology
Avec la tendance au développement de la miniaturisation, de la portabilité, de la multifonctionnalisation, de la faible consommation d'énergie et du faible coût des produits électroniques, la technologie d'emballage 2d (2d) ne peut plus répondre aux exigences et certains produits commencent à évoluer vers l'emballage 2.5D ou 3D. Dans une structure d'encapsulation 2.5D ou 3D, l'Association d'une plaque adaptatrice à base de silicium avec un substrat organique est une voie importante pour réaliser l'interconnexion puce - puce, puce - substrat.
Le processus traditionnel de fabrication de PCB pour le substrat d'adaptateur TSV est le suivant: 1) Faire des trous borgnes sur le substrat; 2) une couche de passivation sur la paroi latérale du via est déposée par PECVD sur une face du substrat; 3) dépôt sur le substrat d'une barrière d'adhérence / diffusion de paroi latérale traversante et d'une couche de germination métallique par Pulvérisation magnétron monoface; 4) Le remplissage métallique par trou traversant est terminé par un processus de placage; 5) aplatissement du métal par trou; 6) le métal traversant à l'arrière du substrat est exposé par amincissement; 7) Faire le câblage métallique, les Plots et leur couche de protection.
Les procédés traditionnels de préparation de substrats IC à transfert TSV présentent les inconvénients ou inconvénients suivants:
(1) l'uniformité de la couche de passivation de paroi latérale profondément poreuse déposée par PECVD est mauvaise. L'épaisseur de la couche isolante inférieure du trou profond n'est que d'environ 1 / 5 de l'épaisseur de la couche isolante supérieure et la couverture de la couche isolante inférieure est médiocre. Il est facile de créer des défauts discontinus qui affectent gravement l'effet d'isolation et la fiabilité. Ceci limite également la capacité de dépôt en rapport profondeur / largeur du procédé de dépôt de couche de passivation;
(2) Mauvaise uniformité de la barrière d'adhérence / diffusion et de la couche de germination sur les parois latérales profondément poreuses déposées par Pulvérisation magnétron. L'épaisseur du fond du trou profond n'est que d'environ 1 / 5 de l'épaisseur du haut. La couverture au fond des trous profonds est faible. Les défauts discontinus sont susceptibles de se produire et de provoquer des cavités lors du placage, ce qui affecte gravement la fiabilité des vias. Actuellement, les équipements de Pulvérisation magnétron les plus avancés ont une capacité de dépôt inférieure à 15: 1, ce qui limite la capacité de dépôt des TSV;
(3) Lorsque le rapport d'aspect du trou profond est de 20: 1 - 30: 1, il est difficile de réaliser le processus de remplissage de placage non poreux, la grande ouverture occupera la zone d'assemblage des éléments, réduisant la zone de câblage et ne favorisant pas l'emballage à haute densité;
(4) limité par le processus traditionnel de fabrication de substrat de transfert TSV, l'épaisseur du substrat de transfert est généralement inférieure à 200 μm. Il ne peut être utilisé que comme substrat de transfert et ne peut pas être assemblé directement avec la plaque entière;
(5) Le coût élevé de la plaque de transfert TSV, le processus d'emballage est complexe et il n'y a pas d'avantage de coût dans de nombreuses technologies d'emballage;
(6) Les plaques de transfert TSV ont des problèmes de fiabilité en raison des différences physiques entre le silicium et le matériau du substrat organique, ce qui rend difficile l'intégration de la structure;
(7) Les substrats organiques ordinaires peuvent répondre aux exigences d'encapsulation de densité générale, mais ne peuvent pas atteindre les exigences d'encapsulation de densité ultra - élevée (telles que l'installation inversée de billes espacées de moins de 55 µm).
Le but de ce modèle d'utilité est atteint comme suit:
La structure du substrat d'encapsulation IC comprend un substrat commun dont la face supérieure du substrat commun est pourvue d'une pluralité de Plots I et dont la face inférieure est pourvue de plusieurs Plots II,
Il comprend également un substrat à très haute densité, une puce à haute densité, une puce à faible densité et une couche d'encapsulation I. la couche d'encapsulation I est disposée sur la face supérieure d'un substrat ordinaire. Un substrat à très haute densité constitué de plusieurs couches métalliques de recâblage à haute densité et de couches isolantes sélectivement espacées, la face supérieure étant pourvue de Plots, deux ou plusieurs couches métalliques de recâblage à haute densité étant sélectivement reliées électriquement entre elles, le substrat à très haute densité étant noyé dans la couche d'encapsulation I, Et dont la face supérieure et les Plots sont exposés de la couche d'encapsulation I, et une partie des plots de la face supérieure du substrat à très haute densité est connectée en inverse à la puce à haute densité, plusieurs électrodes métalliques externes du substrat étant formées en dehors des zones verticales de la puce à haute densité, La face supérieure d'une partie de l'électrode métallique externe du substrat est connectée en inverse à la puce de faible densité, la face inférieure de l'électrode externe du substrat étant connectée à une partie des plots I du substrat commun par des trous borgnes pénétrant dans la couche d'encapsulation I et du métal dans les trous borgnes, Une partie de la face inférieure de l'électrode métallique externe du substrat est reliée à une partie des plots du substrat à très haute densité et les Plots II sont munis de plots de soudure. La largeur de ligne / pas de ligne de la couche métallique de recâblage haute densité du substrat ultra haute densité de ce modèle d'utilité est inférieure à 6 / 6 µm. Alternativement, la couche métallique de recâblage haute densité du substrat ultra haute densité a une largeur de ligne / pas de ligne de 5 / 5 µm, 3 / 3 µm ou 1,8 / 1,8 µm. Alternativement, le nombre de couches de la couche métallique de recâblage haute densité du substrat ultra haute densité est de 6, 7 et 8. Ce modèle d'utilité comprend également une couche d'encapsulation II recouvrant les parties exposées de la puce haute densité, de la puce basse densité, du substrat haute densité, de la couche d'encapsulation I et de l'électrode métallique externe du substrat. Alternativement, il comporte également des Vias traversant la gaine I et le substrat commun, l'intérieur des Vias étant rempli de métal, la face inférieure d'une partie de l'électrode métallique externe du substrat étant reliée à une partie des plots II du substrat commun par le métal dans les vias.
Les effets bénéfiques de ce modèle d'utilité sont:
La structure de substrat d'encapsulation à densité mixte de ce modèle d'utilité utilise un substrat organique à ultra haute densité au lieu de la couche d'interpolation de silicium, noyé dans une structure de substrat organique ordinaire, offrant une plus petite largeur de ligne / espacement de ligne et plus de couches de la couche métallique de recâblage à haute densité, Ainsi, l'encapsulation intégrée de plusieurs puces haute densité et de puces basse densité dans la même zone d'encapsulation peut non seulement raccourcir efficacement le chemin de transmission de l'information, mais également réaliser plus de fonctions, plus de puissance et plus de fils, favorisant une transmission de signal plus rapide, s'adaptant ainsi à l'amélioration rapide et rapide des composants semi - conducteurs IC, Haute capacité à haute fréquence, réduisant encore l'épaisseur globale de l'emballage, est une technologie d'emballage flexible rentable, adaptée à de nombreuses applications de haute performance influencées par l'espace;
Ce modèle d'utilité tire pleinement parti des caractéristiques flexibles du substrat ultra haute densité, améliore la fiabilité de l'emballage et favorise l'amélioration du rendement du produit fini.
Parmi ceux - ci: substrat ultra haute densité 10, électrode métallique externe 110, trous borgnes 150, trous traversants 170, substrat ordinaire 20, plots I 230, plots II 250, billes de soudure 251, gaine I 310, gaine II 430, puce haute densité 51, puce basse densité 53, gaine II 610.
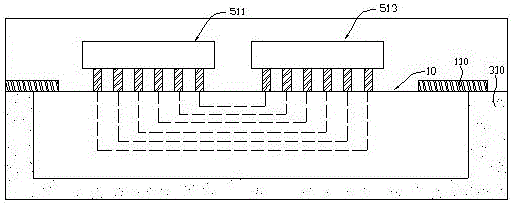
Exemples de modes de mise en œuvre spécifiques
Par substrat universel IC 20, on entend de manière générale le matériau de base utilisé pour fabriquer IC un substrat d'encapsulation électronique et une carte mère portant des composants électroniques. Il a trois fonctions de conduction, d'isolation et de support. En général, le substrat est un stratifié recouvert de cuivre. Par traitement sélectif des trous, cuivrage chimique, cuivrage, gravure, etc., on obtient des figures de circuit sur le substrat et on forme plusieurs Plots i230 et plusieurs Plots 2250 sur la face supérieure du substrat commun 20. Typiquement, l'espacement largeur / ligne des couches métalliques du substrat commun 20 est de 40 / 40 µm, 20 / 20 µm et 8 / 8 µm, et dans le cas limite, l'espacement largeur / ligne peut atteindre 10 / 10 µm. La structure du substrat d'encapsulation du présent modèle d'utilité est disposée au - dessus du substrat commun 20 du substrat 10 à très haute densité présentant des propriétés de flexibilité. Le substrat 10 à très haute densité est constitué de plusieurs couches métalliques de recâblage à haute densité et de couches isolantes espacées sélectivement entre elles. Il existe une connexion électrique sélective entre deux ou plusieurs couches métalliques de recâblage haute densité. Les Plots sont disposés sur la face supérieure du substrat ultra haute densité 10 et se caractérisent par leur légèreté, leur finesse, leur résistance aux chutes et leur plasticité de forme élevée. On voit que le substrat uhd 10 présente une distance largeur / ligne plus faible, un plus grand nombre de couches de couches métalliques de recâblage haute densité et un film métallique de recâblage par unité de surface plus dense que le substrat ordinaire 20. Il s'agit donc d'un substrat 10 dit ultra haute densité dont l'épaisseur totale ne dépasse pas 100 µm, ce qui est favorable à une réduction de l'épaisseur globale d'encapsulation IC.
Le substrat d'encapsulation de ce modèle d'utilité utilise la technologie de traitement au niveau de la plaquette, ne nécessite pas l'utilisation d'un processus TSV complexe, évite une série de problèmes tels que le processus de placage de trous profonds, l'application du substrat IC flexible à ultra haute densité 10 améliore la fiabilité de l'encapsulation et favorise l'amélioration de la performance du produit.