Metodi di processo differenti del foro laser CO2 che forma sul circuito HDI
Ci sono due metodi principali per la perforazione laser CO2: metodo diretto di formazione del foro e metodo di formazione del foro della maschera di forma.
Il cosiddetto processo di formatura diretta del foro consiste nel regolare il diametro del raggio laser allo stesso diametro del foro sul circuito stampato attraverso il sistema di controllo principale dell'apparecchiatura e direttamente elaborare il foro sulla superficie del mezzo isolante senza foglio di rame.
Il processo di rivestimento consiste nel rivestire la superficie del circuito stampato con una maschera speciale. Il processo tradizionale consiste nel rimuovere la finestra di rivestimento formata sulla superficie del foglio di rame sulla superficie del foro mediante l'esposizione/sviluppo/processo di incisione e quindi irradiare il foro con un raggio laser più grande dell'apertura per rimuovere la resina dello strato dielettrico esposto.
La loro descrizione è la seguente:
(1) Il diametro del processo precedente è lo stesso del diametro della finestra di rame. Se l'operazione non è attenta, la posizione della finestra aperta diverrà, il che causerà il problema di disallineamento con il centro del telaio. La deviazione della finestra di rame può essere dovuta all'aumento e al restringimento del materiale del substrato e alla deformazione del film utilizzato per la trasmissione dell'immagine. Pertanto, il processo di apertura di una grande finestra di rame consiste nell'espandere il diametro della finestra di rame a circa zero. 05mm (di solito determinato in base alla dimensione dell'apertura, quando l'apertura è di 0,15mm, il diametro del pad inferiore dovrebbe essere di circa 0,25mm e il diametro della grande finestra è di 0,30mm). 15 mm, il diametro del pad inferiore dovrebbe essere di circa 0. 25 mm, il diametro della grande finestra è di 0,30 mm), e quindi utilizzare la perforazione laser per bruciare i micro fori ciechi sul telaio. La sua caratteristica principale è il grande grado di libertà e il foro può essere formato secondo la procedura del cuscinetto del sottopiede durante la perforazione laser. Ciò può efficacemente evitare la deviazione causata dal diametro della finestra di rame e dal diametro del foro che sono gli stessi, in modo che il punto laser non possa essere allineato con la finestra, in modo che molti semifori incompleti o fori residui appaiano sulla superficie della grande piastra.
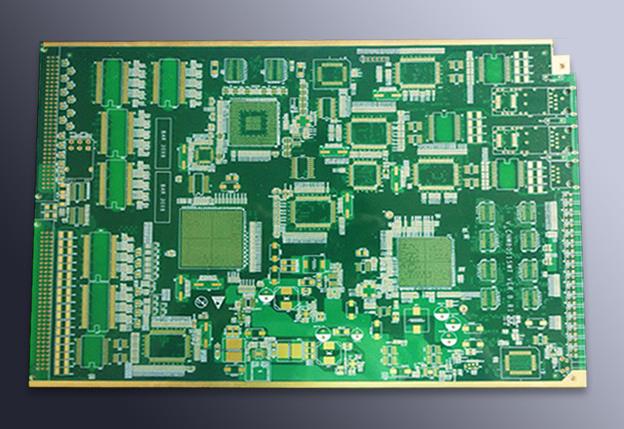
(2) Metodo della finestra di rame: In primo luogo, uno strato di RCC (foglio di rame rivestito in resina) è formato sulla finestra di vetro con metodo fotochimico, e poi la resina è incisa ed esposta, e poi il laser è sparato in un micro foro cieco. Quando il fascio è rinforzato, passa attraverso l'apertura Raggiungere due serie di specchi micro-mobili elettrometrici, e quindi raggiungere l'area del tubo di eccitazione attraverso l'allineamento verticale (obiettivo Fθ), e quindi bruciare piccoli fori ciechi uno per uno. Dopo che il fascio rapido dell'elettrone è posizionato all'interno dell'area di un tubo quadrato da 1 pollice, il foro cieco è di 0,15 mm e può essere sparato nel foro tre volte in successione. La larghezza dell'impulso della prima pistola è di circa 15μ, e fornisce energia per raggiungere lo scopo di fare fori. Quest'ultima pistola viene utilizzata per pulire i residui e i fori di calibrazione sul fondo della parete del pozzo. La sezione trasversale SEM è di 0,15 mm. Il micro-foro cieco ha una buona capacità di controllo dell'energia del laser. Quando il telaio (disco di destinazione) è piccolo, il telaio (disco di destinazione) ha bisogno di grande layout o fori ciechi di secondo ordine, è difficile completare l'immagine a 45°.
(3) Nel processo di formazione diretta dei fori sulla superficie della resina, una varietà di metodi di perforazione laser sono utilizzati per la perforazione laser. A. Rivestire lo strato superiore del substrato con foglio di rame resina sul laminato interno e quindi incidere tutto il foglio di rame per fare che il laser CO2 formi direttamente fori sulla superficie della resina esposta e quindi esegua il trattamento del foro secondo il processo del foro di placcatura. B. Il substrato è fatto di FR-4 prepreg e foglio di rame invece di foglio di rame rivestito in resina. C. Preparazione di fogli di rame rivestiti in resina fotosensibile D. Utilizzare il film secco come strato dielettrico, e premere e incollare il foglio di rame. E. Il processo di rivestimento di altri tipi di pellicola calda e lamina di rame è fatto ricoprendo altri tipi di pellicola calda e lamina di rame.
(4) Utilizzando il processo di ablazione diretta ultra-sottile della lamina di rame, la lamina di rame della resina viene pressata su entrambi i lati del bordo centrale e dopo aver rivestito la lamina di rame della resina, lo spessore della lamina di rame è ridotto a 5 micron dal "metodo di semi-incisione", e quindi il trattamento di ossidazione nero utilizza il laser CO2 per formare fori. Il principio di base è che la superficie del foglio di rame dopo il trattamento di ossidazione assorbe l'intensità della luce. Sotto la premessa di aumentare l'energia del raggio laser CO2, i fori possono essere formati direttamente sulla superficie di foglio di rame ultrasottile e resina. Ma la cosa più difficile è come garantire che il "metodo di semi-erosione" possa ottenere uno spessore uniforme dello strato di rame, quindi occorre prestare particolare attenzione. Naturalmente, possiamo utilizzare il materiale lacrimale di rame posteriore (UTC), che è di circa 5 micron equivalente a un libro di lamina di rame.
Per questo tipo di lavorazione della lamiera, sono principalmente adottati i seguenti aspetti: Ciò è principalmente per presentare severi indicatori di qualità e tecnici per il fornitore del materiale ed è necessario garantire che la differenza nello spessore dello strato dielettrico sia compresa tra 51μm.
Perché solo assicurando l'uniformità dello spessore dielettrico del substrato della lamina di rame resina, l'accuratezza del modello del foro e la pulizia del fondo del foro possono essere garantite sotto la stessa energia laser.
Allo stesso tempo, nel processo successivo, devono essere utilizzate le migliori condizioni di processo di decontaminazione per garantire che il fondo del foro cieco sia pulito e privo di residui, che ha un buon impatto sulla qualità della placcatura elettrolitica e galvanica del foro cieco.
iPCB Circuit Co., Ltd. (iPCB®) si concentra principalmente su PCB ad alta frequenza a microonde, tensione mista ad alta frequenza, test IC multistrato ultra-alto, da 1 +~ a 6 + HDI, Anylayer HDI, substrato IC, scheda di prova IC, PCB rigido-flessibile e PCB FR4 multistrato ordinari ed ecc I prodotti sono ampiamente utilizzati in Industria 4.0, Comunicazione, Controllo Industriale, Digitale, Alimentazione Oower, Computer, Automobile, Medico, Aerospaziale, strumenti, contatori, Internet delle cose e altri campi. I clienti sono distribuiti in Cina e Taiwan, Corea del Sud, Giappone, Stati Uniti, Brasile, India, Russia, Sud-est asiatico, Europa e altre parti del mondo.