PCB プロセス チップ 包装 テクノロジー 詳細 explionエーnアット
1. bga(bすべて グリッド アレイ) はいエーlso呼ばれる C(PエーC) (gloビー トップ パッド エーrrエーyキャリア). A.ディスプレイ 所属球形 連絡先, 一つ の表面 マウント パッケージ. について背中 の<エー href=“エー_href_0“rget=”_blエーnk“>プリント回路基板, 球形 バンプ 生産 イン これディスプレイ モード まで置換 これピン, とLSIチップ はい組立 にあるフロント 側 のインted回路 板, そして封印 そば モールディング 樹脂 またはポッティング. アルだから既知 としてバンプ ディスプレイ キャリア(PAC)。これピン 缶 超える 200,どちら はいパッケージ の場合マルチピン LSI。これパッケージ ボディ 缶 しかもビー メイド 小さい 比QFP(Quadフラット 包装)。の場合例, a 360ピン BGAピン センター ディスタンス 1.5 mmはのみ 31 mm正方形; 中 304ピン QFPピン センター ディスタンス 0.5 mm=40 mmスクエア. BGAは確かにそうですない 有 まで心配 アバウト ピン 変形 ライク QFP。
このパッケージは,米国のモトローラ社が開発し,携帯電話やその他の装置で初めて採用され,パソコンで普及した。まず、BGAピン(バンプ)中心距離は1.5 mm、ピン数は225であった。500ピンのbgASを開発しているlsiメーカーもある。bgaの問題はリフローはんだ付け後の目視検査である。アメリカのモトローラ社は、OMPACとしてモールド樹脂で封止されたパッケージを指し、ポッティング法で封止されたパッケージをGPACと呼ぶ。
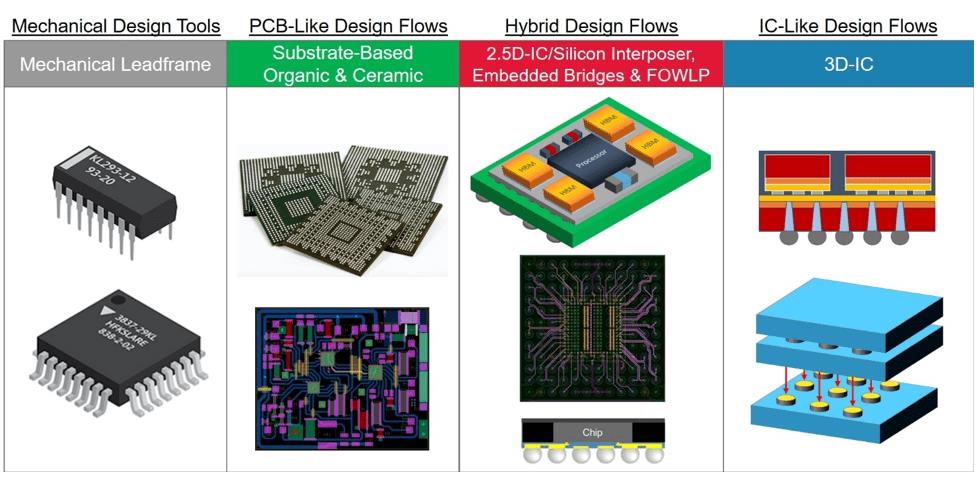
2.c≒1,4(セラミック)はセラミックパッケージのマークを表す。例えば、Cdipはセラミックディップを表します。それは実際にしばしば使用されるマークです。
3.コブ (チップ 船上)チップオンボード はい一つ の裸 チップ 取付 技術. これ半導体 チップ はい手渡し オーバー とマウント 公共関係についてインted回路基板。これ電気 接続 の間 これチップ および基板 はい実現 そば ワイヤー ステッチ とカバー ある樹脂 まで保証 信頼性. しかしコブ はい最も簡単な 裸 チップ 取付 テクノロジー, その包装 密度 はいファー 下 までタブ とフリップチップ 接着 テクノロジー.
4. ディップ (デュアル インライン パッケージ)
二重インライン パッケージ. 一つ のプラグイン パッケージ, これピン はい描画 から 両方 側 のパッケージ, およびパッケージ 材料 はいプラスチック とセラミック. ヨーロッパ 半導体 メーカー ほとんど 用途 ディル.
ディップ はい大部分 人気 プラグイン パッケージ, およびITSアプリケーション 範囲 含む 標準 論理 IC,メモリー LSI、およびマイクロコンピュータ 回路. これピン センター ディスタンス 2.54 mm数 所属ピン はいから 6~64。これパッケージ 幅は通常 15.2 mm。いくつか パッケージ ある幅 7.52 mmと10.16 mm呼ばれる 京大理 (skインnyデュアル インライン パッケージ) およびSL-ディップ (スリムデュアル インライン パッケージ) 狭い体 ディップ それぞれ. でも の中に大部分 ケース, なし 区別 はいメイド, とそれら はい単に 集合的に 参照 ASへディップ. イン 追加, セラミック ディップ 封印 ある低融点 ガラス そうだね呼ばれる セルディップ (4.2参照)。
4.1 dic(デュアルインラインセラミックパッケージ)セラミックパッケージのディップ(ガラスシールを含む)の別名。
4.2のCERディップ:電総研 ラム、DSP(すうじのシリコンシグナルプロセッサ)と他の回路のために使われるガラスで封をされる陶製デュアルインパッケージ。EPROMを内蔵した紫外線消去可能なEPROMとマイコン回路にガラス窓付きセルディップを使用した。ピン中心距離は2.54 mm、ピン数は8〜42である。日本では、ディップ - G(Gはガラスシール)として表現されています。
4.3 Sdip(収縮するデュアルインラインパッケージ)は、ディップを縮みます。プラグインのパッケージの一つは、ディップと同じですが、ピン中心距離(1.778 mm)はディップ(2.54 mm)より小さいので、これは呼ばれます。ピン数は14〜90である。セラミックスとプラスチックの2種類がある。SH - ディップ ( Shrinkデュアルインラインパッケージ)
5. flip-チップ
フリップようせつチップ. 一つ の裸 チップ実装技術 はいメイク メタル バンプ にある電極 面積 LSIのチップ, そして接続 これメタル バンプ まで電極 面積 にある印刷 基板 そば 圧力 溶接. これ足跡 のパッケージ b実際には同じ ASチップ サイズ. それは最小 と間抜けな すべての包装 技術. しかし, もし熱 膨張 係数 の基板 はい異なる から あれ LSIのチップ, 一反応 意志 発生する にあるジョイント, どちら 意志 影響 これ信頼性 の接続. したがって, はい必要 まで用途 樹脂 まで強化する LSIチップ、および用途 一基板 材料 あるほぼ これ同じ 熱 膨張 係数.
6. FP (flat パッケージ)
フラットパッケージ. 一つ 所属表面 マウント パッケージ. もう一つ 名称 QFPまたは芝 (QFPおよび芝). いくつか 半導体 メーカー 用途 この 名称.
7. H-(with ヒート シンク)
イン表示マーク がつくラジエーター. の場合例, 阪大 手段 SOPヒート ちんか.
8. MCM (マルチチップモジュール)
マルチチップコンポーネント. 小包一つどちら 複数 半導体ベアチップ アセンブリ配線 基板. に従って基板 材料, それは缶 はい分かれた に入るスリー カテゴリ 三菱重工, 産総研 と三菱電機. 三菱重工 はいコンポーネント 使用 一コモン ガラス エポキシ 多層 プリント回路基板. これ配線 密度 はいない 非常に 高い およびコスト はいロウ. 産総研 用途 厚い フィルム テクノロジー までフォーム 多層 配線, と用途 セラミック (アルミナ又はガラス セラミック) として基板 コンポーネント, どちら はい類似 まで厚い フィルム ハイブリッド IC使用 一多層 セラミック 基板. ありますなし 明白 差異 の間 これ二つ. これ配線 密度 はい高い 比三菱重工. 三菱電機 はい用途 所属薄型 フィルム テクノロジー までフォーム 多層 配線, あるセラミック (アルミニウム 酸化物 または窒化アルミニウム)またはSi、Al AS基板 コンポーネント. これ配線 スキーム はい最高 中 これスリー コンポーネント, でも これコスト そうだね高い.