Penjelasan terperinci teknologi pakej cip PCB
1.BGA (tatasusunan grid bola) juga dipanggil CPAC (pembawa tatasusunan pad atas globe). Paparan kenalan sferik, salah satu pakej lekap permukaan. Di belakang papan sirkuit cetak, bumps sferik dihasilkan dalam mod paparan untuk menggantikan pins, dan cip LSI dihasilkan di sisi depan papan sirkuit cetak, kemudian ditutup dengan membentuk resin atau potting. Juga dikenali sebagai pembawa paparan bump (PAC). Pin boleh melebihi 200, yang merupakan pakej untuk LSI berbilang pin. Tubuh pakej juga boleh dibuat lebih kecil daripada QFP (Pakej Flat Quad). Contohnya, BGA 360 pin dengan jarak tengah pin 1.5 mm hanya 31mm persegi, sementara QFP 304 pin dengan jarak tengah pin 0.5 mm adalah 40mm persegi. Dan BGA tidak perlu bimbang tentang deformasi pin seperti QFP.
Pakej ini telah dikembangkan oleh Syarikat Motorola Amerika Syarikat, dan pertama kali diadopsi dalam telefon portable dan peranti lain, dan kemudian terkenal dalam komputer peribadi. Pada awalnya, jarak pusat pin BGA (bump) adalah 1.5 mm, dan bilangan pin 225. Ada juga beberapa pembuat LSI yang mengembangkan BGA 500 pin. Masalahnya dengan BGA ialah pemeriksaan visual selepas penelitian semula. Syarikat Motorola Amerika merujuk kepada pakej yang ditutup dengan resin bentuk sebagai OMPAC, sementara pakej ditutup dengan kaedah pemotong dipanggil GPAC.
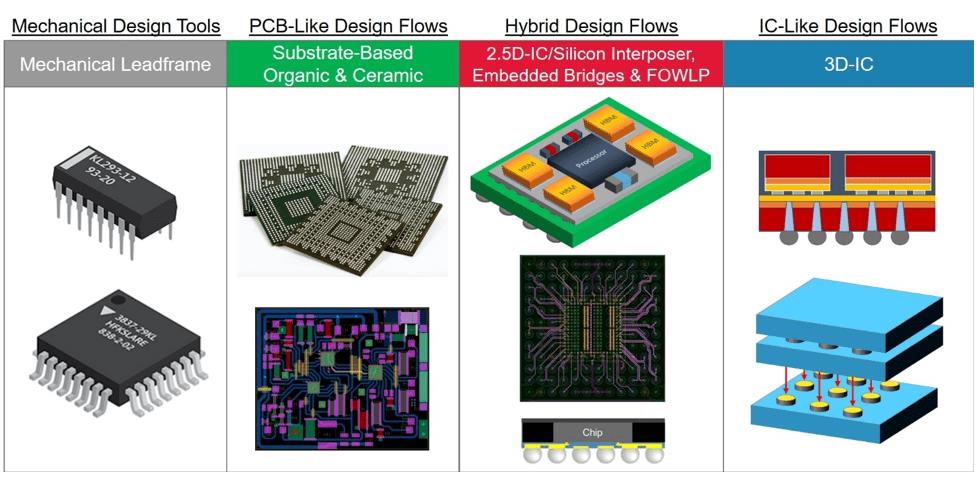
2.C ï¼( keramik) mewakili tanda pakej keramik. Contohnya, CDIP bermakna keramik DIP. Ia adalah tanda yang sering digunakan dalam latihan.
3.COB (cip di atas kapal) cip di atas pakej adalah salah satu teknologi pemasangan cip kosong. Cip setengah konduktor diserahkan dan diletak pada papan sirkuit cetak. Sambungan elektrik diantara cip dan substrat diselesaikan dengan jahitan wayar dan ditutup dengan resin untuk memastikan kepercayaan. Walaupun COB adalah teknologi pemasangan cip kosong paling sederhana, densiti pakejinya jauh lebih rendah daripada teknologi pengikatan TAB dan cip-flip.
4.DIP (pakej dalam baris dua)Pakej dalam baris dua. Salah satu pakej pemalam, pins dilukis dari kedua-dua sisi pakej, dan bahan pakej adalah plastik dan keramik. Pembuat semikonduktor Eropah kebanyakan menggunakan DIL. DIP adalah pakej pemalam paling popular, dan julat aplikasinya termasuk ICs logik piawai, LSIs ingatan, dan sirkuit mikrokomputer. Jarak pusat pin adalah 2.54 mm, dan bilangan pin adalah dari 6 hingga 64. Lebar pakej biasanya 15.2 mm. Beberapa pakej dengan lebar 7.52 mm dan 10.16 mm dipanggil SK-DIP (pakej dua dalam baris kurus) dan SL-DIP (pakej dua dalam baris kurus) DIP-sempit badan sesuai. Tetapi dalam kebanyakan kes, tiada perbezaan, dan mereka hanya secara kolektif disebut sebagai DIP. Selain itu, keramik DIP ditutup dengan kaca mencair rendah juga dipanggil Cerdip (lihat 4.2).
4.1DIC (pakej keramik dalam baris dua) Nama lain untuk DIP (termasuk segel kaca) pakej keramik.
4.2Cerdip:Pakej keramik dua-dalam-baris ditutup dengan kaca, digunakan untuk ECL RAM, DSP (pemproses isyarat digital) dan sirkuit lain. Cerdip dengan tetingkap kaca digunakan untuk EPROM yang boleh dipadam ultraviolet dan sirkuit mikrokomputer dengan EPROM di dalam. Jarak pusat pin adalah 2.54 mm, dan bilangan pin adalah dari 8 hingga 42. Di Jepun, pakej ini diekspresikan sebagai DIP-G (G bermakna segel kaca).
4.3SDIP (mengecilkan pakej dua dalam baris) Kurangkan DIP. Salah satu pakej pemalam, bentuk sama dengan DIP, tetapi jarak tengah pin (1.778mm) lebih kecil daripada DIP (2.54mm), jadi ia dipanggil ini. Bilangan pins berlainan dari 14 hingga 90. Ada dua jenis keramik dan plastik. Juga dikenali sebagai SH-DIP (mengecilkan pakej dua dalam baris)
5.flip-chipFlip-soldering cip. Salah satu teknologi pakej cip kosong adalah untuk membuat bumps logam di kawasan elektrod cip LSI, dan kemudian sambung bumps logam ke kawasan elektrod pada substrat cetak dengan penyelamatan tekanan. cap kaki pakej pada dasarnya sama dengan saiz cip. Ia adalah teknologi pakej yang paling kecil dan paling tipis. Namun, jika koeficien pengembangan panas substrat berbeza dari cip LSI, reaksi akan berlaku pada gabungan, yang akan mempengaruhi kepercayaan sambungan. Oleh itu, perlu menggunakan resin untuk menguatkan cip LSI, dan menggunakan bahan substrat dengan koeficien pengembangan panas yang sama.
6.FP (pakej rata)Pakej rata. Salah satu pakej lekap permukaan. Nama lain untuk QFP atau SOP (lihat QFP dan SOP). Beberapa pembuat setengah konduktor menggunakan nama ini.
7.H-(dengan sink panas)Menunjukkan tanda dengan radiator. Contohnya, HSOP bermakna SOP dengan sink panas.
8.MCM (modul berbilang-cip)Komponen berbilang-cip. Pakej di mana cip kosong semikonduktor berbilang dikumpulkan pada substrat kabel. Menurut bahan substrat, ia boleh dibahagi menjadi tiga kategori: MCM-L, MCM-C dan MCM-D. MCM-L adalah komponen menggunakan papan sirkuit cetak epoksi kaca biasa berbilang lapisan. Kepadatan kabel tidak terlalu tinggi dan biaya rendah. MCM-C menggunakan teknologi filem tebal untuk membentuk wayar berbilang lapisan, dan menggunakan keramik (alumina atau ceramik kaca) sebagai komponen substrat, yang sama dengan IC hibrid filem tebal menggunakan substrat keramik berbilang lapisan. Tidak ada perbezaan yang jelas antara kedua-dua. Kepadatan kabel lebih tinggi dari MCM-L. MCM-D adalah penggunaan teknologi filem tipis untuk membentuk wayar berbilang lapisan, dengan keramik (oksid aluminum atau nitrid aluminum) atau Si, Al sebagai komponen substrat. Skema kawat adalah yang tertinggi di antara tiga komponen, tetapi biaya juga tinggi.