異構3DIC仍面臨量產門檻
Although the 3DIC+TSV three-dimensional stacking technology can increase the density of the chip with the smallest area, 降低成本,縮小產品尺寸, 從而提高了晶片的效能和可靠性, 3星也是第一家推出同類3DIC堆疊NANDFlash閃存的公司, DDR3記憶體, 和堆疊寬度/桌上型電腦和筆記型電腦用ODRAM晶片.積體電路設計 高通公司和BroadComm等公司也引入了3DTSV科技來設計下一代高密度IC.
2.5D科技已廣泛應用於中央處理器/GPU/FPGA等邏輯運算晶片。 IBM/AMD 2.5D/3DIC科技將進一步推動DRAM、CIS、RF、LED和光電子元件等異構集成應用。 Yole International Semiconductor Association(SEMI)繼續實施3DTSV計畫,邀請惠普、IBM、英特爾、3星、高通、台積電、UMC、海力士、Atotech、(ASE、ST、3星、Micron、GlobalFoundries、NEXX、FRMC等行業積極投入3DIC研發和生產,構建了規格明確的3D產業鏈生態。
現時3DIC的集成應用仍然屬於同一制造技術、同質晶片(同質)集成,如DRAM、NANDFlash晶片或多核微處理器。 IEK預計,從今年(2013年)起,具有均勻堆疊的DRAM和NANDFlash等3DIC有望進入批量生產。 對於邏輯晶片(logic)、存儲晶片(DRAM)、射頻IC(RF)、功率放大器(PA)、光電轉換晶片等的異構集成,受到功耗和封裝資料係數等科技問題的限制。 它尚未被克服。
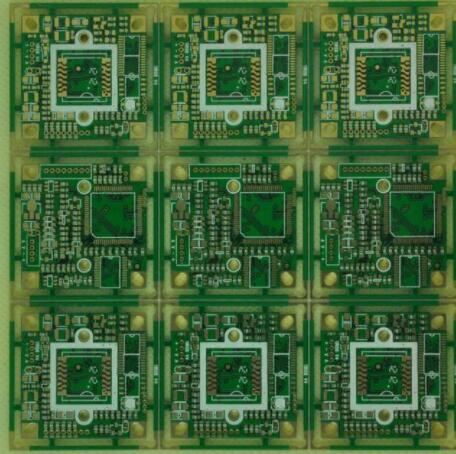
2.5D仲介科技率先將FPGA、GPU/APU引入量產
如前所述,3DIC用於異構集成。 它將具有不同邏輯過程和操作特性的裸矽晶片堆疊起來,並使用TSV(矽鑽孔)科技互連晶片。 當堆疊不同類型的晶片時,功耗和散熱問題將需要特殊處理。
如果只堆疊電壓為1V、功耗為2W的DRAM晶片,則啟動電流約為2安培。 如果在其上堆疊2GHz多核處理器CPU或圖形處理單元(GPU),則很容易需要數十瓦甚至更多的功率。 100瓦,輕啟動電流可能高達數十安培,這幾乎可以由汽車級電池來處理。 這種晶片對於移動便攜設備的設計是致命的; 它在如此有限和密集的區域提供大電流。 電源電路的佈線設計和電源晶片的選擇都是科技挑戰,甚至電流本身也是影響電路效率和穩定性的最大干擾源。
高頻操作CPU和 GPU晶片 通常可以加熱到120度. 然而, 當DRAM和NANDFlash晶片溫度超過85°C時, 重繪機制和存儲容差將异常. 如果CPU與DRAM結合使用, NANDFlash堆疊在一起, CPU的高熱會影響DRAM和NANDFlash; 此外, 像光電轉換裝置, 當溫度達到80°C或以上時,操作穩定性將大大降低. 也有不同類型的裸模資料. 堆疊在一起時, 必須考慮不同熱膨脹係數對封裝機理的熱應力影響, 甚至過熱也會導致疊層晶圓層變形,甚至錫開裂. 如何合理安排這些具有不同溫度特性的晶片的堆疊順序,使它們在散熱過程中不會相互影響,這是一個非常嚴峻的科技挑戰. 這就是為什麼3DIC, 已經批量生產, 首次出現在低功耗DRAM和NANDFlash等效堆疊產品中.
2.5DIC (or 2.5DInterposer) technology was first proposed by the factory leader (ASE), 後來成為一個術語 電晶體 工業. 方法是製作各種工藝的模具/工作特性未相互疊加, 但是平行排列並且彼此靠近, placed on the glass or silicon-based 材料 Interposer (interposer) for connection, 然後連接到底部 PCB電路板 縮短訊號延遲時間,提高系統整體效能; 每個平行模具可以單獨測試,然後並排穿孔和組裝. 它不需要經過高溫/電磁輻射試驗, as long as it is placed on the intermediate board ( Interposer) can go through an overall integration test after 包裝材料. 執行3DIC堆疊時, 熱的/必須對煙囪中的每一層進行電磁測試; 如果其中一個模具有缺陷, 必須報帳整個3DIC堆疊設備.
2.5DIC由 電晶體 產業作為過渡到未來3DIC的仲介科技. 除了使用插入器作為晶片之間的通信橋樑之外, 還必須注意諸如模具和插入器的組合等問題, 資料特性, 和熱應力. 與3DIC相比, 2.5DIC的科技瓶頸較低. The silicon interposer used in the circuit board (SIInterposer) generally does not need to use the 40nm or even 28nm advanced manufacturing process like the processor chip, 並且可以降低製造成本.
拿 Xilinx2.5D FPGA處理器晶片 例如. 裸體後28/40nm FPGA晶片並排排列, 它們被放置在65nm矽插入器上. 總成本低於之前的40nm甚至28nm SOC工藝. 因此, 2的應用領域.5DIC不限於記憶體晶片. FPGA等高效能、高集成度的邏輯計算晶片, CPU, GPU, 等., 已開始應用2.5DInterposer科技.
2.5D/3DIC killer應用
電晶體公司推出了2.5DIC concept into mass production are represented by the leading programmable logic gate array (FPGA) manufacturers Xilinx and Altera. Both companies use TSMC's CoWos (ChiponWaferonSubstrate) 2.5DIC科技. 像Xilinx的Virtex-72000TFPGA晶片, 28nm裸模並排緊密排列. 裸晶片下的微凸塊連接到65nm矽插入器. 之後, 它們通過TSV科技連接到焊球上,然後進行滲透. 將焊球連接到 PCB板 在下麵.
此外,與IBM Power8處理器、英特爾第四代Corei處理器(Haswell)和AMD的半定制8核APU匹配的IntelIrisPro5200(GT3e)圖形晶片也將使用2.5DIC封裝技術。
至於3DIC部分,除了DRAM晶片(WideI/O)和NANDFlash晶片的同質堆疊之外,Altera最近宣佈了下一代20nm FPGA產品,該產品將使用TSMC的下一代20nm工藝加上3DIC異質集成和堆疊科技。 集成了兩套以上的FPGA晶片、ARM多核處理器晶片、用戶可定制的硬拷貝ASIC晶片、可調精度的DSP數位信號處理器和多層堆疊式MemoryCube存儲晶片。
ASE、Silicon Products、Licheng和Nanmao佔據全球封裝和測試鑄造市場56%的份額,這也是3DIC產業鏈最後一英里的關鍵所在。 ASE採用半規範平臺的3DS-IC標準,並積極與DesignHouse和Foundry合作,完成DietoDie、DietoSiP疊加互連規範,以及3D堆疊、量測和封裝可靠性確認; 在鑄造廠、記憶體倉庫、包裝和測試3D載體板、夾具、工廠之間的保持程式,以及參與TSV晶片、JEDECJC-11WideI/O記憶體堆疊方法和3DQA品質保證相關規範。
此外,台積電還引進了2.5D/3DIC結構CoWoS(ChiponWaferonSubscriber)集成生產科技,提供TSV/3D、包括植球科技在內的各種凸點資料、矽仲介層(Si仲介層)和各種子系統集成等一站式服務。 同時,繼續投資2.5D/3DIC科技,加快EDA、IP、測試、設備、矽片供應商和封裝廠全產業鏈的引進。 UMC和下游包裝和測試工廠正在尋找一種開放式行業模型(OpeneCosystemodel)來開發3DIC科技。
IEK指出,在2010年之前,3DIC科技已經被引入NANDFlash和DRAM等記憶體存儲晶片中. 自2010年起, mass production of CIS (CMOS image sensor) and MEMS (microelectromechanical) components has also been introduced. There are applications such as power amplifier chip (PA), LED照明晶片 packaging, 光電轉換元件封裝. 2013年, 預計均勻多層存儲管和寬帶/ODRAM will be mass-produced; and the heterogeneous 3DIC (Heterogeneous 3DIC) integrating multi-core CPU, FPGA, ASIC, 記憶力, 光電元件預計將在2014年至2015年實際量產階段推出.