有許多包裝類型 半導體器件 s, 來自DIP, 標準操作程式, QFP, PGA公司公司, BGA到CSP到SIP. 技術指標一代比一代先進. 這些都是前人根據當時的裝配科技和市場需求開發的. 一般來說, 它有大約3大創新:第一次是在20世紀80年代從插針插入式封裝到表面貼裝封裝, 大大提高了印刷電路板的組裝密度; 第二次是在20世紀90年代, 球力矩正組件的出現不僅滿足了市場對高銷的需求, 而且大大提高了 半導體器件s 晶圓級封裝, 系統包裝, 晶片級封裝是該產品的第3項創新, 其目的是儘量減少包裝. 每種包裝都有其獨特的方面, 即其優點和缺點, 以及包裝材料, 包裝設備, 所使用的包裝科技因其需要而异. 持續發展的驅動力 電晶體 包裝是它的價格和效能.
概述 電晶體 設備包裝
電子產品包括半導體器件 (集成電路和分立器件), 印刷電路板, 電線, 整機機架, 外殼, 和顯示器. 集成電路用於處理和控制訊號. 分立器件通常是訊號放大和列印. PCB電路板 和電線用於連接訊號, 整機框架外殼用於支撐和保護, 顯示部分用作與人通信的介面. 因此, 半導體器件s是電子產品的主要和重要組成部分, 在電子行業享有“工業大米”的美譽.
我國在20世紀60年代開發並生產了第一臺電腦. 占地面積約100平方米或以上. 今天的可擕式電腦只有書包那麼大, 而未來的電腦可能只有鋼筆大小或更小. 電腦規模的迅速縮小及其功能的日益强大,充分證明了 電晶體 科技. 主要原因是:(1) 電晶體 晶片集成和晶圓製造(晶圓製造) 改進 光刻精度使晶片更加强大,尺寸變得更小; (2)改進電晶體 封裝技術極大地提高了 印刷線路板, 電子產品的數量大大新增. 降低.
改進電晶體 組裝科技(assembly technology)主要體現在其封裝類型(package)的不斷發展。 一般稱為組裝(assembly)可定義為:利用薄膜科技和微連接科技連接 電晶體晶片(晶片) 以及框架(引線框架)或基板(Sulbstrate)或塑膠板(Film)或印刷電路板的導體部分。為了引出接線引脚, 並用塑膠絕緣介質灌封固定, 形成整體3維結構的工藝科技. 具有電路連接功能, 物理支持和保護, 外場遮罩, 應力緩衝, 散熱,散熱, 超大和標準化. 從3極管時代的挿件封裝和20世紀80年代的表面貼裝封裝到當前的模塊封裝, 系統包, 等., 前人開發了許多包裝形式, 每種新的包裝形式都可能需要新的資料, 使用新工藝或新設備.
推動電晶體封裝不斷發展的動力是其價格和效能。 電子市場的最終客戶可分為3類:家庭用戶、工業用戶和國家用戶。 家庭用戶最大的特點是價格便宜,效能要求不高; 國內用戶對效能要求高,價格通常是普通用戶的幾十倍甚至幾千倍,主要用於軍事、航太等領域。; 工業用戶通常價格和效能都介於上述兩者之間。 低價格要求在原來的基礎上降低成本,這樣使用的資料越少越好,一次性產量越大越好。 高性能要求產品壽命長,並能承受高低溫和高濕度等惡劣環境。 電晶體製造商一直在努力降低成本,提高效能。 當然,還有其他因素,如環境保護要求和專利問題,迫使他們改變包裝類型。
2封裝的作用
封裝(Package)是晶片所必需的,也是非常重要的。 封裝也可以說是指用於安裝半導體積體電路晶片的外殼。 它不僅可以保護晶片並提高導熱性,還可以作為晶片內部世界與外部電路之間的橋樑,以及規範的一般功能。 封裝的主要功能有:
(1)實物保護。 因為晶片必須與外界隔離,以防止空氣中的雜質腐蝕晶片電路,導致電效能下降,保護晶片表面和連接導線等,從而保護較軟的晶片免受外力損壞和電或熱物理方面的外部損壞。 環境影響; 同時,晶片的熱膨脹係數通過封裝與框架或基板的熱膨脹係數相匹配,可以緩解外部環境變化(如熱)引起的應力和晶片熱引起的應力,從而防止晶片損壞失效。 根據散熱要求,封裝越薄越好。 當晶片功耗大於2W時,需要在封裝中添加散熱器或散熱器,以增强其散熱和冷卻功能; 當溫度為5~1OW時,必須採用強制冷卻。 另一方面,封裝晶片也更易於安裝和運輸。
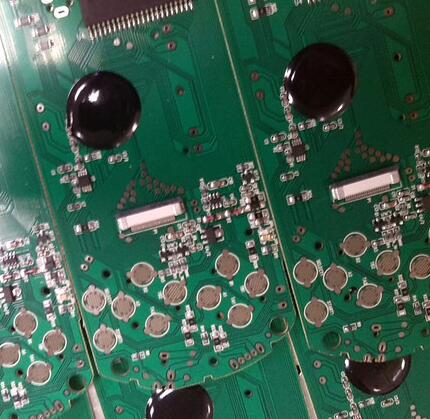
(2)電力連接。 封裝的尺寸調整(間距轉換)功能可以從晶片的極細引線間距調整到安裝基板的尺寸和間距,從而方便安裝操作。 例如,從以亞微米(當前低於0.13μ¼m)為特徵尺寸的晶片,到以10μ¼m為組織的晶片焊點,到以100μ¼m為組織的外部引脚,最後以毫米為組織列印。 電路板均由封裝儀錶實現。 這裡的封裝起到了從小到大、從難到易、從複雜到簡單的轉變作用,可以降低運營成本和材料成本,提高工作效率和可靠性,特別是通過實現佈線長度和阻抗比盡可能低以降低連接電阻, 寄生電容和電感,以確保正確的訊號波形和傳送速率。
(3)標準化。 規範的一般功能是指對封裝的尺寸、形狀、引脚數量、間距、長度等有標準規範,易於加工,易於與印刷電路板匹配。 相關生產線和生產設備具有通用性。 這對於封裝用戶、電路板製造商和電晶體製造商來說非常方便,並且易於標準化。 相比之下,裸晶片安裝和倒裝晶片安裝現時沒有這一優勢。 由於裝配科技的質量也直接影響到晶片本身的效能以及與其相連的印刷電路板(PCB)的設計和製造,對於許多集成電路產品來說,裝配科技是一個非常關鍵的部分。
3包裝分類
包裝 電晶體(包括集成電路 和離散設備) 經歷了幾代人的變化, 來自DIP, 標準操作程式, QFP, PGA, BGA到MCP,然後到SIP. 技術指標代代相傳, 包括晶片區和封裝區. 比率越來越接近1, 適用頻率越來越高, 耐溫性越來越好, the 引脚數量新增,銷 間距 减少,重量減輕, 提高了可靠性, 使用更方便. 有多種類型的套裝軟體, 每種類型的套裝軟體都有其獨特的功能, 即其優點和缺點. 當然, 包裝材料, 包裝設備, 所使用的包裝科技因其需要而异.