Công nghệ đóng gói chip xử lý PCB Chi tiết
1. BGA (mảng lưới bóng) còn được gọi là CPAC (tàu sân bay mảng tấm trên cùng). Hiển thị tiếp xúc hình cầu, một trong những gói gắn trên bề mặt. Ở mặt sau của bảng mạch in, một quả bóng lồi được tạo ra ở chế độ hiển thị thay vì pin và chip LSI được lắp ráp ở mặt trước của chất nền mạch in, sau đó được niêm phong bằng nhựa đúc hoặc bầu. Còn được gọi là Convex Display Carrier (PAC). Pin có thể vượt quá 200, đây là gói LSI đa pin. Các gói cũng có thể được thực hiện với kích thước nhỏ hơn QFP (Quad Flat Package). Ví dụ, một BGA 360 pin với khoảng cách trung tâm pin là 1,5mm chỉ có hình vuông 31mm, trong khi QFP 304 pin với khoảng cách trung tâm pin là 0,5mm là hình vuông 40mm. Và BGA không phải lo lắng về biến dạng pin như QFP.
Được phát triển bởi công ty Motorola của Mỹ, gói phần mềm này lần đầu tiên được áp dụng trong điện thoại di động và các thiết bị khác, sau đó phổ biến trong máy tính cá nhân. Ban đầu, khoảng cách trung tâm của chân BGA (lồi) là 1,5mm và số chân là 225. Ngoài ra còn có một số nhà sản xuất LSI đang phát triển BGA 500 chân. Vấn đề với BGA là kiểm tra trực quan sau khi hàn trở lại. Công ty Motorola của Mỹ sẽ gọi gói niêm phong bằng nhựa đúc là OMPAC, trong khi gói niêm phong bằng phương pháp chiết rót được gọi là GPAC.
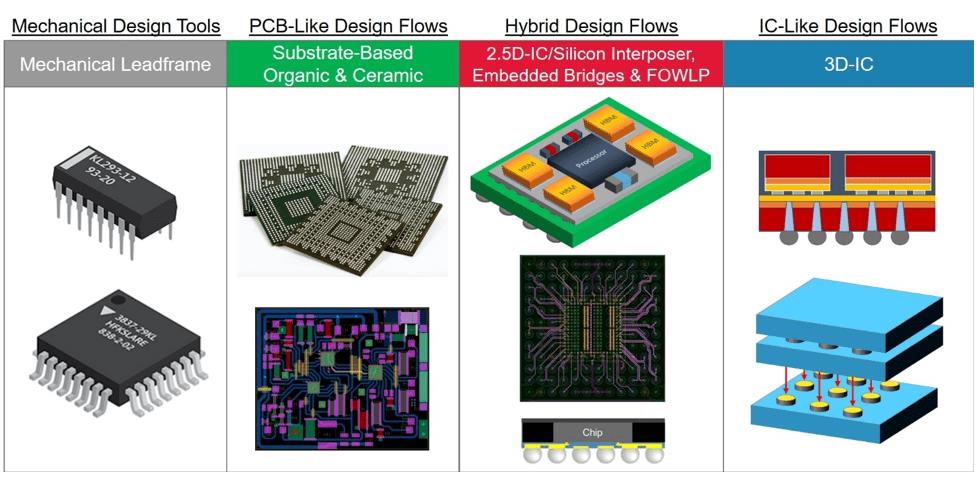
2. Cï¼ (gốm) đại diện cho dấu hiệu của bao bì gốm. CDIP là viết tắt của Ceramic DIP. Đây là một dấu hiệu thường được sử dụng trong thực tế.
COB (chip-on-board) đóng gói chip là một trong những công nghệ gắn chip trần. Các chip bán dẫn được bàn giao và lắp đặt trên bảng mạch in. Kết nối điện giữa chip và chất nền được thực hiện thông qua các đường may và được phủ bằng nhựa để đảm bảo độ tin cậy. Mặc dù COB là công nghệ gắn chip trần đơn giản nhất, mật độ đóng gói của nó kém hơn nhiều so với TAB và công nghệ gắn chip ngược.
4. DIP (Double Column Straight Pack) Bao bì hai cột thẳng. Một trong những gói plug-in, với các chân được rút ra từ cả hai bên của gói, vật liệu đóng gói là nhựa và gốm. Các nhà sản xuất chất bán dẫn châu Âu chủ yếu sử dụng DIL. DIP là gói plugin phổ biến nhất và phạm vi ứng dụng của nó bao gồm IC logic tiêu chuẩn, LSI bộ nhớ và mạch máy vi tính. Khoảng cách trung tâm của pin là 2,54mm và số lượng pin từ 6 đến 64. Chiều rộng gói thường là 15,2mm. Một số gói có chiều rộng 7,52mm và 10,16mm được gọi là SK-DIP (Thin Double Column Straight Pack) và SL-DIP (Thin Double Column Straight Pack) Narrow Body DIP. Nhưng trong hầu hết các trường hợp, không có sự khác biệt, chúng chỉ được gọi chung là DIP. Ngoài ra, DIP gốm được niêm phong bằng thủy tinh có điểm nóng chảy thấp còn được gọi là Cerdip (xem 4.2).
4.1DIC (Double Row Direct Plug Ceramic Pack) Một biệt danh cho gói gốm DIP (bao gồm cả con dấu thủy tinh).
4.2Cerdip: Gốm hai cột thẳng đóng gói niêm phong bằng thủy tinh cho các mạch như RAM ECL, DSP (Bộ xử lý tín hiệu kỹ thuật số), v.v. Cerdip với cửa sổ kính được sử dụng trong các mạch máy vi tính có tia cực tím có thể xóa EPROM và EPROM tích hợp. Khoảng cách trung tâm của pin là 2,54mm và số lượng pin từ 8 đến 42. Tại Nhật Bản, bao bì này được ký hiệu là DIP-G (G là con dấu thủy tinh).
4. 3SDIP (Shrink Double Column Direct Plug Pack) Shrink DIP. Một trong những gói plug-in có hình dạng giống như DIP, nhưng khoảng cách trung tâm pin (1,778mm) nhỏ hơn DIP (2,54mm), do đó được gọi là. Số pin từ 14 đến 90. Có hai loại gốm và nhựa. Còn được gọi là SH-DIP (Shrink Double Column Direct Plug Pack)
5. Lật chip lật chip. Một trong những kỹ thuật đóng gói chip trần là tạo ra các vết lồi kim loại trong vùng điện cực của chip LSI, sau đó gắn các vết lồi kim loại vào vùng điện cực trên bề mặt in thông qua hàn áp lực. Dấu chân của gói về cơ bản giống như kích thước của chip. Đây là công nghệ nhỏ nhất và mỏng nhất trong tất cả các công nghệ đóng gói. Tuy nhiên, nếu hệ số giãn nở nhiệt của chất nền khác với tốc độ giãn nở nhiệt của chip LSI, phản ứng sẽ xảy ra tại điểm nối, điều này sẽ ảnh hưởng đến độ tin cậy của kết nối. Do đó, cần phải sử dụng nhựa để tăng cường chip LSI và vật liệu cơ bản có cùng hệ số giãn nở nhiệt.
6. FP (Flat Pack) đóng gói phẳng. Một trong những gói cài đặt bề mặt. Một tên gọi khác cho QFP hoặc SOP (xem QFP và SOP). Một số nhà sản xuất chất bán dẫn sử dụng tên này.
7. H - (với tản nhiệt) cho biết dấu hiệu với tản nhiệt. Ví dụ, HSOP là viết tắt của SOP với bộ tản nhiệt.
8. MCM (mô-đun đa chip) thành phần đa chip. Một gói trong đó nhiều chip bán dẫn trần được lắp ráp trên một chất nền dây. Theo vật liệu cơ bản, nó có thể được chia thành ba loại: MCM-L, MCM-C và MCM-D. MCM-L là một thành phần sử dụng bảng mạch in nhiều lớp nhựa epoxy thủy tinh thông thường. Mật độ cáp không cao lắm và chi phí thấp. MCM-C sử dụng công nghệ màng dày để tạo thành dây nhiều lớp và sử dụng gốm (alumina hoặc gốm thủy tinh) làm cụm lót, tương tự như IC trộn màng dày sử dụng lớp lót gốm nhiều lớp. Không có sự khác biệt rõ ràng giữa hai. Mật độ dây cao hơn MCM-L. MCM-D sử dụng công nghệ màng mỏng để tạo thành hệ thống dây nhiều lớp với gốm (alumina hoặc alumina nitride) hoặc silicon, nhôm làm thành phần lót. Sơ đồ cáp là cao nhất trong ba thành phần, nhưng cũng tốn kém.