BGA'nın tam adı "Ball Grid Array" demek oluyor. Yani bir PCB, topu grid dizisi yapısı ile. Organik taşıyıcıları kullanarak integral devreler için bir paketleme metodu. BGA ile PCB tahtalarının genellikle daha küçük delikleri vardır, ve BGA delikten a şağıdaki bGA genellikle 8-12 mil diametriyle tamamlanmış bir delik olarak tasarlanır. BGA delikten aşağı düşük bağlanması gerekiyor, sol patlaması inkele edilmesi izin verilmez ve sol patlaması boğulmaz.
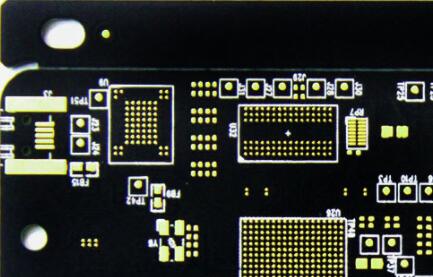
BGA, solder topu tablosu paketleme yöntemini kullanan bir komponent türüdür. Devre tahtasıyla bağlantılı devre tahtasıyla bağlantılı devre tahtasının altında soluk topları üretir. BGA komponentleri devredeki büyük bir sürü pinler, yüksek paketleme yoğunluğu, daha güçlü fonksiyonluluğu ve daha yüksek güveniliği için uygun. BGA'nın CPU genellikle laptoplarda kullanılır.
BGA plak tasarımı için genel kurallar
1) Solder tuvaletinin elması genellikle solder topunun elmasından daha küçüktür. Güvenilir bir adhesion elde etmek için genellikle %20-25'e düşürülür. Solder patlaması daha büyük, iki patlama arasındaki uçuş alanı daha küçük.
2) BGA aparatının patlaması PCB'deki patlaması ile aynı diametri var.
3) BGA'nin soldaşın dizaynı şablon açılışının çöplüklerinin çöplüklerinin â™137 sızıntısını sağlaması gerektiğini sağlamalıdır; ¥ 0.08mm3, bu da soldaşın bağlantısının güveniliğini sağlamak için en az gerektiğini sağlamalıdır.
BGA Paket İşlemi Prensipi
BGA paketlemesinin ana süreci akışı solder topu üretimi, substrat üretimi, çip bağlaması, paketleme solidifikasyonu ve paketlemeyi içeriyor.
1) Solder Ball üretimi: Yüksek temizlik tin-lead alloy ya da soğuk topu üretilmek için, sıradan bir sferik pine çizgisini oluşturuyor.
2) Üstüne üretim: Yüksek yoğunluklara ve yüksek performanslı elektrik bağlantısına ulaşmak için çoklu katı basılı devre tahtalarını kullanarak.
3) Chip bağlantısı: Chip'i substrat'e bağlayın ve kırmızı serbest veya ön tabanlı solder kullanarak substrat'e bağlayın.
4) Paketleme ve kurma: Çip, çevre etkisinden korumak için epoksi resin ile kaplanmış.
5) Paket paketi: Paket paketi ayrı BGA paketlerine kesin.
BGA Paket Teknikleri
1. Pad tasarımı: Güvenlik kalitesini ve güveniliğini sağlamak için, pad tasarımı bazı rehberlerine uymalı. İlk olarak, solder topunun boyutunu solder topu ile eşleştirmesini sağlamak gerekiyor. İkinci olarak, sıcak genişleme ve kontratlama üzerinde patlama şeklinin ve düzenlemenin etkisi düşünmeli. Sonunda, kaldırma güveniliğini geliştirmek için yukarıdaki yeryüzü tedavisine de dikkat vermelidir.
2. Karışma süreci: BGA karışması genellikle yeni çözüm teknolojisini kullanır. Kutlama kalitesini sağlamak için, kuşlama sıcaklığını, zamanı ve ateş sıcaklığını kontrol etmek gerekir. Ayrıca sıcaklık stresine de dikkat verilmesi gerekiyor.
3. kalite denetim: BGA paketlendiğinden sonra, bağlantının güveniliğini sağlamak için kalite denetim gerekiyor. Genelde kullanılan değerlendirme metodları X-ray testi, akustik emisyon testi vb. Akustik emisyon testi akustik sinyalleri analiz eden küvet kalitesini belirliyor.
4. Düzeltme ve gözetleme: BGA'nin kötü bir kayıtla paketlemesi için özel tamir ekipmanları yeniden kayıtlama için kullanılabilir. Genelde tamir süreci, patlama temizlemesi, solder topu doldurulması ve çip tekrarlaması gibi adımlar içeriyor. tamir sürecinde, sıcaklık sıcaklığını ve zamanı kontrol etmek gerekiyor.
5. Tasarım ve Düzenleme: devre tasarımında BGA paketlerinin düzenlemesi ve düzenlemesi önemlidir. Elektrik performansı, sıcak performansı ve mekanik gücü gibi faktörler tamamen düşünmeli. Düzenleme sürecinde, yüksek performanslık elektronik sistemlerine ulaşmak için sinyal integritet, güç stabiliyeti ve sıcak yönetimi gibi sorunlara dikkat vermelidir.
BGA paketlerinin önlemleri ve sıkıntıları
İlaçlar:
1) Yüksek yoğunluğu: BGA paketi daha büyük bir pin uzağı var, bu da yüksek bir sayı I/O pinleri ulaşabilir ve yüksek performanslı integral devrelerin ihtiyaçlarına uyuyor.
2) Mükemmel sinyal iletişim performansı: BGA paketlemesinin kısa bağlantı yolu yüzünden, yüksek hızlı sinyal iletişimi sağlayan parazitik etkisi ve kapasitesi düşüyor.
3) Güzel sıcak performansı: BGA-encapsulated solder topları sıcaklığı etkili olarak kullanabilir ve çip operasyon sıcaklığını azaltmak için yardımcı olabilir.
Küçük durumlar:
Yüksek talep üretim süreci: BGA paketleme işlemleri ve ekipmanlar için yüksek ihtiyaçları var. Bu üretim maliyetlerini arttırır.
BGA paketlemesi paketin dibinde düzenli bir sferik pinin çizgisinin oluşturulmasıyla karakteriz edilen bir yüzey dağıtma teknolojidir. Bu paketleme yöntemi, büyük pin uzağı, iyi termal performansı ve üst sinyal transmisi performansı gibi avantajlar vardır. Bu şekilde yüksek hızlı ve yüksek performanslı devrelerde geniş kullanılır.