IC paketleme tahtası, ürün modeli ve bağımsız çipleri elde etmek için ölçülü wafer işleme sürecine göre anlatır. IC paketleri ilk olarak güzel silikon çiplerini genişletilmiş devre tahtalarına bağlamak için bir ortam sağlar ve aygıtları suyundan korumak için.
Özellikle paketleme formları:

paketleme formu
Toplu paket

1970'lerin sonunda, pazarda geniş olarak kabul edilen ilk paket iki çizgi (DIP), bir keramik ve plastik paketi vardı. İlerlemeler paketin her iki tarafından çizdi ve paketin perpendikli. Paket PCB'ye yüklenebilir, tabağın deliğinden bir parçasını yerleştirerek, tabanın diğer tarafını tıklayıp dalga çözme teknolojisini kullanarak çözülebilir. Paket 40 ve 0,65mm tabak boşluğunun en büyük sayısına ulaşabilir.
1970'lerin sonunda ve 1980'lerin başlarında yüzey dağı ortaya çıktı. Çip üzerindeki ipleri ve komponentler devre tahtasının yüzeyine karıştırılır. Bu, tahtın her iki tarafından çip'i bağlamak için kullanılır. Yükleme sırasında yeniden soldurum teknolojisini kullanarak, 80'lik maksimum pin sayısıyla.
1980'lerin ortasına göre tüm taraflarda ipucu olan paketler ortaya çıktı. Bu paketle dört düz paket (QFP) deniz kanalı gibi şekilde oluşturulmuş veya önlü çip taşıyıcısı (önlük yıkanmış). J. En sık kullanılan tipik dörtgen düz paketleri 0,65mm ya da 0,5mm ile 208 kadar ileri sayısı var. Bu paketler 1990'ların başlarında hard disk diski ve grafik pazarlarında geniş olarak kullanıldı.
80'lerin sonunda ve 1990'ların başlarında açık-Pad Yönetici Paket doğdu. Paket, çip bağlama sonu altından a çılan bir çip bağlama paketi dörtgene düz veya küçük bir şekil paketi. Bu açık bağlama sonları devre kuruluna karıştırılabilir, çipi için etkili bir ısı parçalama yolu oluşturur.
Miniature Lead Frame (MLF) paketler ailesi 1990'larda geliştirildi. MLF Chip Scale Paketine (CSP) yakındır. Paketin en aşağı önlü sonu PCB tahtasıyla elektrik bağlantısı sağlamak için kullanılır. Gull kanatları Soic ve Qual Paketine karşı, bu Paket sıcak dağıtımı ve elektrik performansını sağlamak için yardım eder.
2. Düzenli paketleme
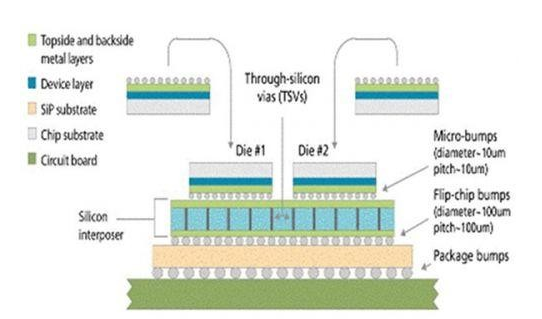
katı paketleme
1990'larda, topu Grid Array (BGA) denilen yeni bir paketleme türü, ilaçlı tabakları substrat materyal olarak kullanarak ortaya çıktı. Yüksek çerçeve tabanlı paketleme sadece paketlerin periferisine ulaşabilir. Toplu ağ seri paketinin liderleri tüm paketin altındaki solder topuna yönlendirilebilir. Başlangıçta, BGA paket tahtalarının tipik topu saçmalığı 1,27 mm oldu.
3. Dalga seviyesi paketleme
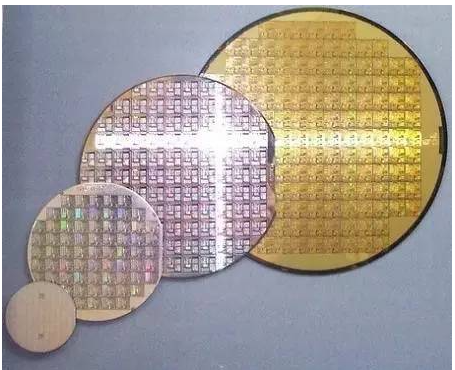
wafer seviyesi paketleme
Uzay gerektiğinde en iyi paketleme hiç paketleme değil. Ekstra işleme devre masasında direkte yüklenebilecek aygıtlar üretmek için wafer seviyesinde yapabilir. Bu süreç genellikle bir yeniden dağıtım katını kullanarak, bölüm üzerindeki güzel uzayı kendi çip üzerindeki bölüm boşluğuna (genellikle 0,5 mm) geçirmek için kullanılır ve sonra yeniden düzenleme fonksiyonunun üzerindeki bölüm noktaları oluşturur. Kırtın ayrı ayrı ayrı ayrılacak ve wafer seviyesi paketi konvex blok çekirdeğidir.
4. Sistem seviyesi kapsamlama (SIP)
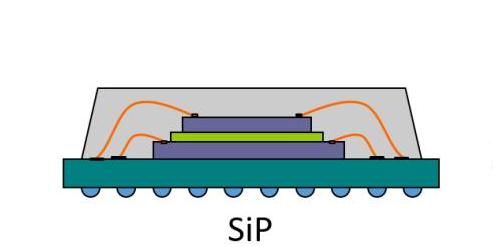
Şimdi yeni bir çevre integrasyon sistem seviyesi paketi (SIP) denilen bir pakete çoklu çip koyuyor. Çoklu çip paketi aynı pakette iki ya da daha fazla çip yerleştirerek (genellikle katlanmış substratları kullanarak), ya da aynı pakette bir çip diğerinin üstüne koyarak başarılır.
5. Pakete bağlantı teknolojisinin geliştirilmesi
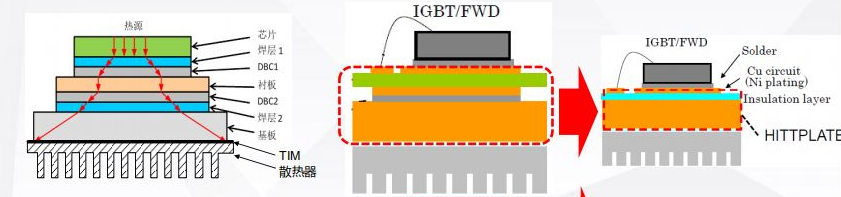
Arayüz bağlantısı paketli bir substrat ile çips nasıl bağlanıldığını anlatır. Çoğu paketlerde, paket vücudu ilk defa altın ya da aluminium kablo kullanarak çep bağlantı terminalinin ön yüzeyine katılır. Yüksek. Bu bağlantı tekniki ön bağlantı denir ve çoğu paketleme uygulamaları için uygun. Yeni bir bağlantı taslağı Flip Chip Binding denir. Patlama pozisyonunda çip yüzeyinde yönetici bir patlama oluşturuyor. Büyük çip, sonra dönüştü ve doğrudan substrata bağlanıyor. Çoğu durumda, katlı bir substrat kullanılır. Topu bağlantısı yeniden çözümleme sürecini kullanacak. Altratı ve reflozu bağlandıktan sonra, cip ve altratı arasında kullanıldığı sırada aygıtın karıştırma parçası tarafından sebep olan stresimi azaltmak için kullanılır.
6.Material Paketleme Plastik Paketleme, sıcaklık ve süt olabilir. Başlangıç paketi delik bir yerleştirmekteydi, bu güveniliğe daha az ihtiyaç duyuyordu çünkü sıcaklık kaynağı sıcaklığı paketlerden uzaktaydı (tahtın diğer tarafında). Sanayi, kuruyu toplantıya ihtiyacını yok etmek için çörek kombinasyonu ve çip bağlantı materyallerini geliştirmek için çalışıyor. Paketleme maddeleri için yeni bir ihtiyaç tamamen özgür olmak ve çevre ihtiyaçlarına uygun "yeşil maddeler" kullanmak.
7, yazılma sürecinden sonra vafer vasör sürecindeki paketleme süreci ChengXiaoJing round (Die) kesildi ve sonra çerçevesinin uyuşturucu altının (ön çerçevesinin) adasındaki vafer takımını kesti, sonra metal (altın, tin, baker, aluminum) ile süper finans kullanın veya yönetici resin çip bağlantı patlaması ve IC paketi bağlantısı ile ilişkin liderlik bağlantısı arasında kullanın, devre oluşturun; Birleşik çipler plastik bir dava tarafından kapsullanmış ve korunacak. Plastik paketlendikten sonra, bir dizi operasyon yapmak gerekiyor, sonrası kızartmak, kaldırmak, elektroplatma ve yazdırmak gibi. Paketleme tamamlandıktan sonra, bitiş ürünün teste edilmesi, genellikle gelir maddeler, teste, paketleme ve sonunda depo ve göndermesi üzere. Tipik paketleme süreci: kesme, yükleme, bağlama, plastik paketleme, sıkıştırma, elektroplatma, yazma, kaburga kesme ve biçimleme, görünüm kontrolü, ürün testi, paketleme ve teslimat tamamlama.