Полное название BGA - « решетчатый массив», что означает PCB со структурой решетчатого массива. Это метод упаковки интегральных схем с использованием органических носителей. Платы PCB с BGA обычно имеют больше маленьких отверстий, а нижние отверстия BGA обычно предназначены для готовых отверстий диаметром 8 - 12 миль. Нижняя проходная скважина BGA должна быть заблокирована, сварочный диск не допускает чернильного покрытия, сварочный диск не просверлен.
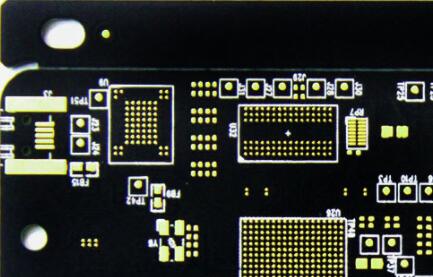
BGA - это компонент, использующий метод упаковки сварных шаровых массивов. Он производит сварные шары на дне упакованной основной платы, которая служит интерфейсом для платы, соединенной с платой. Компоненты BGA подходят для поверхностно - монтажных компонентов с большим количеством выводов в цепи, более высокой плотностью упаковки, более мощными функциями и более высокой надежностью. Процессор BGA используется в основном для ноутбуков.
Общие принципы проектирования сварных дисков BGA
1) Диаметр сварочного диска обычно меньше диаметра сварного шара. Чтобы получить надежную адгезию, ее обычно снижают на 20 - 25%. Чем больше сварочный диск, тем меньше пространство для проводки между двумя сварочными дисками.
2) Сварочный диск на базе BGA имеет тот же диаметр, что и прокладка на PCB.
3) Конструкция сварного диска BGA должна гарантировать, что отверстие шаблона вызывает утечку пасты 0,08 мм, что является минимальным требованием для обеспечения надежности точки сварки.
BGA Принципы упаковки
Основные технологические процессы инкапсуляции BGA включают производство сварных шаров, производство фундаментных пластин, соединение чипов, отверждение упаковки и раздельное инкапсуляция.
1) Производство сварных шаров: производство сварных шаров с использованием высокочистых оловянно - свинцовых сплавов или неэтилированных материалов для формирования стандартной сферической решетки выводов.
2) Производство базовых плат: использование многослойных печатных плат в качестве базовых плат для достижения высокой плотности, высокой производительности электрического взаимодействия.
3) Соединение с чипом: подключите чип к основной плате и подключите его к основной плате с использованием неэтилированного или свинцового припоя.
4) инкапсуляция и отверждение: чип инкапсулируется эпоксидной смолой для защиты от воздействия окружающей среды.
5) Разделить упаковку: нарезать упакованный чип на отдельный пакет BGA.
Технология упаковки BGA
1. Конструкция сварного диска: Для обеспечения качества и надежности сварки конструкция сварного диска должна соответствовать определенным руководящим принципам. Во - первых, необходимо убедиться, что размер сварного диска соответствует размеру сварного шара. Во - вторых, необходимо учитывать влияние формы и компоновки прокладки на тепловое расширение и тепловое сжатие. Наконец, следует обратить внимание на обработку поверхности сварного диска, чтобы повысить надежность сварки.
2. Процесс сварки: сварка BGA обычно осуществляется методом обратной сварки. Для обеспечения качества сварки необходимо контролировать температуру сварки, время и кривую температуры печи. Кроме того, следует обратить внимание на тепловое напряжение при сварке, чтобы избежать дефектов сварки.
3.Проверка качества: После сварки в упаковке BGA требуется проверка качества для обеспечения надежности соединения. Обычные методы обнаружения включают рентгеновское обнаружение, акустическое обнаружение и т. Д. Рентгеновское обнаружение позволяет визуально наблюдать внутреннюю структуру сварной точки и обнаруживать дефекты сварки. Испытание акустической эмиссии определяет качество сварки путем анализа звуковых сигналов.
Ремонт и техническое обслуживание: Для плохо сваренной упаковки BGA может быть проведена повторная сварка с использованием специального ремонтного оборудования. Обычно процесс восстановления включает в себя такие этапы, как очистка сварного диска, пополнение сварного шара и повторное подключение чипа. Во время ремонта необходимо контролировать температуру и время нагрева, чтобы избежать повреждения чипа.
5. Конструкция и компоновка: при проектировании схемы компоновка и проводка упаковки BGA имеют решающее значение. Следует в полной мере учитывать такие факторы, как электрические свойства, тепловые свойства и механическая прочность. В процессе компоновки следует обратить внимание на целостность сигнала, стабильность питания и тепловое управление и другие проблемы для достижения высокопроизводительной электронной системы.
Преимущества и недостатки BGA
Преимущества:
1) Высокая плотность: упаковка BGA имеет большее расстояние между выводами, что позволяет достичь более высокого количества выводов I / O для удовлетворения требований высокопроизводительных интегральных схем.
2) Превосходная производительность передачи сигнала: из - за короткого пути соединения сварных шаров упаковка BGA имеет более низкую паразитную индуктивность и емкость, что способствует высокоскоростной передаче сигнала.
3) Хорошая теплопроизводительность: сварочные шары в упаковке BGA могут эффективно проводить тепло, помогая снизить рабочую температуру чипа.
Недостатки:
Высокий спрос на производственный процесс: упаковка BGA требует высоких требований к сварочному процессу и оборудованию, увеличивая затраты на производство.
Упаковка BGA - это технология поверхностной установки, которая характеризуется формированием стандартной сферической решетки выводов на дне упаковки. Этот метод упаковки имеет преимущества большого расстояния между выводами, хороших тепловых характеристик, превосходных характеристик передачи сигнала и широко используется в высокоскоростных высокопроизводительных интегральных схемах.