1.BGA (массив сферической решетки) также известен как CPAC (носитель массива сферических верхних дисков). Показ сферических контактов, один из корпусов, установленных на поверхности. На обратной стороне печатной платы вместо выводов в режиме дисплея создаются сферические выпуклые блоки, и чип LSI собирается на передней части основной платы печатной схемы, а затем уплотняется формованной смолой или заливкой. Также известен как носитель выпуклого дисплея (PAC). Вывод может превышать 200, это многоходовой пакет LSI. Корпус также может быть изготовлен в меньшем размере, чем QFP (Quad Flat Package). Например, 360 выводов BGA с центром выводов 1,5 мм имеют только 31mm квадрат, а 304 вывода QFP с центром выводов 0,5 мм - 40mm квадрат. И BGA не нужно беспокоиться о деформации выводов, как QFP.
Пакет был разработан американской компанией Motorola и сначала использовался в портативных телефонах и других устройствах, а затем стал популярным в персональных компьютерах. Первоначально расстояние по центру выводов BGA (выпуклых блоков) составляло 1,5 мм, а количество выводов - 225. Некоторые производители LSI также разрабатывают 500 - контактный BGA. Проблема с BGA заключается в проверке внешнего вида после обратной сварки. & quot; Моторола & quot; в Соединенных Штатах называет упаковку, запечатанную смолой, OMPAC, а упаковку, запечатанную методом заливки, - GPAC.
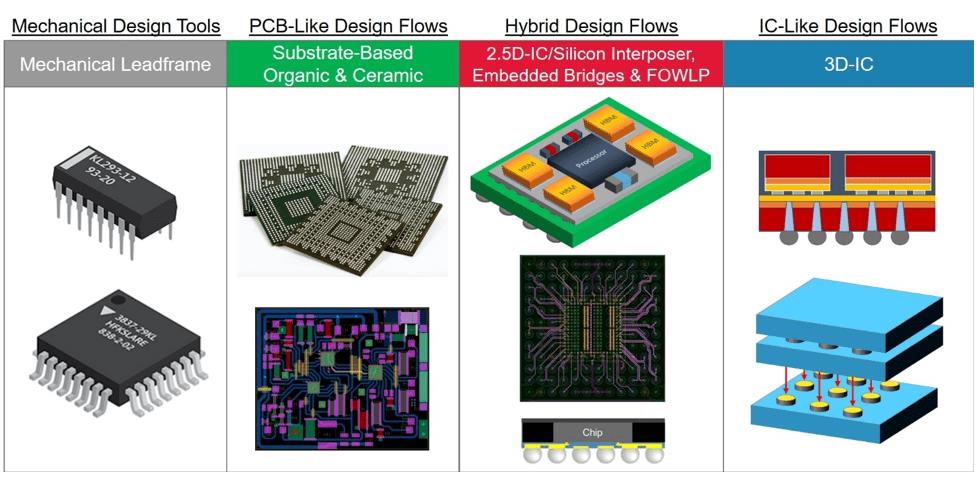
2.Cneneneen (керамика) означает маркировку керамической упаковки. Например, CDIP означает керамический DIP. Это знак, который часто используется на практике.
3.COB (chip - on - board) инкапсуляция чипа на панели является одной из технологий установки голых чипов. Полупроводниковые чипы были переданы и установлены на печатных платах. Электрическое соединение между чипом и фундаментом осуществляется через щели и покрыто смолой для обеспечения надежности. Несмотря на то, что COB является самой простой технологией установки голых чипов, его плотность упаковки намного ниже, чем у технологии соединения TAB и перевернутых чипов.
4.DIP (двухрядная прямолинейная упаковка) двухрядная прямая упаковка. Одна из таких вставных упаковок, которая выводится с обеих сторон упаковки, состоит из пластика и керамики. Большинство европейских производителей полупроводников используют DIL. DIP является наиболее популярным пакетом плагинов, который включает в себя стандартные логические IC, LSI памяти и микрокомпьютерные схемы. Расстояние по центру выводов составляет 2,54 мм, а количество выводов - от 6 до 64. Ширина упаковки обычно составляет 15,2 мм. Некоторые упаковки шириной 7,52 мм и 10,16 мм называются SK - DIP (тонкая двухрядная прямая вставка) и SL - DIP (тонкая двухрядная прямая вставка). Но в большинстве случаев нет разницы, они просто в совокупности называются DIP. Кроме того, керамический DIP, запечатанный стеклом с низкой температурой плавления, также известен как Cerdip (см. 4.2).
4.1DIC (двухрядное прямое керамическое уплотнение) Другое название керамического уплотнения DIP (включая стеклянное уплотнение).
4.2 Cerdip: керамическая двухрядная прямолинейная упаковка, запечатанная стеклом, для таких схем, как ECL RAM, DSP (цифровой сигнальный процессор) и т.д. Cerdip со стеклянными окнами используется для ультрафиолетового стирания EPROM и встроенных микрокомпьютерных схем EPROM. Расстояние по центру штыря составляет 2,54 мм, а количество штырей - от 8 до 42. В Японии эта упаковка обозначена как DIP - G (G означает стеклянное уплотнение).
4.3 SDIP (сжатая двухрядная прямая упаковка) сжимает DIP. Одна из таких вставных инкапсуляций имеет ту же форму, что и DIP, но расстояние от центра выводов (1.778 мм) меньше DIP (2.54 мм), поэтому называется для этого. Количество ходов от 14 до 90. Существует два типа керамики и пластика. Также известен как SH - DIP (сжатая двухрядная прямая упаковка).
5. Переверните чип, чтобы перевернуть чип. Одной из технологий упаковки голых чипов является изготовление металлических выпуклостей в электродной области чипа LSI, которые затем соединяются с электродной областью на печатной базе с помощью сварки под давлением. Площадь упаковки в основном такая же, как и размер чипа. Это самая маленькая и самая тонкая из всех технологий упаковки. Однако, если коэффициент теплового расширения базовой пластины отличается от коэффициента теплового расширения чипа LSI, реакция будет происходить на стыке, что повлияет на надежность соединения. Поэтому необходимо использовать смолу для усиления чипа LSI, а также использовать материал для фундамента с практически одинаковым коэффициентом теплового расширения.
6.FP (Плоская упаковка) Плоская упаковка. Один из пакетов для установки поверхности. Другое название QFP или SOP (см. QFP и SOP). Некоторые производители полупроводников используют это название.
7.H - (с радиатором) означает маркировку с радиатором. Например, HSOP означает SOP с радиатором.
8.MCM (многочиповый модуль) многочиповый компонент. Пакет, в котором несколько полупроводниковых голых чипов собираются на базе проводки. В зависимости от материала базовой платы, его можно разделить на три категории: MCM - L, MCM - C и MCM - D. MCM - L представляет собой компонент, использующий обычные стеклянные эпоксидные печатные платы. Плотность проводки не очень высока и низкая стоимость. MCM - C использует толстопленочную технологию для формирования многослойной проводки и использует керамику (оксид алюминия или стеклянную керамику) в качестве компонентов подложки, аналогичной толстопленочной гибридной IC с многослойной керамической подложкой. Между ними нет никакой очевидной разницы. Плотность проводки выше, чем у MCM - L. MCM - D представляет собой многослойную проводку с использованием тонкопленочной технологии, состоящей из керамики (оксид алюминия или нитрид алюминия) или Si, Al в качестве компонентов подложки. Схема проводки является самой высокой из трех компонентов, но и дорогостоящей.