Heterogeneous 3DIC hâlâ kütle üretim sınıfı ile karşılaşıyor.
3DIC+TSV üçboyutlu stacking teknolojisi en küçük bölge ile çipinin yoğunluğunu arttırabilir, maliyetleri azaltır ve ürün boyutunu azaltır ve bu yüzden çipinin performansını ve güveniliğini geliştirir. Samsung aynı zamanda eşcinsel bir 3DIC, NANDFlash Flash Hafızası, DDR3 hafızası ile tanıştıran ilk kişi. Qualcomm ve BroadComm gibi IC tasarım şirketleri, önümüzdeki nesillerin yüksek yoğunlukta IC tasarımı için 3DTSV teknolojisini de tasarladılar.
3DIC'nin şimdiki integral uygulaması hala aynı üretim sürecine, eşcinsel çip (homogenus) integrasyonuna ait, yani DRAM, NANDFlash ölmesi veya çoklu çekirdek mikroprocessöre gibi. IEK, bu yıl (2013 yılından), DRAM ve NANDFlash gibi 3DIC'in, eşcinsel toplama ile toplam üretimi girmesini bekliyor. Mantık çipların (Mantık), hafıza çipların (DRAM), radyo frekansı ICs (RF), güç amplifikatörleri (PA), fotoelektrik dönüştürme çipların, etc., enerji tüketmesi ve paketleme materyal koefikantörleri gibi teknik sorunları ile sınırlı. Henüz üstün olmalı.
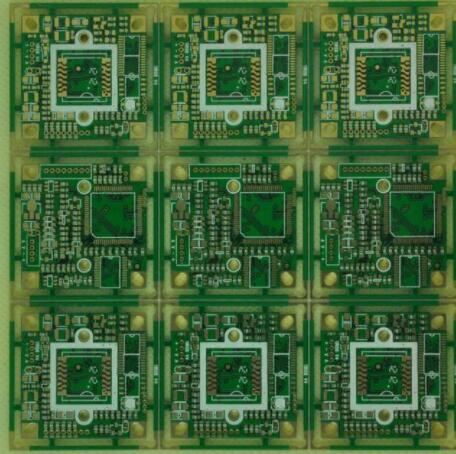
2.5D ortalama teknolojisi, FPGA, GPU/APU'yu kütle üretimi olarak ilk tanıştıran
Daha önce bahsettiği gibi, 3DIC Hetergeneous Integrated'de kullanılır. TSV (Silicon Drilling) teknolojisini çeşitli mantıklı süreçler ve işleme özellikleriyle birleştirir ve çipleri bağlamak için TSV (Silicon Drilling) teknolojisini kullanır. Farklı tür çip toplandığında, enerji tüketimi ve ısı patlama sorunları özel tedavi gerekecek.
Eğer sadece 1V voltajı ve 2W elektrik tüketiminde bir DRAM çipi yerleştirilirse, başlangıç akışı yaklaşık iki amper. Eğer 2GHz, çoklu çekirdek işlemci CPU veya grafik işleme birimi (GPU) üzerinde yerleştirilirse, on watt veya daha fazla kolayca gerekecek. Yüz watt, ışık başlatma akışı on amper kadar yüksek olabilir. Bu neredeyse araba sınıfı batterileriyle halledilebilir. Bu tür çip, mobil taşınabilir aygıtların tasarımı için ölümcüdür. ve bu kadar sınırlı ve yoğun bir bölgede büyük akışı sağlar. Elektrik tasarımı ve elektrik çiplerinin seçimi teknik zorluklardır. Hatta şu anda bile devreğin etkileşimliliğini ve stabilliğini etkileyen en büyük araştırma kaynağı.
Yüksek frekans operasyonu CPU ve GPU çipleri genellikle 120 derece ısılabilir. Ancak, DRAM ve NANDFlash'ın ölmesi 85ÂC'den fazla, yenilenme mekanizması ve depolama toleransı normal olacak. Eğer CPU DRAM ile birleştirirse, NANDFlash birleştirildi, CPU'nun yüksek ısısı DRAM ve NANDFlash'a etkileyecek; ve Ayrıca fotoelektrik dönüştürme aygıtları gibi, sıcaklığın 80°C ya da daha fazla ulaşırken operasyon stabiliyeti büyük düşürülecek. Ayrıca çok farklı tür çıplak ölüm materyalleri var. Birlikte sıcak stres etkisi farklı sıcak genişleme koefitörleri tarafından sebep olan paketleme mekanizması üzerinde düşünmeli ve hatta ısınma bile sıcaklık sıcaklığı sıkıştırılmış wafer katmanının deformasyonuna neden olur. Bu çipların sıcaklık dizisini farklı sıcaklık özellikleriyle düzeltmeyi nasıl düzenleyeceğiz ki sıcaklık patlamasında birbirlerine etkilenmeyecekler, çok ciddi teknik bir sorun. Yüksek üretilmiş 3DIC'nin ilk olarak düşük güç DRAM ve NANDFlash eşittiği toplu ürünlerde görünüyor.
2.5DIC (ya da 2.5DInterposer) teknolojisi ilk defa fabrika lideri (ASE) tarafından önerildi ve sonra yarı yönetici endüstri tarafından takip edilen bir terim oldu. Metodo, birbirlerine sıkıştırılmayan, paralel ve birbirlerine yakın olmayan çeşitli süreç/çalışma özelliklerinin ölümlerini yapmak, bağlantı için bardak veya silikon tabanlı materyal Interposer (karşılaştırıcı) üzerinde yerleştirilmiş ve sonra aşağıya bağlanmış PCB devre tabağı sinyal erteleme zamanı kısaltır ve tüm sistem performansını geliştirir; Her paralel ölüm bireysel test edilebilir, sonra parfümer ve yandan toplanabilir. Sıcak/elektromagnyetik radyasyon testinden geçmesi gerekmiyor, paketlendikten sonra orta tahta (Interposer) yerleştirildiği sürece. 3DIC sıkıştırma yaptığında, sıcak/elektromagnet testi çubuktaki her katta gerçekleştirilmeli; Eğer ölümden birisi yanlış olursa, tüm 3DIC stacking aygıtı geri ödemeli olmalı.
2.5DIC, yarı yönetici endüstri tarafından gelecekte 3DIC'ye geçiş için ortalama teknoloji olarak kabul edilir. Çiftler arasındaki iletişim köprüsü olarak hareket etmek için Interposer kullanarak, ölüm ve Interposer, materyal özellikleri ve sıcak stres kombinasyonu gibi sorunlara dikkat vermelidir. 3DIC ile karşılaştığında, 2.5DIC'nin düşük teknik boğazı var. Devre tahtasında kullanılan silikon karşılaştırıcısı (SIInterposer) genelde 40 nm ya da 28 nm gelişmiş üretim sürecini kullanmak zorunda değildir ve üretim maliyeti azaltılabilir.
Xilinx2.5D FPGA işlemci çipi örnek olarak alın. Sıplak 28/40nm FPGA çipleri tarafından ayarlandıktan sonra 65nm silikon karşılaştırıcısına yerleştiriler. Toplam maliyeti önceki 40nm veya 28 nm SOC sürecinden daha düşük. Bu yüzden 2.5DIC uygulama alanı hafıza çiplerine sınırlı değil. FPGA, CPU, GPU, etc. gibi yüksek performans ve yüksek bütün mantıklı bilgisayar çipleri 2.5DInterposer teknolojisini uygulamaya başladılar.
2.5D/3DIC katil uygulaması
2.5DIC konseptini kütler üretimi ile tanıştıran yarısı programlı mantıklı kapı dizisi (FPGA) Xilinx ve Altera üreticileri tarafından temsil edilir. İki şirket de TSMC'in CoWos (ChiponWaferonSubstrate) 2.5DIC teknolojisini kullanır. Xilinx â'nin Virtex-72000TFPGA çipleri gibi, 28 nm çıplak ölümler tarafından yaklaşık düzenlenmiş. Sıplak ölümlerin altındaki mikro patlamalar 65nm silikon karşılaştırıcısına bağlı. Bundan sonra, TSV teknolojisi tarafından sol toplarına bağlı ve sonra içeri girdi. Solder topunu aşağıdaki PCB tahtasına bağla.
Ayrıca, IntelIrisPro5200 (GT3e) grafik çipi, IBM Power8 işlemcisi, Intel â'nın dördüncü nesil Corei işlemcisi (Haswell) ve AMD â'nın yarı özellendirilmiş 8. Çirdek APU da 2.5DIC paketleme teknolojisini kullanacak.
3DIC bölümüne gelince, DRAM çipinlerin (WideI/O) ve NANDFlash çipinlerin eşcinsel toplamasına rağmen Altera yeni gelecek nesil 20nm FPGA ürünlerini duyurdu, ki TSMC â'nin gelecek nesil 20nm süreç artı 3DIC heterogenel integrasyon ve stacking teknolojisini kullanacak bir sonraki nesil 20nm FPGA ürünlerini duyurdu. İki setden fazla FPGA ölmesi, ARM çoklu çekirdek işlemci çipi, kullanıcı özelleştirilebilir HardCopyASIC çipi, ayarlanabilir kesinlikle DSP dijital sinyal işlemcisi ve çoklu katlı MemoryCube hafıza çipi.
ASE, Silicon Products, Licheng ve Nanmao küresel paketleme ve temel pazarının %56'ünün payısı var. Bu da 3DIC endüstri zincirindeki son mil'in anahtarı. ASE SEMI belirlenme platformunun 3DS-IC standartini kabul ediyor ve DietoDie, DietoSiP arası bağlantı belirlenmesini tamamlamak için tasarımcısı ve kurulu ile aktif bir işbirliği yapıyor ve 3D düzenleme, ölçüm ve paketleme güveniliğini onaylamak için; Üç boyutlu taşıma tahtaları, fixtürler, fabrikalar arasındaki prosedürler tutuyor, TSV waferlere katılıyor, JEDECJC-11WideI/O hafıza toplama metodları ve 3DQA kalite güvenlik özelliklerine katılıyor.
Ayrıca TSMC, 2.5D/3DIC yapısı CoWoS (ChiponWaferonSubstrate) ile birleştirilmiş üretim teknolojisini, TSV/3D, topu bitirme teknolojisi, silikon etkileyici (Si-Interposer) ve çeşitli altı sistem integrasyonunu temsil eden çeşitli bölüm materyallerini temsil etti. Aynı zamanda, EDA, IP, testi, ekipman, silikon wafer temsilcisi ve paketleme santrallerinin tüm endüstri zincirini hızlandırmak için 2.5D/3DIC teknolojisine yatırım yapmaya devam ediyoruz. UMC ve aşağıdaki paketleme ve testi santralleri 3DIC teknolojisini geliştirmek için açık endüstri modeli (OpenEcosystemModel) arıyor.
IEK, 2010 yılından önce NANDFlash ve DRAM gibi hafıza depolama çiplerinde 3DIC teknolojisi girdiğini belirtti. 2010 yılından beri, CIS (CMOS görüntü sensörü) ve MEMS (mikroelektromekanik) komponentlerin kütle üretimi de ortaya çıktı. Güç amplifikatör çip (PA), LED ışık çip paketi ve fotoelektrik dönüştürme elementi paketi gibi uygulamalar var. 2013 yılında, eşcinsel çoklu katlı Memory Cube ve WideI/ODRAM kütle üretileceğini bekliyor; ve çoklu çekirdek CPU, FPGA, ASIC, hafıza ve optoelectronik komponentleri ile birleştirilen heterogenel 3DIC (Heterogeneous 3DIC) 2014 ile 2015 arasında gerçek kütle üretim sahnesi ortaya çıkacak bekleniyor.