1.BGA (ball grid array) is also called CPAC (globe top pad array carrier). Kuzey bağlantıların görüntüsü, yüzey dağıtma paketlerinden biri. Bastırılmış devre tahtasının arkasında, küferik patlamalar parçaları değiştirmek için gösterim modunda üretilir, LSI çipi bastırılmış devre tahtasının ön tarafında toplanır, sonra da sıçrama ya da sıçrama tarafından mühür edilir. Kıpırdama gösterisi taşıyıcısı (PAC) olarak da bilinir. Pin 200'den fazla yükselebilir. Bu çoklu pin LSI için bir paket. Paket vücudu da QFP'den daha küçük (Quad Flat Paket) yapabilir. Örneğin, 1,5 mm boyunca bir pint merkezinde 360 pint BGA sadece 31mm karedir. 304 pint QFP 0,5 mm boyunca bir pint merkezinde 40mm karedir. BGA'nın QFP gibi pin deformasyonu için endişelenmesi gerekmiyor.
Bu paket ABD Motorola Şirketi tarafından geliştirildi ve ilk olarak taşınabilir telefonlar ve diğer cihazlar ile kabul edildi ve sonra kişisel bilgisayarlar içinde popüler edildi. İlk olarak, BGA pin (bump) merkez mesafeyi 1,5 mm ve pins sayısı 225. 500-pin BGA geliştirilen LSI üreticileri de var. BGA'daki sorun, yeniden çözümlenmeden sonra görüntü incelemesi. Amerikan Motorola Şirketi, oluşturulmuş resin ile mühürlenmiş paketi OMPAC olarak refere ediyor. Paketi poting metodu ile mühürlenmiş halde GPAC deniyor.
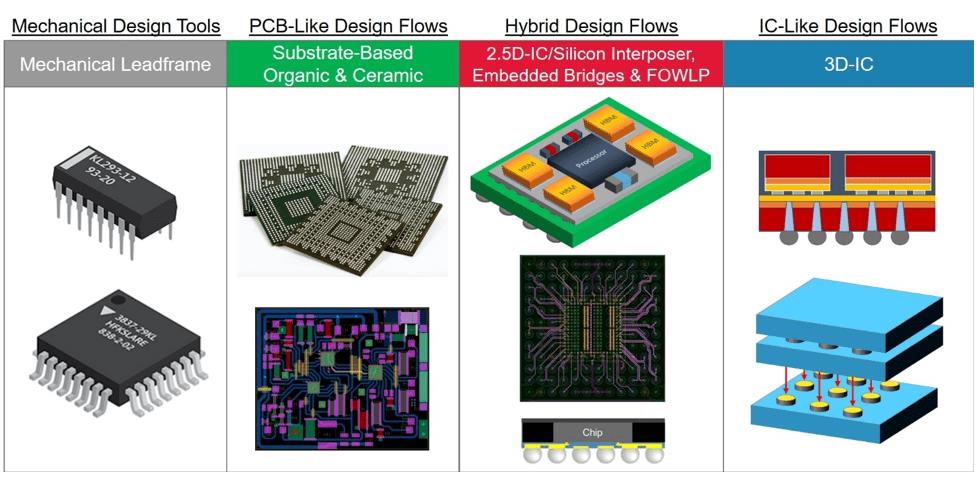
2.C ï¼(keramik) keramik paketinin işaretini temsil ediyor. Örneğin, CDIP keramik DIP'ye benziyor. Çalışmada sık sık kullanılan bir işaret.
3.COB (gemideki çip) çip paketlenmesi boş çip yükleme teknolojilerinden biridir. Yarı yönetici çipi, basılı devre masasına bağlanır. The electrical connection between the chip and the substrate is realized by wire stitching and covered with resin to ensure reliability. COB'nin en basit çıplak çip yükleme teknolojisi olsa da, paketleme yoğunluğu TAB'ye ve dönüşüm çip bağlama teknolojisine çok daha aşağıdır.
4.DIP (ikili çizgi paket)İki çizgi paket. Eklenti paketlerinden biri, pinler paketin her iki tarafından çizdirilir ve paket materyalleri plastik ve keramiktir. Avrupa yarı yönetici üreticileri genellikle DIL kullanır. DIP en popüler eklenti paketi ve uygulama menzili standart lojik IC, hafıza LSI ve mikro bilgisayar devreleri içeriyor. Pin merkezi mesafe 2,54mm ve pins sayısı 6'dan 64'dir. Paket genişliği genellikle 15,2 mm. 7,52mm ve 10,16mm genişliği olan bazı paketler SK-DIP (çizgi çizgi çizgi paket) ve SL-DIP (çizgi çizgi çizgi paket) kısa vücut DIP denir. Fakat çoğu durumda hiçbir fark edilmez, ve bunlar sadece DIP olarak toplumda adlandırılır. Ayrıca, düşük eriyen bardakla mühürlenen keramik DIP de Cerdip denir (4.2 görün).
4.1DIC (ikili çizgi keramik paketi) keramik paketinin DIP (bardak mühürü dahil olmak üzere) başka bir isim.
4.2Cerdip:ECL RAM, DSP (dijital sinyal işlemcisi) ve diğer devreler için kullanılan Ceramic dual-in-line paket. Bardak pencereyle Cerdip içerisindeki EPROM ile ultraviolet silebilir EPROM ve mikro bilgisayar devreleri için kullanılır. Pin merkezinin mesafesi 2,54mm ve pins sayısı 8'den 42'dir. Japonya'da bu paket DIP-G olarak ifade edilir (G cam mühürü demek).
4.3SDIP (çizgi çizgi paket küçültür) DIP küçültür. Eklenti paketlerinden biri, şekil DIP ile aynı, fakat pin merkezi mesafe (1.778mm) DIP (2.54mm) ile daha küçük, bu yüzden buna denilir. Pins sayısı 14'den 90'a kadar. İki tür keramik ve plastik var. Ayrıca SH-DIP olarak bilinen (çizgi çizgi paketleri küçültür)
5.flip-chipFlip-soldering chip. One of the bare chip packaging technologies is to make metal bumps in the electrode area of the LSI chip, and then connect the metal bumps to the electrode area on the printed substrate by pressure welding. Paketin ayak izi basitçe çip boyutuna benziyor. Bütün paketleme teknolojilerin en küçük ve en ince. Ancak, substratın termal genişleme koefitinin LSI çipinin farklı olduğu zaman, bağlantının güveniliğini etkileyecek bir tepki oluşacak. Bu yüzden LSI çipini güçlendirmek için resin kullanılması gerekiyor ve aynı termal genişleme koefitörü ile altı bir materyal kullanması gerekiyor.
6.FP (flat package)Flat package. Yüzey bağlama paketlerinden biri. QFP veya SOP için başka bir isim (QFP ve SOP görün). Bazı yarı yöneticiler bu isimi kullanır.
7.H-(sıcak patlaması ile)Radyatör ile bir mark a gösteriyor. For example, HSOP means SOP with heat sink.
8.MCM (çoklu çip modulu)Çoklu çip komponentleri. Bir paket içinde birçok yarı yönlendirici çıplak çiplar sürükleme altına toplanıyor. Substrat materyaline göre, üç kategoriye bölünebilir: MCM-L, MCM-C ve MCM-D. MCM-L, ortak bir cam epoksi çoklukatlı devre tahtasını kullanan bir komponent. Yönlendirme yoğunluğu çok yüksek değil ve maliyeti düşük. MCM-C, çoklu katı sürücüğü oluşturmak için kalın film teknolojisini kullanır ve çok katı bir keramik substratı kullanarak seramik (alumini ya da cam keramik) bir substrat komponenti olarak kullanır. İkisi arasında açık bir fark yok. The wiring density is higher than MCM-L.MCM-D is the use of thin film technology to form multilayer wiring, with ceramic (aluminum oxide or aluminum nitride) or Si, Al as the substrate component. Üç komponent arasındaki en yüksektir, ama maliyeti de yüksektir.