BGA의 정식 명칭은 "볼격자 패턴"으로, 볼격자 패턴 구조를 가진 PCB를 의미한다.이것은 유기 캐리어를 사용하는 집적 회로 패키징 방법이다.BGA가 있는 PCB 보드에는 일반적으로 더 많은 작은 구멍이 있으며 BGA 하단 구멍은 일반적으로 지름 8-12mil의 최종 품목 구멍으로 설계됩니다.BGA 아래쪽 구멍은 막아야 합니다. 용접판은 잉크를 허용하지 않습니다. 용접판은 구멍을 뚫지 않았습니다.
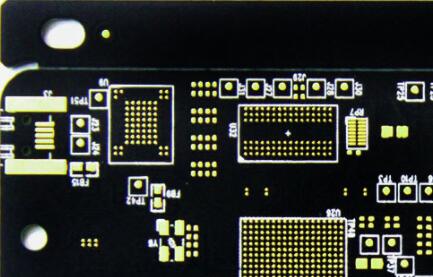
BGA는 용접구 패턴 패키지 방법을 사용하는 어셈블리입니다.패키징 기판의 하단에 용접구가 생성되어 회로 기판의 인터페이스로서 회로 기판과 회로 기판이 연결됩니다.BGA 구성 요소는 표면 설치 구성 요소에 적용되며, 회로에 대량의 핀이 있고, 패키지 밀도가 더 높으며, 기능이 더 강하고, 신뢰성이 더 높다.BGA의 CPU는 주로 노트북에 사용됩니다.
BGA 용접판 설계 통칙
1) 일반적으로 용접 디스크의 지름은 용접구의 지름보다 작습니다.신뢰할 수 있는 부착력을 얻기 위해 일반적으로 20~25% 를 낮춥니다.용접 디스크가 클수록 두 용접 디스크 간의 경로설정 공간이 작아집니다.
2) BGA 기판의 용접판은 PCB의 용접패드와 같은 지름을 가지고 있다.
3) BGA의 용접판 설계는 용접점의 신뢰성을 확보하기 위한 최소 요구사항인 0.08mm3의 용접고가 누출되는 템플릿 개구부를 확보해야 한다.
BGA 포장 공정 원리
BGA 패키지의 주요 공정에는 용접구 생산, 기판 생산, 칩 접합, 패키지 경화 및 분리 패키지가 포함됩니다.
1) 용접구 생산: 순도 높은 주석 납 합금 또는 무연 재료를 사용하여 용접구를 생산하여 규칙적인 구형 핀 패턴을 형성한다.
2) 기판 생산: 다층 인쇄회로기판을 기판으로 하여 고밀도, 고성능의 전기 상호 연결을 실현한다.
3) 칩 접합: 칩을 기판에 연결하고 무연 또는 납 기반 용접재를 사용하여 기판에 연결합니다.
4) 패키징 및 경화: 칩은 환경으로부터 보호하기 위해 에폭시 수지로 패키징됩니다.
5) 분리 패키지: 패키지된 칩을 별도의 BGA 패키지로 절단합니다.
BGA 패키징 기술
1. 용접판 설계: 용접의 품질과 신뢰성을 확보하기 위해 용접판 설계는 반드시 일정한 준칙을 따라야 한다.먼저 용접 디스크의 크기가 용접구의 크기와 일치하는지 확인해야 합니다.둘째, 패드 형태와 레이아웃이 열 팽창과 열 수축에 미치는 영향을 고려해야 한다.마지막으로 용접 디스크의 표면 처리에 주의하여 용접의 신뢰성을 높여야 한다.
2. 용접 공정: BGA 용접은 일반적으로 환류 용접 기술을 사용한다.용접 품질을 보장하기 위해서는 용접 온도, 시간 및 난로 온도 곡선을 제어 할 필요가 있습니다.또한 용접 시 열 응력에 주의하여 용접 결함이 발생하지 않도록 해야 한다.
3.품질 검사: BGA 패키징 용접 후, 연결의 신뢰성을 보장하기 위해 품질 검사를 수행해야합니다.흔히 사용하는 검출 방법으로는 엑스선 검출, 음향 발사 검출 등이 있다. 엑스선 검출은 용접점의 내부 구조를 직관적으로 관찰해 용접 결함을 감지할 수 있다.음향 발사 테스트는 음향 신호를 분석하여 용접 품질을 확정한다.
4. 수리 및 정비: 용접이 불량한 BGA 포장의 경우 전용 수리 설비를 사용하여 다시 용접할 수 있다.일반적으로 복구 프로세스에는 용접 디스크 청소, 용접 볼 보충 및 칩 재연결 등의 절차가 포함됩니다.복구 과정에서 칩이 손상되지 않도록 가열 온도와 시간을 제어할 필요가 있습니다.
5.설계 및 레이아웃: 회로 설계에서 BGA 패키지의 레이아웃과 경로설정은 매우 중요합니다.전기성능, 열성능, 기계강도 등을 충분히 고려해야 한다.레이아웃 과정에서 고성능 전자 시스템을 구현하기 위해 신호 무결성, 전원 안정성, 열 관리 등의 문제에 주의해야 한다.
BGA 패키지의 장점과 단점
이점:
1) 고밀도: BGA 패키지는 고성능 집적회로의 요구를 충족시키기 위해 더 큰 핀 간격을 가지고 더 많은 I/O 핀을 구현할 수 있습니다.
2) 우수한 신호 전송 성능: 용접구의 연결 경로가 비교적 짧기 때문에 BGA 패키지는 비교적 낮은 기생 감각과 용량을 가지고 있어 신호의 고속 전송에 유리하다.
3) 좋은 열 성능: BGA 패키지의 용접구는 효과적으로 열을 전도할 수 있으며 칩의 작동 온도를 낮추는 데 도움이됩니다.
단점:
고수요 생산 공정: BGA 패키지는 용접 공정과 설비에 대한 요구가 높아 생산 원가를 증가시켰다.
BGA 패키징은 패키징 하단에 규칙적인 구형 핀 패턴을 형성하는 표면 장착 기술입니다.이런 포장 방법은 발 간격이 크고 열 성능이 좋으며 신호 전송 성능이 우수하다는 장점을 가지고 고속 고성능 집적 회로에 광범위하게 응용된다.