1. BGA(볼격자 패턴)는 CPAC(볼톱 용접판 패턴 캐리어)라고도 합니다.표면 마운트 패키지의 하나인 구형 접점의 디스플레이인쇄회로기판의 뒷면에서 디스플레이 모드에서 구형 볼록 블록을 생성하여 핀을 대체하고 LSI 칩을 인쇄회로기판의 앞면에 조립한 후 모듈러 수지나 관봉을 통해 밀봉한다.또한 볼록 블록 디스플레이 캐리어(PAC)라고도 합니다.핀은 200개를 초과할 수 있습니다. 이것은 다중 핀 LSI의 패키지입니다.패키지는 QFP(Quad Flat package)보다 작은 크기로도 만들 수 있다.예를 들어, 핀 중심 거리가 1.5mm인 360핀 BGA는 31mm에 불과하지만 핀 중심 거리가 0.5mm인 304핀 QFP는 40mm에 불과하다.또한 BGA는 QFP처럼 핀 변형을 걱정할 필요가 없습니다.
미국 모토로라사가 개발한 이 패키지는 휴대용 전화기와 다른 기기에 먼저 적용된 뒤 개인용 컴퓨터에 보급됐다.처음에 BGA 핀(볼록 블록)의 중심 거리는 1.5mm, 핀 수는 225였습니다.500핀 BGA를 개발하고 있는 LSI 제조업체도 있다.BGA는 환류 용접 후 외관 검사가 문제다. 미국 모토로라는 몰드 수지로 밀봉된 패키지를 OMPAC, 관봉법으로 밀봉된 패키지를 GPAC라고 부른다.
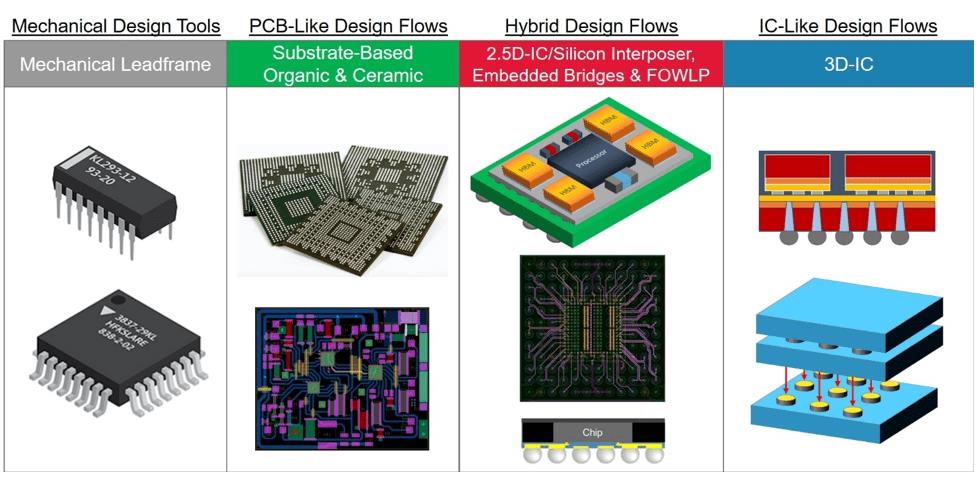
2. Cï(도자기) 는 도자기 포장의 표시를 대표한다.예를 들어, CDIP는 세라믹 DIP를 나타냅니다.이것은 실천에서 자주 사용하는 표식이다.
3. COB (chip-on-board) 보드의 칩 패키지는 원시 칩 설치 기술 중 하나입니다.반도체 칩은 인계되어 인쇄회로기판에 설치되었다.칩과 기판 사이의 전기 연결은 선봉으로 이루어지며 수지로 덮여 신뢰성을 확보합니다.COB는 가장 간단한 원시 칩 장착 기술이지만 패키징 밀도는 TAB와 역장착 칩 접합 기술보다 훨씬 못하다.
4. DIP(2열 직렬 패키징) 2열 직렬 패키징.그 중 하나는 삽입식 패키지로, 핀은 패키지의 양쪽에서 끌어내며, 패키지 재료는 플라스틱과 도자기이다.유럽 반도체 제조업체들은 대부분 DIL을 사용한다.DIP는 표준 논리 IC, 스토리지 LSI 및 마이크로컴퓨터 회로를 포함하는 가장 인기있는 플러그인 패키지입니다.핀의 중심 거리는 2.54mm이고 핀의 수는 6~64개입니다.포장 너비는 보통 15.2mm이다.폭이 7.52mm와 10.16mm인 일부 패키지는 각각 SK-DIP(슬림형 2열 직삽 패키지) 및 SL-DIP(슬림형 2열 직삽 패키지) 슬림형 DIP라고 합니다.그러나 대부분의 경우 차이가 없으며 DIP라고 통칭합니다.또한 저융점 유리로 밀봉된 세라믹 DIP는 Cerdip이라고도 합니다(4.2 참조).
4.1DIC(2열 직렬 세라믹 패키지) 세라믹 패키지 DIP(유리 밀봉 포함)의 별칭.
4.2Cerdip: 유리로 밀봉된 세라믹 2열 직렬 패키징으로 ECL RAM, DSP(디지털 신호 처리기) 등의 회로에 사용된다.유리창이 있는 Cerdip은 자외선이 EPROM과 EPROM이 내장된 마이크로컴퓨터 회로를 지울 수 있도록 설계되었습니다.핀 중심 거리는 2.54mm이고 핀 수는 8~42개입니다.일본에서는 이 포장이 DIP-G(G는 유리 밀봉)를 나타냅니다.
4.3SDIP(수축 2열 직렬 패키지)는 DIP를 축소합니다.삽입형 패키지 중 하나는 DIP와 모양이 같지만 핀 중심 거리 (1.778mm) 가 DIP (2.54mm) 보다 작기 때문에 이것이라고 합니다.핀의 수는 14에서 90 사이입니다.두 가지 종류의 도자기와 플라스틱이 있다.SH-DIP라고도 합니다(수축 2열 직렬 패키징).
5.뒤집기 칩 뒤집기 칩.원시 칩 패키징 기술 중 하나는 LSI 칩의 전극 영역에서 금속 볼록 블록을 만든 다음 압력 용접을 통해 금속 볼록 블록을 인쇄 기판의 전극 영역에 연결하는 것입니다.패키지의 설치 공간은 칩 크기와 거의 같습니다.그것은 모든 포장 기술 중에서 가장 작고 가장 얇다.그러나 기판의 열팽창 계수가 LSI 칩의 열팽창률과 다르면 접합부에서 반응이 일어나 연결의 신뢰성에 영향을 미친다.따라서 LSI 칩을 강화하기 위해 수지를 사용하고 기본적으로 동일한 열 팽창 계수를 가진 기판 재료를 사용할 필요가 있습니다.
6.FP(플랫 패키지)플랫 패키지.표면 마운트 패키지 중 하나입니다.QFP 또는 SOP의 다른 이름(QFP 및 SOP 참조).일부 반도체 제조업체는 이 명칭을 사용한다.
7.H - (히트싱크 포함) 히트싱크 표시를 나타냅니다.예를 들어, HSOP는 히트싱크가 있는 SOP를 나타냅니다.
8.MCM(멀티칩 모듈) 멀티칩 구성 요소.여러 개의 반도체 나체 칩이 배선 기판에 조립된 패키지.기판 재료에 따라 MCM-L, MCM-C, MCM-D 등 세 종류로 나눌 수 있다. MCM-L은 일반 유리 에폭시 다층 인쇄회로기판을 사용하는 부품이다.케이블 연결 밀도가 높지 않고 비용이 적게 듭니다.MCM-C는 두꺼운 필름 기술을 사용하여 여러 겹의 배선을 형성하고 세라믹 (산화 알루미늄 또는 유리 세라믹) 을 라이닝 부품으로 사용하는데, 이는 여러 겹의 세라믹 라이닝을 사용하는 두꺼운 필름 혼합 IC와 유사합니다.둘 사이에는 뚜렷한 차이가 없다.배선 밀도는 MCM-L보다 높다. MCM-D는 박막 기술을 이용해 세라믹(산화알루미늄 또는 질화알루미늄)이나 Si, Al을 라이닝 성분으로 하는 다층 배선을 형성한다.경로설정 시나리오는 세 구성 요소 중 가장 높지만 비용도 많이 듭니다.