Базовая плата упаковки является одной из самых дорогостоящих в упаковке IC, на которую приходится более 30%. Расходы на упаковку IC включают в себя упаковку фундамента, упаковочные материалы, амортизацию оборудования и испытания, из которых стоимость фундамента IC составляет более 30%. Это самая большая стоимость упаковки интегральных схем и занимает важное место в упаковке интегральных схем. Для фундамента IC материал фундамента включает медную фольгу, фундаментную пластину, сухую пленку (твердотельный фоторезист), влажную пленку (жидкий фоторезист) и металлические материалы (медные шарики, никелевые шарики и золотую соль), где доля фундамента составляет более 30%, что является самой большой ценой фундамента IC.
1. Одно из основных сырьевых материалов: медная фольга похожа на PCB, медная фольга, необходимая для фундамента IC, также является электролитической медной фольгой и требует сверхтонкой однородной медной фольги толщиной до 1,5 э., как правило, 2 - 18 э., в то время как толщина медной фольги, используемой в традиционных PCB, составляет 18 э., или около 35 э. Цена сверхтонкой медной фольги выше, чем обычная электролитическая медная фольга, обработка сложнее.
2. Основное сырье - бис. Фундамент фундаментной пластины IC аналогичен пластине с покрытым медью слоем PCB, которая в основном делится на три типа: жесткий фундамент, гибкий фундамент с тонкой пленкой и керамический фундамент с общим сжиганием. Среди них жесткая и гибкая подложка имеет больше возможностей для развития, в то время как развитие керамической подложки с общим сжиганием, как правило, замедляется.
Основные соображения, связанные с фундаментом IC, включают стабильность размеров, высокочастотные характеристики, термостойкость и теплопроводность, а также другие требования.
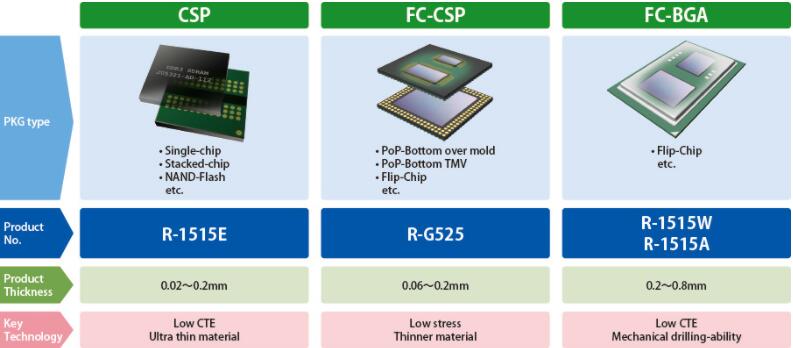
В настоящее время существует три основных материала жесткой упаковки, а именно: материал BT, материал ABF и материал MIS;
Гибкие упаковочные материалы в основном включают PI (полиамид) и PE (полиэфирные) смолы. Керамические упаковочные материалы в основном керамические материалы, такие как оксид алюминия, нитрид алюминия и карбид кремния.
Материалы жесткой подложки: смоляные материалы BT, ABF, MIS1.BT
БТ - смола, полностью известная как бималеиновая триазиновая смола, была разработана японской компанией Mitsubishi Gas. Несмотря на то, что срок действия патента на смолу BT истек, Mitsubishi Gas остается лидером в разработке и применении смолы BT. БТ - смола имеет преимущества высокой Тг, высокой термостойкости, влагонепроницаемости, низкой диэлектрической константы (DK) и низкого коэффициента рассеяния (Df), но из - за слоя стекловолокна она более жесткая, чем FC - матрица, изготовленная из ABF. Проводка более проблематична, лазерная перфорация более сложна, не может соответствовать требованиям тонких линий, но может стабилизировать размер, чтобы предотвратить тепловое расширение и тепловое сжатие, влияющие на скорость выпуска линий. Поэтому БТ - материалы в основном используются в сетях с высокими требованиями к надежности. Чипы и программируемые логические чипы. В настоящее время базовая плата BT в основном используется в мобильных чипах MEMS, коммуникационных чипах и чипах хранения и других продуктах. С быстрым развитием светодиодных чипов, применение базовой платы BT в упаковке светодиодных чипов также быстро развивается.
2.Материалы ABF
Материалы ABF - это материал под руководством Intel, используемый для производства высококачественных несущих плат, таких как перевернутые чипы. По сравнению с базовым материалом BT, материал ABF может использоваться в качестве IC с более тонкими схемами, подходящими для высокого числа выводов и высокой передачи, в основном для больших высококачественных чипов, таких как CPU, GPU и чипсеты. В качестве строительного материала ABF может использоваться в качестве схемы, прикрепляя ABF непосредственно к основной пластине медной фольги и не требуя процесса термокомпрессионного соединения. В прошлом у ABFFC были проблемы с толщиной. Однако по мере того, как технология медной фольги становится все более продвинутой, ABFFC может решить проблему толщины при использовании тонкой пластины. Изначально ABF - платы использовались в основном для процессоров на компьютерах и игровых консолях. С ростом смартфонов и изменениями в технологии инкапсуляции индустрия ABF находится на низком уровне, но в последние годы скорость сети ускорилась, и технологические прорывы привели к появлению новых высокопроизводительных вычислительных приложений на рабочем столе. Спрос на ABF снова увеличился. Судя по отраслевым тенденциям, базовые платы ABF могут идти в ногу с передовыми процессами производства полупроводников и соответствовать требованиям ширины и расстояния между тонкими линиями. Потенциал будущего роста рынка предсказуем. Из - за ограниченных производственных мощностей лидеры отрасли начали расширять производство. В мае 2019 года Emerging объявила, что, как ожидается, с 2019 по 2022 год инвестирует 20 млрд. юаней в расширение высококачественного завода по производству чипов с перевернутыми чипами IC и энергично развивает базовые платы ABF. Что касается других тайваньских производителей, Jingshou, как ожидается, переместит производство аналогичных базовых панелей в ABF, и Southern Electric продолжает наращивать свои производственные мощности.
3.MIS Фундамент
Технология упаковки подложек MIS - это новая технология, которая в настоящее время быстро развивается на рынках аналоговых, силовых IC и цифровых валют. MIS отличается от традиционной подложки тем, что она содержит слой или слой предварительно упакованной конструкции и каждый слой соединяется между собой гальванической медью для обеспечения электрического соединения во время упаковки. MIS может заменить некоторые традиционные упаковки, такие как QFN или упаковки, основанные на выводах, поскольку MIS обладает более тонкой проводкой, лучшими электрическими и тепловыми характеристиками и меньшим внешним видом.
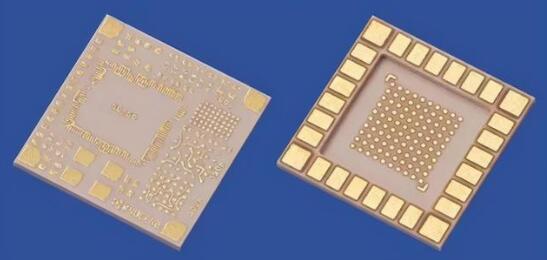
Материалы гибкой матрицы: PI, PE
PI и PE - смолы широко используются в гибких PCB и IC - матрицах, особенно ленточных IC - матрицах. Гибкий тонкопленочный фундамент в основном делится на три слоя склеенного фундамента и два слоя несвязанного фундамента. Трехслойные резиновые пластины первоначально использовались в основном для военной электроники, такой как ракеты - носители, крылатые ракеты и космические спутники, а затем были расширены до различных чипов гражданской электроники; Безрезиновые пластины имеют меньшую толщину, подходят для проводки высокой плотности и являются термостойкими. Уменьшение и сокращение имеют очевидные преимущества. Продукция широко используется в потребительской электронике, автомобильной электронике и других областях, является основным направлением развития гибкой упаковки фундамента в будущем.
Производителей базовых материалов вверх по течению много, отечественные технологии относительно слабы. Базовая плата IC имеет широкий спектр основных материалов, производители вверх по течению в основном иностранные предприятия. Возьмем, к примеру, наиболее часто используемые материалы BT и ABF. Основными мировыми производителями твердой матрицы являются японская компания MGC и японские корейские компании Doushan и LG. Материалы ABF в основном производятся японцами, страна только начинается.