Подложка для упаковки ИС - технология изготовления печатных плат
в связи с тенденцией к минимизации, портативности, многофункциональности, малой мощности и низкой себестоимости электронных продуктов технологии герметизации для двухмерного (2D) оборудования уже не отвечают требованиям, и некоторые продукты начали развиваться в направлении упаковки 2,5 D или триD. в конструкциях упаковки 2.5D или 3D адаптер на основе кремния и органическая базовая плата являются важными средствами обеспечения связи между чипами и чипами, чипами и основной пластиной.
Традиционный процесс производства печатных плат - производство подложки для TSV-адаптера происходит следующим образом:
1) создание глухих отверстий на подложке;
2) Пассивирующий слой на боковой стенке сквозного отверстия осаждается методом PECVD на одной стороне подложки;
3) адгезионный / диффузионный барьерный слой боковой стенки сквозного отверстия и металл затравочного слоя были нанесены на подложку односторонним магнетронным распылением;
4) Заполнение металлом сквозного отверстия завершается гальваническим процессом; 5) Сплющивание металла сквозного отверстия;
6) Металл сквозного отверстия на задней стороне подложки обнажается тонким способом;
7) Производится металлическая проводка, паяльная тарелка и ее защитный слой.
Традиционный метод подготовки подложки для переноса ИС TSV имеет следующие дефекты или недостатки:
1) неоднородность пассивирующего слоя в глубинных стенках отложений PECVD. толщина теплоизоляционного слоя в глубине глубоких отверстий составляет только около 1 / 5 толщины верхнего теплоносителя, нижняя теплоизоляция плохо покрыта. легко создавать разрывные дефекты, серьезно влияет на эффективность и надежность изоляции. Это также ограничивает способность к осаждению на глубину и ширину процесса осаждения пассивирующего слоя;
2) вяжущее / диффузионное заграждение и однородность семенного покрова на боковых стенках глубоких отверстий, готовых к магнитному распылению, являются менее однородными. толщина нижней части глубокого отверстия составляет около 1 / 5 толщины верхней части. нижняя часть глубоких отверстий плохо покрыта. в процессе гальванизации могут возникать нарушения непрерывности, которые приводят к пустоте и серьезным образом сказываются на надежности проходного отверстия. В настоящее время осадочная мощность самого современного магнитоуправляемого распылителя составляет менее 15: 1, что ограничивает осадочную мощность TSV;
3) когда соотношение сторон в глубоких отверстиях составляет 20: 1 - 30: 1, трудно осуществить процесс наполнения без пористого гальванического покрытия, большая апертура занимает площадь сборки элементов, уменьшает площадь монтажа и не способствует герметизации высокой плотностью;
4) в соответствии с традиционным технологическим ограничением для изготовления транзисторных плит TSV, толщина передающей плиты обычно составляет менее 200 бит / мин.
5) высокая стоимость тарелок TSV, сложность процесса упаковки и отсутствие у многих технологий упаковки преимуществ с точки зрения затрат;
6) из - за физических различий между кремниевыми и органическими подложками у адаптеров TSV возникают проблемы с надежностью, что затрудняет интеграцию;
7) обычные биологические базисы удовлетворяют требованиям общей плотности упаковки, но не могут быть удовлетворены требованиями к упаковке, предъявляемыми к сверхвысокой плотности (например, менее 55um с переходом на обратную точку).
Цель полезной модели реализуется следующим образом
Структура корпусной платы ИС включает в себя общую подложку, из которой на вышеописанных общих базовых пластинах на верхней поверхности установлено множество паяльных пластин I, на нижеперечисленных поверхностях установлено множество разделителей II, она также включает сверхплотную основу, чип высокой плотности, чип низкой плотности и слой инкапсуляции I.
Установите упаковочный слой I на верхнюю поверхность обычной базовой платы. Основа сверхвысокой плотности состоит из изоляционного слоя, состоящего из нескольких слоев металлического покрытия высокой плотности и избирательного расстояния между ними, накладки на вышележащую поверхность, избирательной геоэлектрической связи между двумя или несколькими слоями проводов высокой плотности, вставьте высокоплотную подложку в герметичный слой I, верхняя поверхность и паяльная пластина торчат из герметичного слоя I, и Ширина линии / расстояние между линиями металлического слоя высокой плотности перемотки подложки сверхвысокой плотности полезной модели составляет менее 6 / 6um. или, ширина линии / расстояние между линиями металлического слоя высокой плотности перемотки подложки сверхвысокой плотности полезной модели составляет 5 / 5um, 3 / 3um или 1,8 / 1,8um. Количество слоев металлического слоя высокой плотности перемотки подложки сверхвысокой плотности полезной модели составляет более пяти. Альтернативно, количество слоев металлического слоя высокой плотности перемотки подложки сверхвысокой плотности составляет 6, 7 и 8. Эта новая полезная модель также включает инкапсулированный слой II, обнаженный графитовый носик кристалла высокой плотности, чип низкой плотности, подложку высокой плотности, внешний металлический электрод с покрытием и основание. Альтернативно, она также включает сквозное отверстие, сквозное отверстие инкапсулированного слоя I и общей подложки, внутренняя часть сквозного отверстия заполнена металлом, нижняя часть площади поверхности внешнего металлического электрода основания соединена через сквозное отверстие сквозного металла с частью общей подложки II.
полезные результаты этого практического нового типа:
этот практический новый тип конструкции гибридной плотности упаковки базы с плотностью упаковки использует ультраплотную органическую базу вместо промежуточного слоя кремния, а также встраивает в обычную структуру органической базы, чтобы обеспечить более мелкие ширины линии / линейные расстояния и более высокий уровень плотности слоистого металлического покрытия, интегрирование в одну и ту же область герметизации нескольких ис высокой плотностью и низкой плотностью кристаллов не только позволяет эффективно сократить путь передачи информации, но и может обеспечить большую функциональность, большую мощность и большее количество проводов, способствовать более быстрой передаче сигналов, адаптироваться к быстрым усовершенствованиям высокоскоростных полупроводниковых компонентов IC, высокая частотная емкость, дальнейшее снижение общей толщины упаковки, является высокорентабельной и гибкой технологии упаковки, которая может адаптироваться ко многим высокоэксплуатационным видам применения, которые затронуты пространством;
этот практический новый тип в полной мере использует гибкость сверхплотной базы материала, повышает надежность упаковки и улучшает выход продукции.
среди них: плита сверхвысокой плотности 10, металлический электрод 110, слепое отверстие 150, проходное отверстие 170, обычная базовая плита 20, паяльная площадка I 230, паяльная площадка II 250, паяльная сфера 251, наплавленный слой I 310, наплавленный слой II 430, микросхема высокой плотности 51, микросхема низкой плотности 53, наплавленный слой II 610.
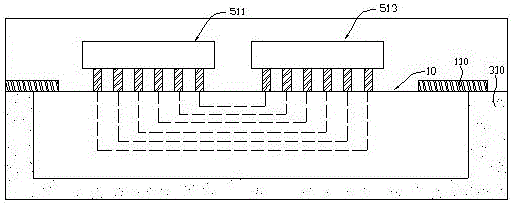
Пример конкретного режима реализации
обычная ic - основная плита 20 обычно относится к основному материалу, изготовленному из электронной обшивки и несущего электронного элемента. Она выполняет три функции: электропроводность, изоляция и поддержка. как правило, основная плита состоит из листов, покрытых медным слоем. на основе селективной обработки отверстий, химического омеднения, омеднения, травления и т.д. на основной плите получаются схемы, а на верхней поверхности общественной плиты 20 образуются несколько паяльных плит i230 и несколько паяльных плит –250. как правило, ширина металлического слоя / ширина линий на обычной базовой пластине 20 составляет соответственно 40 / 40 хм, 20 / 20um и 8 / 8um, а в крайних случаях - 10 / 10um. этот практический новый тип конструкции тарелочного фундамента установлен над обычным базисом 20 с характеристиками гибкости сверхвысокой плотности базиса 10. основа сверхвысокой плотности состоит из нескольких слоев металлического покрытия с высокой плотностью переплетения и изоляции между ними. Существует селективная электрическая связь между металлическим слоем проводов с высокой плотностью переплетения. описанный паяльный арочный устанавливается на верхней поверхности пластины сверхвысокой плотности 10 с характеристиками легкой, тонкой, несимметричной и высокой формы пластичности. можно отметить, что ширина листов UHD 10 / линейное расстояние менее велико по сравнению с обычными базовыми пластинами 20, при большей плотности переплетения металлического слоя и при более плотной укладке металлического слоя на единицу площади. Таким образом, он называется сверхвысокой плотностью базы 10, общая толщина которой не превышает 100um, что способствует снижению толщины общего ic - упаковки.
Эта новая практичная технология производства панелей в форме пластин, не требующая использования сложных процессов TSV, позволяет избежать таких проблем, как гальванизация глубоких отверстий, высокая плотность гибкого применения интегральной схемы на основе 10 улучшает надежность упаковки, способствует повышению выхода продукции.