Heterogeneous 3DIC still faces mass production threshold
Although the 3DIC+TSV three-dimensional stacking technology can increase the density of the chip with the smallest area, Снижение себестоимости, уменьшение размера продукции, это повышает производительность и надежность кристаллов, три звезды is also the first to introduce a homogeneous 3DIC stacked NANDFlash flash Memory, память DDR3, есть я/ODRAM chips for desktop and notebook computers. IC design companies such as Qualcomm and BroadComm have also introduced 3DTSV technology to design next-generation higher-density ICs.
- 2....5D technology has been widely applied to logic operation chips such as центральный процессор/GPU/FPGA. международная компания коммерческих машин/AMD 2.5D/3DIC technology will further drive heterogeneous integration applications such as DRAM, Содружество Независимых Государств, RF, светодиод, and optoelectronic components. Yole International Semiconductor Association (SEMI) continues to carry out the 3DTSV plan, & пригласить HP, международная компания коммерческих машин, Intel, три звезды, Qualcomm, станционное накопление, UMC, современный, Atotech, ( ASE, ST, Samsung, микрон, грофанде, NEXX, FRMC and other industries have actively invested in 3DIC R&D and production, and built a 3D профессия chain ecology with clear specifications.
В настоящее время интегрированные приложения 3DIC по - прежнему представляют собой одну и ту же технологию изготовления, homogeneous chip (Homogenuous) integration, such as DRAM, кристалл NANDFlash, многоядерный микропроцессор. IEK expects that from this year (2013), Ожидается, что такие 3DIC, как DRAM и NANDFlash. As for the heterogeneous integration of logic chips (Logic), memory chips (DRAM), radio frequency ICs (RF), power amplifiers (PA), photoelectric conversion chips, сорт., it is limited by technical issues such as power consumption and packaging material coefficients. Это ещё не преодолено.
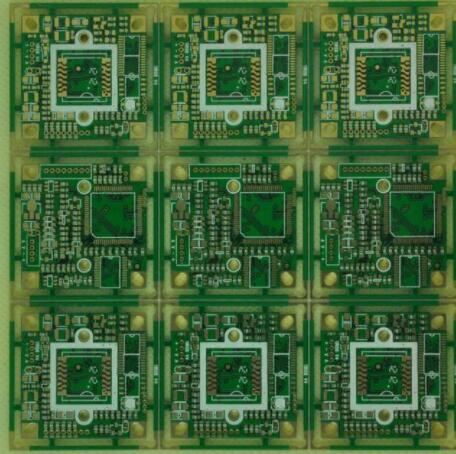
2.5 технология посредничества - первая технология, внедренная в крупномасштабное производство FPGA, GPU / APU
As mentioned earlier, Применение трехмерной интегральной схемы в изомерной ИС. он сложит голый кремниевый кристалл с различными логическими процессами и эксплуатационными характеристиками, and uses TSV (Silicon Drilling) technology to interconnect the chips. При укладке различных типов кристаллов, power consumption and heat dissipation issues will require special treatment.
Если сложить только один чип DRAM с напряжением 1V и энергопотреблением 2W, пусковой ток составляет около 2 ампер. Если сгруппировать на них 2GHz, процессор с несколькими ядерными процессорами или графический процессор (GPU), то для этого потребуется несколько десятков ватт или даже больше мощности. при 100 Вт ток легкого пуска может достигать нескольких десятков ампер, что почти может быть обработано батареями уровня автомобиля. этот чип смертельно опасен для проектирования мобильных портативных устройств; Она обеспечивает большой ток в такой ограниченной и плотной зоне. дизайн электропроводки и выбор электрических чипов является техническим вызовом, даже сам ток является крупнейшим источником помех, влияющим на эффективность и стабильность цепи.
High-frequency operation CPU and GPU chips can usually heat up to 120 degrees. However, при температуре кристаллов DRAM и NANDFlash выше 85°C, the refresh mechanism and storage tolerance will be abnormal. если процессор подключен к DRAM, NANDFlash складывается, the high heat of the CPU will affect DRAM and NANDFlash; in addition, фотоэлектрическое устройство, the operation stability will be greatly reduced when the temperature reaches 80°C or more. есть также различные виды голых мод. When stacked together, необходимо учитывать эффект теплового напряжения различных коэффициентов теплового расширения на механизм герметизации, and even overheating will cause the deformation of the stacked wafer layer and even the tin cracking. как рационально организовать укладку этих чипов с различными температурными характеристиками, с тем чтобы они не взаимодействовали в процессе теплоотвода, это очень серьезная техническая задача. This is the reason why 3DIC, уже серийный выпуск, в первую очередь, это низкое энергопотребление в эквиваленте DRAM и NANDFlash.
- 2....5DIC (or 2.5DInterposer) technology was first proposed by the factory leader (ASE), потом стал термин, потом полупроводник industry. The method is to make the dies of various processes/рабочие характеристики не накладываются друг на друга, but arranged in parallel and close to each other, placed on the glass or silicon-based material Interposer (interposer) for connection, and then connected to the bottom The плата PCBсократить время задержки сигнала, повысить общую производительность системы; каждый параллельный пресс - форма может быть проверен отдельно, затем рядом с перфорацией и сборкой. Ему не нужна высокая температура/electromagnetic radiation test, as long as it is placed on the intermediate board ( Interposer) can go through an overall integration test after packaging. при выполнении укладки 3DIC, жаркий/electromagnetic testing must be performed on each layer in the stack; if one of the die is defective, полный комплект 3DIC должен быть возмещен.
2.5DIC считается полупроводник industry as an intermediary technology for the transition to the future 3DIC. Кроме использования вставки как связующего звена между чипами, Следует также обратить внимание на такие вопросы, как сочетание die и вставщика, material properties, тепловое напряжение. Compared with 3DIC, 2.5DIC has a lower technical bottleneck. The silicon interposer used in the circuit board (SIInterposer) generally does not need to use the 40nm or even 28nm advanced manufacturing process like the processor chip, и можно снизить себестоимость производства.
Take Xilinx2. процессор 5D FPGAпривести пример. After the bare 28/40nm FPGA, Они были размещены на 65 нано - кремниевых вставках. The total cost is lower than the previous 40nm or even 28nm SOC process. поэтому, the application field of 2.5DIC не ограничивается запоминающим чипом. высокопроизводительные и высокоинтегрированные логические вычислительные чипы, такие как FPGA, CPU, GPU, сорт., have begun to apply 2.5dinterposer техника.
2.5D/3DIC killer application
Semiconductors who have introduced the 2.5DIC concept into mass production are represented by the leading programmable logic gate array (FPGA) manufacturers Xilinx and Altera. Both companies use TSMC's CoWos (ChiponWaferonSubstrate) 2.5DIC Technology. например, чип Virtex - 720000 TFPGA Xilinx, 28nm bare dies are closely arranged side by side. микровыпуклый блок под голым чипом подключен к 65nm кремниевой вставке. после, they are connected to the solder balls by TSV technology and then penetrated. Connect the solder ball to the PCB board below.
Кроме того, для графических чипов IntelIrisPro5200 (GT3e), совместимых с восьмью ядерными Апу, полумодифицированными процессором IBM Power8, процессором Corei IV поколения Intel (Haswell) и AMD, будет использоваться технология упаковки 2,5 DIC.
Что касается компонента 3DIC, то, помимо однородной упаковки чипов DRAM (Widei / O) и NANDFlash, компания "Altera" недавно объявила о выпуске следующего поколения 20 нм FPGA, на котором будет использоваться процесс 20нм следующего поколения TSMC плюс 3DIC. были собраны более двух наборов чипов FPGA, многоярусных микропроцессоров ARM, адаптированных пользователем пакетов ASIC, цифровых сигналов DSP с регулируемой точностью и многослойных пакетных накопителей.
на долю асе, силикон продактс, сиань и намо приходится 56 процентов мировых рынков герметизации и тестирования литья, что также является ключом к последней миле промышленной цепи 3DIC. ASE использует стандарт 3DS - IC для полуспецификаций платформ и активно сотрудничает с DesignHouse и Foundry в целях завершения работы над спецификациями для совмещения Dietode, Dietosip и подтверждения надежности упаковки 3D; инструкция по обеспечению качества 3DQA для установки литья, склада памяти, упаковки и испытания 3D - носителей, зажимов, установки, а также для участия в сборке TSV, JEDEECJC - 11WideI / O памяти и 3DQA.
Кроме того, были введены в строй 2,5 D / 3DIC - структура CoWOS (ChiponWaferonSubgrade) - интегрированная технология производства, обеспечивающая TSV / 3D, различные материалы с рельефными точками, включая технологии посадки, кремниевые вставки (Si Integrator) и комплексные подсистемы. В то же время продолжались инвестиции в технологии 2,5 D / 3DIC в целях ускорения внедрения во всю промышленную цепочку EDA, IP, тестирования, оборудования, поставщиков кремниевых пластин и предприятий по упаковке. UMC и заводы по упаковке и испытаниям в нижнем течении реки ищут открытую отраслевую модель (OpeneCosystemodel) для разработки 3DIC технологий.
IEK pointed out that 3DIC technology has been introduced into memory storage chips such as NANDFlash and DRAM before 2010. с 2010 года, mass production of CIS (CMOS image sensor) and MEMS (microelectromechanical) components has also been introduced. There are applications such as power amplifier chip (PA), светодиодный чипpackaging, герметизация фототрансформаторных элементов. 2013 год, it is expected that the homogeneous multi-layered MemoryCube and WideI/ODRAM will be mass-produced; and the heterogeneous 3DIC (Heterogeneous 3DIC) integrating multi-core CPU, FPGA, ASIC, memory, Ожидается, что фотоэлемент будет введен в эксплуатацию в 2014 - 2015 гг..