За последние сто лет с быстрым развитием интегральных схем совершенствовалась и технология производства упаковочных плат для ИС - integrated circuit , увеличивались потребности в применении ИС в промышленности, повышалась степень интеграции. Общий процесс развития упаковки: TO-DIP-PLCC-QFP-PGA-BGA-CSP-MCM, технические показатели улучшаются от поколения к поколению, соотношение площади микросхемы и площади упаковки все ближе и ближе к 1, электрические характеристики и надежность постепенно улучшаются, объем становится все меньше и тоньше.
1. MCM (multi-chip component)
По сути, это компонент микросхемы, новейшая технология. Это технология упаковки, при которой несколько полупроводниковых чипов собираются на проводящей подложке. Таким образом, она позволяет отказаться от материалов и процессов упаковки ИС, что обеспечивает экономию материалов. При этом сокращается необходимый производственный процесс, поэтому, строго говоря, продукт представляет собой высокоплотную сборку
2. CSP (chip-level package)
Упаковка CSP - это упаковка на уровне микросхемы. Как известно, микросхемы имеют небольшие размеры. Поэтому CSP-упаковка последнего поколения технологии упаковки микросхем памяти позволяет сделать соотношение площади микросхемы к площади упаковки более чем 1:1,14, что довольно близко. Идеальная ситуация 1:1 оценивается промышленностью как наивысшая форма для одной микросхемы. По сравнению с платой BGA пакет CSP позволяет увеличить объем памяти в три раза на той же площади. Этот пакет характеризуется малыми размерами, большим количеством входных/выходных выводов и хорошими электрическими характеристиками. Существуют CSP BGA (ball grid array), LFCSP (lead frame), LGA (grid array), WLCSP (wafer level) и т.д.
1. CSP BGA

(2) LFCSP (выводная структура)
LFCSP, этот пакет похож на свинцовую рамку, в которой используются обычные пластиковые упаковочные схемы, но имеет меньшие размеры и меньшую толщину, а подушечки пальцев выходят во внутреннюю область микросхемы. LFCSP представляет собой пластиковый пакет на основе свинцовой рамки. Внутреннее соединение пакета обычно осуществляется с помощью проводов, а внешнее электрическое соединение - путем приварки периферийных выводов к плате печатной платы. Помимо выводов, LFCSPS обычно имеют большие открытые тепловые площадки, которые могут быть приварены к печатной плате для улучшения теплоотвода.
3. LGA (Grid Array)
Это пакет с решеткой, аналогичный BGA, за исключением того, что BGA припаивается, а LGA можно открепить и заменить в любой момент. То есть, по сравнению с BGA, его можно заменить, но процесс замены должен быть очень аккуратным.
4. WLCSP (уровень подложки)

4. BGA (Ball grid Array)
Один из видов массивов шариковых контактов, пакеты поверхностного монтажа. На задней стороне печатной платы вместо штырьков изготавливаются сферические выпуклости в режиме дисплея, а микросхема LSI монтируется на передней стороне печатной платы, которая затем герметизируется с помощью литьевой смолы или поттинга. Также известна как bump display carrier (PAC). К BGA в основном относятся: PBGA (пластиковый пакет BGA), CBGA (керамический пакет BGA), CCBGA (керамический цилиндрический пакет BGA), TBGA (несущий пакет BGA) и т.д. Используемые в настоящее время упаковочные устройства BGA в зависимости от типа подложки в основном включают CBGA (ceramic grid array package), PBGA (plastic grid array package), TBGA (carrier grid array package), FC-BGA (flip-chip grid array package), EPBG (enhanced plastic grid array package) и др.
4-1 CBGA (керамика)

CBGA имеет самую долгую историю в семействе корпусов BGA. Основание имеет многослойное керамическое покрытие, а металлическая крышка приваривается к основанию с помощью герметизирующего припоя для защиты микросхемы, выводов и площадки. Это пакет для поверхностного монтажа с набором припоев в нижней части для легкого доступа.
4-2 FCBGA
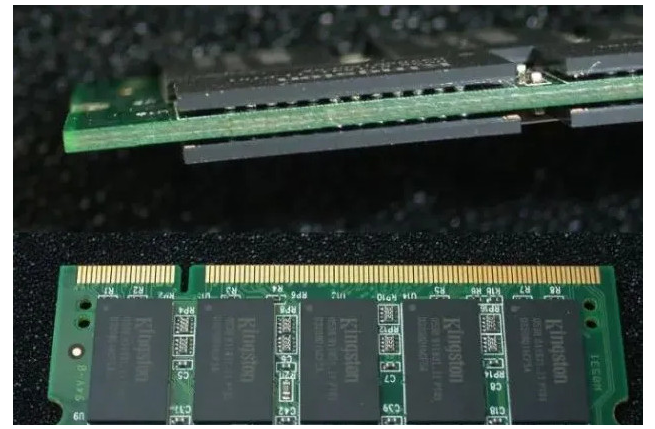
FCBGA реализует прямое соединение между шариком припоя микросхемы и подложкой BGA с помощью флип-чипа. В изделиях BGA достигается более высокая плотность упаковки и улучшаются электрические и тепловые характеристики.
4 - 3PBGA

BGA-пакет, в котором в качестве подложки используется ламинат BT-смола/стекло, а в качестве материала для герметизации - эпоксидный формовочный пластик. Такая микросхема чувствительна к влаге и не подходит для корпусирования устройств с высокими требованиями к герметичности и надежности.
4-4 SBGA

В SBGA используется усовершенствованная конструкция подложки, включающая медные ребра для улучшения теплоотвода, а также надежные технологии сборки и материалы, обеспечивающие высокую надежность и превосходные эксплуатационные характеристики. Сочетая высокую производительность с малым весом, типичный пакет SBGA площадью 35 мм² монтируется на высоту менее 1,4 мм и весит всего 7,09.
5. PGA (Needle Grid Array)

Инкапсуляция выводов дисплея. В одном из вставных корпусов вертикальные выводы на дне расположены в виде массива. Упаковочная подложка представляет собой многослойную керамическую подложку. Используется для высокоскоростных крупномасштабных логических схем LSI. Выводы расположены в нижней части микросхемы, обычно имеют квадратную форму, расстояние от центра до вывода обычно составляет 2,54 мм. Количество выводов варьируется от 64 до 447. Как правило, они бывают двух типов: CPGA (Ceramic Pin Grid Array Package) и PPGA (Plastic Pin Grid Array Package).
6. QFP (Quad Flat Package)
Этот тип упаковки представляет собой квадратный плоский пакет, обычно квадратный, с четырьмя сторонами выводов. В этом пакете расстояние между выводами микросхемы процессора очень мало, выводы очень тонкие. Как правило, в таких пакетах используются крупномасштабные или очень крупномасштабные интегральные схемы, число выводов которых обычно превышает 100. Благодаря меньшему размеру пакета уменьшаются паразитные параметры, что позволяет использовать его в высокочастотных приложениях. К таким пакетам относятся: CQFP (Ceramic Quad Flat Package), PQFP (Plastic Quad Flat Package), SSQFP (Self Binder Quad Flat Package), TQFP (Slim Quad) Flat Package), SQFP (Shrink Quad Flat Package).
(1) LQFP (тонкий)
Это тонкий QFP. Относится к QFP с толщиной упаковки 1,4 мм, что является названием, используемым японской электронной промышленностью в соответствии с новой спецификацией формы QFP.
(2) TQFP (тонкий квадрат)
7. LCC (lead or lead-free chip carrier)
Керамический корпус для микросхем с выводами, один из корпусов поверхностного монтажа, с выводами, идущими с четырех сторон корпуса. Это пакет для высокоскоростных высокочастотных ИС, также известный как керамический QFN или QFN-C.
(1) CLCC (крыльевой вывод)
(2) Наименее развитые страны
Микросхема с С-образным штырьком, штырек выдвигается из верхней части микросхемы и загибается вниз в С-образную форму
(3) PLCC
Штырьки выдвигаются с четырех сторон корпуса, имеют Т-образную форму и изготовлены из пластика. Расстояние между центрами выводов составляет 1,27 мм, а количество выводов варьируется от 18 до 84. Он проще в эксплуатации, чем QFP, но сложнее в проверке внешнего вида после сварки.
8. SIP (single-in-line Encapsulation)
Выводы в однорядном корпусе выводятся с одной стороны корпуса по прямой линии. Обычно в сквозном корпусе выводы идут с одной стороны пакета и выстраиваются в прямую линию. При монтаже на печатную плату пакет располагается сбоку. Межосевое расстояние между выводами обычно составляет 2,54 мм, количество выводов варьируется от 2 до 23, большинство из которых являются заказными изделиями. Форма корпусов различна.
9. SOIC (маленькая интегральная схема)
SOIC - это пакет интегральной схемы малой формы. Количество внешних выводов не должно превышать 28 ик малой формы. Как правило, существует два типа корпусов: ширококорпусный и узкокорпусный. По сравнению с аналогичным пакетом DIP он занимает примерно на 30-50% меньше места. Толщина уменьшается примерно на 70%.
10. SOP (small package)
Упаковка SOP - это разновидность упаковки компонентов. Распространенными упаковочными материалами являются: пластик, керамика, стекло, металл и т.д., в настоящее время в основном используется пластиковая упаковка. Она имеет широкий спектр применения, в основном используется в различных интегральных схемах. Затем появились TSOP (тонкий пакет малого профиля), VSOP (пакет очень малого профиля), SSOP (пакет уменьшенного профиля), TSSOP (тонкий пакет уменьшенного профиля), MSOP (пакет микропрофиля), QSOP (пакет профиля четверти размера), QVSOP (пакет профиля четверти размера очень малого профиля) и др.
(1) SSOP (уменьшенный тип)
(2) TSOP (тонкий пакет малой формы)
(3) TSSOP (тонкий уменьшенный)
11. SOT (маленький транзистор)
SOT - это разновидность SMD-пакета. Для устройств, имеющих менее 5 выводов (3pin, 4pin), обычно используется SMD-пакет. При небольших размерах в этом корпусе используется большое количество транзисторов.
Это также транзисторный пакет. Как правило, обе стороны имеют выводы, количество выводов - 3, 4, 5, чаще всего не более 7.
12. DIP (двухпроводный пакет)
Пакеты DIP также известны как пакеты с двойным проводом или пакеты с двумя проводами. В большинстве малых и средних интегральных схем используется именно такая форма упаковки, количество выводов обычно не превышает 100. Микросхемы в такой упаковке имеют два ряда выводов. Выводы могут быть приварены непосредственно к гнезду микросхемы DIP-структуры или к месту сварки с тем же количеством отверстий. Его особенность заключается в том, что он может легко реализовать сварку со сверлением печатной платы, хорошо совместим с материнской платой.
(1) CerDIP (керамический двухрядный пакет)
Керамический двухрядный пакет Cerdip предназначен для оперативной памяти ECL, DSP (Digital Signal Processor) и других схем. Cerdip со стеклянным окном используется для стираемых УЛЬТРАВИОЛЕТНЫХ EPROM и микрокомпьютерных схем со встроенными EPROM и т.д.
(2) PDIP (пластиковый пакет)
Этот вид пластикового пакета типа "два в линию" достаточно распространен. Подходит для установки в сквозные отверстия печатной платы. Прост в эксплуатации, может использоваться для отладки сокетов ИС. Однако размер пакета намного больше размера микросхемы, эффективность упаковки очень низкая. Большая площадь эффективной установки.
13. TO (Transistor shape package)
Упаковочная плата ИС TO представляет собой упаковку транзисторной формы. Один из них представляет собой транзисторный пакет, допускающий поверхностный монтаж выводов, а другой - круглый металлический корпус без компонентов поверхностного монтажа. Этот пакет широко распространен, в нем используются многие транзисторы, МОП-трубки, тиристоры и т.д. integrated circuit