Название продукта: подложка бга IC
табличка "Mitsubishi Gas HBT HL832NX - A - HS"
минимальная ширина/расстояние: 30/30um
Поверхность: ENEPIG (2U)
толщина печатной платы: 0,3 мм
этаж: 4
структура: 1л - 4л, 1л - 2л, 3л - 4л
антикоррозийная краска: сайян PSR4000 AUS308
отверстие: лазерное отверстие 0,075 мм, механическое отверстие 0,1 мм
назначение: базовая интегральная схема бга
подложка интегральной схемы бга каркас - ключевой специальный базовый материал, используемый основа интегральной схемы. Он используется главным образом для защиты чипов, выполняя функции IC Чипа и внешнего интерфейса. Его форма - шёлковая лента, обычно золотой. Конкретный процесс использования выглядит следующим образом: сначала эта основополагающая интегральная схема наклеивается на интегральную схему рама автомата дисков, затем контакты на интегральную схему и узлы на интегральную схему соединения станины через преобразование и, наконец, на микросхему микросхемы. защищен упаковочным материалом для формирования фундаментальной интегральной схемы,удобный для последующего применения. снабжение основа интегральной схемы рамка зависит от импорта.
TAIYO PSR4000 AUS308 — специальные чернила для основа интегральной схемы. сверхгрубая и вертикальная Предварительная обработка. чернила очень тонкая. Предварительная обработка включает пескоструйную обработку + суперогрубление. технология никеля палладия не повторяется масла. Цвет очень красивый. поверхность меди должна быть очищена. шероховатость не очень важна. прилипание хорошее. необходимо использовать пескоструйную обработку, чтобы свести к минимальному различию на поверхности меди, параметры затычки: 75 * 132х132х1х1ч, 95–1 час, 110 в течение 1 часа, 150 минут, чтобы продлить 50 минут, выпечка в течение 25 минут после печати текста, горизонтальная сухая часть текста, 180 градусов. Примечание: эффект от пуццолана хуже, чем от пескоструя. решение проблемы увеличения массы и увеличения массы меди не требует больших результатов. Так же, как разница в цвете золотой поверхности, нужно немного песка. Наждак может быть чуть толще, 280 предметов.
BGA (Ball Grid Array) - технология упаковки массива шариковых штифтов, оборудование герметизации и герметизации поверхности достигает больших размеров. В нижнем пакете контакты имеют сферическую форму и расположены в виде сетки, так называемого BGA. группа кристаллов управления основной пластиной использует эту упаковку упаковки, а материал в основном керамический. Использование технологии BGA для хранения памяти может увеличить объем памяти в два-три раза без изменения объема памяти. По сравнению с TSOP, бга имеет меньший объем, Улучшение теплоотводящих и обычных свойств. технологии бга значительно увеличили емкость хранения на квадратный дюйм. получение возможности, продукты памяти с использованием технологии упаковки BGA составляют лишь треть объема упаковки TSOP; по сравнению с традиционной упаковкой TSOP, упаковка бга имеет более быстрый и быстрый способ выделения тепла.
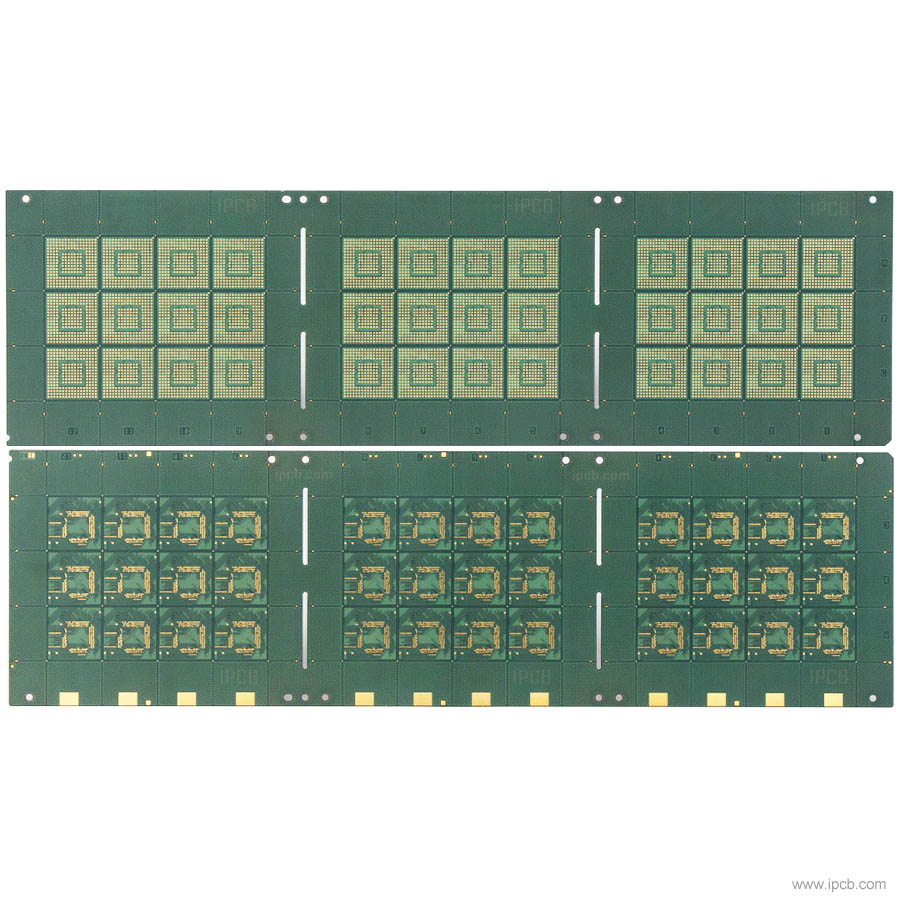
Зажимы, установленные в бга, распределяются в форме круглых или цилиндрических сварных точек. преимущества технологии бга заключаются в том, что, несмотря на увеличение числа ссылок I / O, расстояние между ними не сокращается, а увеличивается. увеличение коэффициента сборочной и готовой продукции; Несмотря на увеличение энергопотребления, BGA может производить сварку с помощью управляемых складных чипов, повышая тем самым свою тепловую производительность; по сравнению с предыдущими технологиями упаковки, толщина и вес уменьшились; паразитный параметр уменьшается, задержка передачи сигнала мала, частота использования значительно повышается; сборка может стыковой сварки, высокая надежность.
пломбы BGA (Ball Grid Array, шаровая сетка), т.е. оборудование, использующее такую техническую упаковку, - оборудование для нанесения покрытия на поверхность. по сравнению с традиционным оборудованием для монтажа ног (QFP, PLCC и т.д.)
1) есть много I / O. количество встроенных в BGA устройств I / O в основном зависит от размера упаковки и расстояния между сварными шариками. Поскольку сварные шарики, упакованные в BGA, размещаются в решетке под крышкой, их можно значительно увеличить в количестве I / O, уменьшить размер упаковки и сэкономить места, занимаемые сборкой. в целом, при одинаковом количестве проводов размер упаковки может быть уменьшен более чем на 30%. например, CBGA - 49, бга - 320 (интервал 1.27 мм) и MOFP - 304 (интервал 0,8 мм), соответственно, размер упаковки сократился на 84% и 47%.
2) увеличить размещение продукции и, возможно, снизить себестоимость. обычные устройства QFP и PLCC равномерно распределены вокруг герметизированного корпуса, а расстояние между ними составляет соответственно 1,27, 1,0, 0,8, 0,65 и 0,5 мм. с увеличением количества I / O интервал должен быть все меньше и меньше. когда шаг винта меньше 0.4 мм, точность устройства smt не удовлетворяет требованиям. Кроме того, провода очень легко деформируются, что приводит к увеличению числа сбоев при размещении. шарики для сварки в устройстве BGA расположены в нижней части массива и могут быть размещены вместе с другими устройствами I / O. стандартное расстояние между паяльными шариками составляет 1.5 мм, 1.27 мм, 1.0 мм, тонкое расстояние BGA (напечатано BGA, также известное как CSP - BGA, может быть классифицировано как CSP - пломбирование), которое составляет 0.8 мм, 0.65 мм, 0.5 мм, и в настоящее время некоторые технологические установки SMT совместимы с коэффициентом отказов менее 10 ppm.
3) контактная поверхность паяльного шара в решетке бга является большой и короткой и способствует охлаждению.
4) У сварных шаров бга очень короткие штыри, сужает путь передачи сигналов, снижает индуктивность и сопротивление проводов, это повышает производительность цепи.
5) заметно улучшилось сходство оконечностей I / O, что привело к значительному сокращению потерь, связанных с общим разрывом в процессе сборки.
6) BGA применяется к упаковке MCM, что обеспечивает высокую плотность и высокую производительность MCM.
7) бга и ~ BGA являются более прочными и надежными, чем IC с мелкими интервалами.
Название продукта: подложка бга IC
табличка "Mitsubishi Gas HBT HL832NX - A - HS"
минимальная ширина/расстояние: 30/30um
Поверхность: ENEPIG (2U)
толщина печатной платы: 0,3 мм
этаж: 4
структура: 1л - 4л, 1л - 2л, 3л - 4л
антикоррозийная краска: сайян PSR4000 AUS308
отверстие: лазерное отверстие 0,075 мм, механическое отверстие 0,1 мм
назначение: базовая интегральная схема бга
Что касается технических проблем PCB, то команда поддержки iPCB, обладающая обширными знаниями, поможет вам сделать каждый шаг. можно вас попросить PCB Вот цитата. Пожалуйста, свяжитесь по электронной почте sales@ipcb.com
мы будем быстро реагировать.