Yüksek performans ve güvenilir-IC Paketi ile encapsulasyon çipinlerin teknolojisini araştırma teknolojisi
Elektronik komponentlerin pazar geliştirme yöntemi (Yazık Dönüş Tahtası Kurulu-PCBA için)
Yüksek integrasyon ve hızlı LSI'nin yetişkin teknolojisi için uygun olarak K materyalleri kullanarak izolasyon teknolojisini geliştirmek gerekir. Fakat bu birimlerin yüksek performansını tatmin etmek için, izolasyon, porous ve çok katı yapısı yüzünden daha ince ve ince olur. Sonuç olarak LSI küçük oluyor. Diğer taraftan, yüksek hızlı ihtiyaçları yerine getirmek için LSI akışı sürekli arttırılır. Büyük ve küçük, sıcak yoğunluğu ve güç tüketiminin yanında da artıyor. Bu nedenle gelecekte yarı yönetici paketleme altınında (IC Altı paketleme paketleme) için bu sorunları çözmek gerekir, yani, karışık katmanın ortamının kırıklığı, yüksek ısı, yüksek hızlı ve düşük maliyeti. Yarı yönetici süreçlerin gelecekteki önlemi 20 nm nesilinde ve aşağıda olacak. Bu çok daha zayıf olacak.
20 nm üretimi için gerekli paketleme teknolojisi
Bir sonraki nesil 20 nm için gereken belirlenme:
K ı düşük katı için düşük stres
Yüksek üstünlük LSI için yüksek sıcak radyasyon â137W;
Yüksek çalışmalar için yüksek hızlı â137;¥10GHz
Semikonduktor paketleme geliştirme yöntemi
Mobil tesisleri dahil elektrik tesislerin fonksiyonel büyüme ve maliyeti azaltmak için, wafer ön ayarlama kuralları daha büyük ve daha iyi ön ayarlama kurallarına doğru ilerliyor. Bu yüzden ve maliyetleri azaltmak için, yarı yönetici paketleme teknolojisi kullanılan altın miktarını azaltmak için en standart bağlama teknolojisinden hemen değiştiriliyor. Ayrıca, flip-chip bağlama teknolojisinin kullanımı LSI'nin yüksek integrasyonu ve performansını çok tatmin etti. 2010 yılında dönüş çip bağlantıs ı yüzde 15 ve dünyanın yarı yönetici paketleme teknolojisinin yüzde 85 bağlantısı sayıldı. 2015 yılına kadar, dönüş çip bağlantısının %25'e ulaşmasını bekliyor ve ön bağlantısının %75'e ulaşmasını bekliyor. Özellikle yüksek integrasyon ve yüksek performans LSI için, yüksek sıcak radyasyon ve yüksek sinyal hızına ihtiyacı olan, flip-chip bağlama teknolojisi aktif olarak uygun olarak kabul ediliyor.
Ortak mantıklı dönüştürme teknolojisi
Daha düşük K için yeteneklik
Genelde dönüş çip teknolojisi kullanılır:
Yaklaşık tarafı karıştırmak, ana yapı C4 (kontrol edilebilir subsistence çip işareti)
Au bump ve ACF türünün basınç bağlaması için.
AU- AU tipi imzalaması için Ultrasonik bağlama.
Basınç ve ultrasyonik bağlaması LSI'ye uygulanan yüksek basınç ve mekanik oscilasyon var. Bu yüzden bu metodlar K LSI düşük için kullanılamaz. Bu yüzden, yukarıdaki metodlarda C4 uygun olarak kullanılabilir ve üç metodların karşılaştığı için, bağ C4'nin chip'e en azından hasar yaptığı gerçeğine uygun.
C4 teknolojisi genel amaçlı bilgisayarlar için 40'lerin başlarında oluşturuldu ve bundan beri kullanıldı. UBM yapıları, malzemeleri ve geliştirmeleri yerine koyarak, K4'nin düşük kanallarının arttığı sayısıyla, K4'nin düşük K için kullanıldı.
Son zamanlarda geliştirilmiş Cu sütun böcekleri (C4'deki gelişmelere yaklaşık benzer) düşük K waferleri için değil çizgi veya aşağılık böcekleri için uygun. Cu sütun yapısı kapsamülasyonu Cu (130GPa) yüksek elastik modulusu yüzünden düşük k katmanı hasar edebilir. Ateş genişleme koefitörünün (CTE) eşleşmesi hızlandırma faktörüdür.
Ayrıca, C4 teknolojisi ilk olarak fluks ve yüksek elastik fluks (50GPa) modulusu uygun olarak kabul edilmiştir. Bu yüzden anne tabağını bağlama ve kurulma sıcaklık genişlemesinin farklılığı yüzünden LSI'e stres miktarı eklendi. Bu yüzden C4 teknolojisi gelecekte LSI için kullanılamaz. Bu çok daha zayıf.
Termal radyasyon
Şimdiye kadar, organik substratlar çevrileme paketi için kullanıldı. Organik substratların sıcak davranışları küçük, 0, 5 W/ MK ve yüksek güç tüketimleri ile LSI'ye uygulamak zor. Eğer sıcak radyasyonu geliştirmek için soğuk veya soğuk sistemi eklenirse, kapsullama maliyeti, uça ğın veya yüzeyin boyutu ve yüksekliği artırır.
Aslında, sıcak radyasyon düşük olduğu için biraz LSI potansiyelini sınırlıyor. Büyük bir miktar ısı üretmek için. Ayrıca, sıcak radyasyon iyi değildir, birleşme sıcaklığı arttır, sıçma sıcaklığı arttırır, güç tüketimini daha da arttırır ve enerji tüketiminin arttırılması sıcaklığı arttırır. Tehlikeli kötü bir çevre. Bu yüzden sıcak radyasyon geliştirmesi yakın bir sorun.
Sinyalin yüksek hızı
Organik substratın orta katının kaybı yüksektir (0.02), ve merkez katının deliğinin (T/H) engellemesi yüksektir. Sonuç olarak yüksek frekans menzilinde giriş hasarı kaybı yüksektir. Ancak, geleneksel organik substratları ile aynı maddelerin korunulmaz substratlarını kullanmak temel çözüm değil. Ayrıca, kompozit katı materyalleri farklı olabilir, bu yüzden en iyi materyali seçmek için kullanıcı daha zordur, yüksek hızlı performansın problemini düşünmek için bütün ön ayarlama ihtiyaçları.
Çünkü substrat ince, bir dizi tesis değişmesi gerekiyor. Bu üretim için saçma bir blok olur. Bu problemin yüzünden, korunulmaz bir substrata taşımak yüksek riskdir ve sadece yerel ürünler için uygun.
Gelecek 20 nm nesilini tatmin etmek için geleneksel teknoloji zor. Bu yüzden yeni merkezi teknolojiyle yeni yarı yönetici paketlemek gerekiyor.
Monsterpac-typec ve işlem temel
Monsterpac-typec, geleneksel paketleme teknolojisine uyum sağlamak için 20 nm sürecini sağlamak için geliştirildi. Bu geleneksel paketleme süreci ve yapı paketlemekten kesinlikle farklı.
Kıpırdama yapısı
Paketleme yapımız, aparatımız seramik, yarı yönlendirici çip, çarpma, çip ve substrat toplama NCP (yönlendirilmez pasta). Epoksi gazı ya da doğal resin ile dolu değildir. Yani çipinin arkası açıldı. Yüksek sıcaklık kayıtların yüksek sıcaklık savaş sayfası küçük, 30-50μm'den az, bu yüzden paket kayıtlar olmadan LGA(bağlantı sistemi paketi), BGA değil. Gümüş içerisindeki yönetici pasta, yeraltında yazılmış, bu şekilde modullar artık patlarda üretilmeyecek şekilde kullanılır. Lafür patlama süreci olmadan, çipinin Al patlarının üstünde yalnızca altın ve patlaması yok (1-3 görüntü).
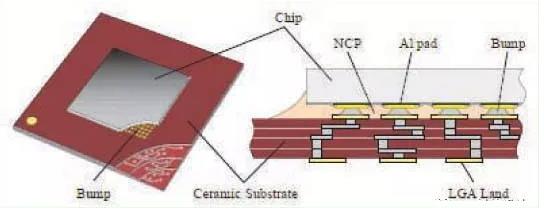
FIC-1 Paket Yapısı
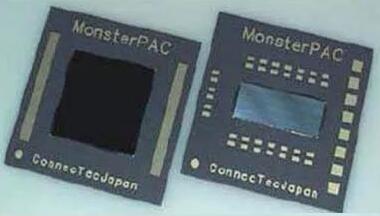
FIC- 2 Paket Resimi
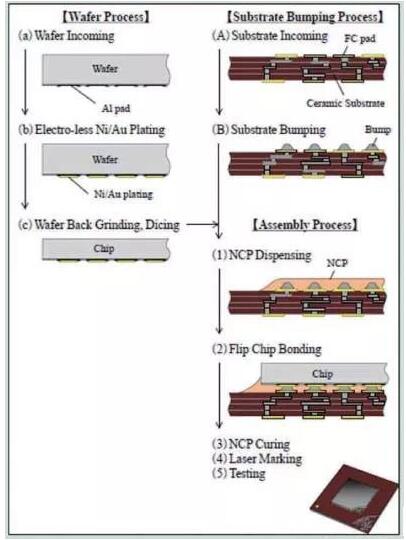
FIC- 3 İşlemi
Yukarıdakilere benziyor, paketimiz sadece 4 materyal (çip, bump, keramik ve NCP) oluşur. Bu basit yapı küçük, ince ve hafif bir paket için yapıyor.
Mevcut iki ana tür keramik substrat maddeleri var: HTCC (yüksek sıcaklık kopya atılan keramik) ve LTCC (düşük sıcaklık kopya atılan keramik). Keramiklerin özel özellikleri (elektrik özellikleri, sıcaklık yönetimi, CTE ve warping gibi) ve çep bağlaması paketlerimizin, elektrik ürünlerden yarı yönetici çiplere kadar en geniş bir süre gerekli çözümünü sağlaması için en iyi çözümü sağlayabilir.
Monsterpac-typec yapısı eşsiz.
Eşcinsel yerler böyle tanımlanır:
Hasar bağlaması yok.
Yüksek sıcak radyasyon.
Düşük giriş kaybı.
Yüksek güvenilir.
Bu büyük avantajlardan her birini birleştirerek, MonsterPac-TypeC 20 nm nesil LSI için en iyi mümkün performansı sağlayacak.
Hasar bağı yok
Paketimizin temel teknolojisi hasar değildir. Bu, kesim kesim kesim kıymetli işlemle üretilen yarı yönetici çipleri için zarar ve güvenilir bir bağlantı sağlamayan bir teknolojidir.
Hasar olmadan yarım bölümcül çipleri:
Düşük basınç bağlaması
0, 12g/ bump'ın bir bağlama basıncıs ını elde edebiliriz. Bu normal C4'nin 2, 4g/ bump'unun 1/20. Bu sınıra bağlantı yükünü azaltarak, bağlantı etkili ortamın hasarından kaçınılabilir.
Konveks kurşunu sırasında düşük gerileme stresi
Konveks noktasının solidifikasyonu sırasında azaltma stresi 10MPA/ konveks noktasından az, bu çok küçük. Yüksek yiyecek ve güvenilir dönüş çip bağlaması sıcaklığın, yüksek sınırların azaltması, yüksek ve geri çekilmesi stresinin (düşük K ve Al pads ve çizgiler, etc.) arasından uzaklaştırılması ve kırıklardan uzaklaştırılması için uygulanan yukarı katı ve güvenilir dönüş çipi bağlaması başarıyla başarıyla başarıyla başarı
Bu avantajlardan, K katı hasarından kaçırmak için yapımın tek paketi olduğunu görülebilir.
Yüksek sıcak radyasyon
Yarı yönetici çipinin kalorilerinin kapsüllenmiş substrat tarafından yayıldığını gerçekleştirerek, ortak organik substrat yerine (0.5W/mk sıcaklık süreci) keramik substratını seçtik, çünkü sıcaklık süreci 14W/mk organik substratından daha fazlasıdır. Paket büyüklüğü 21*21mm ve keramik substratı kullanılır, güç dağıtımı 6W'e ulaşır. 3.6W güç patlaması ile organik substratından 1.7 kat daha yüksektir.
Düşük bir yerleştirme sana zarar verecek.
Elektronik tesisler yüksek frekans menzilinde yüksek seviye performansı gerekiyor. Keramik substratının giriş kaybı 0.42dB (@20GHz, L=5mm), organik substrat 0.62dB. Keramik substrat tarafından izin verilen frekans 10GHz'den fazlasıdır, organik substrat 3GHz'dir.
Yüksek güvenilir ve suyu dirençliğine yüksek tolerans
Normal refloji dirençliği (MSL: Silahlık Seviye) 3. seviye (@30DEG /60% RH192Hr). Monsterpac-typec, her birinin bir yarı yönetici çipi vardır. Bu da gücünüz yok ve çarpışmalar karışık olmayan materyallerden yapılır. Yüksek sıcaklık refleksiyonunda, patlama karışık değildir, bu yüzden yeniden erime ve yeniden kurma tekrar etmez ve keramik substratı suyu ödünç almaz. Sonuç olarak, MonsterPac-TypeC MSL 1. seviye (@85DEG/85% RH192Hr), suyu ve suyu kanıtlarını silmek için önceden pişirmek zorunda değildir ve MonsterPac-TypeC'in bitkilerin hayatı sınırsız.
Yüksek bitki hızı
Sıçramak yerine, üretimi kolaylaştırmak için epoksi gaz patlama yapısı geliştirdik. Sonuç olarak, büyük bir sürü wafer bump süreci tesislerinin ihtiyacı vardır. Büyük bir sürü kanun + reflow yakınlarındaki dalgaların maliyeti de gerekli. Bu yüzden, uyuşturucunun veya yüzeyinin boyutunu aynı boyutlu bir C4 süreci bitkisiyle karşılaştırıldı. Uça ğın veya yüzeyinin yüzde 69'e düşülebilir ve bitkilerin enerji tüketiminin yüzde 85'e düşülebilir. Enerji kurtarma ve düşük arka plan yük fabrikasını başarıyla ulaşabilir.

Kapacite
Monsterpac-typec süreç eşsiz yer
Keramik teknoloji patlaması
Monsterpac-typec gümüş içeren yönetici pastasını yumruk materyali olarak kullanmak için uygun görüyor. Keramik altyapının üzerinde sıradan küvet yazdırma bölümlerini uygun olarak kabul edilen SMD yazdırma tekniklerini kullanarak fırlatmak için. Görüntüleri yükseltmeden önce keramik altyapının yüzeyini önden çıkarmak ve temizlemek gerekmiyor ve yeryüzünü yükseltmekten sonra elektrodaklatmak gerekmiyor. Sıradan organik FCBGA'nın yarı yönetici waferlerin Al patlarında uzun patlaması gerekiyor. Ancak keramik tabanlı böcekler, bu böcek uzun böcek sürecine ihtiyaç duymuyor. Bunun yerine, yarı yönlendirici çipleri üzerinde elektrikli olmayan Ni ve Au üretiyorlar. Keramik teknolojisine dayanan böcekler basit destek ve düşük maliyetin sürecini başarıyla fark ettiler.
Ayrıca, sıcaklık, Au ve Cu bumps gibi ortak mantıklı tekniklerde kullanılan zor bump (sertlik â™137;¢ 10Hv) gibi yumuşak bump (â™137;¢ 1Hv) örnekleri düşük zorluk altında tutmak için geliştirilmiştir.
Gümüş içerisinde yumuşak konveks sürücü pastaları için, düşük stres, düşük kontrast dirençliği ve detaylı baskı üzerinde deneyimli fikirleme noktaları geliştirdik. Şimdiye kadar oluşturduğumuz çalışma kapasitesi, yüzleşme bölümlerine yüzleşmektir: 150 milyon dolar. Periferik parçalar: 75μm. Ancak, bu patlama topu gerçek ön ayarlama kuralları tarafından düşünülüyor, yani yüzey tablosu 60 mil boyunca sadece çarpma açılması için uygulanır.
Hasar bağı yok
Yavaş dönüş çip bağlama teknolojisi ile NCP, keramik çarpma teknolojisi tarafından oluşturduğu yumuşak çarpmaları dağıtmak için kullanıldı ve yarı yönetici çipi dönüş çipi ile bağlanıldı. İlişim süreci sırasında, böceklerin ve NCP yönetici pastası aynı zamanda sabitlenmiş. Sonuç olarak, ikisi de kosignatur ve bağımlılık başarıyla başarılı olarak başarılı oldu.
FCB tesisinin sıcaklığı normal bağlama teknolojisinden 40 derece daha düşük olan 200 derece Celsius altındadır. İlişim basıncısı 0, 12g/ noktadan az. Bu normal bağlama teknolojinin 1/20 olduğunu gösteriyor. Bu düşük sıcaklık ve düşük basınç sıcak basınç bağları ile, yarı yönetici çipleri bağlama ve bağlama sonrasında stres ve dış kuvvetlere uygun değildir. NCP'nin her iki tarafında ve patlama tarafında bulunan ilaçlar da dahil ediyor. Ancak, çip anahtarlarını düşük basıncıda dönüştürmek ortak. Toplama çarpışlarda gömülmüş, bu yüzden çip patlaması ve çarpışları arasındaki imzalamayı etkilemiyor. Bu yumuşak patlamaların avantajlarından biri. NCP'nin dağıtımından önce dönüştüğünü kolayca, konveks noktası ve kısa boşluğu arasında, ve düşük yük anahtarı ile, çip ve substrat arasındaki hedef olamayacak. Bu yüzden, bu bağlama tekniki kısa patlamalar ile kullanılabilir.
Ortak bağlama teknikleri ile ilgili sorun şu ki, karışık patlamaları ile karıştırmak için çok büyük retrakt stresleri (yaklaşık 200-500 mpa/bump) yarı yönetici çipinin ve yarı yönetici çipinin Al patlamalarına uygulanır. Düşük stres bağlama tekniki başarılı, çünkü erişmeyen konveks materyallerinin düşük elastik moduluları çok küçük bir tekrar bağlama stresi gerekiyor (10MPa/ konvex'den az).
Yukarıdaki bu temel teknoloji geliştirmenin yapılandığı süreç yüzünden, kusursuz çep bağlantısının başarısı. FIG. 4, dönüş çipinin anahtar noktasını ve karşılaştırma noktasını kestirme görünümüdür.
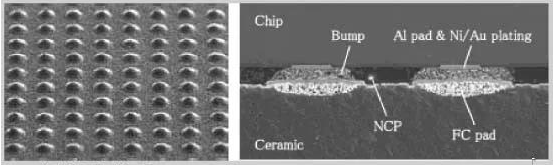
FIG-4 Görsel ve Bölüm Fotoğrafı

Paketleme Güvenliği
TC arka konveks noktasının profilini teste etti, fakat kırıklık bağlantısıyla etkilenecek kırıklıkları test etmedi ve ölçülemedi.
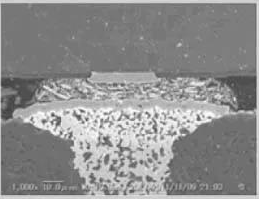
APIC (Uygulama aygıtı IC)
Bugünkü APIC işleme düşük-K materyallerinin tam makinelerinin kullanımına doğru hareket ediyor. Bu, yüksek s ıcaklık toleransi ve yüksek hızlı ihtiyaç duyuyor. Monsterpac-TypeC, aşağıdaki özelliklerle bu ihtiyaçları yerine getirir.
Hasar bağlaması yok.
Yüksek sıcak radyasyon.
Yüksek hızla
Birkaç APIC müşterisi ölçekli üretim için MonsterPAC-TypeC'i değerlendiriyor
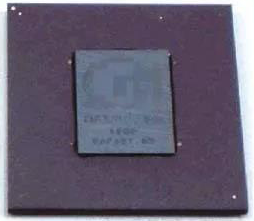
PAC- TypeC
Aynı şartlar altında organik FCBGA ve canavarpac-TypeC arasındaki gerçek değerlendirme sonuçlarına göre (aynı deniz, aynı çip ve aynı patlama çubuğu), canavarpac-TypeC sıcaklığı Tj organik paketinden 10 derece daha a şağıdır. Tj'in çok doğru karşılaştığından sonra, fark 20 derece Celsius olacak.
RF Board(Radio Frequency Board):
Şu anda, yüksek hızlı iletişim LSI için plate encapsulasyonu sürekli iyileşiyor. Bu bölümler aşağıdaki özelliklere ihtiyaç duyuyor:
Yüksek hızlı ve yüksek frekans için yeterli.
Küçük boyutlu
Yüksek hızlı ve yüksek frekans uygulamaları için, yukarıdaki gibi, uygun olursa, keramik substratlarının kullanımı içeri kaybını geliştirebilir, 10GHz için kullanılabilir.
Ayrıca, küçük, detaylar-pitch flip-chip bağlaması için küçük paketlerde kullanılabilir.
RF plakası müşteriyle birlikte, örnek geliştirdi, müşteriler tarafından onaylandı, ölçek üretim için hazırlanıyor.

RF Modülü
Bu tabak çevrelerine göre substratın ıslanması çok sıkıdır. Yıldırıcı derece boğulması için MSL 1. seviyedir.
Canavar PAC-TypeC'in plak paketlemesi için en uygun olduğunu görülebilir. Bu, standart organik paketlemesi SMD ve flip-chip için çoklu refloz kurma gerekiyor.
Yargıç.
Gelecek 20 nm sürecinin nesilleri için paketler yüksek sıcak radyasyon ve yüksek hızları uygulamak için gerekli. Ancak, ortak mantıklı paketleme teknolojisi bu ihtiyaçları yerine getirmek zordur. Bu yüzden 20 nm süreç üretimi için uygun bir yeni paketleme teknolojisini geliştirmek gerekiyor.
Monsterpac-TypeC'imiz gelecek 20 nm süreç üretimi için uygun ve LSI performansını arttırır. Yüksek performansı muhteşem garip bir ürün gibidir. Geliştirdiğimiz MonsterPAC, C4'i eskiden yaptı ve gelecekte yarı yöneticilerin sonraki nesillerine katkı sağlayan ana teknoloji oldu.
Bir sonraki nesil teknoloji geliştirme için
Yeni keramik substrat araştırma ve geliştirme
Keramik substrat teknolojinin geliştirilmesi parlak bir teknolojiden daha fazlasıdır. Şimdiye kadar, yüksek yoğunluğuyla tam ve detaylı çizim organik IC Alttratları'nın arkasında uzakta kaldı.
Bu sorunu çözmek ve ilerleme yapmak için, maliyete etkilenmeden yüksek yoğunluğuyla tam bir keramik substratını geliştirmek için ayarladık. Amacım ız 20 milyon çizgi çubuğu, uyumlu olarak ulaştırmak ve kesinlikle ve detaylı grafiklerin kullanımı daha fleksibil öntanımlığı, delik çubuğu aracılığıyla aynı zamanda daha preciz ve detaylı olması gerekiyor, amacı 50mil.
Şimdiye dek keramik substratı uygun olarak görülüyor gibi punç ve maske yazdırması kullanarak yapıldı. Bu mevcut teknikler tam ve detaylı çizime çok sınırlı. Onları lazer ve doğru yazdırma süreciyle değiştirmeyi düşünüyoruz. Bu teknolojiyi gerçekleştirmek organik substratlardan daha iyi performans sağlayacak. Şimdiye kadar, keramik substratları genellikle yüksek sonlu ürünlerde kullanılır, fakat bu yeni substrat tüketici ürünlere hedef alınacak. Ve substrat, kendini büyütmek için yüksek performans tüketici ürünlerine ihtiyacı var.
Bu ilaç ve MonsterPAC teknolojisinin birleşmesi dünyaya en iyi performans ve yüksek güvenilir Yazım Dönüş Taşı (PCB) ile sağlayacak.