2021 yılında Wafer seviyesi çip ölçüsü Paketleme (WLCSP) teknoloji uygulama durumu ve pazar ihtimali analizi.
Gelişmiş IC Paketi, o zamanlar en kısıtlı kısıtlı paketleme formu ve teknolojiyi anlatıyor. Şu anda, dönüş çip (FC) yapısıyla, vafer seviyesi paketleme (WLP), 2.5D paketleme, 3D paketleme gelişmiş paketleme kategorisi olarak kabul edilir.
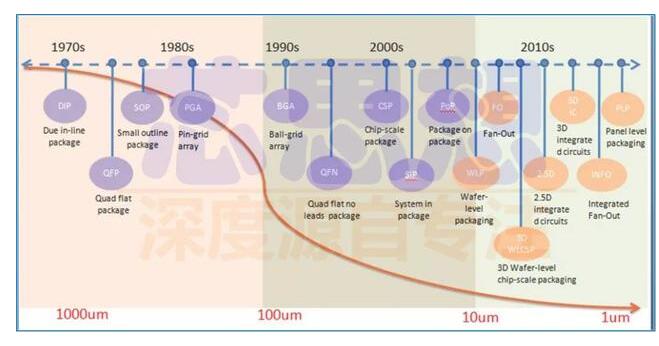
Gelişmiş paketleme geliştirme devre diagram ı
Tüm yarı yönetici paketleme pazarı, 2018'den 2024'e kadar %5,2 oranla birleşmiş yıllık büyüme oranına (CAGR) gelir ve gelişmiş paketleme pazarı %8 oranında büyüyecek ve pazar büyüklüğü 2023'e kadar %40 milyar dolara büyüyecek. On the other hand, the traditional packing market is growing at a cagR of less than 3.3%. The various advanced packing platforms, 3D silicon through hole (TSV) and fan-out (FAN-out) packages will grow respectively %29 and 15%. Gelişmiş paket pazarının çoğunluğuna göre çeviri paketleri, yaklaşık yüzde 8 yıllık geliştirme oranından büyüyecek. Bu arada, WLP'in fanı da yüzde 8'lik bir CAGR'de büyüyecek. Genellikle mobil pazarı tarafından kullanılmış.
Küresel Gelişmiş Pakete Teknoloji Paketi Ölçümü Ölçümü tahmini, 2018-2024 (1 milyar dolar)

Ayrıca, ön tarafta vafer üretimi gelişmiş arka tarafta paketleme ile birleştirmek için büyüyen bir trende var. Intel, TSMC ve Samsung gibi büyük küresel vafer üreticileri (Intel, TSMC ve Samsung gibi) IC ürünlerin ürünlerinin teknoloji integrasyon avantajlarını güçlendirmek için gelişmiş vafer üretim teknolojisi ile gelişmiş paketleme formlarıyla yakın bir birleştirdiler. Hem teknoloji hem ölçek tarafından etkilenmiş, küresel mühürleme ve testi endüstrisinin konsantrasyonu sürekli arttır. 2017'den önce, gelişmiş paketleme pazarı payının %87'inden yaklaşık sekiz mühürleme ve testi şirketleri (kaynakların arka tarafından paketleme işi dahil olmak üzere) meşgul oldu.
Dalga seviyesi çip boyutlu paketleme (WLCSP), gelişmiş paketleme teknolojisi olarak, tüketici elektronik geliştirmenin ihtiyaçlarını ve trenleriyle uyuyor (ışık, küçük, kısa, ince ve düşük fiyatı). tradisyonel paketleme ile karşılaştırıldı, WLCSP paketlemesi, bu ana avantajları vardır: (1) WLCSP paketleme endüstri zincirini iyileştirdi. Tradisyonel paketleme yönteminde, wafer ilk defa bir çip parçalanmış. Kvalifik bir çip olarak teste edildikten sonra, çamaşır ön çerçevesine veya paketleme altyapısına yerleştiriler ve sonra paketleme testi gerçekleştiriler. Sanayi zinciri, wafer fabrikası, substrat fabrikası, mühürleme fabrikası ve testi fabrikası dahil ediyor. Vafer büyüklüğü paketlemek, vaferleri kapsüllemek ve test etmek ve kapsüllenmeden sonra vaferleri kesmek. tradisyonel paketleme ile karşılaştırıldı, WLCSP paketleme, altyapı fabrikasını, paketleme fabrikasını ve teste fabrikasını geleneksel paketleme endüstri zincirinde bir tane olarak integre edebilir, böylece çip üretim döngüsü çok kısayılır, üretim etkinliğini geliştirir ve üretim maliyeti azaldı. İkinci olarak, WLCSP paketi paketi paketlemeden önce kvalifiksel çip testini azaltır ve paketleme maliyetini etkili olarak azaltır; Sonunda WLCSP paketi, yarı yönetici arka bölümü ve ön bölümü arasındaki teknik farkı (paketleme) ve ön bölümü (wafer üretimi) arasındaki, yarı yönetici arka bölümünün ve ön bölümünün arasındaki teknik noktalarını fark etmek kolaylaştırıyor. WLCSP paketleme IC tasarımı, wafer üretimi, paketleme testi, bir fabrikaya aparatı fabrikası integre edebilir, endüstri zincirini iyileştirir, IC tasarımında teknik ve standart docking sorunu çözebilir, wafer üretimi, paketleme testi, aparatı fabrikası ve diğer bağlantılar ve profesyonel temel modunun geliştirmesini daha fazla destekleyebilir.
Gelişmiş paketleme kullanarak (12 in ç ekvivalent) ve iş modellerinden 2018 yılında dağıtılıp

2. Paketleme maliyeti wafer üzerindeki çip sayısının arttırılmasıyla azaldı. Wafer seviyesi çip büyüklüğü paketlemek, bütün vafer paketlemek ve sonra çip kesmek, geleneksel paketlemek önce vafer çip'e kesmek ve sonra çip paketlemek. Genellikle konuşurken, WLCSP'nin paketleme maliyeti waferlerin sayısına göre ölçülür ve kesildikten sonra çip sayısı geleneksel paketleme maliyetiyle ilgili değildir. Bu yüzden WLCSP'nin paketleme maliyeti, wafer büyüklüğü arttığında ve çip sayısı arttığında azalır. Tüketici elektronik pazarı geliştirme trendi ışık, küçük, kısa, ince, wafer seviyesinde paketleme maliyeti fiyatları daha açık, geleneksel paketleme pazarı paylaşımını yavaş yavaş kullanacak.
3. WLCSP gelecekte en iyi paketleme yöntemi olacak. Sanayi, silikon deliğinden (TSV) tabanlı 3. paketleme teknolojisinin Moore Kanunun önündeki ana çözümü ve yarı yönetici paketleme teknolojinin gelecekte geliştirme treni olduğunu düşünüyor. WLCSP paketleme delik teknolojisi ile silikon tabanıdır ve iki süreç çok benziyor. WLCSP paketleme teknolojisini (özellikle Shellcase serisi WLCSP) yönetmek üzere silikon alanına delik teknolojisinden hızlı girip gelecekte 3D paketleme teknolojisinde önemli bir rol oynayabiliriz.
Vafer seviyesi çip boyutlu paketi ve geleneksel paket arasındaki fark
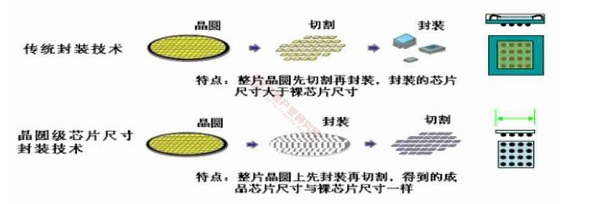
Yole geliştirmesi, WLCSP paket pazarının 2010 yılında yaklaşık 1,4 milyar dolardan 2018 yılında 3,2 milyar dolara %12 yıllık geliştirme oranında büyüyeceğini tahmin ediyor, yaklaşık %11 gelişmiş paketlerin ve yaklaşık %6 küresel kapalı beta endüstrisinin. Tüketici elektronik ve otomatik elektronik gibi küçük boyutlu çipler talebiyle kullanılan WLCSP paket pazarının 2019 yılında yaklaşık 3,5 milyar dolar ulaşmasını bekliyoruz ve daha fazla büyüme sahibi olacağını bekliyoruz.
WLCSP genellikle wafer bump paketleme ve Shellcase serisi WLCSP paketleme teknolojisini kabul ediyor. Wafer bump paketi, yaklaşık düşük teknik zorluğu olan WLCSP paketinin bir formudur. Ana özelliği, devre ve kaynağı çipinin önünde doğrudan yönlendirilebilir. Shellcase serisi WLCSP sadece devreyi yönlendiremez ve çip önünde direkte kaynaklayabilir, ama da çip devreyi çip arkasına yönlendirebilir ve sonra da karıştırma kulübesini oluşturur. Shellcase serisi WLCSP paketi wafer bump paketinin anahtar teknik noktalarını içeriyor. Bu, wafer bump paketinden daha zor ve süreç wafer bump paketinden daha karmaşık. Teknik zorluklarda ve uygulama alanlarında önemli farklılıklar yüzünden, wafer bump paketleme teknolojisi Shellcase serisinde paketleme teknolojisinden daha düşük. WLCSP'nin görüntü sensörü paketlemesinde harika avantajlar vardır, fakat wafer bump paketlemesi çipinin önündeki kaldırma patlaması yüzünden görüntü sensörüne ve diğer alanlara uygulanamaz.
2018 yılında, paketleme aparatı pazarının büyüklüğü yaklaşık 7 milyar dolardı.