Kötülük genellikle karıştırılmış ortaklarla ilgili bir sorun. Özellikle PCB teknolojisini kullanarak sol pastasını yenilemek için liderlik olmayan keramik çiplerinde büyük porlar (>0.0005 santim/0.01 mm) arasında LCCC solder makineleri ve basılı devre tabağı solder makineleri aynı zamanda, LCCC kalesinin yakınlarındaki fillet içinde sadece birkaç küçük porlar var. The existence of pores will affect the mechanical properties of the welded joint, and will damage the strength, ductility and fatigue life of the joint. This is because the growth of pores will coalesce into extensible cracks and cause fatigue. Porlar, aynı zamanda da zarar nedeni olan soldaşın stresi ve kovaryanlığını artıracak. Shanghai SMT çip işleme fabrikası, ayrıca soldaşın solidifikasyon sırasında, exhaust gazının ertelenmesini ve içeri girdiği fluksi çöplüklerden çöplüklendiği zaman, çöplüklerden çöplüklenen elektrikleri de porozitenin sebepleri olduğunu belirtti.
PCB çözüm sürecinde porları oluşturma mekanizması daha karmaşık. Genellikle konuşurken, porlar, sandviç yapısı sıfırlama sırasında solucuğun içine girdiği fluksi patlamasına neden oluyor (2,13) Porlar oluşturulması, genellikle metal alanının solderliğine göre belirlenir ve flux aktivitesinin azaltmasına göre değişiklikler, pulun metal yükünün arttırılmasına ve ön bağlantının altında kapatma alanının arttırılmasına neden oluyor.
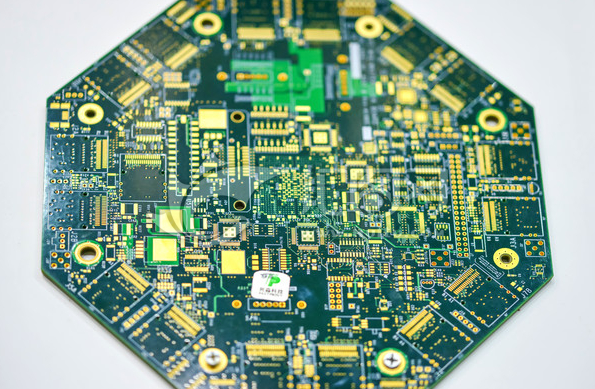
Solder parçacıklarının büyüklüğünü azaltmak sadece poroziteyi arttırabilir. Ayrıca, porların oluşturulması da, sol çöpün koalisyonu ve sabit metal oksidilerin yok edilmesi arasındaki zaman ayırmasıyla bağlantılı. Daha önce solder pasta kömürleri, daha fazla boş oluşturuyor. Genelde büyük porların oranı toplam porların arttırılmasıyla artıyor. Toplam porların analiz sonuçları tarafından gösterilen durumlarla karşılaştırılmış, porları neden eden öğretmen faktörleri, güveniliğin güveniliğine daha büyük etkisi olacak. Some circuit board welding companies pointed out that methods to control the formation of pores include:
1. PCB komponentlerinin/gömleğin altındaki sol gücünü geliştirir;
2. Yüksek flux etkinliği ile flux kullanın;
3. Solder pulu oksidlerini azaltın;
4.Yangın ısınma atmosferini kullanarak.
5. Yeniden ısınma sürecini yavaşlatın. Yüksek durumlarla karşılaştırıldığında, BGA toplantısında porlar oluşturulması biraz farklı bir örnek uyuyor. Genelde konuşuyor. BGA toplantısında 63 solder bloklarını kullanarak porlar genellikle kurulu seviye toplantısı sırasında oluşturulmuş. BGA konektöründeki porun sayısı çözücüsünün, metal kompozisyonu ve sıcaklık sıcaklığının yükselmesiyle artıyor ve parçacık ölçüsünün azalmasıyla da artıyor. This can be explained by the viscosity that determines the discharge rate of the flux. According to this model, a flux medium with a higher viscosity at the reflow temperature will prevent the flux from being discharged from the molten solder. Bu yüzden, giriş akışının miktarını arttırmak yükselecek. Benzin olasılığı, BGA toplantısında daha büyük bir porozite sebep oldu. Beklenmiş metallisasyon bölgesinin solderliğini düşünmeden, fışkırın etkinliğin in ve porların genelliğinde refloş atmosferinin etkisi, büyük porların oranı toplam porların arttırılmasıyla arttırılacak gibi görünüyor. BGA'daki porların yaptığı faktörlerin toplam porların analiz sonuçlarıyla gösterilen porların güveniliğinden daha büyük etkisi vardır. Etkiler SMT sürecinde boş büyüyen şehrin durumu gibi.
Solder pasta ısınmış bir ortamda olduğunda, solder pasta reflozi beş fazla bölünür. İlk olarak, gerekli viskozitet ve ekran bastırma performansını ulaştırmak için kullanılan çözücü ortaya çıkmaya başlar ve sıcaklık yükselmesi (saniye yaklaşık 3°C üzerinde) kaynağı ve parçalanmasını engellemek için yavaş olmalı. Ayrıca, bazı komponentler iç strese daha hassas. PCB komponentlerin dış sıcaklığı çok hızlı yükselirse, kırıklığına sebep olur.
Flüks aktif ve kimyasal temizleme eylemi başlar. Su çözülebilir fluks ve temiz fluks aynı temizleme eylemi olacak ama sıcaklık biraz farklı. Metal oksideleri ve bazı bağlantıları bağlamak için metal ve solder parçacıklarından kaldırın. Güzel metallurgik kaldırıcı toplantılar "temiz" yüzüne ihtiyacı var.
When the temperature continues to rise, the solder particles first melt individually and begin the "dark grass" process of liquefaction and surface tin absorption. Bu bütün mümkün yüzlere kaplıyor ve çözücüler toplantıları oluşturmaya başlar.
Bu sahne en önemli. When the individual solder particles are all melted, they combine to form liquid tin. Bu zamanlar yüzeysel tensiyle sol ayağının yüzeyini oluşturmaya başlar. Eğer komponent pin ve PCB pad arasındaki boşluğu 4 mil aştıysa, muhtemelen PCB yüzey Tensiyonun yüzünden oluşan bölümü patlamadan ayrılır, bu da kalın noktasındaki açık devre nedenidir. In the cooling stage, if the cooling is fast, the tin point strength will be slightly larger, but it should not be too fast to cause temperature stress inside the component.