El nombre completo de bga es "matriz de rejilla esférica", que significa PCB con estructura de matriz de rejilla esférica. Este es un método de encapsulamiento de circuitos integrados que utiliza portadores orgánicos. Las placas de PCB con bga suelen tener más agujeros pequeños, y los agujeros inferiores de bga suelen diseñarse como agujeros terminados de 8 - 12 milímetros de diámetro. El agujero inferior de bga necesita ser bloqueado, la almohadilla no está permitida con tinta y la almohadilla no está perforada.
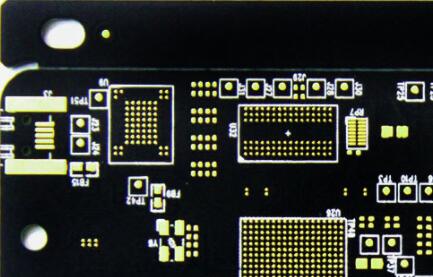
Bga es un componente que utiliza un método de encapsulamiento de matriz de bolas de soldadura. Produce bolas de soldadura en la parte inferior del sustrato de encapsulamiento, que actúan como interfaz de la placa de circuito, que está conectada a la placa de circuito. Los componentes bga son adecuados para componentes de montaje de superficie, con un gran número de pines en el circuito, una mayor densidad de encapsulamiento, una función más fuerte y una mayor fiabilidad. La CPU de bga se utiliza principalmente en computadoras portátiles.
Principios generales para el diseño de almohadillas bga
1) el diámetro de la almohadilla suele ser menor que el diámetro de la bola de soldadura. Para obtener una adherencia confiable, generalmente se reduce entre un 20% y un 25%. Cuanto mayor sea la almohadilla, menor será el espacio de cableado entre las dos almohadillas.
2) la almohadilla en el sustrato bga tiene el mismo diámetro que la almohadilla en el pcb.
3) el diseño de la almohadilla de bga debe garantizar que la apertura del encofrado provoque una fuga de pasta de soldadura de 0,08 mm3, que es el requisito mínimo para garantizar la fiabilidad de la soldadura.
Principios del proceso de embalaje bga
Los principales procesos del embalaje bga incluyen la producción de bolas de soldadura, la producción de sustratos, la Unión de chips, la solidificación del embalaje y el embalaje de Corte.
1) producción de bolas de soldadura: producción de bolas de soldadura utilizando aleación de estaño y plomo de alta pureza o materiales sin plomo, formando una matriz de pin esférico regular.
2) producción de sustratos: se utiliza una placa de circuito impreso multicapa como sustrato para lograr una interconexión eléctrica de alta densidad y alto rendimiento.
3) Unión del chip: conectar el chip al sustrato y conectarlo al sustrato con soldadura a base de plomo o sin plomo.
4) encapsulamiento y curado: el chip está encapsulado en resina epoxi para protegerlo del impacto ambiental.
5) encapsulamiento dividido: cortar el chip encapsulado en un encapsulamiento bga separado.
Tecnología de encapsulamiento bga
1. diseño de la Plataforma de soldadura: para garantizar la calidad y fiabilidad de la soldadura, el diseño de la Plataforma de soldadura debe seguir ciertas pautas. En primer lugar, se debe garantizar que el tamaño de la almohadilla coincida con el tamaño de la bola de soldadura. En segundo lugar, es necesario considerar el impacto de la forma y el diseño de la almohadilla en la expansión térmica y la contracción térmica. Por último, también se debe prestar atención al tratamiento de la superficie de la almohadilla para mejorar la fiabilidad de la soldadura.
2. proceso de soldadura: la soldadura bga generalmente utiliza la tecnología de soldadura de retorno. Para garantizar la calidad de la soldadura, es necesario controlar la temperatura de soldadura, el tiempo y la curva de temperatura del horno. Además, se debe prestar atención a la tensión térmica durante la soldadura para evitar defectos de soldadura.
3. inspección de calidad: después de la soldadura del paquete bga, se requiere una inspección de calidad para garantizar la fiabilidad de la conexión. Los métodos de detección comunes incluyen la detección de rayos x, la detección de emisiones acústicas, etc. la detección de rayos X puede observar intuitivamente la estructura interna de los puntos de soldadura y detectar defectos de soldadura. La prueba de emisión acústica determina la calidad de la soldadura analizando la señal acústica.
4. reparación y mantenimiento: para los envases bga mal soldados, se puede volver a soldar con equipos de mantenimiento especiales. Por lo general, el proceso de reparación incluye pasos como la limpieza de la almohadilla, la reposición de la bola de soldadura y la reconexión del chip. Durante el proceso de reparación, es necesario controlar la temperatura y el tiempo de calentamiento para evitar daños en el chip.
5. diseño y diseño: en el diseño de circuitos, el diseño y el cableado de los paquetes bga son cruciales. Se deben tener plenamente en cuenta factores como el rendimiento eléctrico, el rendimiento térmico y la resistencia mecánica. Durante el proceso de diseño, se debe prestar atención a problemas como la integridad de la señal, la estabilidad de la fuente de alimentación y la gestión térmica para lograr un sistema electrónico de alto rendimiento.
Ventajas y desventajas del paquete bga
Ventajas:
1) alta densidad: el paquete bga tiene una mayor distancia de pin, lo que puede lograr un mayor número de pin de E / s, cumpliendo con los requisitos de los circuitos integrados de alto rendimiento.
2) excelente rendimiento de transmisión de señal: debido a la ruta de conexión más corta de la bola de soldadura, el paquete bga tiene una menor inducción parasitaria y condensadores, lo que favorece la transmisión de alta velocidad de la señal.
3) buenas propiedades térmicas: las bolas de soldadura encapsuladas por bga pueden conducir eficazmente el calor y ayudar a reducir la temperatura de trabajo del chip.
Deficiencias:
Proceso de producción de alta demanda: el embalaje bga tiene altos requisitos para el proceso de soldadura y el equipo, lo que aumenta los costos de producción.
El encapsulamiento bga es una tecnología de instalación de superficie que se caracteriza por formar una matriz de pin esférico regular en la parte inferior del encapsulamiento. Este método de encapsulamiento tiene las ventajas de una gran distancia de pin, un buen rendimiento térmico y un rendimiento de transmisión de señal superior, y es ampliamente utilizado en circuitos integrados de alta velocidad y alto rendimiento.