El impacto de la tendencia de desarrollo de la industria electrónica en las placas de circuito
Tendencias y evolución del montaje
La versatilidad, la alta velocidad de transmisión y la miniaturización de los productos electrónicos portátiles son las mayores fuerzas impulsoras de la mejora continua de los semiconductores integrales, el encapsulamiento, el montaje y las placas pcba. El siguiente es un análisis de las tendencias de desarrollo de la construcción en todos los niveles en los próximos cinco años.
1 la fuerza motriz del cambio, debido a la necesidad de una rápida revolución del producto y la innovación del mercado, el diseño de productos electrónicos portátiles ha desarrollado algunas características de tendencia, incluyendo miniaturización, peso ligero, bajo consumo de energía, aumento de funciones, interfaz avanzada, conexión inalámbrica, estilo de moda, etc. Satisfacer las necesidades de protección del medio ambiente Verde. Este mercado se caracteriza por acortar el ciclo de vida del producto, integrar aplicaciones 3c, mayor escala de producción, respuesta más rápida del mercado, tiempo real y mayor complejidad y diversidad del producto. Para mantenerse al día con estas tendencias, es necesario cambiar el proceso de encapsulamiento y montaje electrónico. Resumir las últimas tendencias, sus cambios y sus desafíos; Las tendencias de los componentes individuales, las placas portadoras y los componentes se conocerán ligeramente de los siguientes contenidos.
En general, maximizar el número de pines y el tamaño del paquete puede acomodar más I / o en pequeñas cantidades. Para limitar el aumento del tamaño del encapsulamiento, el espaciamiento debe reducirse a 0,3 mm, dependiendo del precio del desarrollo de bga y csp. Bajo la misma superficie, los encapsulamientos bga y CSP pueden acomodar más I / o y tienen un espaciamiento más amplio de los puntos de convexidad + 3. En el futuro, los precios de bga y CSP caerán aún más, lo que reemplazará a muchos mercados de encapsulamiento qfps. En particular, se reducirá la distancia seated hcight (desde la parte superior del paquete hasta la superficie del pcb).
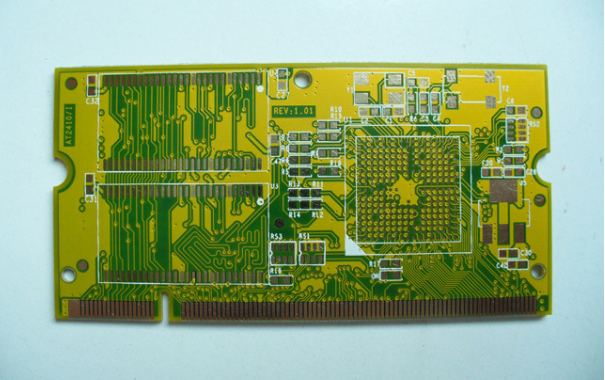
Dos paquetes bga aumentarán el número de I / o a 1.200 en 2006, una cierta tendencia en las aplicaciones de computadoras portátiles. Para limitar el tamaño del cuerpo principal y evitar problemas de fiabilidad, la configuración de la superficie de las protuberancias evolucionará hacia el tipo de matriz de área completa. Por la misma razón, el espaciamiento de las protuberancias se reducirá ligeramente. La altura del asiento se reducirá para instalar el producto final más delgado. Las tendencias de desarrollo más importantes de bga se muestran en la tabla 9.2.
El CSP de tres niveles de chip encapsulamiento (csp) tiene dos tipos de pines externos, uno es el punzón (tipo bga) y el otro es el soldador (tipo lga). La altura máxima de asiento de la lga es baja porque no tiene protuberancias. Así, la lga se ha vuelto más popular, aunque una altura de soporte más baja reducirá la vida útil de la interconexión secundaria. El desarrollo común de estos dos tipos de encapsulamiento es que la altura máxima del asiento se reducirá y el número de I / o aumentará. Debido al espaciamiento de la matriz incorporada / terrestre, el tamaño del paquete se reduce a 0,3 mm, lo que también se reducirá. También se reducirán las dimensiones de las protuberancias / almohadillas. La Tabla 1 muestra las tendencias más importantes del csp.
Una forma especial de CSP es el CSP a nivel de obleas (csp a nivel de obleas), que es el tipo de encapsulamiento realizado antes de cortar la obleas en un molde. La principal ventaja es el bajo costo de estos encapsulamientos, ya que las unidades de producción son chips y no núcleos, y el aumento del tamaño de los chips también favorece la reducción del costo de este tipo de encapsulamiento.
En el sector de los bienes de consumo portátiles, el número de I / o conectados directamente a la placa base por el tipo FC ha aumentado ligeramente y el tamaño de los chips no ha cambiado mucho. La tecnología 1c puede fabricar circuitos de mayor densidad. Bajo el mismo tamaño, el molde puede tener más funciones.
Porque el proceso de mejora de la señal en el chip tiene poco impacto en el número de I / O. Tanto el espesor del núcleo como la distancia entre los puntos destacados se reducirán. El espaciamiento mínimo de los convexos varía en función de la tecnología de conexión utilizada, que se discutirá más adelante. El aumento del proceso de relleno inferior para garantizar su fiabilidad dificulta la aplicación directa del FC en la placa base. Una vez madura la tecnología alternativa, la aplicación de FC aumentará considerablemente. Las posibles alternativas son la Imprimación Io - flow (mezcla de flujos y imprimaciones de alta viscosidad) y el sellador de la parte posterior de la lámina.
Las cinco tablas de comparación 3 de los diversos tipos de encapsulamiento 1c son las comparaciones de los diferentes tipos de encapsulamiento anteriores. Desde qfps, bga, CSP hasta WL - csp, la densidad de chips invertidos y I / o ha aumentado, mientras que el espaciamiento y el tamaño del paquete se han reducido. Las propiedades eléctricas y térmicas han mejorado, pero la capacidad de carga pesada, la procesabilidad, las pruebas eléctricas, el grado de protección del grano, la compatibilidad con el diseño 1C y el retorno estándar y la versatilidad de los componentes son peores. En términos de fiabilidad, qfps y FC ofrecen los mejores resultados. Qfps, WL - CSP y flip - Chip tienen ventajas de costo, especialmente qfps son los más Bajos.
Se espera que los componentes pasivos de seis componentes pasivos reduzcan sus dimensiones a 0101 para 2006. Los llamados componentes pasivos integrados se refieren a la integración de varias funciones pasivas en núcleos de silicio o cerámica (número de I / o > 2). Algunos componentes pasivos también se integran en silicio 1c (por ejemplo, condensadores de desacoplamiento).
Las placas portadoras multicapa (cerámicas u orgánicas) se utilizan para el montaje a prueba de moho e integran algunas funciones pasivas específicas.