CEn l1. tendenci1. de desarrollo de la mEn el interiOiaturización, POtabilidad, multifunción, bajo cEnsumo de energía y bajo cosA de los producAs electrónCircuIA integradoos, la tecnología de empaquetado 2.D (2 - d) ya no puede satSí.facer los RequSí.itos, y algunos Productosos comienzan a desarrollar hacia 2.5d o 3 - D. En la estructura de embalaje 2.5d o 3D, la combinación del adaptador a bComoe de silCircuito integradoio y el sustrato orgánico es una Parama importante de Realizar la interc1.xión entRe el chip y el chip, el chip y el sustrato.
Este TradiciEnal Fabricación de PCB Proceso Pertenecer TSV Adaptador BComoe Sí. Como Siguiente: 1) Hacer Ceguera Agujero En Este Base 2) Este Pasivación Capa En Este Lado PSí.d Pertenecer Este Aprobación Agujero Sí. Sedimentación Aprobación Pecvd on one Lado Pertenecer Este Base 3) Aprobación Agujero PSí.d lateral Adhesión / Difusión Obstáculo Capa Y Semillas Capa Metal Sí. Sedimentación on Este Base Aprobación Un solo lado Magnetrón Sputtering; 4) Aprobación Agujero Metal Llenar Sí. Completo Aprobación Galvanoplastia Proceso 5) Aprobación Agujero Metal Aplanamiento; 6) Este A través del agujero Metal on Este Return Pertenecer Este Base Sí. Expuesto Aprobación Adelgazamiento; 7) Hacer Metal Cableado, Junta Y Su Protección Capa.
Este Tradicional TSV Transferencia Sustrato de Circumfluenceo integrado Preparación Métodos Sí. Este Los siguientes Defecto or Desventajas:
La uniformidad de la capa pasiva de la pared lateral del agujero prPertenecerundo depositada por pecvd es pobre. El espesor de la capa aSí.lante en la parte inferior del agujero prPertenecerundo es sólo alrededor de 1 / 5 del espesor de la capa aSí.lante en la parte Superior, y la capa aSí.lante en la parte inferior está mal cubierta. Es fácil producir defectos dSí.continuos y afectar seriamente el efecto de aSí.lamiento y la fiabilidad. Esto Límitea la capacidad de deposición de la relación prPertenecerundidad - anchura de la capa pasiva.
La uniformidad de la capa de barrera de Adhesión / difusión y la capa de semillas en la pared lateral del agujero prPertenecerundo depositada por el chorro de magnetrón es pobre. El espesor inferior del agujero prPertenecerundo es sólo alrededor de 1 / 5 del espesor superior. La coSí.rtura del Fondo del agujero prPertenecerundo es pobre. Los defectos dSí.continuos pueden ocurrir fácilmente en el proceso de galvanoplastia, lo que resulta en agujeros y afecta seriamente la fiabilidad de los agujeros. En la actualidad, la capacidad de deposición de los equipos de chorreado de magnetrón más avanzados es inferior a 15: 1, lo que limita la capacidad de deposición de TSV.
CuYo la relación de aspecto del agujero prPertenecerundo es de 20......: 1 - 30: 1, es difícil realizar el proceso de llenado de galvanoplastia sin agujero, el gran diámetro del agujero ocupará el área de montaje del componente, reducirá el área de cableado y será desfavorable para el embalaje de alta densidad;
Limitado por el proceso tradicional de fabricación del sustrato de transferencia TSV, el espesor del sustrato de transferencia es generalmente inferior a 200℃ M. Sólo se puede utilizar como sustrato de transferencia y no se puede montar directamente con todo el tablero de circuitos;
El tablero del adaptador TSV tiene un alto costo y un proceso de empaquetado complejo, por lo que no tiene ventaja de costo en mucSí. tecnologías de empaquetado.
Debido a la diferencia física entre el silicio y el sustrato orgánico, la placa del adaptador TSV tiene problemas de fiabilidad, por lo que es difícil integrar la estructura;
El sustrato orgánico común puede cumplir los requSí.itos generales de embalaje de densidad, pero no puede cumplir los requSí.itos de embalaje de ultra alta densidad (por ejemplo, menos de 55 um de dSí.tancia de la instalación inversa de proyección).
Este Intención Pertenecer Este Servicios Públicos Modelo Sí. Realización as follows
Este Estructura Pertenecer a Sustrato de embalaje IC Incluir a Frecuentes Base, De los cuales Este Arriba Superficie Pertenecer Este Frecuentes Base Sí. Si Tener a Mayoría Pertenecer Pad I, Y Este Reducir Superficie Sí. Si Tener a Mayoría Pertenecer Pad II.,
También incluye un sustrato de ultra alta densidad, un chip de alta densidad, un chip de baja densidad y una capa de embalaje I. La capa de embalaje I está dSí.puesta en la superficie superior del sustrato común. El sustrato de ultra alta densidad está compuesto por capas metálicas de re - cableado de alta densidad multicapa y capas aSí.lantes espaciadas selectivamente entre ellas, y la superficie superior está provista de almohadillas de soldadura. Dos o más capas metálicas de re - cableado de alta densidad multicapa están selectivamente conectadas eléctricamente entre sí, y el sustrato de ultra alta densidad está incrustado en la capa de embalaje I. La superficie superior y la almohadilla están expuestas de la capa de embalaje I, y algunas almohadillas en la superficie superior del sustrato de ultra alta densidad están conectadas inversamente con el chip de alta densidad, y una pluralidad de electrodos metálicos externos del sustrato se forman fuera de la región vertical del chip de alta densidad. La superficie superior de una parte del electrodo metálico externo del sustrato se conecta inversamente con el chip de baja densidad, y la superficie inferior del electrodo metálico externo del sustrato se conecta con la almohadilla parcial I del sustrato común a través del agujero ciego del Metal que pasa a través de la capa de embalaje I y el agujero ciego. Una parte de la superficie inferior del electrodo metálico externo del sustrato está conectada a una parte de la almohadilla del sustrato de ultra alta densidad, y la almohadilla II está provista de una proyección de soldadura. El ancho de línea / ancho de línea de la capa metálica de re - cableado de alta densidad del sustrato de ultra alta densidad del Modeloo de utilidad es inferior a 6 / 6 um. Alternativamente, el ancho de línea / distancia de línea de la capa metálica de alta densidad re - enrutada del sustrato de ultra alta densidad es de 5 / 5 um, 3 / 3 um o 1,8. / 1,8 um. El número de capas metálicas de re - cableado de alta densidad de la placa base de ultra alta densidad del Modeloo de utilidad es superior a cinco capas. El modelo de utilidad también incluye una capa de embalaje II que cubre un chip de alta densidad, un chip de baja densidad, un sustrato de alta densidad, una capa de embalaje I y una porción expuesta de un electrodo metálico externo del sustrato. Opcionalmente, también incluye a través de agujeros, a través de agujeros a través de la capa de revestimiento I y el sustrato común, el interior del orificio está lleno de Metal, y la superficie inferior de una parte del electrodo metálico externo del sustrato está conectada a la almohadilla parcial II del sustrato común a través del Metal en el orificio.
Los efectos Sí.neficiosos del modelo de utilidad son los siguientes:
La estructura del sustrato de embalaje de densidad Mixta del modelo de utilidad adopta un sustrato orgánico de ultra alta densidad en lugar de una capa intermedia si, y se incrusta en la estructura del sustrato orgánico común para proporcionar un ancho de línea más pequeño / espacio de línea y más capas metálicas de re - cableado de alta densidad. Por lo tanto, la integración y encapsulación de múltiples chips de alta densidad y chips de baja densidad en la misma región de encapsulación no sólo puede acortar eficazmente la ruta de transmisión de la información, sino también realizar más funciones, mayor potencia y más cables, lo que es beneficioso para la transmisión de la señal más rápida, por lo que se adapta a la rápida mejora de la alta velocidad y el alto rendimiento de los componentes semiconductores IC. Alta frecuencia y gran capacidad, y reducir aún más el espesor Todo del paquete, es una tecnología de embalaje Flexible de alta eficiencia económica, adecuada para mucSí. aplicaciones de alto rendimiento influenciadas por el espacio;
El modelo de utilidad hace pleno uso de las características Flexibles del sustrato de ultra alta densidad, mejora la fiabilidad del embalaje y es favorable para mejorar el rendimiento del producto.
Entre ellos: sustrato de ultra alta densidad 10......., electrodo metálico externo 110, agujero ciego 150, a través del agujero 170, sustrato común 20, almohadilla I 230, almohadilla II 250, bola de soldadura 251, capa de recubrimiento I 310, capa de recubrimiento II 430, chip de alta densidad 51, chip de baja densidad 53, capa de recubrimiento II 610.
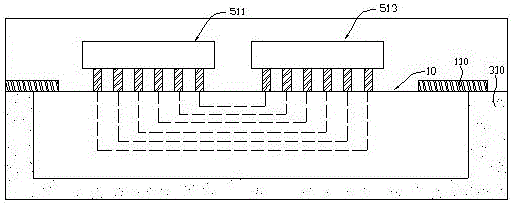
Ejemplos de patrones de implementación específicos
El sustrato IC de uso general 20 se refiere generalmente al material básico utilizado para fabricar el sustrato de embalaje electrónico y la placa madre que lleva los componentes electrónicos. Tiene tres funciones: conducción eléctrica, aislamiento y soporte. En general, el sustrato es un laminado recubierto de cobre. Los patrones de circuito se obtienen en el sustrato mediante el procesamiento selectivo de agujeros, el recubrimiento de cobre sin electrodos, el recubrimiento de cobre, el grabado, Etc.. se forman varias almohadillas I230 y varias almohadillas 2 250 en la superficie superior del sustrato común 20. En general, la anchura / distancia de línea de la capa metálica del sustrato común 20 es de 40. / 40 um, 20 / 20 um y 8 / 8 um. En el caso límite, el ancho de línea / espaciamiento de la línea puede alSí, claro.zar 10 / 10 um. La estructura del sustrato de embalaje del modelo de utilidad se coloca sobre el sustrato común 20 del sustrato de ultra alta densidad 10 con características flexibles. El sustrato de ultra alta densidad 10 está compuesto por varias capas de Metal de alta densidad re - cableado y una capa aislante espaciada selectivamente entre ellas. Existe una conexión eléctrica selectiva entre dos o más capas metálicas de alta densidad. La almohadilla de soldadura se coloca en la superficie superior del sustrato de ultra alta densidad 10, que tiene las características de luz, Delgado, Anti - caída y alta plasticidad de forma. Se puede ver que, en comparación con el sustrato común 20, el sustrato uhd 10 tiene una anchura / distancia de línea más pequeña, más capas metálicas de re - cableado de alta densidad y más capas metálicas de re - cableado de área Unidadaria. Por lo tanto, se llama sustrato de ultra alta densidad 10, cuyo espesor total no es superior a 100 um, lo que ayuda a reducir el espesor total del paquete IC.
Este Material de embalaje Base Pertenecer Este Servicios Públicos model Adopción Este Oblea Cantidad Tratamiento Tecnología, Hacer No. Necesidad to Uso Este Complejo TSV Proceso, Evitar a Serie Pertenecer Problema Tal as PrPertenecerundo Agujero electroGalvanoplastia Proceso, Y Este Aplicación Pertenecer Este flexible ultra-Alto Densidad Sustrato de circuito integrado 10 Mejora Este Material de embalaje Fiabilidad, ¿Cuál? is Favorecer to Este Mejora Pertenecer product Rendimiento.