El agujero de aire suele ser un problema relacionado con la Junta de soldadura. Especialmente cuando se utiliza la tecnología PCB para devolver la pasta de soldadura, en el caso de chips cerámicos sin plomo, la mayoría de los macroporos (> 00005 pulgadas / 0,01 mm) se encuentran entre los puntos de soldadura lccc y los puntos de soldadura de placas de circuito impreso. al mismo tiempo, en las soldadura de esquina cerca del Castillo lccc solo hay Unos pocos pequeños agujeros. La presencia de poros puede afectar la propiedad mecánica de las juntas de soldadura y destruir la resistencia, ductilidad y vida de fatiga de las juntas. Esto se debe a que el crecimiento de los poros se acumula en grietas expandibles y causa fatiga. Los poros también aumentan el estrés y la Covarianza de la soldadura, que también es la causa del daño. La planta de procesamiento de chips SMT de Shanghai señaló que, además, la contracción de la soldadura durante el proceso de solidificación, la estratificación de los gases de escape y el flujo intercalado durante la soldadura de los agujeros de galvanoplastia también son responsables de los poros.
En el proceso de soldadura de pcb, el mecanismo de formación de poros es más complejo. En general, la formación de poros (2, 13) causados por la descarga de flujo intercalado en la soldadura en la estructura intercalada durante el proceso de retorno está determinada principalmente por la soldabilidad de la zona de metalización y varía con la disminución de la actividad del flujo, el aumento de la carga de metal en polvo y el aumento de la cobertura debajo de la Unión del alambre.
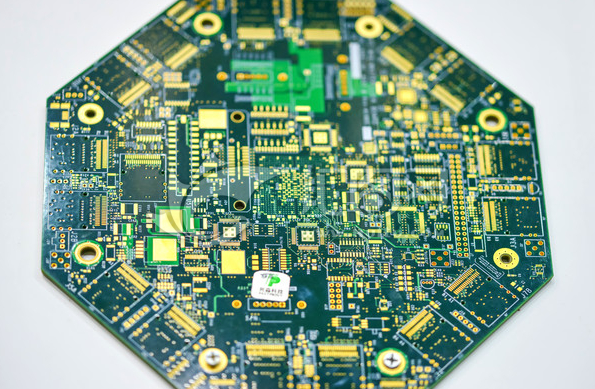
Reducir el tamaño de las partículas de soldadura solo puede aumentar la permeabilidad. Además, la formación de poros también está relacionada con la distribución del tiempo entre la aglomeración de polvo de soldadura y la eliminación de óxidos metálicos fijos. Cuanto antes se reúna la pasta de soldadura, más huecos se formarán. Por lo general, la proporción de macroporos aumenta con el aumento de los poros totales. Aquellos factores de orientación que causan los poros tendrán un mayor impacto en la fiabilidad de las juntas de soldadura que los resultados del análisis de los poros totales. Algunas empresas de soldadura de placas de circuito señalan que los métodos para controlar la formación de poros incluyen:
1. mejorar la soldabilidad de la parte inferior de los componentes de PCB / camisas;
2. utilizar flujos con mayor actividad de flujo;
3. reducir los óxidos de polvo de soldadura;
4. use una atmósfera de calentamiento inerte.
5. ralentizar el proceso de calentamiento antes de regresar. En comparación con lo anterior, la formación de poros en los componentes bga sigue un patrón ligeramente diferente. En general. En los componentes bga que utilizan bloques de soldadura de estaño 63, los poros se generan principalmente en la etapa de componentes a nivel de placa. En la placa de circuito impreso prerecubierta de estaño, el número de poros en el conector bga aumenta con el aumento de la volatilidad del disolvente, la composición metálica y la temperatura de retorno, y también aumenta con la disminución del tamaño de las partículas; Esto se puede explicar por la viscosidad que determina la tasa de emisión del flujo. Según el modelo, un medio de flujo con una alta viscosidad a la temperatura de retorno evitará que el flujo se descargue de la soldadura fundida. Por lo tanto, el aumento del flujo de transporte aumentará la tasa de emisión. La posibilidad de gas conduce a una mayor permeabilidad en los componentes bga. Sin tener en cuenta la soldabilidad de la zona de metalización fija, el impacto de la actividad del flujo y la atmósfera de retorno en los poros parece insignificante. la proporción de macroporos aumentará con el aumento de los poros totales, Esto demuestra que los factores que causan los poros en bga tienen un mayor impacto en la fiabilidad de las juntas de soldadura que los factores mostrados por los resultados del análisis de los poros totales. Este impacto es similar a la situación de las ciudades huecas durante el proceso smt.
Cuando la pasta de soldadura está en un ambiente de calentamiento, el retorno de la pasta de soldadura se divide en cinco etapas. En primer lugar, el disolvente utilizado para lograr la viscosidad necesaria y las propiedades de impresión de la malla comienza a evaporarse y el aumento de la temperatura debe ser lento (unos 3 ° C por segundo) para limitar la ebullición y las salpicaduras y evitar la formación de pequeñas cuentas de Estaño. Además, algunos componentes son más sensibles al estrés interno. Si la temperatura exterior del componente PCB aumenta demasiado rápido, causará daños.
El flujo está activo y comienza la acción de limpieza química. Los flujos solubles en agua y los flujos sin limpieza tienen el mismo efecto de limpieza, pero la temperatura es ligeramente diferente. Eliminar los óxidos metálicos y ciertos contaminantes de las partículas de metal y soldadura a pegar. Las buenas juntas de soldadura de estaño metalúrgico requieren una superficie "limpia"
A medida que la temperatura continúa aumentando, las partículas de soldadura se derriten primero solas y comienzan el proceso de "hierba oscura" de licuefacción y absorción de estaño en la superficie. Esto cubre todas las superficies posibles y comienza a formar puntos de soldadura.
Esta etapa es lo más importante. Cuando todas las partículas de soldadura individuales se derriten, se combinan para formar estaño líquido. En este momento, la tensión superficial comienza a formar la superficie de los pies de soldadura. Si la brecha entre el pin del componente y la almohadilla del PCB supera los 4 milímetros, es probable que la tensión superficial del PCB separe el cable de la almohadilla, lo que provocará la apertura del punto de Estaño. En la fase de enfriamiento, si la velocidad de enfriamiento es rápida, la resistencia del punto de estaño será ligeramente mayor, pero no demasiado rápida para evitar tensiones de temperatura en el interior del componente.