Con el rápido desarrollo de la tecnología microelectrónica, la amplia aplicación de circuitos integrados a gran escala y a gran escala, así como el progreso de la tecnología de microambalaje, la fabricación de placas de circuito de PCB HDI se está desarrollando en una dirección jerárquica y multifuncional, y los cables gráficos de placas de circuito de PCB son microporos finos y espaciados estrechos. La tecnología de perforación mecánica utilizada en el procesamiento ya no cumple con los requisitos y ha desarrollado rápidamente un nuevo método de mecanizado microporoso, la tecnología de perforación láser.
Principio de formación de agujeros láser de PCB HDI
El láser es un potente haz de luz que recibe estímulos externos para aumentar la energía, en el que la luz infrarroja y visible tiene energía térmica y la luz ultravioleta tiene energía luminosa. Cuando este tipo de luz brilla sobre la superficie de la pieza de trabajo, aparecen tres fenómenos: reflexión, absorción y penetración.
Al irradiar el punto láser sobre el sustrato a través de otro dispositivo óptico, se pueden producir varios modos sintéticos y hay tres reacciones con el punto iluminado.
La función principal de la perforación láser es eliminar rápidamente el material de base a tratar. Depende principalmente de la ablación fototérmica y fotoquímica o de la llamada extirpación.
1. ablación fototérmica: el principio de un agujero formado por un material en proceso que absorbe láseres de alta energía y se calienta, derrite y evapora en muy poco tiempo. Bajo la acción de alta energía, los residuos de coque negro en la pared del agujero formados por este proceso deben eliminarse antes de la gasificación.
2. ablación fotoquímica: se refiere a la energía de fotones altos en la región ultravioleta que supera el voltio electrónico 2ev. Resultado de fotones de alta energía con una longitud de onda láser superior a 400 nanómetros. Este fotón de alta energía destruye la larga cadena molecular del material orgánico y se convierte en una partícula más pequeña, pero su energía es mayor que la de la molécula original y se ve obligado a escapar de ella, eliminando así rápidamente el material de base bajo una abrazadera externa y formando microporos.
Por lo tanto, este tipo de proceso no contiene ebullición ni carbonización. Por lo tanto, la limpieza de agujeros preestablecidos es muy simple.
Estos son los principios básicos de la formación de agujeros por láser. En la actualidad, los métodos de perforación láser más utilizados son dos: los láseres utilizados para perforar en placas de circuito impreso están compuestos principalmente por láseres de gas CO2 estimulados por radiofrecuencia y láseres nd: YAG de estado sólido ultravioleta.
3. sobre la absorción del sustrato: la tasa de éxito del láser está directamente relacionada con la absorción del sustrato. La placa de circuito impreso es una combinación de lámina de cobre, tela de vidrio y resina. La absorción de estos tres materiales varía según la longitud de onda, pero la absorción de la lámina de cobre y la tela de vidrio a los rayos ultravioleta es de 0,3 metros. Las siguientes áreas tienen una alta tasa de absorción, pero disminuyen drásticamente después de entrar en la luz visible e ir. el material de resina orgánica mantiene una tasa de absorción bastante alta en los tres segmentos espectrales. Esta es la característica del material de resina y la base de la popularidad de la tecnología de perforación láser.
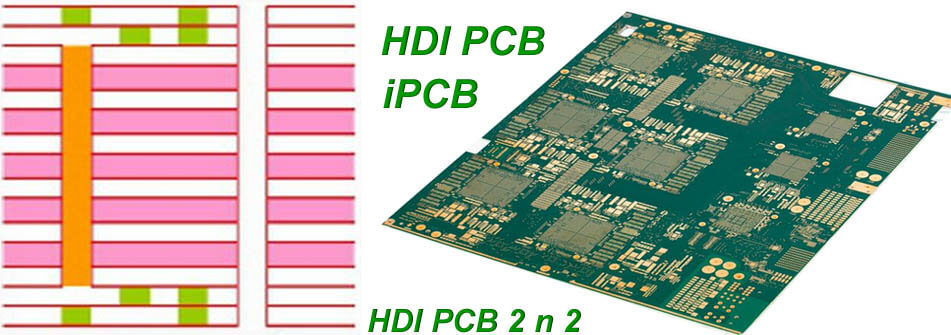
Diferentes procesos de PCB HDI para la formación de agujeros láser de CO2
La perforación láser de CO2 tiene dos métodos principales de perforación, perforación directa y perforación de máscara de reparación. La llamada tecnología de formación directa de agujeros consiste en modular el diámetro del haz láser al mismo diámetro que el agujero en la placa de circuito impreso a través del sistema de control principal del equipo y procesar directamente el agujero en la superficie dieléctrica sin usar lámina de cobre. El proceso de recubrimiento de la máscara consiste en recubrir la superficie de la placa impresa con una máscara especial y eliminar la lámina de cobre de la superficie del agujero mediante exposición / Desarrollo / grabado con el proceso tradicional. A continuación, estos agujeros son irradiados con rayos láser mayores que el tamaño del agujero para eliminar la resina de capa dieléctrica expuesta. Los siguientes contenidos se describen por separado:
1. método de apertura de ventanas de bronce:
En primer lugar, se presiona una capa de lámina de cobre de resina recubierta de hormigón compactado en el panel Interior. La ventana se hace fotoquímica, luego se graba la resina para exponerla, y luego se utiliza un láser para erosionar el material de base dentro de la ventana para formar un micro - agujero ciego:
Cuando el haz se mejora, pasa por el agujero hasta llegar a dos conjuntos de escáneres de microreflexión tipo galvanómetro, que se alinean verticalmente con la lente F positiva una vez. Llegar a la zona de la tubería donde se puede hacer una mesa emocionante y luego quemar los agujeros ciegos en miniatura uno por uno.
Una vez posicionado por un haz rápido de electrones en una zona tubular de una pulgada cuadrada, el agujero ciego de 0,15 MM se puede perforar con tres inyecciones. El ancho del pulso del primer disparo es de unos 15 ° s, proporcionando energía para la formación del agujero. Después de eso, se puede usar una pistola de pulverización para limpiar los residuos en la parte inferior de la pared del agujero y corregir el agujero.
La sección transversal del SEM y la vista completa de 45 grados del agujero microciego de 0,15 mm tienen un buen control de energía láser. Este proceso de apertura de ventanas se utiliza como objetivo de respaldo. Cuando no es frecuente que se necesiten grandes tipografía o agujeros ciegos de segundo orden, son difíciles de alinear.
2. método de proceso de apertura de ventanas:
El diámetro del agujero formado por el proceso anterior es el mismo que el diámetro de la ventana de cobre abierta. Un ligero error en la operación puede provocar un desplazamiento de la posición de la ventana abierta, lo que hace que la posición del agujero ciego no esté alineada con el Centro de la almohadilla de la base. La desviación de la ventana de cobre puede deberse a la expansión y contracción del material de base y a la distorsión de las negativos para la transferencia de imágenes. Por lo tanto, el proceso de apertura de la gran ventana de cobre es ampliar el diámetro de la ventana de cobre a 0,05 mm más grande que el diámetro de la almohadilla de base. Por lo general, el tamaño del agujero está determinado por el tamaño del agujero. Cuando el agujero sea de 0,15 mm, el diámetro de la almohadilla debe ser de aproximadamente 0,25 mm y el diámetro de la ventana grande debe ser de 0,30 mm. a continuación, se puede realizar una perforación láser para alinear con precisión la posición de agotamiento con el agujero microciego de la almohadilla. Su característica principal es que tiene un gran grado de libertad de elección. Al perforar con láser, puede optar por presionar el procedimiento de la almohadilla interior de la base para perforar. Esto evitó efectivamente la dislocación debido al mismo diámetro de la ventana de cobre que el del agujero, lo que evitó que el punto láser señalara la ventana hacia adelante y provocó la aparición de muchos agujeros medios incompletos o residuales en un gran número de losas.
3. proceso de formación directa de agujeros en la superficie de la resina de PCB HDI
Hay varios tipos de métodos de perforación láser que utilizan la perforación láser HDI pcb:
R. la capa interior del sustrato está recubierta con láminas de cobre recubiertas de resina, y luego todas las láminas de cobre están grabadas. el láser CO2 se puede utilizar para formar agujeros directamente en la superficie desnuda de la resina, y luego los agujeros se pueden tratar más a fondo de acuerdo con el proceso de galvanoplastia.
El sustrato es un proceso similar que utiliza láminas semicuradas FR - 4 y láminas de cobre en lugar de láminas de cobre recubiertas de resina.
Proceso de laminación posterior de láminas de cobre con resina fotosensible recubierta.
D. hecho a través de película seca como capa dieléctrica y proceso de prensado de lámina de cobre.
Proceso de recubrimiento de otros tipos de películas térmicas con láminas de cobre.
4. ablación directa de láminas de cobre ultrafinas
Después de presionar la lámina de cobre de resina a ambos lados del núcleo interior, el espesor de la lámina de cobre de 17 metros se puede reducir a 5 micras mediante el método de "semigrabado", y luego el agujero se puede formar a través del láser CO2 mediante un tratamiento de oxidación negra.
Su principio básico es que las superficies negras oxidadas absorben fuertemente la luz, por lo que bajo la premisa de aumentar la energía del haz láser de co2, se pueden perforar directamente las superficies ultrafinas de cobre y resina. Sin embargo, lo más difícil es garantizar que el "método de semigrabado" pueda obtener una capa de cobre uniforme y gruesa, por lo que se debe prestar especial atención a su fabricación. Por supuesto, el material desgarrable de la espalda de cobre utc. La lámina de cobre equivale a un libro de unos 5 micras.
Según este tipo de procesamiento de placas, el proceso actual utiliza principalmente los siguientes aspectos:
Esto establece principalmente normas de calidad y técnicas estrictas para los proveedores de materiales para garantizar que la diferencia de espesor de la capa dieléctrica sea de 510 micras a M. dado que solo se puede garantizar la uniformidad del espesor dieléctrico de la lámina de cobre recubierta de resina, se puede garantizar la precisión del tipo de agujero y la limpieza del Fondo del agujero con la misma energía láser. Al mismo tiempo, en las operaciones posteriores, se deben utilizar las mejores condiciones del proceso para eliminar la suciedad de la perforación y garantizar que el Fondo del agujero ciego esté limpio y sin residuos después de la perforación láser. Tiene un buen impacto en la calidad del recubrimiento químico y la galvanoplastia de agujeros ciegos.
Proceso de perforación láser de HDI PCB nd: YAG
Nd: YAG es Granate de neodimio y aluminio de itrio. El láser ultravioleta es emitido por dos cristales sólidos juntos. Recientemente, los rayos láser más utilizados estimulados por pulsos de diodos se pueden utilizar para fabricar sistemas de sellado láser efectivos sin enfriamiento por agua. La longitud de onda armónica terciaria de este láser es de 355 nanómetros. La longitud de las cuatro ondas armónicas es de 266 nanómetros. La longitud de onda está modulada por cristales ópticos.
La mayor característica de este tipo de perforación láser son los rayos ultravioleta. Las regiones espectrales, las láminas de cobre y las fibras de vidrio compuestas por laminados recubiertos de cobre absorben fuertemente en la región ultravioleta, junto con la pequeña energía de estos puntos láser, pueden penetrar fuertemente en las láminas de cobre y las láminas de vidrio, formando directamente agujeros. Debido a que el calor láser del tipo anterior es pequeño, no se produce escoria de carbono después de la perforación láser de co2, lo que proporciona una buena superficie para el posterior funcionamiento de la pared del agujero.
La tecnología láser nd: YAG procesa agujeros ciegos y perforaciones marcadas en varios materiales. Perforó un agujero de un diámetro mínimo de 25 micras en un laminado recubierto de cobre de poliimida. En términos de análisis de costos, el diámetro más económico utilizado es de 25.125 micras. La velocidad de perforación es de 10000 agujeros por minuto. Se puede perforar con láser directo con un diámetro máximo de 50 micras. La superficie interior del agujero formado es limpia, sin carbonización y fácil de galvanoplastia. También puede perforar en laminados recubiertos de cobre de ptfe, con un diámetro mínimo de 25 micras y el diámetro más económico de 25.125 micras. La velocidad de perforación es de 4.500 agujeros por minuto. No se necesita pregrabado de ventana. Estos agujeros están limpios y no requieren requisitos especiales de procesamiento. También hay otros materiales como el procesamiento de agujeros de formación. En el tratamiento específico se puede utilizar el siguiente proceso: 1. De acuerdo con la velocidad de dos tipos de perforación láser, se utilizan dos procesos combinados.
El método básico de operación es utilizar primero la lámina de cobre en la superficie de la posición del agujero de ablación yag, y luego utilizar un láser de CO2 más rápido que la perforación YAG para quemar directamente la resina para formar el agujero.
Problemas de calidad en la fabricación real de PCB HDI
En el proceso de perforación láser, hay muchos problemas de calidad que aún no se han descrito completamente. Solo los problemas de calidad más comunes se plantean para referencia de pares.
A. dislocación entre la posición de perforación láser CO 2 y la posición objetivo inferior en el método de apertura de ventanas
En el perforación láser de PCB hdi, el sistema de posicionamiento del haz de luz es crucial para la precisión de la formación del agujero. Aunque el sistema de posicionamiento del haz se utiliza para un posicionamiento preciso, a menudo se producen llamas porosas debido a otros factores. El análisis de los problemas de calidad que aparecen en el proceso de producción es el siguiente:
1. hacer el negativo de la almohadilla de núcleo interior y el patrón de alambre de soldadura, así como el hormigón compactado con lámina de cobre recubierta de resina. Abrir la ventana después de agregar la capa es negativo, ya que ambos son factores potenciales de aumento y disminución del tamaño debido a la humedad y la temperatura.
2. el tamaño del sustrato aumenta o disminuye cuando se utiliza una placa central para hacer un patrón de almohadilla transversal y se presiona el RCC de la lámina de cobre recubierta de resina a altas temperaturas. Después de la adición de la capa, hay factores de expansión y contracción del tamaño del material del sustrato interno y externo.
3. el tamaño y la ubicación de la ventana de cobre grabada también pueden causar errores.
4. errores causados por el desplazamiento del punto óptico y la superficie del propio láser.
5. la alineación de los agujeros ciegos de segundo orden es más difícil y puede causar fácilmente errores de posición.
Por las razones anteriores, de acuerdo con los datos técnicos relevantes y la experiencia práctica obtenida en la producción, las principales estrategias técnicas adoptadas son las siguientes:
1. para reducir el tamaño de la composición tipográfica, la mayoría de los fabricantes de PCB HDI utilizan 450 para la composición tipográfica multicapa * 600 o 525 * 600mm. Sin embargo, para los paneles de teléfonos móviles con un ancho de alambre de 0,10 mm y un diámetro de agujero ciego de 0,15 mm, el tamaño óptimo de diseño es de 350. 450 mm. Límite superior.
2. aumentar el diámetro del láser: el objetivo es aumentar el área cubierta por la ventana de cobre. El método específico es "diámetro del haz = apertura + 90 a 100". cuando la densidad energética es baja, se emite una o dos veces más para resolver el problema.
3. tomemos como ejemplo la apertura de una gran ventana de cobre: en este momento, solo el tamaño de la ventana de cobre se hace más grande y el diámetro del agujero no cambia, por lo que el diámetro del agujero láser ya no está completamente determinado por la posición de la ventana, de modo que la posición del agujero se puede basar directamente En la posición del objetivo base en la placa central.
4. cambiar el método de apertura de ventanas de imagen fotoquímica y grabado a láser yag: primero abrir ventanas con puntos láser YAG de acuerdo con el agujero base de la placa central, y luego quemar el agujero en su posición de ventana con láser CO2 para resolver el error causado por la imagen.
5. método de fabricación de agujeros micro - ciegos de segundo orden en dos capas: cuando los dos lados de la placa central están recubiertos con RCC de lámina de cobre de resina. Después de eso, si el hormigón compactado se acumula nuevamente y se hacen agujeros ciegos de segundo orden, los ojos ciegos de segundo orden se acumularán. En el caso de la alineación de "dos" agujeros ciegos, los agujeros deben formarse apuntando "uno tras otro". El objetivo original del núcleo no se puede reutilizar. Es decir, cuando "se acumula uno" en el agujero y la soldadura, el borde de su placa también se convierte en el objetivo. Por lo tanto, después de presionar el hormigón compactado "ji 2", se pueden perforar cuatro agujeros adicionales de referencia mecánica "ji 2" a través de una máquina de rayos x, apuntando a "ji 1" y luego alinear los agujeros. Este método permite alinear "ji 2" con "ji 1" tanto como sea posible.
B. pase incorrecto
Según muchas experiencias de producción, principalmente debido a problemas de calidad en la formación de sustratos, el principal problema de calidad es que el espesor de la capa dieléctrica después de la prensada de la lámina de cobre recubierta de resina es inevitablemente diferente. Con la misma energía de perforación, la almohadilla de la parte más delgada de la capa dieléctrica no solo soportará más energía, sino que también reflejará más energía. Por lo tanto, la pared del agujero se forma en una tetera que se expande hacia afuera. Esto tendrá un impacto significativo en la calidad de la interconexión eléctrica entre capas de varias capas.
Debido a la apertura incorrecta, la fiabilidad de la estructura de interconexión de alta densidad de placas de circuito impreso multicapa estratificadas (mlpcb) traerá una serie de problemas técnicos.
Por lo tanto, se deben tomar medidas de proceso para controlar y resolver el problema. Se utilizan principalmente los siguientes procesos:
1. controlar estrictamente la diferencia de espesor de la capa dieléctrica entre la lámina de cobre recubierta de resina y la lámina de cobre laminada de 510 micras a M.
2. cambiar la densidad de energía del láser y el número de pistolas de pulso. Las condiciones del proceso de producción a gran escala se pueden encontrar a través del método de prueba.
3. la eliminación de la escoria inferior del agujero y la escoria rota de la pared del agujero no está en su lugar.
Es más probable que los problemas de calidad de este tipo de PCB HDI se produzcan debido a un ligero control inadecuado. Especialmente para los laminados de múltiples agujeros en placas grandes, es imposible garantizar una calidad del 100% sin problemas de calidad. Esto se debe a que el número de agujeros micro - ciegos en la plantilla grande procesada es demasiado grande, con un promedio de unos 60 - 90.000 agujeros. Cuando se utiliza la perforación láser de la misma energía, el espesor de la capa dieléctrica es diferente, al igual que el espesor de los residuos que permanecen en el sustrato. Después de manipular la suciedad de la perforación, no se puede garantizar que todos los residuos estén completamente limpios. Además, los malos métodos de inspección suelen provocar el posterior chapado en cobre de los PCB HDI y la Unión entre la almohadilla inferior y la pared del agujero cuando hay defectos.