Heterogen 3DIC masih menghadapi ambang produksi massa
Walaupun teknologi pengumpulan tiga-dimensi 3DIC+TSV boleh meningkatkan ketepatan cip dengan kawasan yang paling kecil, mengurangkan kos dan mengurangkan saiz produk, dan dengan itu meningkatkan prestasi dan kepercayaan cip, Samsung juga adalah yang pertama untuk memperkenalkan Memori Flash NANDFlash stacked homogen, memori DDR3, dan cip WideI/ODRAM stacked untuk komputer desktop dan notebook. Syarikat desain IC seperti Qualcomm dan BroadComm juga memperkenalkan teknologi 3DTSV untuk merancang ICs densiti generasi seterusnya.
Aplikasi terintegrasi semasa 3DIC masih milik proses penghasilan yang sama, integrasi cip homogen (Homogenuous), seperti DRAM, NANDFlash mati, atau mikroprosesor berbilang-inti. IEK mengharapkan bahawa dari tahun ini (2013), 3DIC seperti DRAM dan NANDFlash dengan tumpukan homogen dijangka untuk memasuki produksi massa. Adapun integrasi heterogene cip logik (Logik), cip memori (DRAM), ICs frekuensi radio (RF), amplifiers kuasa (PA), cip konversi fotoelektrik, dll., ia terbatas oleh isu teknik seperti konsumsi kuasa dan koeficien bahan pakej. Masih belum dikalahkan.
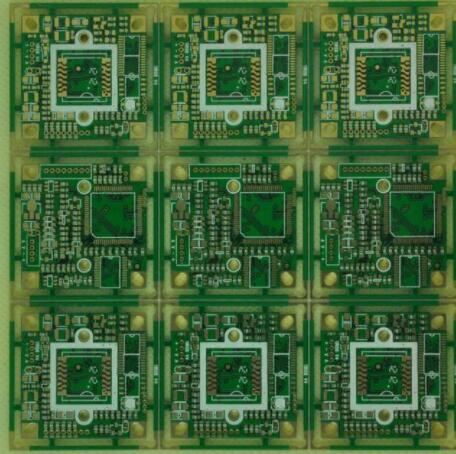
Teknologi perdagangan 2.5D adalah yang pertama untuk memperkenalkan FPGA, GPU/APU ke dalam produksi massa
Seperti yang disebutkan tadi, 3DIC digunakan dalam Hetergeneous Integrated. Ia mengumpulkan cip silikon kosong dengan proses logik dan ciri-ciri operasi yang berbeza, dan menggunakan teknologi TSV (Silicon Drilling) untuk menyambungkan cip. Apabila jenis cip yang berbeza dikumpulkan, konsumsi kuasa dan masalah penyebaran panas akan memerlukan rawatan istimewa.
Jika hanya cip DRAM dengan tegangan 1V dan penggunaan kuasa 2W ditampung, arus permulaan adalah kira-kira dua ampera. Jika CPU pemproses berbilang-inti, atau unit pemproses grafik (GPU) ditampung di atasnya, ia akan perlukan puluhan watt atau lebih. Seratus watt, arus pemula cahaya mungkin setinggi sepuluh-puluh amper, yang hampir boleh ditangani oleh bateri-gred kereta. Jenis cip ini adalah fatal untuk desain peranti bergerak bergerak; dan ia menyediakan arus besar di kawasan yang sempit dan tebal. Rancangan kabel sirkuit bekalan kuasa dan pemilihan cip kuasa adalah cabaran teknikal, dan bahkan semasa itu sendiri adalah sumber terkena gangguan yang mempengaruhi efisiensi dan kestabilan sirkuit.
Operasi frekuensi tinggi CPU dan cip GPU biasanya boleh panas sehingga 120 darjah. Namun, apabila DRAM dan NANDFlash mati melebihi 85°C, mekanisme segar dan toleransi penyimpanan akan tidak normal. Jika CPU digabungkan dengan DRAM, NANDFlash Ditumpukan bersama-sama, panas tinggi CPU akan mempengaruhi DRAM dan NANDFlash; Selain itu, seperti peranti pertukaran fotoelektrik, kestabilan operasi akan dikurangi dengan besar apabila suhu mencapai 80°C atau lebih. Terdapat juga jenis berbeza bahan mati kosong. Apabila dikumpulkan bersama-sama, kesan tekanan panas pada mekanisme pakej disebabkan oleh koeficien pengembangan panas berbeza mesti dianggap, dan bahkan overheating akan menyebabkan deformasi lapisan wafer dikumpulkan dan bahkan retakan tin. Bagaimana untuk mengatur urutan tumpukan cip ini dengan ciri suhu yang berbeza sehingga ia tidak akan mempengaruhi satu sama lain semasa penyebaran panas adalah cabaran teknikal yang sangat berat. Inilah sebabnya 3DIC, yang telah dihasilkan secara massa, muncul pertama dalam DRAM kuasa rendah dan produk tumpukan yang sama dengan NANDFlash.
Teknologi 2.5DIC (atau 2.5DInterposer) pertama kali diusulkan oleh pemimpin kilang (ASE), kemudian menjadi istilah diikuti oleh industri setengah konduktor. Kaedah adalah untuk membuat kematian berbagai proses/ciri-ciri kerja tidak dikumpulkan satu sama lain, tetapi diatur secara selari dan dekat satu sama lain, ditempatkan pada kaca atau bahan berdasarkan silikon Interposer (interposer) untuk sambungan, dan kemudian disambung ke bawah Papan sirkuit PCB pendek masa lambat isyarat dan meningkatkan prestasi sistem keseluruhan; Setiap kematian selari boleh diuji secara individu dan kemudian dibuka dan dikumpulkan sebelah sebelah sebelah. Ia tidak perlu melalui ujian radiasi panas/elektromagnetik, selama ia ditempatkan pada papan antarabangsa (Interposer) boleh melalui ujian integrasi keseluruhan selepas pakej. Apabila melakukan stacking 3DIC, ujian panas/elektromagnetik mesti dilakukan pada setiap lapisan dalam stack; Jika salah satu kematian cacat, keseluruhan peranti pengumpulan 3DIC mesti dikembalikan.
2.5DIC dianggap oleh industri setengah konduktor sebagai teknologi antarabangsa untuk transisi ke 3DIC masa depan. Selain menggunakan Interposer untuk bertindak sebagai jambatan komunikasi antara cip, perhatian juga perlu diberikan kepada isu-isu seperti kombinasi mati dan Interposer, ciri-ciri bahan, dan tekanan panas. Compared with 3DIC, 2.5DIC has a lower technical bottleneck. Interposer silikon yang digunakan dalam papan sirkuit (SIInterposer) biasanya tidak perlu menggunakan proses penghasilan lanjutan 40 nm atau 28 nm seperti cip pemproses, dan biaya penghasilan boleh dikurangkan.
Ambil cip pemproses FPGA Xilinx2.5D sebagai contoh. Selepas cip FPGA 28/40 nm telanjang diatur sebelah sebelah, mereka ditempatkan pada interposer silikon 65nm. Jumlah kos lebih rendah daripada proses SOC 40 nm atau 28 nm sebelumnya. Oleh itu, medan aplikasi 2.5DIC tidak terbatas kepada cip memori. Chip pengiraan logik yang berfungsi tinggi dan terintegrasi tinggi seperti FPGA, CPU, GPU, dll., telah mula menerapkan teknologi 2.5DInterposer.
Aplikasi pembunuh 2.5D/3DIC
Semikoduktor yang telah memperkenalkan konsep 2.5DIC ke dalam produksi massa adalah mewakili oleh penghasil array pintu logik (FPGA) yang boleh diprogramkan utama Xilinx dan Altera. Kedua-dua syarikat menggunakan teknologi CoWos TSMC (ChiponWaferonSubstrate) 2.5DIC. Seperti cip Virtex-72000TFPGA Xilinxxxs, 28 nm mati telanjang ditetapkan secara dekat. Bumps mikro di bawah mati kosong disambung dengan interposer silikon 65nm. Selepas itu, mereka tersambung ke bola tentera dengan teknologi TSV dan kemudian menembus. Sambungkan bola askar ke papan PCB di bawah.
Selain itu, cip grafik IntelIrisPro5200 (GT3e) sepadan dengan pemproses IBM Power8, pemproses Corei generasi keempat Intelâ (Haswell), dan AMD â 8 setengah-suai APU inti juga akan menggunakan teknologi pakej 2.5DIC.
Adapun bahagian 3DIC, selain tumpuan homogen cip DRAM (WideI/O) dan cip NANDFlash, Altera baru-baru ini mengumumkan produk FPGA generasi seterusnya, yang akan menggunakan proses TSMC â™s generasi seterusnya 20nm ditambah teknologi integrasi dan tumpuan heterogen 3DIC. Menyempurnakan lebih dari dua set mati FPGA, cip pemproses berbilang-inti ARM, cip HardCopyASIC yang boleh disesuaikan-pengguna, pemproses isyarat digital DSP yang boleh disesuaikan, dan cip memori MemoryCube bertopak berbilang lapisan.
ASE, Produk Silikon, Licheng dan Nanmao mempunyai bahagian 56% dari pakej global dan ujian pasar pendarahan, yang juga adalah kunci untuk batu terakhir dalam rantai industri 3DIC. ASE menerima piawai 3DS-IC bagi platform spesifikasi SEMI, dan secara aktif bekerjasama dengan DesignHouse dan Foundry untuk menyelesaikan spesifikasi sambungan DietoDie, DietoSiP meliputi, dan pengesahan stacking, pengukuran dan kepercayaan pakej; dalam Foundry, Memory House dan pakej dan menguji papan pembawa 3D, pemasangan, prosedur memegang antara kilang, serta berpartisipasi dalam wafer TSV, kaedah penumpang memori JEDECJC-11WideI/O, dan spesifikasi berkaitan dengan jaminan kualiti 3DQA.
Selain itu, TSMC juga memperkenalkan teknologi produksi terintegrasi struktur 2.5D/3DIC CoWoS (ChiponWaferonSubstrate), menyediakan TSV/3D, berbagai bahan bumping termasuk teknologi penambahan bola, interposer silikon (Si-Interposer) dan pelbagai integrasi sub-sistem, dll. perkhidmatan pembelanjaan satu-stop. Pada masa yang sama, teruskan melabur dalam teknologi 2.5D/3DIC untuk mempercepat perkenalan seluruh rantai industri EDA, IP, ujian, peralatan, penyedia wafer silikon dan kilang pakej. UMC dan kilang pakej dan ujian turun sedang mencari model industri terbuka (OpenEcosystemModel) untuk mengembangkan teknologi 3DIC.
IEK menunjukkan bahawa teknologi 3DIC telah diperkenalkan ke dalam cip penyimpanan ingatan seperti NANDFlash dan DRAM sebelum 2010. Sejak 2010, produksi massa komponen CIS (sensor imej CMOS) dan MEMS (mikroelektromekanik) juga telah diperkenalkan. Terdapat aplikasi seperti cip penuh kuasa (PA), pakej cip pencahayaan LED, dan pakej unsur penukaran fotoelektrik. Pada tahun 2013, dijangka bahawa MemoryCube dan WideI/ODRAM berbilang lapisan homogen akan dihasilkan dalam massa; dan komponen 3DIC heterogene (Heterogeneous 3DIC) yang mengintegrasikan CPU, FPGA, ASIC, memori, dan optoelectronic adalah dijangka untuk diperkenalkan antara 2014 dan 2015 tahap produksi massa yang sebenar.