Untuk maklumat lanjut tentang Kemampuan Teknik Substrate IC, klik "Muat turun Helaian Data Kemampuan Proses" untuk muat turun dokumentasi. Sila hubungi kami jika anda mempunyai soalan.
Tentang papan Substrate IC, sila klik: Papan Substrate IC
Jika anda mempunyai kesulitan dengan desain substrat, Sila klik untuk muat turun peraturan desain Substrate IC: ![]()
atau hubungi jurutera iPCB untuk bantuan, e-mel: eng-ic@ipcb.com
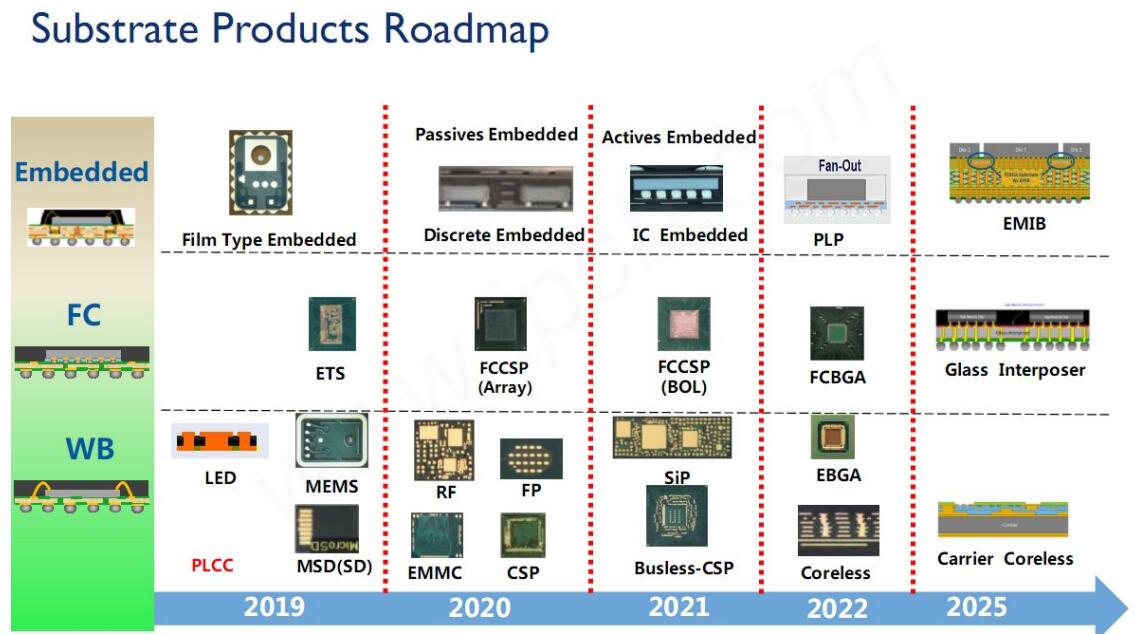

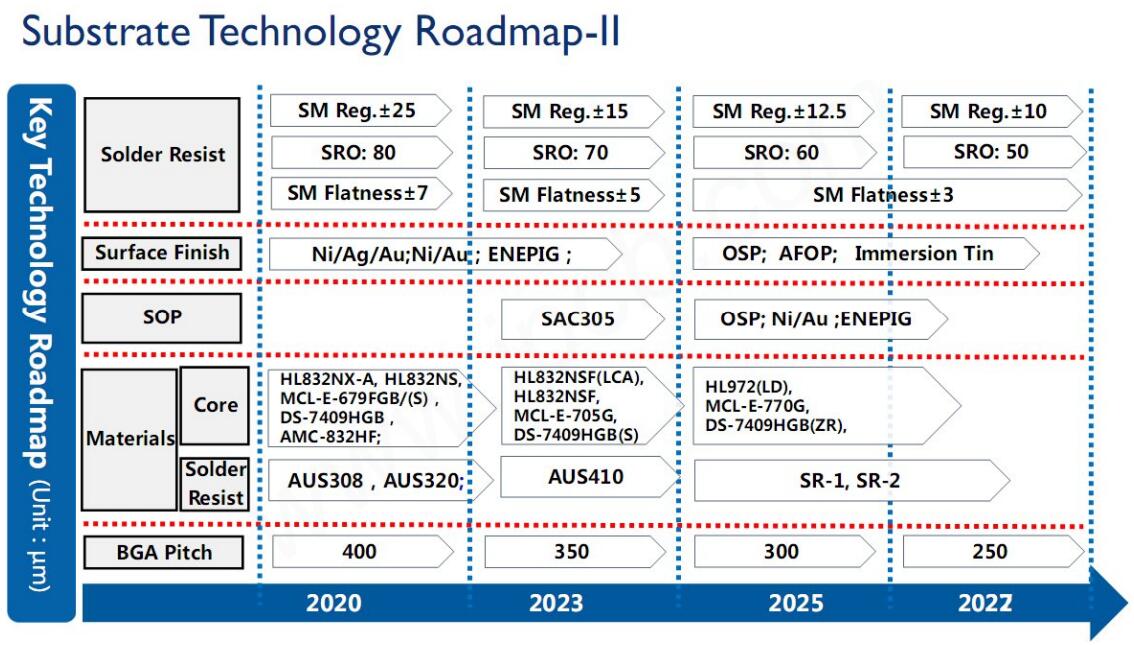
Substrate Sistem-dalam-Pakej (SiP)
Sistem-dalam-pakej adalah platform sistem yang mengumpulkan pelbagai wafer heterogene, komponen sensing, komponen pasif, dll., ke dalam satu pakej. Aplikasinya termasuk modul berbilang-cip (MCM), pakej berbilang-cip (MCP), pakej cip tumpukan, pakej dalam pakej (PiP), dan papan pembawa komponen terbenam. Sistem-dalam-pakej menyediakan perancang sistem IC dengan penyelesaian integrasi fungsi komputer lain selain System-on-Chip (SoC). Ia mempunyai keuntungan untuk mengintegrasikan cip heterogene dari sumber yang berbeza, menjadi lebih kecil dan lebih tipis, dan memasuki pasar dengan cepat.
SiP boleh menjadi pakej planar 2D modul berbilang-cip (Modul berbilang-cip; MCM), dan juga boleh menggunakan semula struktur pakej 3D untuk mengurangkan kawasan pakej dan teknologi ikatan dalamnya boleh menjadi ikatan wayar murni (ikatan wayar), FlipChip juga boleh digunakan, tetapi kedua-dua juga boleh dicampur. Selain struktur pakej 2D dan 3D, cara lain untuk mengintegrasikan komponen dengan substrat berbilang-fungsi juga boleh disertai dalam skop SiP. Teknologi ini terutama memasukkan komponen berbeza dalam substrat berbilang fungsi, dan juga boleh dianggap sebagai konsep SIP untuk mencapai tujuan integrasi fungsi. Peraturan cip berbeza dan teknologi ikatan dalaman berbeza membolehkan jenis pakej SIP untuk menghasilkan kombinasi berbeza. iPCB boleh disesuaikan atau dibuat fleksibel mengikut keperluan pelanggan atau produk.
Ball Gate Array Package Substrate (PBGA)
Ini adalah substrat array gerbang bola paling asas yang digunakan dalam ikatan wayar dan pakej. Bahan asasnya adalah substrat foil tembaga yang dipenuhi serat kaca. Substrat pakej tata bola plastik boleh dilaksanakan pada pakej cip dengan kiraan pin relatif tinggi. Apabila fungsi cip ditatar, struktur pakej bingkai utama tradisional menjadi tidak sesuai dengan peningkatan bilangan pin output/input, dan substrat pakej tata bola plastik menyediakan penyelesaian yang berkesan pada biaya.
Flip Chip Chip Scale Package Substrate (FCCSP)
Cip setengah konduktor tidak disambung ke substrat dengan ikatan wayar tetapi disambung dengan substrat dengan bumps dalam keadaan cip-balik, jadi ia dipanggil FCCSP (Pakej Skala Chip Flip). Pakej saiz-aras wafer-cip balik akan menunjukkan lebih lanjut keuntungan kos. Dalam masa lalu yang baru, biaya proses bumps pada wafer juga terus jatuh, yang juga telah menyebabkan pengurangan lebih cepat dalam biaya pakej. Pakej saiz tahap cip-Flip telah menjadi IC penghitungan pin tinggi.
Flip Chip Ball Gate Array Package Substrate (FCBGA)
Substrat FC-BGA (Flip Chip-Ball Grid Array) adalah substrat pakej setengah konduktor yang mempunyai densiti tinggi yang boleh menyedari kelajuan tinggi dan pengfungsian berbilang cip LSI. Pakej tatasusunan bola flip-chip mempunyai prestasi yang sangat baik dan keuntungan kos dalam pakej mengira pin output/input yang sangat tinggi, seperti cip seperti mikroprosesor atau prosesor imej.
Jika anda perlukan substrat IC, sila jangan ragu-ragu untuk menghubungi iPCB, e-mel: sales@ipcb.com
|
Substrat IC SiP |
Substrat IC BGA |
Substrate Pakej eMMc |