Bu el yazısı COG (camdan çip) ve COF (fleks üzerindeki çip) paketleme teknolojilerini tanıtır. Yüksek yoğunluk paketleme teknolojisinin geliştirilmesiyle, COG ve COF teknolojileri çeşitli düz panel gösterilerinde ve kişisel mobil ürünlerinde geniş kullanılmış. COG ve COF teknolojileri, yüksek yoğunluğu, çoklu I/O yüzünden LCD üretimlerinde kullanılan ana paketleme teknolojisi oldular ve genellikle yönetici uyumlu paketleme kullanarak kullanıldı.
[Anahtar kelimeleri] COG, COF, anisotropik sürücü adhesive, LCD paketi
1 Ön Kelime
Mobil elektronik ürünlerin ve büyük ekran gösterilerinin popularizasyonu, düşük mal, yüksek yoğunlukta ve yüksek yoğunlukta elektronik üretim teknolojisinin hızlı gelişmesini tercih etti. LCD izleyicileri, LCD TVleri, plazma TVleri, mobil telefonları, dijital kameralar, dijital video kameralar ve diğer 3C ürünleri gibi küçük ve orta boyutlu elektronik ürünlere benzer büyük boyutlu elektronik ürünler, ışık, incelenme ve kısıtlığına yönlendiriyor. Bu yüksek yoğunluğu ve küçük boyutu gerekiyor. Yukarıdaki ihtiyaçları yerine getirmek için özgür olarak yüklenebilecek yeni bir nesil paketleme teknolojisi. Bu kontekstde, COG ve COF teknolojileri hızlı geliştirildi, LCD ve PDP gibi düz panel gösterileri için kullanıcı IC'nin büyük paketleme formu haline geldi ve sonra bu gösterim modüllerinin önemli bir parças ı oldu. Aynı zamanda, anisotropik yönetici uyuşturucu paketleme teknolojisi ile uygulama alanları hızlı genişletiyor ve RFID, tıbbi elektronik ekipmanlar, mobil kişisel elektronik ürünler ve diğer mikro elektronik ürünlerde uygulanıyor.
2 COG ve COF yapısı
COG'nin tam adı camdan çip ve Çinlilerde cam teknolojisinde çip denir. Bu bardak IC'yi anisotropik süreci adhesive(ACF) tarafından doğrudan kapsamlayır ve IC süreci böceklerinin ve ITO'nun camdaki transparent süreci böceklerinin arasındaki bağlantısını ve kapsamlayıcını fark ediyor. COF'nin tam adı, film üzerindeki fleks ya da çip çip, Çin'deki fleksible substratlardaki çip teknolojisi ve aynı zamanda yumuşak film toplantı teknolojisi olur. COG teknolojisine benziyor, IC çipi, yüksek paketleme yoğunluğunu, kilo azaltma, volum azaltma ve yerleştirme özgürlüğünü sağlamak için fleksibil basılı devre kurulunda doğrudan paketlenmiş.
Eğer IC, fleksibil substrat, cam paneli, PCB ve diğer pasif komponentler (kapasitörler, rezisterler, etc.) uygun bir şekilde bağlanılırsa (IC, ACF üzerinden doğrudan cam paneli ile bağlanmış, ya da fleksibil substrat ve IC ve cam paneli kullanılan ACF) bağlantısı için fleksibil substrat ve pasif komponentler geleneksel reflow çözümleme ile bağlanılabilir, COG veya COF paketleri ile görüntüleme modulu oluşturmak için geleneksel çözümleme veya bağlama ile birleştirilebilir.
COG ve COF paketlenmesi genellikle, IC ile bardak substrat veya fleksible substrat arasındaki ilişkileri fark etmek için anisotropik davranışçılık uygulamasını kullanır ve IC genellikle dönüş çip yapısını kabul ediyor. Flip-chip teknolojisi ve substratdaki sıkıştırma teknolojisi gelecekte özel maddelerde okuyuculara özel olarak tanıştırılacak. İlk olarak, temel fleksibil üretim ve ACF bağlantı süreci teknolojisini tanıtıyor.
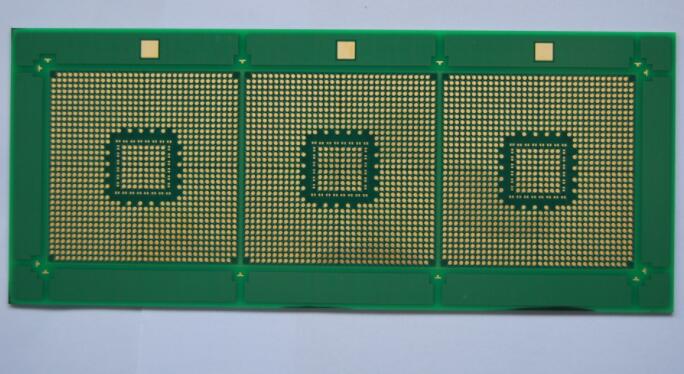
3 Ufak substratlarda güzel devreler üretimi
Ekranların görüntülerin yoğunluğu arttığında, sürücü çip I/O'nun büyük arttırması gerekiyor ve ön çipların arasındaki çip 30 milyon aşağıdır. Bu yüzden fleksibil substratların ince devre modellerinin ihtiyaçları da artıyor ve bağlantı bölgesinin uzağı artıyor. 15 mil'e ulaştı ve devam ediyor. Bu yüzden, elastik devre tahtalarının üretim teknolojisi araştırmaların odaklanması oldu. Şu anda fleksibil substratlardaki ince devrelerin üretimi genellikle çıkarma, yarı bağımlılık ve bağımlık metodları içeriyor.
3.1 Subtractive laye r r method
Çıkarma katı yöntemi geleneksel FPC üretiminin ana yöntemidir. FCCL üzerinde sıvı fotosensitiv bir katmanı guru filme saldırmak veya sıvı fotosensitiv bir katmanı kaplamak ve sonunda ihtiyacı olan devre örneğini göstermek, geliştirmek, etkilenmek, striptiz etmek. Çıkarma yöntemi tarafından ulaşabilen çizgi genişliğinin çözümüne yakın bir bağlantı fotosentik direnç katının çözümüne bağlı. Fotosensif direnç katının çözümlenmesi direnç katının kalıntısıyla belirlenmiştir. Kalınlığın daha ince, daha iyi devre örnekleri fotosensitiv karşı katmanın üzerinde oluşturulabilir. Bu yüzden, karşı katından geçerken ışık yayılacak. Yüksek karşı katmanın, dağıtımın derecesi daha büyük ve oluşturulmuş çizginin hatası daha büyük. 50 milyon a şağıdaki bir çizgi genişliği yapmak için kuruyu film kalınlığı 20 milyon aşağıda olmalı, a m a çok ince bir kuruyu film üretmek çok zor. Bu yüzden insanlar kuruyu filmden daha ince ve kendi kontrol edilebilecek ıslak film sürecini kullanmak için daha isteklidir. Şirketi 5 mil ıslak bir film üretmek için sıvı fotoresist kaplamak için bir roler kullanabilir. Fakat çok ince ıslak film, boğazlar, çöplükler gibi yanlış yanlışlıklar olacak ve üniforması kuruyu film kadar iyi değil, bu yüzden kısa sürede kuruyu filmi değiştiremez. Yukarıdaki sebepler yüzünden, etkinleştirme sırasında dayanılmaz taraf etkinleştirme fenomeniyle birlikte, çıkarma metodun sınır genişliği 20 milyon. Eğer daha ince bir devre almak istiyorsanız, daha ince 9,5,5 milyon, ya da 3,5 milyon ultra ince bakır foliyle birlikte olmalısınız, bu şekilde etkinlik zamanı m ümkün olduğunca kısaltmak için, yandan korozyon azaltmak ve güzel çizgiler elde etmek için. Ancak, bu kalın bakra yağmaları ve ilişkili süreçler hepsi hala deneysel a şamada ve kütle üretilmez.3.2 Yarı bağımlılık katı metodu & # 160; & # 160; Eğer daha geliştirilmiş devre yapmak istiyorsanız, yarı bağımlık katı metodu kullanarak düşünebilirsiniz. Bu, yarı ekleme yönteminin temel materyali genellikle 5μm ince bakra folisi, bazen alışkanlı bakra folisi etkilendikten sonra kullanılabilir [9]. Bu yöntemde, ışık dağıtımı devre örneklerine karşı etkisi yok. 20 μm.3.3 Ekstra katı yöntemi yapmak için daha kalın karşı katı kullanılabilir. Yöntem ekleme yöntemi devre örneğini oluşturmak için süslü süslü süslü örneğini doğrudan işlemek için kullanılır. Bu yöntem, şu anda bulunan en iyi devreleri üretebilir, 3 milyon boyunca kadar çizgi uzanımla. Bu yöntemin başka bir avantajı ise devreğin kalıntısını arttırmak için kalın fotosensitiv kuruyu film kullanılabilir. Böylece 8 kez kalın-genişlik oranı gibi, devre düzenlendiğinde DC dirençliğinin arttığını bastırabilir. Ancak bu metod yarı yönetici üretim için ekipmanın kullanımına ihtiyacı var ve süreç karmaşık ve maliyeti relatively yüksek.
Şu anda fleksibil substratlar ve IC'lerin arası bağlantı teknolojileri, genellikle Au-Sn eutectik bağlantısı, anisotropik süreci bağlantısı ve süreci olmayan bağlantısı içeriyor.
4. 1 Altın-tin eutektik bağlantı süreci
Bu süreç IC çipi üzerindeki altın patlamalarını kullanır ve kaynaklı FPC içerisindeki bağlantı amacını ulaştırmak için toplantı yüzeyinde altın-tin eutektik oluşturur. Bu metodun çözüm sıcaklığı altın-tin eutektik (325-330°C) sıcaklığının oluşturma sıcaklığının üstünde olmalı. Bu substratın sıcaklığın sıcaklığı için ciddi bir test. Bununla birlikte, doğru karışma sıcaklığı anlamak zordur. Bağlantı parçasının sıcaklığı relativ düşük olduğunda, iç liderin etteki oluşturulması yetersiz, iç liderin açık devrelerinde oluşturulmuş. Ancak, bağlantı parçasının sıcaklığı çok yüksek olduğunda, altın-tin eutektik hala erimiş bir durumda olduğu sürece, iç lider a çık devre ortaya çıkmasına kolayca yol açar. Ayrıca, sıcaklık düşük ve iç liderlerin üstündeki kalıntısı daha kalıntıdır, kalıntıyı altın (eutektik formasyon) tarafından absorbe edilmeyecek, bu kısa devreler ve sızdırmayacak. Doğru bir sıcaklık seçmek çok önemli, ve şimdi 400 derece Celsius sıcaklığı daha sık kullanılır.
Daha kısa bağlama ihtiyaçlarını yerine getirmek için insanlar, yerel metal bağları oluşturmak için altın ile altın bağlantılara sıcak sıkıştırma bağlantısını kullanarak, metal dağıtma mekanizmalarını kullanarak araştırdılar ve geliştirdiler. Ancak altın erime noktası oldukça yüksek olduğundan dolayı, fışkırmak için altın-altın bağlaması altın-altın bağlaması altın-tin bağlamasından daha yüksek bir bağlama sıcaklığı ve daha uzun bağlama zamanı gerekiyor. Bu sırada substratın deformasyonu çok ciddi olabilir. Ancak, ultrasyonik yardım edilen kayıt teknolojisi ve plazma yüzey temizleme teknolojisi kullanımı kayıt için gereken sıcaklığı etkili olarak azaltır. Sanayi genelde eutektik sürecinin 20'den fazla bağlantıların uzağına ulaşabileceğine inanıyor. Yoksa kısa devreler olabilir.
4.2 Anisotropik hareketli film (ACF) bağlantı süreci
ACF materyali güzel metal parçacıklarını ya da metal tabanlı plastik sferleri bir resin materyalinde yayılır ve B-sahne durumundaki bir film formunda bulunuyor. ACF'nin altrattaki bölümlerin ve devrelerin arasında bağlandıktan sonra, resin akışını sağlamak için uygun basınç, sıcaklık ve zamanı kullanın ve yönetici parçacıklar elektrik davranışını sağlamak için bölümlerle ve substratdaki devre ile bağlantısı yapılır. Aynı zamanda, uygun bir yönetici parçacık boyutunu ve toplama miktarı seçilmesi yüzünden, anisotropik yönetim özelliklerini ulaştırmak için bump ve bump birbirlerine bağlantı yapamazlar.
Pazarda çeşitli tür ACF var, a m a en sık kullanılan en çok altın plate plastik peletler 3-5μm diametri ile oluşturulmuş, 40,000-60,000 pc/mm2 yoğunluğu olan epoksi resin sisteminde termosetim sisteminde yayılarak oluşturulmuş. Sıcak bastıktan sonra epoksi resin tedavileri ve azaltıldığı sürece, IC patlamaları ve substrat devreleri arasındaki bağlantı gücü iyi, yönetici parçacıklar sıkıştırılır ve değiştiriler, ve sonuçları elastik gücü, sürücü parçacıkları üst ve aşağı arayüzlerle daha yakın bir bağlantı yapar ve sürücü daha iyi. Ayrıca, yönetici parçacıklar elastik olduğu için, bağlantı yüzeyi çok düz değilse bile, yönetici parçacıklar tarafından üretilen basınç farkını yönetici parçacıkların elastik gücü tarafından yükselebilir. Ancak, ACF'nin yönetici parçacıklar yüzünden kısa devre sorunları var, ve çok küçük bir çizgi genişliğin sonuçları, temaslarda yakalanabilen çok az yönetici parçacıklar olabilir ve 17 milyon a şağıdaki çizgi genişliğinle IC bağlantılarını çözemez. ACF bağlantısının elektrik güveniliği eutektik süreci kadar iyi değil. Sonraki yeniden çözümleme sürecinde, sıcak stres yüzünden de değiştirilebilir, elektrik hareketi düşürüyor ya da a çık devre bile olabilir. Ancak ACF bağlama sürecindeki farklı parametreler (sıkıştırma sıcaklığı, basınç, zamanı, ısıma hızı, etc.) masterlendirildiği sürece, ACF güveniliği gerekçelerini tamamen uygulayabilir. Ayrıca, ACF sürecinin sıcaklığı düşük bastırma sıcaklığı (200°C altında), basit işleme, yüksek yiyecek ve çevre koruması vardır. COG ve COF'nin ana bağlantı metodu oldu. Aynı zamanda, ACF da fleksibil substratları ve cam panellerini bağlamak için en önemli yoldur.
4.3 İdare etmeyen adhesive (NCA) bağlantı süreci
NCA bağlama metodu genellikle çip ve elektroda arasındaki direk bağlantıya bağlı oluyor. Elektrik yönetimi sağlamak ve küçülmek için altratın her iki tarafında elektrik yönetimi sağlamak için, NCA amacı elektroda kırılmak ve düşürmek ile elektroda bağlantısını tamamlamak ve resin mekanik özelliklerini kullanmak ve elektroda arasındaki bağlantı ve yönetimi korumak için. Zayıf gücünün ihtiyacı vardı. NCA materyalinin rolü, çarpışmaların ve aparatı devreğin doğru noktaları arasında bağlantı gücünü sağlamak ve bağlantıları korumak ve güveniliğini korumak. Bu yüzden materyal, iyi mekanik ve fiziksel özellikleri olmalı: yüksek Tg, yüksek elastik modüller, yüksek azaltma ve düşük sıcak genişleme koefitörü, iyi ıslama etkisi, mitrenli özellikleri, adhesive özellikleri ve etkisi dirençliği dahil. yüksek sıcaklığında kısa zamanda tedavi edilebilir (20saniye, 150 ~ 250 °C derece Celsius); Mükemmel elektrik izolasyon özellikleri var. NCA süreci ACF süreciyle uyumlu, sadece bir yerleştirme ekipmanının önünde elektro-adhesiv birimi ekle. NCA sürecinde, böcekler ve ilaç devreler doğrudan mekanik bağlantıda ve taraf kısa devrelerin muhtemelesi çok küçük. Bu yüzden NCA, eutectic ve ACF süreçlerinin sınırlarından daha küçük olan IC bağlantıları (17μm veya daha az) idare edebilir. Ancak NCA, ACF'den daha yüksek materyaller için ihtiyaçları var. Örneğin, çip patlama yüksekliğinin düzlüklüğü iyi olmalı, altı yüzeyi çok düz olmalı, temel materyal daha yüksek ölçümsel stabillik olmalı ve bağlantı çizgileri oksid katlarının oluşturmasından kaçırmak için altından elektroplanmış olmalı. NCA'nin bağlantısının güveniliği henüz incelenmesi gerekiyor. Bu faktörler NCA kullanımını kısıtlıyor ve geçici olarak genel bir süreç olamayacak.
6 Sonuç
Yüksek yoğunluk paketleme teknolojisinin geliştirilmesiyle, COG ve COF teknolojileri çeşitli düz panel gösterilerinde ve kişisel mobil ürünlerinde geniş kullanılmış. COG ve COF teknolojileri, yüksek yoğunluğu, çoklu I/O gibi birçok avantajlarına sebep olan LCD sürücü IC'nin ana paketleme formu oldular ve genellikle sürücü uyuşturucu paketleme kullanarak kullanılıyorlar. COF çok söz verici bir paketleme teknolojisi. Fleksibil devre üretim teknolojisinin gelişmesi yüzünden, sıkıştırma gücü yüksek, pasif komponentler eklenilebilir, uzaklaştırılmış ipleri yapmaya gerek yok ve panel alanı kullanma hızı yüksek. ACF arayüz bağlantı teknolojiyle birlikte yüksek yoğunluk paketleme alanına uzatıldı. Şu anda en yüksek paketleme yoğunluğuyla birlikte COF teknolojisi paketleme formu oldu.