Vaferlerden birer birimleri kesmek ve sonra paketlemek için on yıllardır yarı yönetici devreleri paketlemek için norm oldu. Ancak bu yaklaşım bugünkü modüllerin yüksek üretim maliyeti ve arttığı RF komponenti yüzünden büyük yarı yönetici üreticileri tarafından kabul edilmiyor. Böylece, vafer seviyesi paketleme (WLP) durumu düşük maliyetli paketleme geliştirmesinde paradigm değişikliğine yol a çtı. WLP, wafer paketleme aygıtlarını kesmeden önce vafer seviyesi paketleme teknolojisi.
Standart araçlar ve işlemler kullanarak WLP wafer üretim sürecinin uzantısı olarak çalışıyor. Sonunda, üretilen WLP DIE'nin çipinin yüzeyinde metal yapılmış bir parçası olacak. Büyük parçayı kesmeden önce her parçaya yerleştirilmiş bir sol nokta olacak. Bu şekilde, WLP'i geleneksel PCB toplantı süreçleriyle uyumlu yapar ve aygıtlar kendisinin wafer testine izin verir. Sonuç olarak, bu relatively düşük maliyetli ve etkili bir süreç, özellikle vafer ölçüsü arttıkça ve çip DIE küçülüyor. Son birkaç on yıl boyunca, 4, 6 ve 8 in ç diameterde 12 inç yükseliyor. Bunun sonuçları, üretim maliyetlerini azaltmak üzere bir wafer için DIE sayısını arttırır. Elektrik performansı konusunda, WLP diğer paketleme teknolojilerinin üstündür. Bu anlamda, WLP aygıtı yoğun RF modülüne birleştirildiğinde, EM parazitik bağlantısının önemli bir azaltmasına sebep olur çünkü aygıt ve PCB arasındaki bağlantı relativ kısa, bazı tür CSP teknolojilerinde kullanılan kablo bağlantısının aksine.
WLP chip flip-chip teknolojisi
Dönüştürülen Çift Bağlantısı (C4) olarak bilinen Flip-chip teknolojisi 1960'larda IBM tarafından geliştirilen birkaç çip toplantısı teknolojisinden biridir. Hardware in şa edildiğinden sonra tel bağlantısı tabanlı paketleme teknolojisi özgür etkileyici hata kaynağı için özgür etkileyici yeteneklere göre daha fleksib olsa da, ve aynı zamanda güzel sıcak süreci sağlıyor, dönüş-çip paketleme teknolojisindeki sol bulmalarının kullanımı paket altyapısı ve çip arasındaki elektrik bağlantısı, sayısal ölçü azaltması, azaltması, İçeri ve çıkış çizgileriyle daha iyi izolasyon. 1. çizim, çip DIE'nin temel yapısını, çip yüzeyinde büyüyen Cu sütunun üstündeki solder topu ile gösteriyor. Solder toplantısı genelde solder toplantısı için mekanik destek sağlamak için dolduran bir toplantıyla kapsullanır.
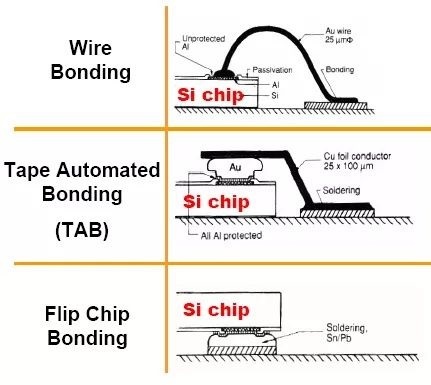
WLP çip seviye paketi
Chip skalası paketleme (CSP) mikro elektronik ve yarı yönetici endüstrisinde en sık kullanılan paketleme metodlarından biridir. Mikroçip üreticileri için birkaç tür CSP teknolojisi artık kullanılmış olsa da, yeni türler yeni özellikleri ve yeni uygulama özellikleri destekleyen ürünlerin talebini yerine getirmeye devam ediyor. Bu paketleme ihtiyaçları güvenilir, maliyeti, ekleme özellikleri ve bütün boyutlarına bağlı olabilir. Adın anlamına gelince, CSP'nin paket büyüklüğü neredeyse aynı çip DIE büyüklüğüne benziyor. Bu da onun ana avantajlarından biridir. WLP üretim sürecini kabul ederek, en küçük mümkün paket ölümü ölümü oranına ulaşmak için CSP sürekli geliştiriliyor. Şekil 2'de gösterildiği gibi, paketteki CSP'nin topu ağırlığı (BGA) tarzı PCB sürücüsünü kolaylaştırmak, PCB toplantısını arttırmak ve üretim maliyetlerini azaltmak için birkaç bağlantı sağlayabilir.
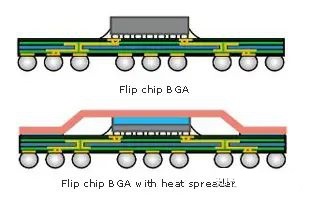
Diğer kapsamülasyon teknolojileri
Uygulama özellendirilmiş modül paketlerine güvensiz integrasyon sağlayan diğer integral IC paketlerinin farklı formları var. Quad Flat Paket (QFP) 3(a) görüntüsünde gösterilen en eski yüzeydeki IC paket teknolojilerinden biridir. Yükselmiş ipleri, metal-insulator-metal (MIM) türü kapasitörü ile eşleşen bir elemente olarak kullanılabilir olan çip DIE metali arasında paket çerçevesine bağlanılır. Bu teknik, paketteki periferal pinlerin sayısı 100 pinden fazla ulaşabileceği milimetre boyutlu IC için uygun. Bu tür encapsulasyonun birkaç türü türü türü kullanılan materyallere bağlı, ceramik kvad düz paketi, ince quad düz paketi, plastik kvad düz paketi, Plastik Quad Flat paketi ve Metal Quad Flat paketi (MQFP). QFN, Quad Flat No Lead, Fig. 3(b) tarafından gösterilen bir kaç yüzeysel yüklü paketleme teknolojisinden biridir, ve radyatör için sıcak aktarma paketi olarak kullanılan bir plastik paketi. Kablo bağlantısı da bağlantılar için kullanılabilir ve bağlantı çizgileri sadece yöneticiler değil, aynı zamanda induktorlar, genelde bu kapsulasyon tekniğinin altında aygıtların performansını etkileyebilirler, genel tasarımın bir parças ı olarak kabul edilmezse. QFN dört tarafından oluşan bir bağlantı olsa da, iki uçak bağlı ipucu (DFN) aynı zamanda ortaya çıktı ve ikisinin de bağlantı uçağın iletişimi oluşturdu.
