3D IC Paketlerinin prensipi ve uygulaması
2.5D ortalama katı bir yapılandırıcıdır, içinde tüp kabloları bir silikon, cam veya organik ortalama katı tarafından bir silikon delikten (TSV) kullanarak ortalama katı üzerinde yerleştiriler. (Bardak veya organik laminatlar orta katı için substrat olarak kullanıldığında, camdan deliklerden (TGV) çağırılır ve deliklerden (TSV) yerleştirirler. Orta katta üretilen devre arasındaki iletişim yapılır.
CMOS görüntü sensörleri (CIS) arası bağlantılar oluşturmak için TSV arka taraf delikleri olarak, ön anahtar birleşmelerini yok etmek için büyüklüğü ve yoğunluğu azaltmak için sağlayacak. Bütün tür 3B paketlerde, paketlerindeki çipler normal devre masasında ayrı bir pakete bağlanmış gibi iletişim kuramak için off-chip sinyalleri kullanır.
Üç boyutlu IC'nin 3D stacked IC'e bölünebilir. Yani IC çipi TSV ile bağlantılı ve bağlantılı olduğu anlamına gelir. Ve gerçek 3D ics, FAB sürecini birkaç aygıt katını tek çip üzerinde yerleştirmek için kullanıyor, bağlantılar oluşturmak için veya çok iyi yer alan TSVS kullanmıyor olabilir.
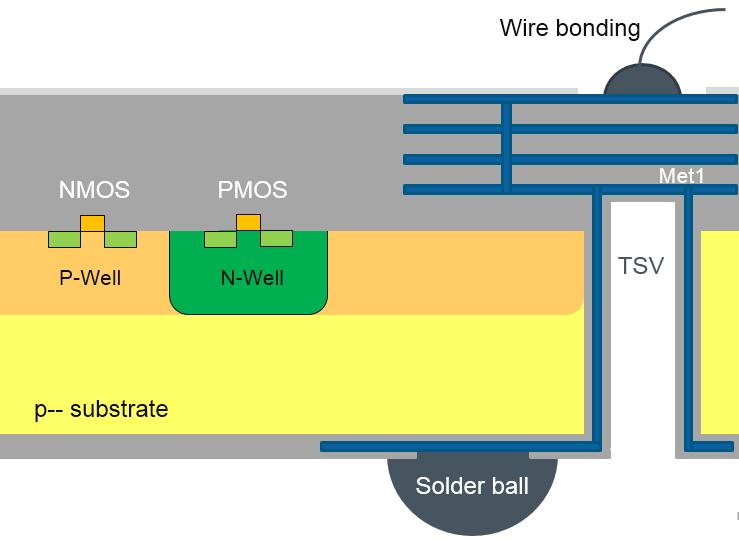
Silikon deliklerden (TSV) bir etkileme sürecini kullanarak silikon waferlerde oluşturulmuş deliklerdir. TSV'yi bakra, tungsten veya polisilikon gibi davranıcı bir materyalle doldurarak bağlantı oluşturulmuş. TSV bağlantılarının en önemli avantajı, sinyaller bir çip'den gelecek ya da bir devre katından sonrakine kadar yolu kısaltmak. Bu gücü azaltmak ve bağlantı yoğunluğunu arttırma yeteneğini sağlar, böylece fonksiyonu ve performansını geliştirir. TSV kendisi 3D IC değil. Bunun yerine, bunlar 3D mikrofonları etkinleştirmek için temel. Görüntü sensörleri, mikroelektromekanik sistemleri (MEMS) ve birleşmiş yarı yöneticileri gibi diğer cihazlarda da kullanılır.
Monolitik 3D IC'nin anlamı nedir?
Üç boyutlu IC oluşturmak için waferler veya modüller toplamak yerine, geleneksel FAB aygıtları kullanarak kristalin silikon, metal katları ve aktif ve pasif devreler gibi eklenmiş bir monolitik 3D IC'nin temel wafer ile başlatılır. Dikey bağlantılar mikro menzili yerine nanometredeki deliklerden kullanarak çipler arasında katlar arasında oluşturulmuş; . TSV gibi. Birçok farklı yaklaşım geliştiriliyor, özellikle hafıza uygulamaları için. Integral 3D bazen sıradan 3D denilir.
3B hafıza nedir?
Bir sürü metodlar hafıza perpendikül olarak iki volatile (NAND flash) ve volatile (DRAM) hafıza aygıtlarına yerleştirildi. DRAM metodları yüksek bandwidth hafıza (HBM), Micron'ın karışık hafıza küpü ve Tezzaron'ın integral RAM (DiRAM) içeriyor. Bütün bunlar TSV kullanarak 3D IC tabanlı (3. figür). Samsung, Toshiba ve diğer çoğu 3 boyutlu 3D yaklaşımlarına dayanan 3D NAND flaş geliştiriyor.
2,5D giriş teknolojisinin faydası nedir?
Üç boyutlu teknoloji için köprü teknoloji olarak geliştirilmiş, 2.5D teknolojisi 3D miktarlarla birlikte bulunacak bir paketleme platform ına büyüdü. 3D-IC'nin aksine, sadece ortalama katı (kendi çekirdek değil) paket altyapısına aktif çekirdeği bağlaması için TSV'e ihtiyacı var. Bu, mevcut mold tasarımlarının kullanımına izin verir.
Üç boyutlu integrasyonun ana teknik sürücüleri nedir?
Bu lithografik adımının arttığı maliyeti ve teknoloji işlemlerinin genellikle sonraki nesil çiplerin düğümünde endüstri elektronik aygıtlarımızın performansını ve işlemlerini geliştirmek ve masraflarını azaltmak için alternatif aramalarını sürüyor. Ayrıca, çeşitli teknolojileri (lojik, hafıza, RF, sensörler, etc.) ile küçük boyutlarda birleştirme ihtiyacı, sanayi 3D integrasyonu çözüm olarak kabul etmek için kullanıyor.
Üç boyutlu integrasyon için pazar sürücüleri nedir?
Üç boyutlu integrasyon (3D integrasyon) pazar sürücü yüksek sonlu bilgisayarlar, sunucular ve veri merkezleri, askeri ve aerospace ve tıbbi ekipmanlar ile başlar, çünkü onlar en büyük talep ediyorlar ve şu anda 3D integrasyon teknolojilerinin maliyetini alabilirler. Tabletler, smartphones ve oyun aygıtları da teknolojiyi kullanıyor.
3D ics'in karşısında ne zorluklar var?
Birçok kişi, kalan teknik zorunların olmadığını ve kalan sorunların kolayca çözülebileceğini iddia ediyor, bazı süreç adımları hala planlama, uygulama ve 3D miktarlarını doğrulama için daha iyi çözümler gerekiyor. Ana sorunlar, ekosistemin büyümesi yüzünden ağımdaki birim maliyetleri, düşük miktarları ve uygulama riskleri. İşlemin maliyetini azaltmak ve endüstri boyunca işbirliği kolaylaştırmak için çabalar yapılıyor. Arttırılmış üretim maliyetleri azaltmaya yardım edecek. Ancak, birçok 3B uzmanları, 3B makinelerin uygulaması sistem maliyetlerini büyük düşüreceğine inanıyor ve kalan zorluk sistem seviyesi mühendislerini sistemlerinde 3B makinelerin tasarlamasının faydaları hakkında öğretmek.
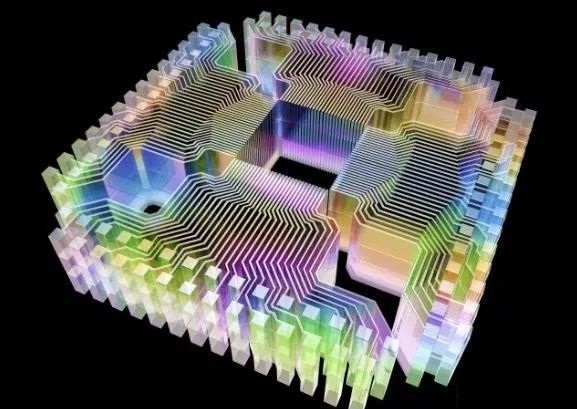
CMOS görüntü sensörü (CIS) büyük miktarlarda delikten geri döndürülecek ilk cihazlardan biridir. Arka taraf ışık (BSI) ile CIS şimdi üretimde ve CIS IC'nin üstünde yerleştirildiğinden dolayı 3D IC aygıtı (Figure 2). Xilinx, 2011 yılında Virtex-7 serisinin tüm programlayabilen FPgas için 2.5D eklenti tasarımı tanıttı. Son birkaç yıl içinde Tezzaron küçük DiRAM miktarını teslim etti.
2014 yılın sonunda, Micron ve Samsung, logik cihazların üstünde 3D DRAM stackları olan hibrid depolama Kupleri (HMCS) üretimi başlatacak. SK Hynix hem HMC hem de HIGH bandwidth hafızasını sağlayacak. Bu 3B integral depo aygıtlarının toplam üretimi 2014/15'de yapıldı ve bundan sonra birkaç yıl sonra mantıklı stack ve heterogenel aygıtları kullanmaya devam etti.
iPCB bütün bilgileri seninle paylaşır!