Nama penuh BGA adalah "Pangkalan Grid Bola", yang bermakna PCB dengan struktur tata grid bola. Ia adalah kaedah pakej untuk sirkuit terpasang menggunakan pembawa organik. Papan PCB dengan BGA biasanya mempunyai lubang kecil, dan BGA lebih rendah melalui lubang biasanya direka sebagai lubang selesai dengan diameter 8-12 juta. BGA yang lebih rendah melalui lubang perlu dipalam, pad askar tidak dibenarkan untuk dicat, dan pad askar tidak dibuang.
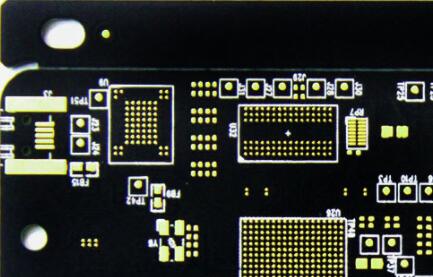
BGA adalah jenis komponen yang menggunakan kaedah pakej tatasusunan bola tentera. Ia menghasilkan bola tentera di bawah substrat pakej sebagai antaramuka papan sirkuit, yang disambung dengan papan sirkuit. Komponen BGA sesuai untuk komponen lekap permukaan, dengan bilangan besar pin dalam sirkuit, ketepatan pakej yang lebih tinggi, fungsi yang lebih kuat, dan kepercayaan yang lebih tinggi. CPU BGA terutamanya digunakan pada laptop.
Peraturan umum untuk desain pad BGA
1) Diameter pad tentera biasanya lebih kecil daripada diameter bola tentera. Untuk mendapat penyekapan yang boleh dipercayai, ia secara umum dikurangi dengan 20% -25%. Semakin besar pad tentera, semakin kecil ruang kawat antara dua pad.
2) Pad pada substrat BGA mempunyai diameter yang sama dengan pad pada PCB.
3) Design pad solder BGA patut memastikan pembukaan templat menyebabkan lekasan paste solder ⥠0.08mm3, yang merupakan keperluan minimum untuk memastikan kepercayaan kongsi solder.
Prinsip Proses Pakej BGA
Aliran proses utama pakej BGA termasuk produksi bola solder, produksi substrat, ikatan cip, penyesalan pakej, dan pemotongan pakej.
1) Produksi bola tentera: Menggunakan liga tin-lead yang bersih tinggi atau bahan-bahan bebas lead untuk menghasilkan bola tentera, membentuk array pin sferik biasa.
2) Produsi substrat: Menggunakan papan sirkuit cetak berbilang lapisan sebagai substrat untuk mencapai ketepatan elektrik yang tinggi dan prestasi tinggi.
3) Pengikatan Chip: Pasang cip ke substrat dan sambungkannya ke substrat menggunakan solder bebas lead atau berdasarkan lead.
4) Pengimbangan dan penyembuhan: Cip ini dikumpulkan dengan resin epoksi untuk melindunginya dari pengaruh persekitaran.
5) Bahagi pakej: Potong cip pakej ke pakej BGA terpisah.
Teknik Pakej BGA
1. Ralat pad: Untuk memastikan kualiti penyeludupan dan kepercayaan, rekaan pad mesti mengikut arahan tertentu. Pertama, perlu pastikan saiz pad askar sepadan dengan bola askar. Kedua, pengaruh bentuk pad dan layout pada pengembangan panas dan kontraksi perlu dipertimbangkan. Akhirnya, perhatian juga perlu diberikan kepada rawatan permukaan pad solder untuk meningkatkan kepercayaan penywelding.
2. Proses penyelesaian: penyelesaian BGA biasanya menggunakan teknologi penyelesaian reflow. Untuk memastikan kualiti penywelding, perlu mengawal suhu penywelding, masa, dan lengkung suhu forn. Selain itu, perhatian juga perlu diberikan kepada tekanan panas pada saat penywelding untuk menghindari cacat penywelding.
3. Pemeriksaan kualiti: Selepas pakej BGA dan penyelamatan, pemeriksaan kualiti diperlukan untuk memastikan kepercayaan sambungan. Kaedah pengesan yang biasa digunakan termasuk ujian sinar-X, ujian emisi akustik, dll. pemeriksaan sinar-X boleh mengamati secara visual struktur dalaman titik penyelut dan mengesan cacat penyelutan. Ujian emisi akustik menentukan kualiti penywelding dengan menganalisis isyarat akustik.
4. Pembaikan dan penyelamatan: Untuk pakej BGA dengan penyelamatan yang tidak baik, peralatan pembaikan istimewa boleh digunakan untuk penyelamatan semula. Biasanya, proses perbaikan termasuk langkah seperti pembersihan pad, penggantian bola tentera, dan penyekatan semula cip. Semasa proses perbaikan, perlu mengawal suhu pemanasan dan masa untuk menghindari kerosakan pada cip.
5. Rancangan dan Bentangan: Dalam rancangan sirkuit, bentangan dan kabel pakej BGA adalah penting. Faktor seperti prestasi elektrik, prestasi panas, dan kekuatan mekanik patut dipertimbangkan sepenuhnya. Semasa proses bentangan, perhatian patut diberikan kepada isu seperti integriti isyarat, kestabilan kuasa, dan pengurusan panas untuk mencapai sistem elektronik prestasi tinggi.
Keuntungan dan kelemahan pakej BGA
Keuntungan:
1) Densitas tinggi: pakej BGA mempunyai ruang pin yang lebih besar, yang boleh mencapai bilangan pin I/O yang lebih tinggi dan memenuhi keperluan sirkuit integrasi prestasi tinggi.
2) Performasi penghantaran isyarat yang hebat: Kerana laluan sambungan pendek bola askar, pakej BGA mempunyai induksi dan kapasitas parasit yang lebih rendah, yang menyebabkan penghantaran isyarat kelajuan tinggi.
3) Performasi panas yang baik: Bola tentera terkumpul BGA boleh mengendalikan panas secara efektif, membantu mengurangi suhu operasi cip.
Kegagalan:
Proses produksi permintaan tinggi: pakej BGA mempunyai keperluan tinggi untuk proses dan peralatan penywelding, yang meningkatkan biaya produksi.
Pakej BGA ialah teknologi peluncuran permukaan yang berkarateristikan oleh bentuk array pin sferik biasa di bawah pakej. Kaedah pakej ini mempunyai keuntungan seperti ruang pin besar, prestasi panas yang baik, dan prestasi penghantaran isyarat yang lebih tinggi, membuat ia digunakan secara luas dalam sirkuit integrasi kelajuan tinggi dan prestasi tinggi.