Gagal reka pad BGA dan peraturan asas
Struktur pakej peranti BGA boleh dibahagi ke dua jenis mengikut bentuk kongsi askar: kongsi askar sferik dan kongsi askar silindrik. Teknologi pembekalan BGA menggunakan kongsi solder bulat atau silindrik yang tersembunyi di bawah pakej, yang dikatakan oleh jarak lead besar dan panjang lead pendek.
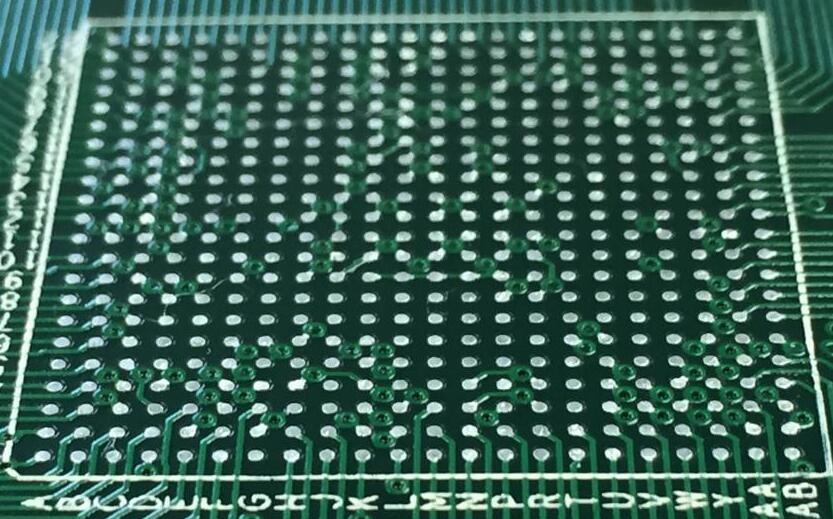
Titik BGA
Ralat pad BGA
Menurut statistik, dalam teknologi lemparan permukaan, 70% cacat penywelding disebabkan oleh sebab rancangan. BGA: Teknologi pemasangan roll bukanlah pengecualian. Dengan miniaturisasi diameter bola solder cip BGA kepada 0.5 mm, 0.45 mm dan 0.30 mm, saiz dan bentuk pad pada papan cetak secara langsung berkaitan dengan sambungan yang boleh dipercayai antara cip BGA dan papan cetak, dan kesan desain pad pada kualiti penyelesaian bola solder juga bertambah secara perlahan-lahan. Cip BGA yang sama (diameter bola 0,5 mm, ruang 0,8 mm) diseweldi pada pads papan cetak dengan diameter 0,4 mm dan 0,3 mm berdasarkan proses penyweldi yang sama. Keputusan pemeriksaan menunjukkan bahawa proporsi tentera palsu BGA dalam yang terakhir adalah setinggi 8%. Oleh itu, desain pad BGA secara langsung berkaitan dengan kualiti penywelding BGA. Ralat pad BGA piawai adalah sebagai berikut:
A. Desain menentang Solder
Raka bentuk 1: lapisan penentang tentera mengelilingi pad foil tembaga dan meninggalkan ruang kosong; Semua petunjuk dan botol di antara pads akan ditempatkan.
Bentuk reka 2: lapisan menentang tentera berada pada pad, dan diameter foil tembaga pad lebih besar daripada saiz pembukaan yang menentang tentera.
Dalam rancangan dua lapisan penentang askar ini, bentuk rancangan pertama biasanya dipilih. Keuntungannya ialah diameter foil tembaga lebih mudah untuk dikawal daripada saiz penentang askar, konsentrasi tekanan kongsi Solder BGA adalah kecil, dan kongsi askar mempunyai penyelesaian ruang yang cukup, yang meningkatkan kepercayaan kongsi askar.
Grafik dan dimensi desain B. Pad
Pad dan melalui BGA disambung dengan wayar dicetak, dan melalui tidak disambung secara langsung dengan pad atau terbuka secara langsung pada pad.

Rancangan BGA
Peraturan umum untuk desain pad BGA:
(1) Diameter Pad tidak hanya boleh mempengaruhi kepercayaan kongsi solder, tetapi juga mempengaruhi kabel komponen. Diameter pad biasanya lebih kecil daripada diameter bola. Untuk mendapatkan pegangan yang boleh dipercayai,
Secara umum dikurangi dengan 20% - 25%. Semakin besar pad, semakin kecil ruang kawat antara dua pads. Contohnya, pakej BGA dengan jarak 1.27 mm mengadopsi pad dengan diameter 0.63 mm. Dua wayar boleh diatur diantara pad, dengan lebar baris 125 mikron. Jika diameter pad 0.8 mm digunakan, hanya satu wayar dengan lebar garis 125 mikron boleh dilewati.
(2) Formula berikut memberikan pengiraan bilangan kabel antara dua pads, di mana p ialah ruang pakej, D ialah diameter pad, n ialah bilangan kabel dan X ialah lebar garis. P-D â¥(2n+1)x
(3) Peraturan umum adalah bahawa diameter pad pada substrat PBGA adalah sama seperti pada PCB.
(4) Design pad CBGA akan memastikan bahawa pembukaan templat membuat solder melekat lekas ⥠0.08mm3. Ini adalah keperluan minimum untuk memastikan kepercayaan kumpulan askar. Oleh itu, pad CBGA lebih besar daripada pad PBGA