Manuskrip ini memperkenalkan teknologi pakej COG (cip pada kaca) dan COF (cip pada flex). Dengan pengembangan teknologi pakej densiti tinggi, teknologi COG dan COF telah digunakan secara luas dalam pelbagai paparan panel rata dan produk bimbit peribadi. Teknologi COG dan COF telah menjadi teknologi pakej utama yang digunakan dalam penghasilan LCD kerana densiti tinggi mereka, I/O berbilang, dan terutama menggunakan pakej lengkap konduktif.
[Kata-kata kunci] COG, COF, anisotropik konduktif lengkap, pakej LCD
1 Kata Sebelumnya
Popularisasi produk elektronik bimbit dan paparan skrin besar telah mempromosikan pembangunan cepat teknologi produksi elektronik yang bernilai rendah, densiti tinggi dan densiti tinggi. Produk elektronik saiz besar seperti pemantau LCD, TV LCD, TV plasma, produk elektronik saiz kecil dan tengah seperti telefon bimbit, kamera digital, kamera video digital, dan produk 3C lainnya semua menuju ke kecerahan, kurus dan pendek. Ini memerlukan ketepatan tinggi dan saiz kecil. Generasi baru teknologi pakej yang boleh dipasang secara bebas untuk memenuhi keperluan di atas. Dalam konteks ini, teknologi COG dan COF telah berkembang dengan cepat, menjadi bentuk pakej utama ICs pemacu untuk paparan panel rata seperti LCD dan PDP, dan kemudian menjadi bahagian penting modul paparan ini. Pada masa yang sama, dengan teknologi pakej lembaran konduktif anisotropik, medan aplikasinya berkembang dengan cepat, dan telah dilaksanakan dalam RFID, peralatan elektronik perubatan, produk elektronik peribadi bergerak dan produk elektronik mikro lain.
2 Struktur COG dan COF
Nama penuh COG adalah cip pada kaca, dan dalam bahasa Cina ia dipanggil cip pada teknologi kaca. Ia secara langsung mengincapsulkan IC pada kaca melalui lembaran konduktif anisotropik (ACF), dan menyedari sambungan dan mengincapsulkan bump konduktif IC dan pads konduktif lutsinar ITO pada kaca. Nama penuh COF adalah cip pada flex atau cip pada filem, yang merupakan teknologi cip pada substrat fleksibel dalam bahasa Cina, dan ia juga menjadi teknologi pemasangan filem lembut. Sama seperti teknologi COG, cip IC dikemas secara langsung pada papan sirkuit cetak fleksibel untuk mencapai tujuan densiti pakej tinggi, pengurangan berat badan, pengurangan volum, dan kebebasan untuk membengkung dan memasang.
Jika IC, substrat fleksibel, panel kaca, PCB, dan komponen pasif lain (kondensator, resistor, dll.) disambung dengan cara yang sesuai (seperti IC yang disambung secara langsung ke panel kaca melalui ACF, atau substrat fleksibel dan IC dan panel kaca menggunakan ACF) Untuk sambungan, substrat fleksibel dan komponen pasif boleh disambung dengan penyeludupan kembali tradisional, - dan substrat fleksibel dan PCB boleh disambungkan dengan soldering tradisional atau plugging) untuk membentuk modul paparan dengan pakej COG atau COF.
Pengepasan COG dan COF terutama menggunakan lembaran konduktif anisotropik untuk menyadari sambungan antara IC dan substrat kaca atau substrat fleksibel, dan IC terutama mengadopsi struktur cip flip. Teknologi bumping flip-chip dan teknologi bumping pada substrat akan dikenalpasti secara khusus kepada pembaca dalam artikel khusus masa depan. Kebanyakan berikut memperkenalkan teknologi proses pengeluaran fleksibel asas dan proses sambungan ACF.
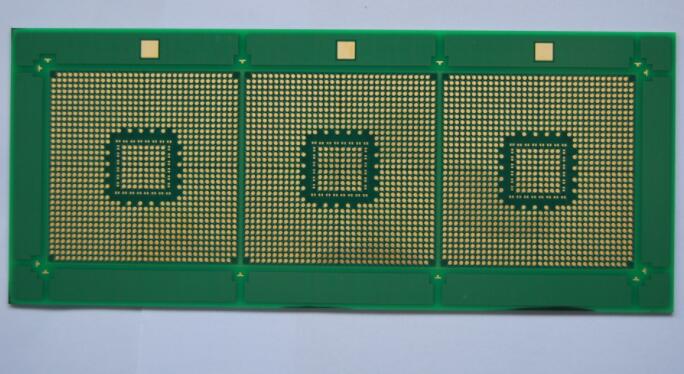
3 Produsi sirkuit halus pada substrat fleksibel
Sebagaimana ketepatan paparan meningkat, cip pemacu I/O diperlukan untuk meningkat jauh, dan pitch antara pads pemimpin telah lebih rendah dari 30μm. Oleh itu, keperluan untuk corak sirkuit halus substrat fleksibel juga meningkat, dan ruang pad sambungan telah meningkat. Ia telah mencapai 15μm dan terus menurun. Oleh itu, teknologi penghasilan papan sirkuit fleksibel telah menjadi fokus penyelidikan. Pada masa ini, produksi sirkuit halus pada substrat fleksibel terutama termasuk kaedah tolak, semi-aditif dan aditif.
3.1 Kaedah laye r subtraktif
Kaedah lapisan tolak adalah kaedah utama produksi FPC tradisional. Ia adalah untuk melekat lapisan filem kering resisten fotosensitif atau meliputi lapisan fotosensitif cair resisten pada FCCL, dan kemudian melalui eksposisi, pembangunan, etching, stripping, dan akhirnya membentuk corak sirkuit yang diperlukan. Pitch lebar baris yang boleh dicapai dengan kaedah tolak berkaitan dengan resolusi lapisan tahan fotosensitif. Resolusi lapisan tahan fotosensitif ditentukan oleh tebal lapisan tahan. Lebih tipis tebal, corak sirkuit lebih baik boleh terbentuk pada lapisan tahan fotosensitif. Ini kerana cahaya akan menyebar apabila melewati lapisan perlawanan. Semakin tebal lapisan menentang, semakin besar darjah penyebaran dan semakin besar ralat garis terbentuk. Untuk membuat lebar garis di bawah 50 μm, tebal filem kering mesti berada di bawah 20 μm, tetapi ia sangat sukar untuk menghasilkan filem kering yang terlalu tipis, jadi orang lebih bersedia untuk menggunakan proses filem basah yang lebih tipis daripada filem kering dan boleh dikawal sendiri. Syarikat pun boleh menggunakan roller untuk menutup photoresist cair untuk menghasilkan filem basah 5 μm. Tapi filem basah terlalu tipis pasti akan mempunyai cacat seperti lubang pinhole, gelembung, goresan, dan keseluruhannya tidak sebaik filem kering, jadi ia tidak boleh menggantikan filem kering dalam jangka pendek. Sebab sebab di atas, ditambah dengan fenomena pencetakan sisi yang tidak dapat dihindari semasa pencetakan, lebar garis had kaedah tolak adalah 20μm. Jika and a mahu mendapatkan sirkuit yang lebih tipis, anda mesti bekerjasama dengan folio tembaga yang lebih tipis 9μm, 5μm atau bahkan 3μm, supaya pendek masa pencetakan sebanyak yang mungkin, mengurangkan kerosakan sisi, dan mendapatkan garis-garis halus. Namun, foli tembaga tebal ini dan proses berkaitan Semua masih dalam tahap percubaan dan tidak boleh dihasilkan-mass a.3.2 Kaedah lapisan setengah-aditif · Jika anda mahu membuat sirkuit yang lebih baik, anda boleh pertimbangkan menggunakan kaedah lapisan setengah-aditif. IniThe base material of the semi-additive method is mostly 5μm thin copper foil, and sometimes the conventional copper foil can be used after being thinned by etching [9]. Dalam kaedah ini, penyebaran cahaya tidak mempunyai kesan negatif pada corak sirkuit, dan lapisan tahan yang lebih tebal boleh digunakan untuk membuat sirkuit di bawah 20μm.3.3 Kaedah lapisan tambahan · Kaedah penambahan lapisan adalah kaedah yang m an a substrat pengisihan secara langsung diproses untuk membentuk corak sirkuit. Alasan untuk menyemprotkan lapisan tipis Cr diantara PI dan lapisan tembaga berikutnya adalah untuk meningkatkan kekuatan ikatan diantara PI dan lapisan tembaga dan mencegah lapisan tembaga berikutnya daripada melepas. Kaedah ini boleh menghasilkan sirkuit terbaik yang sekarang tersedia, dengan jarak garis sehingga 3μm. Keuntungan lain dari kaedah ini ialah bahawa filem kering photosensitif tebal boleh digunakan untuk meningkatkan tebal sirkuit, seperti nisbah tebal-lebar 8 kali, yang boleh menekan meningkatkan resistensi DC (R) apabila sirkuit diterapkan. Namun, kaedah ini memerlukan penggunaan peralatan untuk pembuatan setengah konduktor, dan proses ini rumit dan biaya adalah relatif tinggi.4 Teknologi sambungan antara cip dan substrat
Pada masa ini, teknologi sambungan substrat fleksibel dan ICs terutamanya termasuk sambungan eutek Au-Sn, sambungan konduktif anisotropik, dan sambungan lipat bukan konduktif.
4. 1 Proses sambungan euteks Gold- tin
Proses ini menggunakan bumps emas pada cip IC dan dalaman FPC lapisan tin membawa kepada bentuk eutek emas-tin pada permukaan kenalan melalui pemanasan dan tekanan untuk mencapai tujuan sambungan. Suhu penyelamatan kaedah ini mesti berada di atas suhu formasi Eutetik emas-tin (325-330°C), yang merupakan ujian yang berat untuk resistensi panas substrat. Selain itu, suhu penywelding yang tepat adalah sukar untuk ditangkap. Apabila suhu bahagian sambungan relatif rendah, bentuk euteks bagi pemimpin dalaman tidak cukup, menghasilkan sirkuit terbuka bagi pemimpin dalaman. Bagaimanapun, apabila suhu bahagian sambungan terlalu tinggi, alat penywelding akan meningkat dan meninggalkan sementara eutek emas-tin masih dalam keadaan cair, yang akan mudah menyebabkan kejadian sirkuit terbuka lead dalaman. Selain itu, apabila suhu rendah dan tongkat tin pada peti dalamnya lebih tebal, tongkat itu tidak akan diserap oleh emas (tiada bentuk eutek), yang akan menyebabkan sirkuit pendek dan bocor. Ia sangat penting untuk memilih suhu yang sesuai, dan sekarang suhu 400 darjah Celsius lebih sering digunakan.
Untuk memenuhi keperluan ikatan pitch yang lebih sempit, orang juga telah menyelidiki dan mengembangkan proses ikatan pemampatan panas emas kepada kenalan emas, menggunakan mekanisme penyebaran logam untuk membentuk ikatan logam setempat. Namun, kerana titik cair emas cukup tinggi, untuk membentuk penyebaran, ikatan emas-emas memerlukan suhu ikatan yang lebih tinggi dan masa ikatan yang lebih lama daripada ikatan emas-tin. Pada masa ini, deformasi substrat mungkin sangat serius. Namun, penggunaan teknologi penyeludupan yang membantu ultrasonik dan teknologi pembersihan permukaan plasma boleh mengurangi suhu yang diperlukan untuk penyeludupan. Industri secara umum percaya bahawa proses eutektik boleh memenuhi ruang garis lebih daripada 20um sambungan, jika tidak sirkuit pendek cenderung berlaku.
4.2 Proses sambungan filem konduktif anisotropik (ACF)
Material ACF menyebarkan partikel logam halus atau bola plastik berwarna logam dalam bahan resin, dan wujud dalam bentuk filem dalam keadaan tahap B. Selepas ikatan ACF antara bumps IC dan sirkuit pada substrat, gunakan tekanan, suhu dan masa yang sesuai untuk membuat aliran resin dan partikel konduktif menghubungi bumps dan sirkuit pada substrat untuk mencapai kondukti elektrik. Pada masa yang sama, kerana pilihan saiz partikel konduktif yang sesuai dan jumlah tambahan, bumps dan bumps tidak boleh menghubungi satu sama lain untuk mencapai ciri konduktif anisotropik.
Terdapat berbagai jenis ACF di pasar, tetapi yang paling biasa digunakan adalah pelet plastik berwarna emas dengan diameter 3-5μm, yang dibentuk dengan menyebar dalam sistem resin epoksi termoset dengan densiti 40,000-60,000 pcs/mm2. Sebagaimana resin epoksi sembuh dan berkurang selepas tekanan panas, kekuatan ikatan antara bumps IC dan sirkuit substrat adalah baik, partikel konduktif ditekan dan terganggu, dan kekuatan elastik yang menghasilkan membuat partikel konduktif datang dalam kenalan yang lebih dekat dengan antaramuka atas dan bawah, dan konduktiviti lebih baik. Lagipun, kerana partikel konduktif adalah elastik, walaupun permukaan sambungan tidak terlalu rata, perbezaan tekanan yang dijana oleh partikel konduktif boleh ofset oleh kekuatan elastik partikel konduktif. Namun, ACF mempunyai masalah sirkuit pendek disebabkan partikel konduktif, dan lebar baris terlalu kecil menghasilkan partikel konduktif yang sangat sedikit yang boleh ditangkap pada kenalan, membuatnya tidak dapat menghadapi sambungan IC dengan jarak lebar baris di bawah 17μm. Kekepercayaan elektrik sambungan ACF tidak sebaik proses eutektik. Dalam proses penyelamatan semula kemudian, ia juga boleh terganggu kerana tekanan panas, yang menyebabkan kurangnya konduktiviti elektrik atau bahkan sirkuit terbuka. Walaupun demikian, selama berbagai parameter dalam proses ikatan ACF (suhu pemampatan, tekanan, masa, kadar pemanasan, dll.) dikawal, kepercayaan ACF boleh memenuhi keperluan sepenuhnya. Selain itu, proses ACF mempunyai suhu tekanan rendah (di bawah 200°C), pemprosesan sederhana, hasil tinggi, dan perlindungan persekitaran. Ia telah menjadi kaedah perdamaian utama COG dan COF. Pada masa yang sama, ACF juga adalah cara utama untuk menyambungkan substrat fleksibel dan panel kaca.
4.3 Proses sambungan tidak konduktif (NCA)
Kaedah ikatan NCA kebanyakan bergantung pada kenalan langsung antara cip dan elektrod di kedua-dua sisi substrat untuk mencapai kondukti elektrik, sementara tujuan NCA adalah untuk menyelesaikan pemancaran elektrod dengan keras resin dan mengurangi, dan menggunakan ciri-ciri mekanik resin untuk menjaga kenalan dan kondukti antara elektrod. Kekuatan yang diperlukan. Peran bahan NCA adalah untuk menyediakan kekuatan ikatan antara bumps dan titik langsung sirkuit substrat dan untuk melindungi kenalan dan menjaga kepercayaan yang baik. Oleh itu, bahan ini mesti mempunyai ciri-ciri yang berikut: ciri-ciri mekanik dan fizik yang baik, termasuk Tg tinggi, modulus elastik tinggi, pengurangan tinggi dan koeficien pengembangan panas rendah, kesan basah yang baik, ciri-ciri yang mencegah basah, ciri-ciri melekat dan kekebalan kesan; ia boleh disembuhkan dalam masa singkat pada suhu tinggi (20saat, 150 ~ 250 darjah Celsius); ia mempunyai sifat pengisihan elektrik yang baik. Proses NCA kompatibel dengan proses ACF, hanya tambah unit elektro-melekat di hadapan peralatan penyesuaian. Dalam proses NCA, bumps dan litar substrat berada dalam kontak mekanik langsung, dan kemungkinan litar pendek sisi sangat kecil. Oleh itu, NCA boleh mengendalikan sambungan IC (17μm atau kurang) yang lebih kecil daripada puncak had proses eutektik dan ACF. Namun, NCA mempunyai keperluan yang lebih tinggi untuk bahan daripada ACF. Contohnya, ketinggian bump cip mesti baik, permukaan substrat mesti sangat rata, bahan asas mesti mempunyai kestabilan dimensi yang lebih tinggi, dan garis sambungan mesti elektroplat dengan emas untuk menghindari bentuk lapisan oksid. Kepercayaan sambungan NCA belum diperiksa. Faktor-faktor ini telah membatasi penggunaan NCA, membuat ia sementara tidak dapat menjadi proses mainstream.
6 Kesimpulan
Dengan pengembangan teknologi pakej densiti tinggi, teknologi COG dan COF telah digunakan secara luas dalam pelbagai paparan panel rata dan produk bimbit peribadi. Teknologi COG dan COF telah menjadi bentuk pakej utama ICs pemacu LCD kerana banyak keuntungan mereka seperti densiti tinggi, I/O berbilang dan terutama menggunakan pakej lengkap konduktif. COF adalah teknologi pakej yang sangat berjanji. Kerana kemajuan teknologi penghasilan sirkuit fleksibel, kekuatan pengelilinannya tinggi, komponen pasif boleh ditambah, tidak perlu membuat petunjuk ditangguh, dan kadar penggunaan kawasan panel tinggi. Ia telah dilambangkan ke medan pakej densiti tinggi selain pakej LCD, bergabung dengan teknologi sambungan ACF, teknologi COF telah menjadi bentuk pakej dengan densiti pakej tertinggi pada masa ini.