Prinsip dan aplikasi pakej IC 3D
Lapisan mediasi 2.5D adalah konfigurasi di mana inti tabung dipasang sebelah sebelah sebelah pada lapisan mediasi silikon, kaca atau organik menggunakan silikon melalui lubang (TSV) melalui lapisan mediasi. (Apabila kaca atau laminat organik digunakan sebagai substrat untuk lapisan tengah, mereka dipanggil melalui kaca melalui lubang (TGV) dan substrat melalui lubang (TSV) berdasarkan itu.) Komunikasi antara inti dilakukan melalui sirkuit yang dibuat pada lapisan tengah.
Sensor imej CMOS (CIS) mempunyai TSV sebagai lubang belakang untuk membentuk sambungan antara satu sama lain, menghapuskan gabungan kekunci utama yang membolehkan saiz yang dikurangi dan densiti meningkat. Dalam semua jenis pakej 3D, cip dalam pakej menggunakan isyarat off-cip untuk berkomunikasi seolah-olah ia diletak dalam pakej terpisah pada papan sirkuit normal.
IC 3D boleh dibahagi menjadi IC terkumpul 3D (3D-sic), yang bermakna cip IC terkumpul dan disambung dengan TSV; Dan ics 3D yang sebenar, yang menggunakan proses FAB untuk tumpukan lapisan peranti berbilang pada cip tunggal, mungkin atau tidak menggunakan TSVS yang sangat terpisah untuk membentuk sambungan.
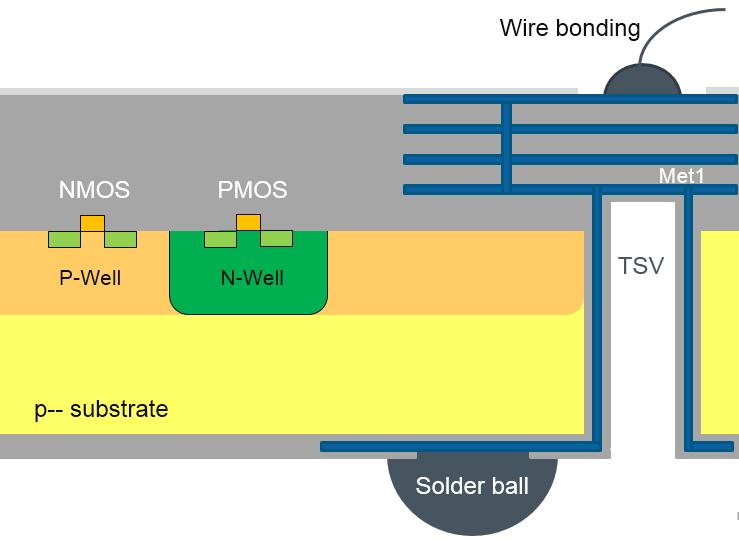
Silikon melalui lubang (TSV) adalah lubang yang dicipta dalam wafer silikon menggunakan proses cetakan. Sambungan dibentuk dengan mengisi TSV dengan bahan konduktif seperti tembaga, tungsten atau polisilikon (Figur 2). Keuntungan utama sambungan TSV ialah bahawa mereka pendek laluan melalui mana isyarat perjalanan dari satu cip ke yang seterusnya atau dari satu lapisan sirkuit ke yang seterusnya. Ini membenarkan kekurangan kuasa dan kemampuan untuk meningkatkan ketepatan sambungan, dengan demikian meningkatkan fungsi dan prestasi. TSV sendiri bukan IC 3D. Sebaliknya, mereka adalah dasar untuk membolehkan ics 3D. Sebelah belakang melalui lubang juga digunakan dalam peranti lain, seperti sensor imej, sistem mikroelektromekanik (MEMS), dan semikonduktor komponen.
Apa maknanya IC 3D monolitik?
Daripada tumpukan wafer atau modul untuk mencipta IC 3D, IC monolitik 3D bermula dengan wafer as as yang mana lapisan tambahan seperti silikon kristal, lapisan logam, dan sirkuit aktif dan pasif ditambah menggunakan peranti FAB tradisional (Figure 2). Sambungan menegak dibentuk diantara lapisan daripada diantara cip menggunakan melalui lubang dalam nanometer daripada julat mikron; - Sama seperti TSV. Beberapa pendekatan berbeza sedang dikembangkan, terutama untuk aplikasi dalam ingatan. @ info 3D Integral kadang-kadang dipanggil 3D urutan.
Apa memori 3D?
Banyak kaedah telah dikembangkan untuk tumpukan ingatan tegak kepada dua peranti ingatan yang tidak volatile (NAND flash) dan volatile (DRAM). Kaedah DRAM mengandungi memori lebar jalur tinggi (HBM), kub memori campuran Micron dan RAM terintegrasi Tezzaron (DiRAM). (1) Semua ini berdasarkan IC 3D menggunakan TSV (Figure 3). Samsung, Toshiba dan banyak yang lain sedang mengembangkan flash NAND 3D berdasarkan pendekatan 3D holistik.
Apa gunanya teknologi penyisip 2.5D?
Awalnya dikembangkan sebagai teknologi bergabung untuk ics 3D, teknologi 2.5D telah tumbuh menjadi platform pakej yang dijangka untuk bersamaan dengan ics 3D. Tidak seperti 3D-IC, hanya lapisan sementara (bukan inti sendiri) memerlukan TSV untuk menyambungkan inti aktif ke substrat pakej. Ini membenarkan penggunaan reka bentuk yang ada.
Apa pemacu teknik utama integrasi 3D?
Kost bertambah langkah litografi ini dan pemprosesan wafer secara umum pada nod cip generasi seterusnya memandu industri untuk mencari alternatif untuk meningkatkan prestasi dan fungsi peranti elektronik kita dan mengurangi kos. Selain itu, keperluan untuk mengintegrasikan berbagai-bagai teknologi (logik, memori, RF, sensor, dll.) pada saiz kecil memandu industri untuk menerima integrasi 3D sebagai penyelesaian.
Apa pemandu pasar untuk integrasi 3D?
Pemacu pasar untuk integrasi 3D (integrasi 3D) bermula dengan komputer, pelayan dan pusat data, tentera dan angkasa udara, dan peralatan perubatan, kerana mereka dalam permintaan terbesar dan mampu membeli kos teknologi integrasi 3D semasa. Tablet, telefon pintar dan peranti permainan juga memandu teknologi.
Cabaran apa yang ics 3D hadapi?
Walaupun banyak menyatakan bahawa tiada cabaran teknikal yang tersisa dan bahawa isu-isu yang tersisa boleh mudah diselesaikan, beberapa langkah proses masih memerlukan penyelesaian yang lebih baik, seperti alat desain untuk merancang, melaksanakan dan mengesahkan ics 2.5D dan 3D, pemprosesan wafer, pengurusan panas dan ujian. Tandakan utama adalah biaya unit semasa, kuantiti rendah dan risiko pelaksanaan disebabkan dewasa ekosistem. Berusaha untuk mengurangi biaya proses dan mempermudahkan kerjasama di seluruh industri. Pertumbuhan meningkat akan membantu untuk mengurangi biaya. Namun, ramai ahli 3D percaya bahawa melaksanakan ics 3D akan mengurangi biaya sistem, dan bahawa cabaran yang tersisa adalah untuk mengajar jurutera aras sistem mengenai keuntungan daripada merancang ics 3D dalam sistem mereka.
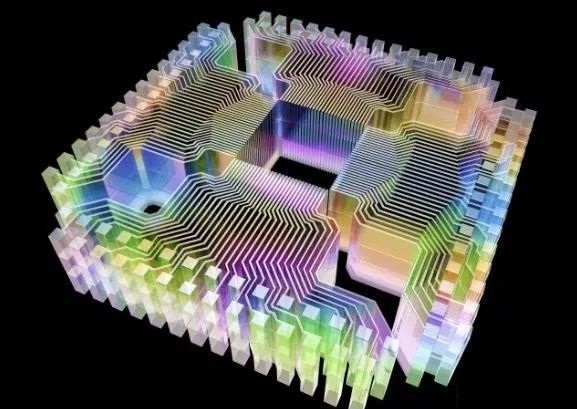
Sensor imej CMOS (CIS) adalah salah satu peranti pertama untuk melaksanakan melalui lubang kembali melalui lubang dalam kuantiti besar. @ info CIS dengan cahaya belakang (BSI) kini dalam produksi, dan kerana CIS ditampung di atas IC, ia adalah peranti IC 3D (Figure 2). Xilinx memperkenalkan rancangan pemalam 2.5D untuk semua FPgas boleh diprogramkan dari siri Virtex-7 pada 2011. Selama beberapa tahun terakhir, Tezzaron telah menghantar jumlah kecil DiRAM.
Pada akhir 2014, Micron dan Samsung akan memulakan produksi kub penyimpanan hibrid (HMCS), yang merupakan tumpukan DRAM 3D di atas peranti logik. SK Hynix akan menyediakan memori lebar band HMC dan HBM tinggi. Produksi massa peranti penyimpanan terintegrasi 3D ini berlaku pada tahun 2014/15 dan terus menggunakan tumpukan logik dan peranti heterogen selama beberapa tahun selepas itu.
iPCB akan berkongsi semua maklumat dengan anda!