Proses elektroplating Substrate IC Baru: lubang buta, melalui lubang dan penuhian groove terbenam
Abstrakt
Pada zaman miniaturisasi produk elektronik, hasil tinggi dan biaya rendah terpisah Substrate IC menyediakan cara yang boleh dipercayai untuk menyadari sambungan densiti tinggi (HDI) antara cip dan PCB. Untuk maksimumkan ruang pembawa yang tersedia, jarak antara corak tembaga -- lebar corak dan jarak corak (L/S) -- sepatutnya diminimumkan. Dalam teknologi PCB umum, lebar corak dan jarak corak lebih besar dari 40 μm, sementara teknologi aras wafer yang lebih maju boleh mencapai lebar corak dan jarak corak sehingga 2 μm. Selama dekade lepas, saiz cip telah menurun secara signifikan dengan L/S di atas kapal, menghasilkan cabaran unik untuk papan sirkuit dicetak dan industri setengah konduktor.
Pakej Aras Panel Fan-out (FOPLP) adalah teknologi penghasilan baru yang direka untuk memecahkan ruang antara medan PCB dan IC/semikonduktor. Walaupun FOPLP masih teknologi yang muncul, ia diberi keuntungan oleh pasar kerana kemampuannya untuk meningkatkan penggunaan ruang tingkat dan kapasitas dan meningkatkan keuntungan kompetitif dengan mengurangkan kos. Di pasar ini, kunci untuk prestasi sirkuit halus adalah keseluruhan atau keseluruhan plating. Kesempatan lapisan, keseluruhan atas lubang wayar/buta (mengukur keseluruhan atas wayar) dan lubang buta adalah ciri-ciri prestasinya. Ini terutama penting dalam pemprosesan PCB berbilang lapisan, di mana ketidakhomogeneiti lapisan bawah boleh mempengaruhi penutup berikutnya, merusak desain peranti dan menyebabkan konsekuensi bencana seperti sirkuit pendek. Selain itu, permukaan yang tidak bersamaan boleh membentuk titik sambungan (iaitu lubang buta dan laluan) dan menyebabkan kehilangan isyarat. Oleh itu, penyelesaian elektroplating yang menyediakan profil bahkan dan rata tanpa mana-mana selepas rawatan istimewa dijangka oleh industri.
Dalam artikel ini, aditif komposit inovatif untuk penapisan tembaga DC untuk Substrate IC diperkenalkan. Penisian tumbuhan terbenam boleh diselesaikan dengan penapis grafik yang lebih baik, dan penisian lubang melalui dan buta boleh diselesaikan pada masa yang sama. Produk baru ini tidak hanya menyediakan profil corak yang lebih baik, tetapi juga boleh dipenuhi lubang but a dan elektroplasi melalui lubang. Kami juga memperkenalkan dua jenis proses elektrolisis tembaga elektroplating, yang boleh dipilih mengikut saiz lubang buta dan keperluan kongsif aplikasi khusus: Proses saya boleh menyediakan penuhian yang baik untuk lubang buta dalam dengan diameter 80μm hingga 120μm dan kedalaman 50μm hingga 100μm (Figure 1); Proses II lebih sesuai untuk lubang buta kecil dan rendah dengan diameter 50μm hingga 75μm dan kedalaman 30μm hingga 50μm.
Dua proses ini boleh mencapai keseluruhan permukaan dan profil garis yang baik (FIG. 2). Artikel ini menggambarkan penuhian lubang buta dan melalui ciri-ciri elektroplating lubang dengan parameter yang diberi dalam julat kawalan. Ia juga menggambarkan bagaimana untuk optimumkan penyebaran panas dan ciri-ciri fizikal elektroplating metalisasi
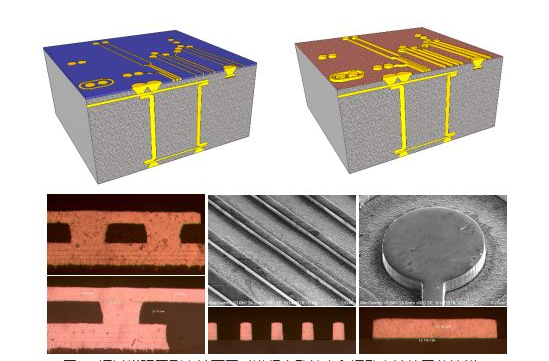
FIG.1 Ciri-ciri proses mengisi lubang buta dan melalui elektroplating lubang boleh dilakukan secara bersamaan dengan elektroplating grafik meningkat

FIG2 Performasi penuhi tumpuan terbenam untuk menunjukkan darjah tinggi konsistensi antara pad dan wayar
Perkenalan
Substrate IC ialah tahap tertinggi teknologi miniaturisasi PCB, menyediakan sambungan antara cip IC dan PCB melalui rangkaian elektrik yang mengarahkan wayar tembaga dan melalui lubang. Kepadatan wayar adalah faktor kunci dalam miniaturisasi, kelajuan dan portabiliti elektronik pengguna. Dalam beberapa dekade terakhir, ketepatan linear telah meningkat dengan besar, dan pembangunan pengimbangan panel penggemar-keluar (FOPLP) telah menjadi topik panas dalam medan mikroelektronik untuk memenuhi keperluan desain sirkuit cetak hari ini, termasuk bahan inti halus, lebar corak ketepatan, dan diameter lebih kecil melalui dan lubang buta.
Pemandu utama yang memandu teknologi baru ini adalah biaya dan produktifiti. Pengemasan aras lapisan penggemar-keluar tradisional (FOWLP) menggunakan lapisan 300 mm sebagai unit produksi kerana memperoleh lapisan yang lebih besar adalah sukar, meningkatkan langkah pemprosesan, kerja, dan kos, dan hasil lebih rendah. Keuntungan menggunakan pemuatan seperti PCB melalui wafer adalah bahawa pembuat mempunyai fleksibiliti desain dan boleh menggunakan kawasan panel yang lebih besar. Contohnya, panel 610 mmx457 mm mempunyai hampir empat kali luas permukaan wafer 300 mm, mengurangi banyak kos, masa dan langkah pemprosesan, yang merupakan keuntungan besar untuk produksi mass a.
Namun, aplikasi teknologi FOPLP kepada substrat memerlukan lebih banyak kajian dan pembangunan dan menghadapi cabaran seperti resolusi dan masalah warping. Jika berjaya dilaksanakan, volum yang lebih tinggi, biaya lebih rendah, dan saiz pakej yang lebih tipis boleh dicapai, menjadikan elektronik konsumen lebih cepat dan lebih ringan.
Penisi lubang buta tembaga asam
Proses elektroplasi adalah salah satu langkah kunci dalam produksi papan PCB. Melalui distribusi semasa, kawat, lubang buta dan melalui elektroplating lubang di papan PCB boleh disedari. Copper, sebagai logam konduktif yang dipilih, diperkirakan oleh biaya rendah dan konduktiviti tinggi. Dengan pembangunan teknologi tembaga elektroplating dalam dekade-dekade terakhir, penggunaan tembaga sebagai logam elektroplating telah meningkat besar. Kecanggihan papan sirkuit khusus memerlukan peralatan elektroplating pinggir terbaik dan penyelesaian elektroplating inovatif, jadi dalam dekade-dekade terakhir, peralatan elektroplating jet telah digunakan secara luas.
Solusi penuhian elektroplating biasanya konsentrasi tinggi tembaga (200 g/L hingga 250 g/L sulfat tembaga) dan konsentrasi rendah asid (kira-kira 50g/L asid sulfur) untuk memudahkan penuhian cepat. Additif organik digunakan untuk mengawal kadar penapisan dan mendapatkan ciri-ciri fisik yang diterima. Additif ini mesti direka dengan hati-hati untuk memenuhi keperluan pelanggan untuk saiz isi lubang panduan, hasil, tebal tembaga permukaan, toleransi distribusi tembaga plat, dan bentuk lubang buta selepas plat. Formulasi plating biasa termasuk inhibitor, brighteners, dan leveler. Secara teori, ia mungkin untuk mengisi lubang but a hanya dengan sistem dua-komponen yang mengandungi inhibitor dan brightener, tetapi sistem dua-komponen mempunyai masalah praktik, seperti depresi besar, mengisi bentuk, dan proses sukar untuk dikawal secara analitik.
Kedua-dua penghalang dan penghalang bertindak sebagai penghalang, tetapi dalam cara yang berbeza. Penghalang Jenis I seperti penghalang boleh dinyahaktifkan oleh penghalang yang cerah, sementara penghalang Jenis II seperti penghalang tidak, dan pembawa biasanya adalah komponen polioksialkil berat molekul tinggi. Biasanya mereka adsorb pada permukaan katod dan membentuk lapisan tipis dengan berinteraksi dengan ion klorid, jadi pembawa mengurangkan kadar plating dengan meningkatkan tebal efektif lapisan penyebaran. Aras tenaga permukaan katod adalah bersamaan (bilangan elektron yang sama boleh digunakan secara setempat untuk elektroplat semua titik permukaan katod), yang mengakibatkan distribusi lebih seragam dari tebal plating yang berasal.
Brighteners, di sisi lain, meningkatkan kadar plating dengan mengurangi penghalangan. Mereka biasanya merupakan komponen molekul kecil yang mengandungi sulfur, juga dikenali sebagai rafiner biji. Agen penerbangan biasanya terdiri dari rantai lurus yang mengandungi nitrogen/polimer cabang dan komponen aromatik heterosiklik atau heterosiklik, komponen biasanya struktur kuaternary (pusat atom yang dimuatkan positif dan empat substituen), mereka akan adsorpsi selektif pada densiti semasa tinggi, seperti pinggir, Sudut dan setempat membengkak, - mencegah penutup tembaga berlebihan di kawasan densiti semasa tinggi.
Kaedah ujian
Ujian dilakukan dalam tangki elektroplating 8L dan tangki ujian 200L. Anod tidak soluble digunakan untuk ketepatan semasa yang berlaku yang lebih tinggi, kemudahan pemeliharaan, dan distribusi permukaan tembaga seragam. Selepas penyelesaian penapisan dikonfigur, penyelesaian penapisan dikonfigur secara palsu pada 1Ah/L, dianalisis, disesuaikan untuk konsentrasi aditif yang betul, dan kemudian ujian penapisan dilakukan. Setiap piring ujian dibersihkan dengan asid selama 1 minit, dibersihkan dengan air selama 1 minit, dan dipilih dengan 10% asid sulfurik selama 1 minit sebelum plating.
Keadaan operasi dan komposisi mandi
FIG 1 menunjukkan keadaan operasi dan konsentrasi aditif optimal untuk kedua-dua formulasi. Biasanya lubang buta mengisi penyelesaian elektroplating tinggi dalam tembaga dan rendah dalam asid untuk mencapai isi bawah lubang yang diperlukan.
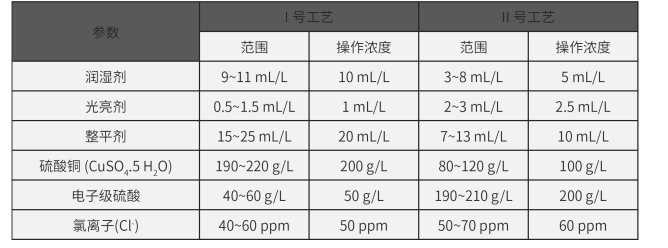
FIG1 - Komposisi mandi elektroplating dan keadaan elektroplating
Mekanisme penuhi lubang buta
Kadar pertumbuhan tembaga di lubang buta dan pada piring dikawal oleh aditif. FIG3 menunjukkan diagram skematik pertumbuhan tembaga lubang buta, menunjukkan peran yang berbeza dimainkan oleh setiap aditif. Penyerangan selektif dan tidak selektif boleh berlaku semasa elektroplating walaupun penyerahan dikembangkan secara setempat. Tambahan mesti dikawal dalam Tetapan yang dipaparkan dalam Jadual 1 untuk mencapai "penuhian bawah-atas" yang diperlukan. Analisis boleh dilakukan menggunakan alat analitik yang biasa digunakan dalam industri, seperti voltametri ciklik (CVS) dan ujian bilik.
Dalam FIG3, hijau mewakili pengendali, merah mewakili ejen penerbangan, dan kuning mewakili penerbangan. Molekul ejen basah terutamanya adsorb di permukaan, menghalang elektroplating di dalamnya, sementara ejen penerbangan selektif adsorb di kawasan yang dimuatkan negatif disebabkan garam kuaternar amine yang dimuatkan positif, yang boleh menghalang penerbangan berlebihan di tepi dan menghindari penutupan awal lubang buta, yang menyebabkan bentuk lubang di tengah. Brightener adalah molekul kecil yang mengandungi sulfur yang menyebar lebih cepat ke lubang buta untuk mempercepat elektroplating. Kerana geometri lubang buta berubah secara terus-menerus semasa elektroplating, pencerah menjadi berkoncentrasi dalam lubang melalui, menghasilkan elektroplating cepat dalam lubang buta. Ini dipanggil mekanisme penyelamatan pemecut (CEAC) meningkatkan lengkung.

Diagram skematik FIG3 bagi mekanik CEAC m
Akhirnya, apabila platting tembaga di lubang buta hampir koplanar dengan permukaan, kadar penutup di lubang buta dan permukaan menjadi sama, dan penutup bawah-atas berhenti. Bergantung pada kekuatan pengangkutan dan desorpsi aditif, penerbangan mungkin tidak tersebar seperti yang dijangka, dan konsentrasi tinggi penerbangan akan terus mempercepat peletakan, yang menyebabkan peletakan berlebihan dikenali sebagai "impuls terburu-buru."
Keukuran profil Corak Tepat
FIG4 menunjukkan pengiraan kadar profil, ditakrif sebagai nisbah antara perbezaan tinggi antara titik rendah dan tertinggi, diekspresikan sebagai peratus, dan nilai R, perbezaan tinggi antara kawasan pad dan garis halus, mengambil minimum kedua-dua nilai.
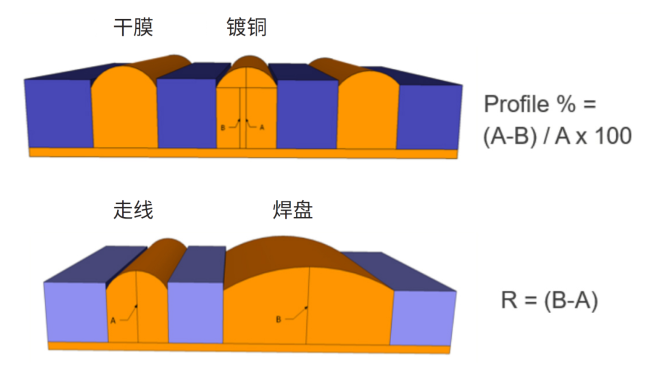
Nisbah lingkungan FIG4 dan pengiraan nilai R
Rancangan proses NO.1 direka untuk mengisi lubang buta, menghasilkan permukaan rata dan profil baris yang lebih baik, dan keadaan penutup ditetapkan, seperti yang dipaparkan dalam FIG 5. Untuk mendapatkan kapasitas penuhi lubang buta yang diperlukan, konsentrasi CuSO4 (200g/L) yang lebih tinggi digabung dengan konsentrasi asam sulfur yang lebih rendah (50g/L).
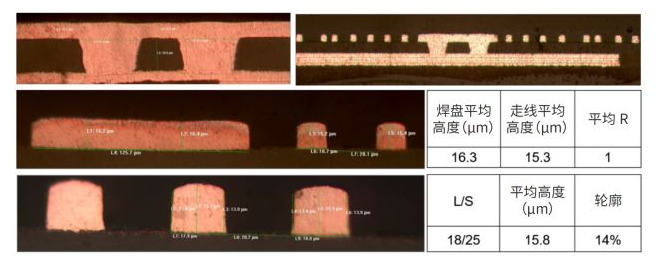
Ciri-ciri elektroplating tipik FIG5
Ciri-ciri biasa proses No.1 dipaparkan dalam FIG5, di mana saiz lubang buta penuh ialah 60 μm*35 μm dan tebal tembaga ialah 15μm. Kerana proses NO.1 boleh mengisi lubang buta dengan permukaan kongkif yang paling kecil, tidak diperlukan langkah penuh tambahan. Nisbah profil biasanya berada dalam julat 10% hingga 15%, bagaimanapun, dalam beberapa kes ia diperhatikan bahawa keadaan sebenar adalah antara 15% dan 20%, tebal plat tembaga wayar adalah 15µm hingga 16μm, dan nilai R adalah antara 1 dan 2. Pad-pads lebih kuasa dua dalam bentuk dan mempunyai permukaan rata, dengan kabel menunjukkan kubah kecil.
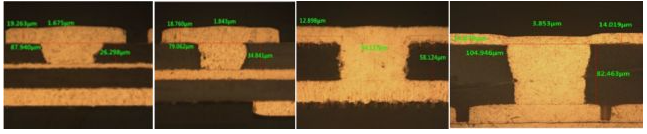
FIG6 Isian 90 μm x 25 μm, 80 μm x 35 μm, 90 μm x 60 μm dan 100 μm x80 μm lubang buta saiz berbeza
Kapasiti penuh formula untuk lubang buta saiz berbeza telah diteliti lebih lanjut. Empat saiz lubang buta berbeza diuji: 90 μm x 25 μm, 80 μm x 35 μm, 90 μm x 60 μm dan 100 μm x80 μm sesuai. Hasil ujian dipaparkan dalam Gambar 6. Untuk mengisi lubang buta di bawah 90 μm*60 μm, tiada permukaan konkav dilihat, sementara lubang buta yang lebih besar 100 μm*80 μm mempunyai permukaan konkav 4 μm.
Belajar tentang penyelesaian elektroplating sepanjang hidup
Selepas penilaian prestasi awal, penyelesaian plating berusia hingga 150 Ah/L dengan volum tangki 8 L. Setiap siklus plating adalah 15ASF selama 45 minit dengan konsentrasi aditif yang sama seperti yang disenaraikan dalam jadual 1.
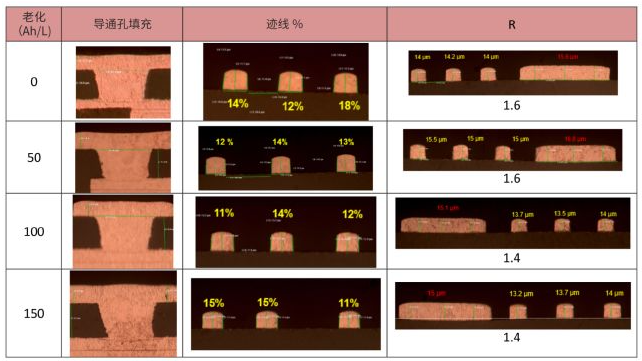
elektroplating solusi seumur hidup
Semasa ujian penuaan mandi, papan ujian telah dipotong secara elektro pada selang 50Ah/L, dan sampel terpisah telah disediakan dan diteliti di bawah mikroskop. Papan ujian terdiri dari 60 µm x35 μm lubang buta dan pelbagai laluan L/S. Keadaan penutup telah disesuaikan untuk mendapatkan tebal sekitar 15 μm di permukaan. Semasa proses penuaan, profil wayar berada dalam julat 10% hingga 15%, dan kadang-kadang 15% hingga 20%, yang konsisten dengan hasil ujian prestasi awal, dan nilai R elektroplating pad rata berada dalam julat 1 hingga 2.
Uji kapasitas penuhi lubang melalui menggunakan papan dengan tebal 40μm dan 60μm. Diameter lubang dua papan sirkuit adalah 40 μm dan 50 μm, respectively. Hasilnya dipaparkan dalam Gambar 7. Period elektroplating adalah 1.24ASD, berlangsung 60 minit
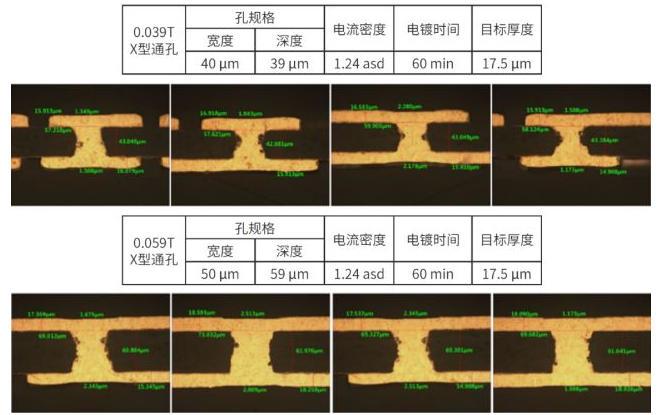
Kapasiti penuh lubang bentuk x
Kekuatan tegang dan panjang
Dua ciri-ciri fisik yang paling penting dalam penghasilan PCB adalah kekuatan tekanan dan panjang konduktor tembaga elektroplad, kerana ciri-ciri ini menunjukkan tekanan panas yang logam tembaga boleh tahan semasa pemasangan dan penggunaan akhir. Ciri-ciri fisik adalah hasil kombinasi aditif termasuk inhibitor, rafiner biji dan leveler. Ciri-ciri ini juga bergantung pada kadar plating atau densiti semasa, suhu plating, dan morfologi kristal. Contohnya, deposit tebal dari arah kristal berbeza mempunyai ciri-ciri fizik yang lebih baik daripada deposit kolom.
Ciri-ciri fizikal diukur mengikut kaedah ujian 2.4.18.1 piawai IPC TM-650, dan kemudian sampel dipotong menjadi garis dan dipanggang dalam oven 125 darjah Celsius selama 4~6 jam. String sampel diuji dengan alat ujian mekanik industri, dan nilai diukur alat digunakan untuk menghitung kekuatan tarik dan peratus panjang. Gambar 8 menunjukkan hasil dua penyelesaian mandi yang berbeza: mandi yang baru dan mandi yang tua sekitar 100 Ah/L. Hasilnya menunjukkan bahawa ciri-ciri tidak berubah banyak dengan meningkatkan masa elektroplating dan memenuhi keperluan standar IPC Aras III.
