Dengan muncul pakej ketinggian miniaturisasi, keperluan kelajuan tinggi Papan PCB dan kumpulan ketepatan tinggi telah menjadi lebih kritik, dan peralatan dan proses pemasangan yang berkaitan menjadi lebih maju dan fleksibel. Sejak cip-balik mempunyai faktor bentuk yang lebih kecil, diameter bola dan pitch bola lebih kecil daripada BGA atau CSP, ia menawarkan kemungkinan tidak terdahulu untuk proses pemasangan bola, teknologi substrat, kompatibiliti bahan, proses penghasilan, dan peralatan dan kaedah pemeriksaan. cabaran. Hari ini, terdapat semakin banyak bentuk pakej miniatur dan densiti tinggi peranti elektronik, such as multi-module packaging (MCM), system-in-package (SiP), flip-chip (FC, Flip-Chip) and other applications. Kemunculan teknologi ini telah mengelirukan garis antara pakej dan kumpulan kedua. Tidak diragukan lagi, dengan pembangkitan pakej ketinggian miniatur, keperluan untuk kumpulan kelajuan tinggi dan ketepatan tinggi telah menjadi lebih kritikal, dan peralatan dan proses pemasangan yang berkaitan menjadi lebih maju dan fleksibel. Sejak cip-balik mempunyai faktor bentuk yang lebih kecil, diameter bola dan pitch bola lebih kecil daripada BGA atau CSP, ia menawarkan kemungkinan tidak terdahulu untuk proses pemasangan bola, teknologi substrat, kompatibiliti bahan, proses penghasilan, dan peralatan dan kaedah pemeriksaan. cabaran. These requirements are analyzed in detail below:
1. Untuk keperluan kawalan tekanan lekap, mengingat bahawa substrat cip-balik untuk PCB adalah silikon relatif lemah, jika tekanan besar dilaksanakan semasa proses pemulihan bahan dan tenggelam aliran, ia mudah untuk patah, and at the same time Small solder bumps are also easily deformed during this process, jadi cuba gunakan tekanan lekap yang relatif rendah. Keperluan umum sekitar 150g. Untuk cip ultra-tipis, seperti 0.3mm, kadang-kadang tekanan lekapan diperlukan untuk dikawal pada 35g.
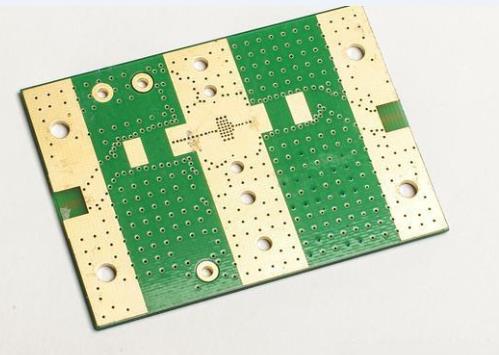
2. Untuk keperluan ketepatan tempatan dan kestabilan, untuk peranti dengan lapisan bola sebanyak 0.1mm, apa ketepatan tempatan yang diperlukan untuk mencapai hasil tinggi? Halaman perang dan deformasi substrat, saiz dan pengalihan kedudukan tetingkap topeng askar, dan ketepatan mesin akan mempengaruhi ketepatan lokasi akhir. Kami tidak akan membincangkan pengaruh desain dan penghasilan substrat pada tempatan, tetapi di sini kita hanya membincangkan ketepatan tempatan mesin.
3. Keperlukan proses pemasangan cip untuk peralatan tempatan, untuk menjawab soalan di atas, let's build a simple hypothetical model:
1) Assume that the solder bumps of the flip-chip Papan PCB ialah sferi, and the corresponding pads on the substrate are circular and have the same diameter;
2) It is assumed that there is no influence of substrate warpage and manufacturing defects;
3) Does not consider the effects of Theta and shock;
4) During the reflow soldering process, peranti ini adalah neutral, dan 50% kenalan antara bola askar dan permukaan basah boleh "ditarik" semasa proses askar. Kemudian, berdasarkan asumsi di atas, jika diameter bola solder dengan diameter 25μm adalah 50μm, the left and right position deviation (X axis) or the front and rear position deviation (Y axis) is 50% of the pad size. Bolanya selalu di pads. Untuk flip-chip Papan PCBs dengan diameter bola tentera 25μm, jika kemampuan proses Cpk mencapai 1.33, ketepatan mesin mesti mencapai 12μm.
4. Menurut keperluan kamera dan teknologi pemprosesan imej, kamera digital dengan megapiksel diperlukan untuk memproses imej cip-balik Papan PCBs dengan peluncuran bola tentera yang baik. Kamera digital dengan piksel yang lebih tinggi mempunyai peningkatan yang lebih tinggi, bagaimanapun, semakin tinggi piksel, the smaller the field of view (FOV), yang bermakna peranti yang lebih besar mungkin perlu "dipotong" berbilang kali. Sumber cahaya kamera biasanya diod yang mengeluarkan cahaya, yang dibahagi menjadi sumber cahaya sisi, sumber cahaya depan dan sumber cahaya paksi, dan boleh dikawal secara bebas. Sumber cahaya imej cip untuk Papan PCB menerima cahaya sisi, cahaya depan, atau kombinasi kedua-dua. Jadi bagaimana anda memilih kamera untuk peranti tertentu? Ini bergantung pada algoritma imej. Contohnya, ia memerlukan N piksel untuk membezakan satu bola askar, and 2N pixels are required to distinguish the ball pitch. Mengambil kamera digital Magellan pada mesin tempatan Instrumen Universal sebagai contoh, perlukan 4 piksel untuk membezakan satu bola askar. Pilih kamera, menganggap semua imej adalah 75% saiz objek sebenar. Pemprosesan imej fiducial flip-chip untuk Papan PCBs sama dengan fiducial biasa. Lekap-cip balik untuk Papan PCBs sering menggunakan fiducial setempat selain fiducial GLOBAL. Pada masa ini, the fiducials will be small (0.15-1.0mm), dan pemilihan kamera merujuk kepada kaedah di atas. Pemilihan sumber cahaya perlu dianggap. Secara umum, sumber cahaya kamera di kepala SMD adalah cahaya merah, dan kesannya sangat lemah bila berurusan dengan titik rujukan pada papan sirkuit fleksibel, dan titik rujukan tidak dapat ditemui. The reason is that the surface of the reference point (copper) The color is very close to the substrate color, dan perbezaan warna tidak jelas. Jika teknologi sumber cahaya biru bagi Instrumen Universal digunakan, masalah ini boleh diselesaikan dengan baik.
5. Selection of nozzles
Since the flip-chip substrate for PCB is silicon, permukaan atas sangat rata dan lembut, dan kepala adalah bahan plastik yang kasar dengan teka-teki ESD porous. Jika anda memilih teka-teki dengan kepala karet, semasa zaman karet, the device may stick to the device during the placement process, menyebabkan tempatan bergerak atau mengambil peranti.
6. Keperlukan bagi unit aplikasi aliran. The flux application unit is an important part of controlling the flux dipping process. Prinsip asas kerjanya adalah untuk mendapatkan filem flux stabil dengan tebal ditetapkan, sehingga setiap bola tentera peranti boleh mudah ditenggelamkan. Ambil jumlah aliran yang sama. Untuk mengendalikan tebal filem aliran semasa memenuhi keperluan tenggelam kelajuan tinggi, the flux application unit must meet the following requirements:
1) It can meet the requirements of dipping multiple devices with flux at the same time (such as dipping 4 or 7 pieces at the same time) to increase the output;
2) The unit for flux should be simple, mudah beroperasi, easy to control and easy to clean;
3) It can handle a wide range of fluxes or solder pastes. Julat viskositi aliran yang sesuai untuk proses tenggelam adalah luas, dan ia boleh menangani aliran yang lebih tipis dan lebih viskus, and the obtained film thickness should be uniform;
4) The dipping process can be controlled, dan parameter proses tenggelam akan berbeza kerana bahan yang berbeza, jadi parameter proses proses tenggelam mesti dikawal secara individu, seperti kecepatan turun, tekanan, Masa, kecepatan naik, dll.
7. Untuk keperluan penyedia, to meet the production of high-speed and high-yield batches, teknologi makan juga sangat kritik. Kaedah pembekalan Flip-chip untuk Papan PCBs mainly include: 2*2 or 4*4 inch JEDEC reels, 200mm or 300mm wafer reels (Wafer), and reel reels (Reel). Penyuap yang sepadan adalah: Penyuap talam Stationary, Penyuap boleh tumpukan secara automatik, Wafer feeder, dan penghapus pita. Semua teknologi makan ini mesti mampu memberi makan kelajuan tinggi, dan penyedia wafer juga diperlukan untuk mengendalikan pelbagai kaedah pakej peranti, seperti: Pakej peranti boleh jadi latar JEDEC, atau wafer kosong, atau bahkan cip lengkap dalam mesin. Tindakan Putar. Let's take an example to illustrate the characteristics of Unovis's bare die feeder (DDF Direct Die Feeder):
1) Can be used in hybrid circuits or sensors, modul-cip-berbilang, system-in-package, RFID and 3D assembly;
2) The disc can be fed vertically to save space, and one machine can install multiple DDFs;
3) The chip can be flipped in DDF;
4) Can be installed on a variety of patch platforms.
8. Requirements for board support and positioning system, beberapa cip penukaran PCB digunakan pada papan sirkuit fleksibel atau papan sirkuit tipis. Pada masa ini, the flat support of the substrate is very important. The solution often uses a carrier plate and a vacuum suction system to form a flat support and positioning system that meets the following requirements:
1) Support control in the Z direction of the substrate, and programming adjustment of the support height;
2) Provide customized board support interface;
3) Complete vacuum generator;
4) Non-standard and standard carrier boards can be applied.
9. Pemeriksaan selepas penyelamatan semula dan penyembuhan penuh, terdapat pemeriksaan yang tidak merusak dan pemeriksaan yang merusak untuk pemeriksaan produk selepas penuh bawah selesai. The non-destructive inspection includes:
1) Use an optical microscope to conduct visual inspection, seperti memeriksa sama ada penumpang mendaki di sisi peranti, sama ada filet pinggir yang baik dibentuk, dan sama ada permukaan peranti itu kotor, dll.;
2) Use an X-ray inspector to check whether the solder joints are short-circuited, buka-sirkuit, ofset, basah, kosong dalam kumpulan askar, dll.;
3) Electrical test (Continuity test), yang boleh uji sama ada ada ada masalah dengan sambungan elektrik. Untuk beberapa papan ujian dengan rancangan rantai daisy, the location of the solder joint failure can also be determined through the continuity test;
4) Use ultrasonic scanning microscope (C-SAM) to check whether there are voids, stratifikasi dan aliran lengkap selepas penuh. Pemeriksaan musnah boleh seksyen kongsi solder atau underfill, kombinasi dengan mikroskopi optik, metallographic microscopy or scanning electron microscopy and energy dispersive analyzers (SEM/EDX) to examine the microstructure of solder joints, e.g., micropecahan/unit synonyms for matching user input, kristalisasi tin, komponen intermetal, keadaan tentera dan basah, sama ada isi bawah mempunyai kosong, cracks, delaminasi, dan sama ada aliran selesai, dll. Kecacatan biasa produk selepas penyelamatan dan proses penyelesaian adalah: jambatan kongsi tentera/sirkuit terbuka, kesakitan tentera miskin basah, kosong kongsi solder/gelembung, pecahan kongsi tentera/kelemahan, underfill and chip delamination and chip cracking, dll. . Untuk keseluruhan isi bawah, whether there are voids, pecahan dan lambat dalam penuh, it needs to be observed by an ultrasonic scanning microscope (C-SAM) or a flat section parallel to the bottom surface of the chip. Kecacatan menambah ke kesulitan. Delaminasi antara bahan penuh bawah dan cip cenderung berlaku di empat sudut peranti tekanan atau di antaramuka kongsi penuh dan askar.
Flip-chip untuk PCB telah menunjukkan keuntungan dalam terma kos produk, performances and high-density packaging, dan aplikasinya secara perlahan-lahan menjadi mainstream. Kerana saiz kecil cip-balik yang digunakan untuk Papan PCBs, perlu memastikan ketepatan tinggi, keuntungan tinggi dan kemampuan ulang tinggi, yang membawa cabaran kepada peralatan dan proses tradisional, which are reflected in the following aspects:
1) The design of the substrate (hard board or soft board);
2) Assembly and inspection of equipment;
3) Manufacturing process, proses lekapan cip, Proses penghasilan PCB, SMT process;
4) Material compatibility.
Name Papan PCB.