Dengan pembangunan cepat teknologi mikroelektronik, aplikasi luas sirkuit terpasang skala besar dan skala ultra besar, dan kemajuan teknologi pemasangan mikro, pembangunan papan sirkuit PCB HDI sedang berkembang menuju arah lapisan dan berbilang fungsi, dan wayar grafik papan sirkuit PCB adalah tipis dan mikroporous dengan jarak sempit. Teknologi pengeboran mekanik yang digunakan dalam pemprosesan tidak lagi boleh memenuhi keperluan dan telah dengan cepat mengembangkan kaedah pemprosesan mikrolubang baru, iaitu teknologi pengeboran laser.
Prinsip Formasi Lubang Laser untuk PCB HDI
Laser adalah sinar cahaya yang kuat yang disembunyikan oleh stimul luar untuk meningkatkan tenaga, di mana cahaya inframerah dan kelihatan mempunyai tenaga panas dan cahaya ultraviolet mempunyai tenaga optik. Terdapat tiga fenomena yang berlaku apabila jenis cahaya ini menyerang permukaan bahagian kerja: refleksi, absorpsi dan penetrasi.
Dengan memukul titik laser pada substrat melalui potongan optik lain, terdapat banyak mod komposisi, dan terdapat tiga tindakan balas dengan titik cahaya.
Fungsi utama pengeboran laser adalah untuk membuang dengan cepat bahan substrat yang akan diproses. Ia bergantung pada ablasi fototermal dan ablasi fotokimia atau yang disebut excision.
1. Ablasi fototermal: prinsip lubang terbentuk oleh bahan yang sedang diproses yang menyerap cahaya laser tenaga tinggi dan dipanas untuk mencair dan menghisap dalam masa yang sangat singkat. Di bawah tindakan tenaga tinggi, sisa berwarna hitam di dinding pori yang terbentuk oleh proses ini mesti dibersihkan sebelum porisasi.
2. Ablasi fotokimia: merujuk kepada tenaga foton tinggi di kawasan ultraviolet melebihi 2eV volts elektron. Hasil foton tenaga tinggi dengan panjang gelombang laser lebih 400 nanometer. Foton tenaga tinggi ini menghancurkan rantai molekul panjang bahan organik dan menjadi partikel yang lebih kecil, tetapi tenaga adalah lebih besar daripada molekul asal, dan ia dipaksa untuk melarikan diri daripadanya, sehingga bahan substrat cepat dibuang dan mikroporo dibentuk di bawah pinch luar.
Oleh itu, jenis proses ini tidak mengandungi mendidih dan tidak akan berlaku karbonisasi. Oleh itu, pembersihan pre-porosisi sangat mudah.
Ini adalah prinsip asas pembentukan pori laser. Pada masa ini, terdapat dua kaedah pengeboran laser yang paling biasa digunakan: laser yang digunakan untuk lubang pengeboran dalam papan sirkuit cetak kebanyakan terdiri dari laser gas CO2 teruja RF dan laser Nd:YAG kuat UV.
3. Tentang penyorban plat asas: Kadar kejayaan laser mempunyai hubungan langsung dengan penyorban bahan asas. Papan sirkuit cetak adalah kombinasi foil tembaga, kain kaca dan resin. Penyerapan tiga bahan ini berbeza mengikut panjang gelombang, tetapi foil tembaga dan kain kaca adalah 0.3 m dalam cahaya ultraviolet. μ Kawasan berikut mempunyai kadar penyorban yang lebih tinggi, tetapi jatuh dengan tajam selepas memasuki cahaya yang kelihatan dan IR. Bahan resin organik menyimpan kadar penyorban yang cukup tinggi dalam semua tiga segmen spektral. Ini adalah karakteristik bahan resin dan dasar popularitas teknologi pengeboran laser.
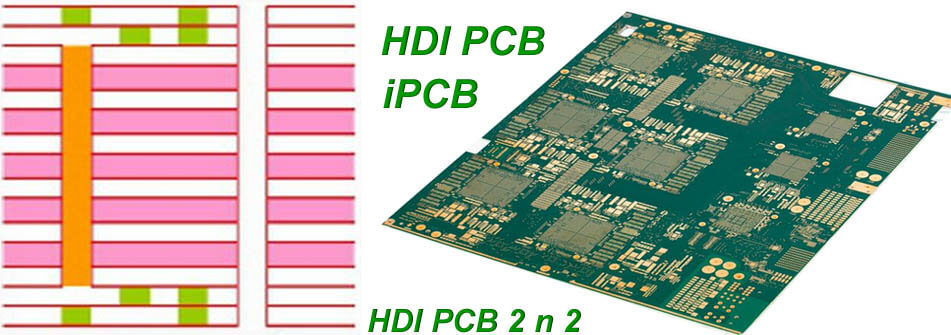
Proses PCB HDI berbeza untuk Formasi Lubang Laser CO2
Ada dua kaedah pengeboran utama untuk pengeboran laser CO2, pengeboran langsung dan pengeboran topeng pakaian. Teknologi yang disebut pembentukan lubang langsung adalah untuk modulasi diameter cahaya laser melalui sistem kawalan utama peranti ke diameter yang sama dengan lubang pada papan sirkuit cetak, dan secara langsung memproses lubang di permukaan dielektrik tanpa foil tembaga. Proses topeng penutup adalah untuk menutup permukaan papan cetak dengan topeng istimewa, dan buang foil tembaga dari permukaan lubang dengan eksposisi/pembangunan/etching dengan proses konvensional. Lubang-lubang ini kemudian diadrasikan dengan sinar laser yang lebih besar daripada terbuka untuk membuang resin lapisan dielektrik yang terkena. Berikut diterangkan secara terpisah:
1. Kaedah pembukaan tetingkap bronz:
Tekan pertama lapisan foil tembaga resin meliputi RCC pada panel dalaman. Tetingkap dibuat oleh fotokimia, kemudian resin dicetak untuk mengekspos ia, dan kemudian bahan substrat di dalam tetingkap dibolehkan oleh laser untuk membentuk lubang mikrobuta:
Apabila cahaya ditambah, ia melewati terbuka untuk mencapai dua kumpulan pemindai mikro-reflektif jenis galvanometer, yang dijajarkan secara menegak sekali ke Lens F θ positif. Kawasan tabung telah mencapai di mana countertop yang menarik boleh dibuat, dan kemudian lubang mikrobuta dibakar satu per satu.
Setelah ditempatkan oleh sinar pantas elektron di kawasan tubular inci-kuasa dua, lubang buta 0.15 mm boleh ditembak dengan tiga tembakan. Lebar denyut pistol pertama adalah kira-kira 15 μ S, yang menyediakan tenaga untuk formasi lubang. Selepas itu, pistol boleh digunakan untuk membersihkan sisa di bawah dinding lubang dan untuk membetulkan lubang.
Sekatan salib SEM dan paparan penuh 45 darjah dari lubang mikro-buta 0.15 mm dengan kawalan tenaga laser yang baik. Proses pembukaan tetingkap ini digunakan sebagai plat sasaran belakang. Apabila penetapan besar atau lubang buta tertib kedua tidak diperlukan sering, penyesuaian mereka sukar.
2. Membuka kaedah proses tetingkap:
Diameter lubang terbentuk oleh proses sebelumnya sama dengan yang bagi tetingkap tembaga terbuka. Kesalahan kecil dalam operasi boleh menyebabkan kedudukan tetingkap terbuka menyimpang, yang menyebabkan penyesuaian kedudukan lubang buta dengan tengah pad asas. Perbezaan tetingkap tembaga mungkin disebabkan pengembangan dan kontraksi bahan matriks dan penyelesaian negatif yang digunakan untuk pemindahan imej. Jadi proses untuk membuka tetingkap tembaga besar adalah untuk memperbesar diameter tetingkap tembaga kepada 0.05 mm lebih besar daripada pad asas. Biasanya, saiz lubang ditentukan oleh saiz lubang. Apabila lubang adalah 0,15 mm, diameter pad asas sepatutnya sekitar 0,25 mm, dan diameter tetingkap besar sepatutnya 0,30 mm. Kemudian pengeboran laser boleh dilakukan untuk mengajar kedudukan pembakaran tepat ke lubang mikrobuta pad asas. Ciri-ciri utamanya ialah ia mempunyai darjah besar kebebasan untuk dipilih. Apabila menggali lubang laser, anda boleh pilih untuk tekan program pad dasar dalaman untuk membuat lubang. Ini secara efektif mengelakkan kesalahan disebabkan oleh diameter yang sama tetingkap tembaga dengan tetingkap lubang, yang menghalang titik laser daripada menunjuk pada tetingkap depan, dan menyebabkan banyak lubang setengah yang tidak lengkap atau lubang sisa muncul pada seri besar slabs.
3. Proses Pembentukan Poro Langsung pada permukaan Resin PCB HDI
Terdapat beberapa jenis kaedah pengeboran laser menggunakan laser PCB HDI untuk pengeboran lubang:
A. Plat asas dikelilingi dengan foil tembaga yang dikelilingi resin pada lapisan dalaman, dan kemudian dicat off semua foil tembaga, laser CO2 boleh digunakan untuk membentuk lubang secara langsung di permukaan tembaga kosong, dan kemudian lubang boleh dikendalikan lebih lanjut mengikut proses penutup.
B. Plat asas adalah proses yang sama menggunakan helaian FR-4 setengah-sembuh dan foli tembaga selain dari foli tembaga meliputi resin.
C. Proses untuk laminasi foil tembaga berikutnya dengan resin fotosensitif tertutup.
D. Dibuat dengan filem kering sebagai lapisan dielektrik dan proses tekan foil tembaga.
E. Proses untuk menutupi jenis lain filem hangat dengan foil tembaga.
4. Ablasi langsung foil tembaga ultra-tipis
Selepas foil tembaga resin ditekan pada kedua-dua sisi plat inti dalam, tebal foli tembaga 17 m boleh dikurangkan kepada 5 mikron dengan kaedah "setengah etching", dan kemudian dirawat dengan oksidasi hitam, lubang boleh dicipta oleh laser CO2.
Prinsip asas ialah permukaan hitam oksidasi akan menyerap cahaya secara intens, sehingga foil tembaga super tipis dan permukaan resin boleh secara langsung pori pada premis untuk meningkatkan tenaga cahaya laser CO2. Bagaimanapun, perkara yang paling sukar adalah memastikan bahawa "kaedah setengah etching" boleh mendapatkan lapisan tembaga tebal secara seragam, jadi perhatian istimewa perlu diberikan kepada pembuatan mereka. Sudah tentu, bahan yang boleh dicabut oleh tembaga UTC. Foil tembaga sama dengan buku sekitar 5um.
Menurut jenis pemprosesan piring ini, aspek utama berikut sedang diterima dalam proses ini:
Ini terutama menetapkan kualiti ketat dan kriteria teknikal bagi penyedia bahan untuk memastikan bahan perbezaan tebal lapisan dielektrik adalah 510 μ M hingga M. Kerana hanya keseluruhan tebal dielektrik foil tembaga meliputi resin boleh dijamin, akurat laluan dan bersih bawah lubang boleh dijamin dengan tenaga laser yang sama. Pada masa yang sama, perlu menerima syarat proses terbaik untuk membuang tanah pengeboran dalam operasi berikutnya untuk memastikan bahawa bawah lubang buta bersih dan bebas dari sisa selepas pengeboran laser. Ia mempunyai kesan yang baik pada kualiti lubang buta platting tanpa elektro dan elektroplating.
Nd:YAG Proses PCB Pemacu Laser HDI
Nd:YAG adalah garnet aluminium neodymium dan yttrium. Laser UV yang dikeluarkan oleh dua kristal kuat bersama-sama. Baru-baru ini, cahaya laser yang paling biasa digunakan teruja oleh denyutan dioda boleh digunakan untuk membuat sistem penyegelan laser yang efektif tanpa sejuk air. Panjang gelombang harmonik ketiga laser ini adalah 355 nanometer. Panjang gelombang harmonik keempat ialah 266 nanometer. Panjang gelombang diubahsuai oleh kristal optik.
Ciri-ciri terbesar jenis pengeboran laser ini adalah UV ultraviolet. Kawasan spektrum, sementara foli tembaga dan serat kaca yang terdiri dari laminat-clad tembaga menyerap kuat di kawasan ultraviolet, bersama dengan tenaga kecil titik cahaya laser seperti itu, mereka boleh menembus kuat melalui foli tembaga dan kain kaca dan membentuk lubang langsung. Kerana panas laser jenis di atas adalah kecil, ia tidak menghasilkan sampah charcoal selepas pengeboran laser CO2, yang menyediakan permukaan yang baik untuk operasi dinding lubang berikutnya.
Nd:YAG proses teknologi laser logo lubang buta dan melalui lubang pada berbagai bahan. Ia berlatih melalui lubang dalam laminat lapisan tembaga poliimid dengan diameter minimum 25 mikron. Dari analisis kos, diameter paling ekonomi digunakan adalah 25125 mikron. Kelajuan pengeboran adalah 10000 lubang/min. Pukulan laser langsung boleh digunakan dengan terbuka maksimum 50 mikron. Permukaan dalaman lubang terbentuk bersih dan bebas karbonisasi dan mudah untuk elektroplak. Ia juga boleh menggali lubang dalam laminat lapisan tembaga PTFE dengan diameter minimum 25 mikron dan diameter paling ekonomi 25125 mikron. Kelajuan pengeboran adalah 4500 lubang/min. Tiada prasetching tetingkap diperlukan. Lubang ini bersih dan tidak memerlukan keperluan pemprosesan khas. Terdapat bahan lain seperti pemprosesan lubang bentuk. Proses berikut boleh digunakan dalam proses khusus: 1. Dua proses bergabung diterima mengikut kelajuan dua jenis pengeboran laser
Kaedah operasi asas ialah menggunakan YAG untuk mematikan foil tembaga pada permukaan kedudukan lubang dahulu, dan kemudian menggunakan laser CO2 yang lebih cepat daripada pengeboran YAG untuk mematikan resin secara langsung untuk membentuk lubang.
Masalah Kualiti dalam penghasilan PCB HDI Sebenarnya
Dalam proses pengeboran laser, terdapat banyak masalah kualiti, yang tidak bersedia untuk diterangkan sepenuhnya. Hanya masalah kualiti yang paling umum ditetapkan untuk rujukan rakan.
A. Kesalahan antara kedudukan pengeboran laser CO_2 dan kedudukan sasaran bawah dalam kaedah tetingkap terbuka
Dalam pengeboran laser PCB HDI, sistem posisi cahaya sangat penting untuk ketepatan bentuk terbuka. Walaupun sistem posisi sinar digunakan untuk posisi tepat, api dengan bentuk lubang sering dihasilkan kerana faktor lain. Masalah kualiti yang muncul dalam proses produksi dianalisis sebagai berikut:
1. Buat negatif untuk pad penyelut plat inti dalaman dan grafik wayar, dan RCC dengan foil tembaga meliputi resin. Negatif untuk membuka tetingkap selepas tambahan lapisan, kerana kedua-dua faktor berpotensi untuk meningkat saiz dan menurun kerana kelembapan dan suhu.
2. Saiz bahan asas meningkat atau berkurang apabila plat inti digunakan untuk membuat corak pad ikatan melalui, dan RCC dari foil tembaga meliputi resin ditekan pada suhu tinggi. Selepas tambah lapisan, faktor pengembangan dimensi dan kontraksi bahan dasar dalam dan luar wujud.
3. Saiz dan kedudukan tetingkap tembaga dicat juga akan menyebabkan ralat.
4. Ralat disebabkan oleh titik cahaya laser sendiri dan pemindahan permukaan.
5. Jajaran lubang buta peringkat kedua lebih sukar dan boleh menyebabkan kesilapan kedudukan.
Berdasarkan sebab-sebab di atas, menurut data teknikal yang relevan yang diperoleh dalam produksi dan pengalaman operasi sebenar, strategi teknologi utama yang diterima adalah sebagai berikut:
1. Untuk mengurangi saiz penetapan, kebanyakan penghasil PCB HDI menggunakan 450 untuk penetapan multi-lapisan * 600 atau 525 * 600mm. Bagaimanapun, bagi panel telefon bimbit dengan lebar wayar 0,10 mm dan diameter lubang buta 0,15 mm, saiz bentangan terbaik adalah 350. * 450mm. Had atas.
2. meningkatkan diameter laser: tujuan adalah meningkatkan kawasan yang ditutup oleh tetingkap tembaga. Kaedah khusus adalah "diameter cahaya = diameter lubang + 90~100" μM. Apabila ketepatan tenaga rendah, tembak satu atau dua tembakan lagi untuk menyelesaikan masalah.
3. Ambil proses membuka tetingkap tembaga besar: pada masa ini, hanya saiz tetingkap tembaga menjadi lebih besar dan bukaan tidak berubah, jadi diameter lubang laser tidak lagi ditentukan sepenuhnya oleh kedudukan tetingkap, sehingga kedudukan lubang boleh berdasarkan secara langsung pada kedudukan sasaran asas pada plat inti.
4. Mengubah kaedah pembukaan tetingkap dari imej fotokimia dan pencetakan ke laser YAG: menggunakan titik cahaya laser YAG untuk membuka tetingkap menurut lubang asas plat inti terlebih dahulu, kemudian menggunakan laser CO2 untuk membakar lubang di posisi tetingkap, untuk menyelesaikan ralat disebabkan imej.
5. Lapisan dua kali untuk membuat kaedah lubang-buta-mikro tertib kedua: apabila plat inti dikelilingi dengan foil tembaga resin RCC pada kedua-dua sisi. Selepas itu, jika RCC akan dikumpulkan sekali lagi dan dibuat lubang buta peringkat kedua, lubang buta peringkat kedua akan dikumpulkan. Dalam kes penyesuaian "dua" lubang buta, lubang mesti bentuk dengan tujuan "satu per satu". Sasaran asal plat inti tidak dapat digunakan semula. Apabila "mengumpulkan satu" ke dalam lubang dan pads, pinggir papannya juga akan membuat sasaran. Oleh itu, selepas menekan RCC dari "Ji 2", empat lubang data mekanik tambahan dari "Ji 2" boleh dibuang melalui mesin sinar-X untuk sasaran pada "Ji 1", dan kemudian lubang-lubang ditutup. Kaedah ini boleh membuat "Ji 2" sepanjang mungkin dengan "Ji 1".
B. Laluan yang salah
Berdasarkan banyak pengalaman produksi, terutama kerana masalah kualiti dalam bentuk bahan asas, masalah kualiti utama ialah bahawa tebal lapisan dielektrik selepas tekanan foil tembaga meliputi resin tidak akan berubah. Dengan tenaga yang sama lubang pengeboran, bantal bahagian yang lebih tipis lapisan dielektrik tidak hanya akan membawa lebih tenaga, tetapi juga merefleksikan lebih tenaga. Jadi, dinding lubang dipukul ke dalam kedel yang berkembang. Ini akan mempunyai kesan yang signifikan pada kualiti sambungan elektrik antara lapisan lapisan berbilang lapisan.
Kerana saiz pori yang salah, kepercayaan struktur sambungan densiti tinggi papan sirkuit cetak berbilang lapisan (MLPCB) akan menimbulkan sejumlah masalah teknikal.
Oleh itu, tindakan proses mesti diterima untuk mengawal dan menyelesaikan masalah. Proses berikut terutama digunakan:
1. Kawalan secara ketat perbezaan tebal lapisan dielektrik antara foli tembaga meliputi resin dan foli tembaga laminasi pada 510 μ M hingga M.
2. Ubah ketepatan tenaga laser dan bilangan senjata tertekan. Kondisi proses untuk produksi massa boleh ditemui melalui kaedah ujian.
3.The slag at the bottom of the hole and the broken slag at the wall of the hole are not removed properly.
Jenis masalah kualiti PCB HDI ini mungkin berlaku kerana kawalan yang sedikit tidak sesuai. Terutama untuk laminat dengan jenis porous pada piring besar, mustahil untuk menjamin kualiti 100% tanpa masalah kualiti. Ini kerana bilangan lubang-buta mikro pada stensil besar yang diproses terlalu besar, berrata-rata sekitar 60-90,000 lubang. Ketebusan lapisan media berbeza, begitu juga ketebusan sisa yang ditinggalkan di dasar apabila pengeboran laser dengan tenaga yang sama digunakan. Tidak mungkin untuk memastikan semua sisa bersih selepas rawatan tanah menggali. Selain itu, kaedah pemeriksaan yang buruk sering mengakibatkan penapisan tembaga HDI PCB kemudian dan ikatan antara pad bawah dan dinding lubang apabila ada cacat.