Многочиповое инкапсуляция (MCP) уже давно удовлетворяет потребность в более высокой производительности и функциональности во все меньшем пространстве (PCB). Естественно ожидать, что MCP памяти будет расширен, чтобы включать ASIC, такие как базовые полосы или мультимедийные процессоры. Но это также сопряжено с трудностями, а именно с высокими затратами на разработку и владение / сокращение затрат. Как решить эти проблемы? Концепция каскадной упаковки IC (POP) получила широкое признание в отрасли.
POP (Packaging on Packaging), также известный как стек компонентов, также известный как упаковочный слой. POP - это пакет, состоящий из двух или более bga (пакетов с шаровой решеткой), сложенных вместе. Как правило, структура пакетного пакета POP использует структуру BGA, которая включает в себя высокоплотное цифровое или гибридное сигнальное логическое устройство на дне пакета POP для удовлетворения характеристик многоштыревого логического устройства. POP, как новая высокоинтегрированная форма упаковки, в основном используется в современных смартфонах, цифровых камерах и других портативных электронных продуктах, играет очень широкую роль.

MCP - это гибридная технология, которая складывает различные типы запоминающих или не запоминающих чипов разных размеров вертикально в пластиковые корпуса. Это позволяет экономить пространство для небольших печатных плат PCB.
С точки зрения архитектуры, SIP - это интеграция нескольких функциональных чипов, включая процессоры, память и другие функциональные чипы, в один пакет для достижения базовой полной функциональности. С точки зрения конечной электроники, SIP фокусируется не только на производительности / энергопотреблении самого чипа, но и на реализации всей конечной электроники короткого, тонкого, многофункционального и низкого энергопотребления. С появлением легких продуктов, таких как мобильные устройства и носимые устройства, спрос на SIP становится все более очевидным.
Основная концепция SoC заключается в интеграции большего количества устройств на одном и том же голом металлическом чипе для достижения целей сокращения размеров, повышения производительности и снижения затрат. Однако на рынке мобильных телефонов с коротким жизненным циклом проекта и высокой стоимостью решения SOC имеют большие ограничения. С точки зрения конфигурации памяти, различные типы памяти требуют много логики, и овладение различными правилами и методами проектирования может быть очень сложным, влияя на время разработки и гибкость, необходимую приложениям.
SOC и SIP
SOC очень похож на SIP, потому что оба объединяют системы, содержащие логические компоненты, компоненты памяти и даже пассивные компоненты в один блок. С точки зрения дизайна, SOC - это высокая степень интеграции компонентов, необходимых для системы на чипе. С точки зрения инкапсуляции, SIP - это метод параллельной или суперпозиции для различных чипов. Это единый стандартный пакет, который объединяет несколько активных электронных компонентов с различными функциями, факультативными пассивными устройствами и другими устройствами, такими как MEMS или оптические устройства, для достижения определенных функций.
Что касается интеграции, то, как правило, SoC интегрирует только логические системы, такие как AP, в то время как SIP интегрирует AP + MobileDR. В некотором смысле SIP = SoC + DDR. По мере роста интеграции в будущем EMMC, скорее всего, будет интегрирован в SIP. С точки зрения развития упаковки, из - за требований электроники с точки зрения объема, скорости обработки или электрических характеристик, SOC был определен в качестве фокуса и направления будущего дизайна электроники. Тем не менее, с ростом производственных издержек SOC в последние годы и частым появлением технических барьеров развитие SOC сталкивается с узкими местами, в результате чего развитие SIP привлекает все большее внимание промышленности.
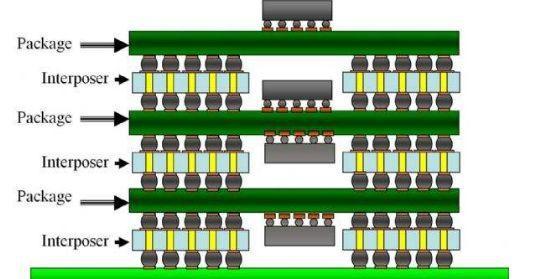
Путь развития MCP к POP
Комбинированная память (Flash + RAM), объединяющая несколько Flash NOR, NAND и RAM в одном пакете, широко используется в мобильных приложениях. Эти однопакетные решения включают в себя многочиповую упаковку (MCP), системную упаковку (SIP) и многочиповый модуль (MCM).
Потребность в предоставлении большего количества функций на все более маленьких телефонах является основной движущей силой роста MCP, но разработка решений для повышения производительности при сохранении небольших размеров является сложной задачей. Проблема не только в размерах, но и в производительности, например, при использовании базового чипсета или мультимедийного сопроцессора в телефоне используется память MCP с интерфейсами SDRAM и DDR.
Пакет POP - это отличный способ миниатюризации с высокой степенью интеграции. В пакетной упаковке внешняя упаковка (POP) становится все более важной в индустрии упаковки, особенно в мобильных приложениях, из - за ее способности складывать логические элементы с высокой плотностью.
Преимущества POP - упаковки
Оборудование для хранения и логическое оборудование могут быть протестированы или заменены отдельно для обеспечения производительности;
Двухэтажная упаковка POP экономит площадь фундамента, а большее продольное пространство позволяет увеличить количество слоев упаковки;
Смешивание DRAM, DDRAMSRAM, FLASH и микропроцессоров вдоль продольного PCB;
4. для чипов разных производителей, обеспечивая гибкость дизайна, можно просто смешать для удовлетворения потребностей клиентов, снижая сложность и стоимость дизайна;
В настоящее время технология может использоваться для покрытия и сборки слоистых чипов в вертикальном направлении;
Электрические соединения, сложенные между верхними и нижними устройствами, обеспечивают более быструю скорость передачи данных и могут справляться с высокоскоростным взаимодействием между логическими устройствами и запоминающими устройствами