Adının önerildiği gibi çepi çevirin ön tarafı (IC devresinin yapıldığı tarafı) aparatıyla bağlantılı bir paketleme yöntemidir. Elektrikli sinyal terminalleri geleneksel solder tarafından yapılır ve substrat ile bağlantılı olabilir. Bu tür bağlantılarda, girdi ve çıkış terminalleri (I/O) bütün çipini kapatabilir, yani aynı çukurda bile, dönüş çipinin bağlantısının yoğunluğu kablo bağlantısından çok daha yüksektir. Tel bağı bağlantısında, I/O sadece çip etrafında ayarlanabilir. Bu yüzden, saçmalığın ne kadar küçük olduğuna rağmen, dönüştürücü çip bağlantısının I/O yoğunluğu başarılamaz. Sonra teknolojisi tüm dönüştürme çip bağlantısı teknolojisinin anahtarı.
Wafer Bumping Teknolojisi'nin öngörüntüsüThe key to making wafer bumps is to deposit an under bump metal layer (UBM). İlk günlerde IBM tarafından kullanılan terim, bağlantı için bir bağlantı katmanı sağlamak için, topun sınırlı metallisasyon katmanı (BLM) olduğunu belirtmeli. Atomik fışkırma barrier katmanı temel metal yapısına engel etmek için atom maddelerinin fışkırmasını sağlayacaktır; Düzenli dielektrik materyal ve metal bir adhesion katmanı sağlar ve bağımsızlıkları dielektrik katmanın yatay yönünde yeraltı metale göndermesini engellemek için engel bir katmanı sağlar.Şu and a kullanılan UBM çoğu süreçler süreçler tarafından yapılır. UBM yapılacak en pahalı etkilidir. Özellikle de tahliye süreciyle karşılaştı. Solder bump yapısının güveniliğini etkileyen en doğrudan faktör UBM üretim kalitesidir. Genellikle konuşurken, UBM yapıları zarar vermeden çoklu (sık olarak 20'e kadar) yenilenmesi gerekiyor. UBM, çöplükler ve metallisasyon katlarını birlikte bağlamak için kullanılan bir yapı olduğundan dolayı, aynı zamanda sıkıcı stres ve tensil stres testlerini geçirmelidir. Mehanik hasar testinde, solder patlama başarısızlığının genel kriterisi çözücüsünde başarısızlığın gerçekleştirilmesidir. Bu yüzden UBM'in yeterli gücü olmalı. Zaman, sıcaklık, yorumluluk ve bias voltasyonu gibi faktörler yüzünden performans degradasyonu olmayacak.
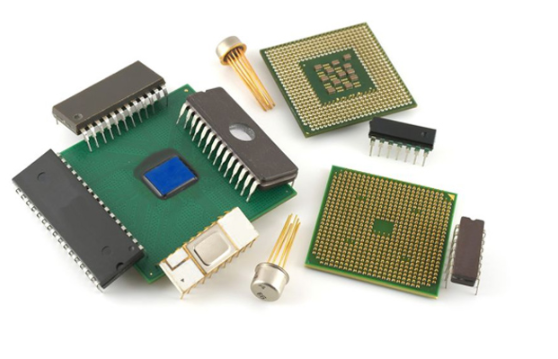
Flip çip pazarının trenleri Flip çip paketlemesi en yayın paketlemek arası bağlantı teknolojisi oldu. Şimdiye kadar, dönüş çipi gerçekten bir tür paketleme, bağlantı teknolojisi değil. Örneğin, Flip Chip Ball Grid Array Packaging (FCBGA) toplantı ve paketleme sürecini tamamlamak için çoğunlukla katlı aparatlı teknolojiyi kullanır, fakat yüksek performanslık integral devre uygulamalarına sınırlı. Bu figur, çevrim bölgelerini gösterir:
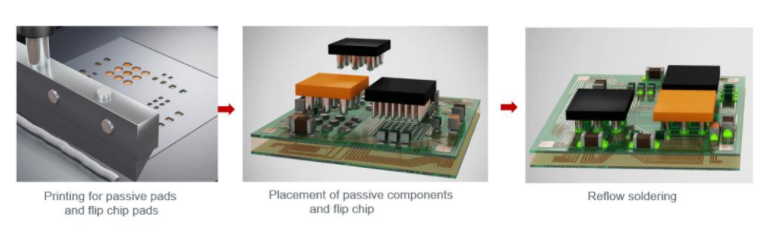
(1) Bump pitch: bump pitch reduction can increase I/O density; (250 mikrondan 125 mikrona hızlı bir değişim);
(2) Solder bump sinking method: evaporation-screen printing-electroplating;
(3) Bump solder composition: high lead content-eutectic-lead-free (Sn-Ag)-Cu column pitch<125 microns;
(4) Paket kompozisyonu: keramik substrat-yüksek yoğunluklar arası bağlantı laminat substrat-preprep laminat substrat-düşük termal genişleme koefitör laminat substrat mi? Kötü süsleme.
(5)Paket yapısı: mühürlenmiş tek çip kapısı
tradisyonel FCCSP pazarlarının uygulaması böyle:
FCCSP uygulama pazarı:
(1) Çip boyutlarına ilişkin yumuşak (I/O) yoğunluğu: çip boyutları için kullanılır >200 I/O veya >5.5mm; Düşük yoğunluk ürünleri daha iyi ve düşük maliyetler için WLCSP kullanır.
(2) Az güç: genel güç<2w bağlı="" on="" chip="" board-level="" packaging="" can="" be="" used="" for="" power="" bare="" fccsp=">2W).
(3) Bölge: El aygıtları için 40nm/65nm teknolojisi çip boyutunu azaltır, ama daha fazla I/O, periferik I/O'yu ayarlamak için yeterli bölge yok. Bu yüzden, bölgeyi yukarı çıkarmak için aparatı kullanmak gerekli.
(4) Ödül: Yüksek-I/O küçük boyutlu çipler için yeterli periferik bölge, Au çizgi maliyeti ve ön tarafından büyük büyük yüksek süsler rekabetçe fiyatlı FCCSP geliştirmesini sağlayacak.
(5) Molding, test ve tutmak kolay, ortak formu CABGA ile aynı.
Toplam
Flip çipi her zaman heyecan verici bir paketleme teknolojisi oldu. Fakat geleneksel tel bağlama paketlerine karşılaştırıldığında, maliyeti sınırları genel bir teknoloji olmak için çepi dönüştürüyor. Ancak, maliyetin sınırları yavaşça yok ediliyor ve strip paketli flip-chips kullanımı, maliyetlerini önemli olarak azalttı. laminat substratları en çok ürün maliyeti için hesaplanmış olduğundan beri, laminat substratların maliyetini azaltmak en etkili yoludur.
Ayrıca, FPFC tasarımı için, Amkor, mevcut bölge dizisini fin bir dizayna dönüştürmek için çok araştırma yaptı. Araştırmaların %80'i, metal katmanın azaltılmasına ve dış boyutunun azaltılmasına neden olan substratın maliyetini azaltır. Flip-chip paketleme ilaçlarının maliyetini azaltarak (maliyeti en yüksektir), diğer pazarlarda geniş kullanılan flip-chip paketlemesi olabilir.