Per ulteriori informazioni sulla capacità tecnica dei substrati IC, fare clic su "Download Process Capability DataSheet" per scaricare la documentazione. Vi preghiamo di contattarci se avete domande.
Informazioni sulla scheda del substrato IC, fare clic su: Scheda di sottostrato IC
Se ha difficoltà con la progettazione del substrato, Fare clic per scaricare IC Substrate Design Rules: ![]()
o contattare gli ingegneri iPCB per aiuto, email: eng-ic@ipcb.com
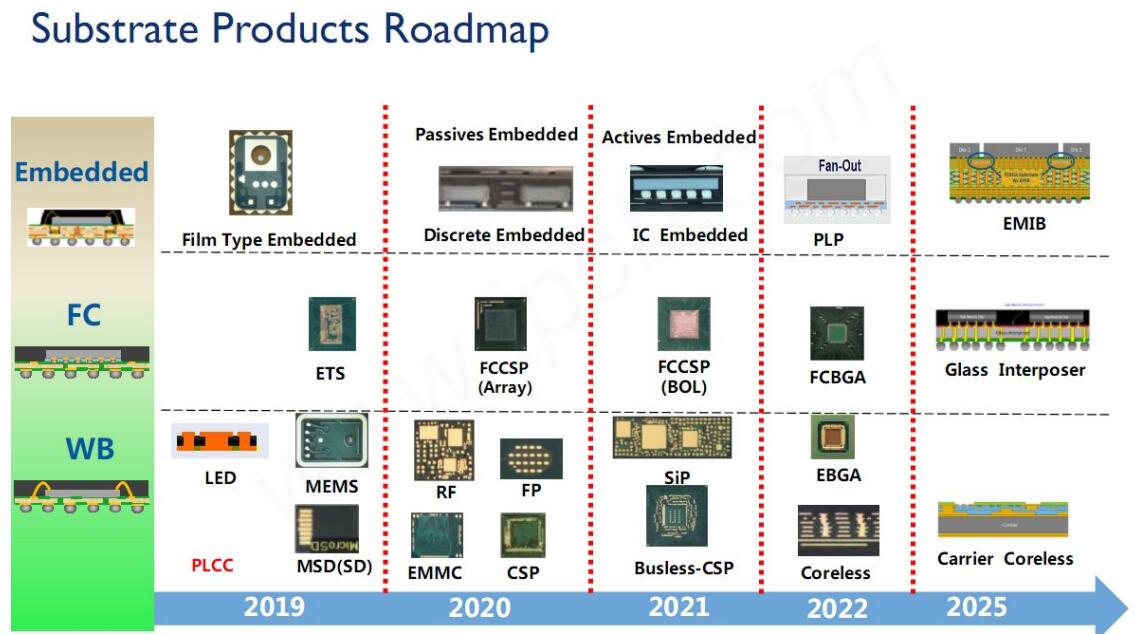

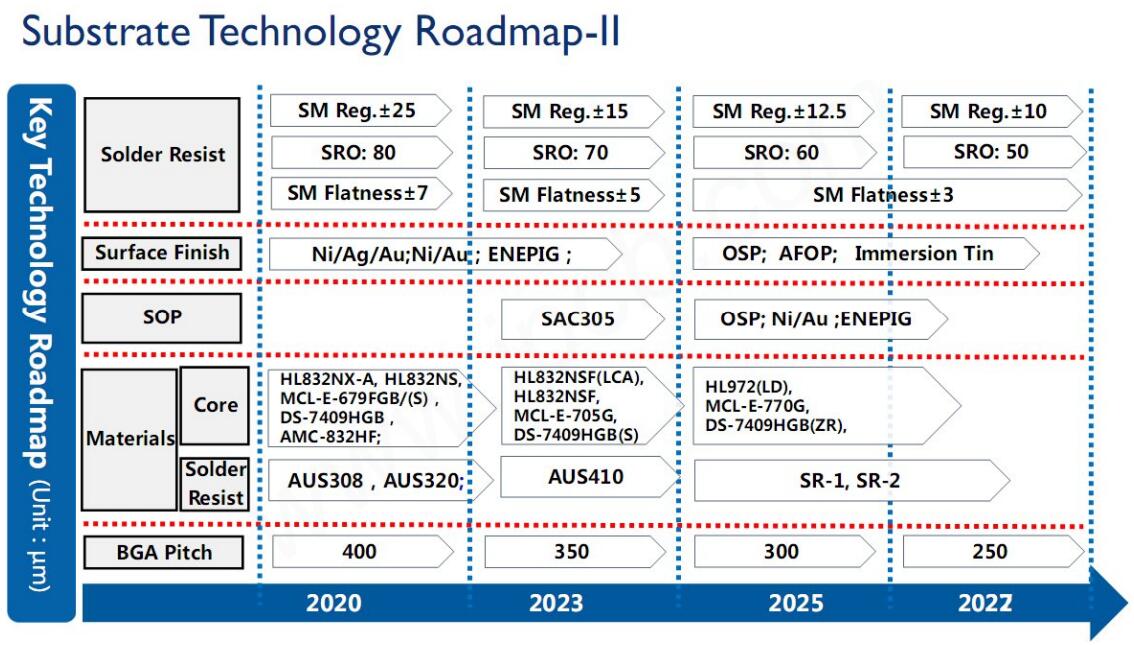
Substrato System-in-Package (SiP)
System-in-package è una piattaforma di sistema che assembla più wafer eterogenei, componenti sensibili, componenti passivi, ecc., in un unico pacchetto. Le sue applicazioni includono modulo multi-chip (MCM), pacchetto multi-chip (MCP), pacchetto chip impilato, pacchetto in pacchetto (PiP) e scheda portante componente incorporata. System-in-package fornisce ai progettisti di sistemi IC un'altra soluzione di integrazione delle funzioni di calcolo oltre a System-on-Chip (SoC). Ha i vantaggi di integrare chip eterogenei provenienti da fonti diverse, essendo più piccoli e sottili, ed entrare rapidamente sul mercato.
SiP può essere un pacchetto planare 2D di modulo multi-chip (modulo multi-chip; MCM) e può anche riutilizzare la struttura 3D del pacchetto per ridurre efficacemente l'area di imballaggio e la sua tecnologia di incollaggio interna può essere pura incollaggio del filo (legame del cavo), FlipChip può anche essere utilizzato, ma i due possono anche essere mescolati. Oltre alle strutture di imballaggio 2D e 3D, un altro modo di integrare componenti con substrati multifunzionali può essere incluso nell'ambito del SiP. Questa tecnologia incorpora principalmente componenti diversi in un substrato multifunzionale e può anche essere considerata come il concetto di SIP per raggiungere lo scopo di integrazione funzionale. Diverse configurazioni di chip e diverse tecnologie di incollaggio interno consentono ai tipi di pacchetti SIP di produrre combinazioni diversificate. iPCB può essere personalizzato o prodotto in modo flessibile secondo le esigenze dei clienti o dei prodotti.
Substrato di plastica del pacchetto dell'array del portone della sfera (PBGA)
Questo è il substrato più basico dell'array del portone della sfera utilizzato nell'incollaggio e nell'imballaggio del filo. Il suo materiale di base è un substrato di lamina di rame impregnato di fibra di vetro. Il substrato di plastica dell'imballaggio dell'array del portone della sfera può essere applicato all'imballaggio del chip con un numero relativamente alto di pin. Quando la funzione del chip viene aggiornata, la struttura tradizionale del pacchetto del telaio del piombo diventa inadeguata con l'aumento del numero di pin di uscita/ingresso e il substrato del pacchetto dell'array della sfera di plastica fornisce una soluzione conveniente.
Substrato del pacchetto della scala del chip di Flip Chip (FCCSP)
Il chip a semiconduttore non è collegato al substrato tramite l'incollaggio del cavo, ma è interconnesso con il substrato da urti in uno stato flip-chip, quindi è chiamato FCCSP (Flip Chip Chip Scale Package). L'imballaggio a livello di wafer Flip-chip mostrerà ulteriormente il vantaggio di costo. Nel recente passato, anche il costo di processo degli urti sui wafer ha continuato a scendere, il che ha anche portato a una riduzione più rapida dei costi di imballaggio. L'imballaggio a livello di chip Flip-chip è diventato un IC ad alto numero di pin.
Substrato del pacchetto dell'array del portone della sfera del chip di capovolgimento (FCBGA)
Il substrato FC-BGA (Flip Chip-Ball Grid Array) è un substrato di pacchetto semiconduttore ad alta densità che può realizzare l'alta velocità e la multifunzionalizzazione dei chip LSI. Il pacchetto dell'array di gate a sfera flip-chip ha prestazioni e vantaggi di costo molto eccellenti nel pacchetto di numeri di pin di uscita / ingresso molto elevati, come un chip come microprocessore o un processore di immagine.
Se avete bisogno di substrato IC, non esitate a contattare iPCB, email: sales@ipcb.com
|
Substrato IC SiP |
Substrato IC BGA |
Substrato del pacchetto eMMC |