1.BGA (matrice della griglia della sfera) è anche chiamato CPAC (vettore della matrice del pad superiore del globo). Visualizzazione di contatti sferici, uno dei pacchetti di montaggio superficiale. Sul retro del circuito stampato, i dossi sferici sono prodotti nella modalità di visualizzazione per sostituire i pin e il chip LSI è assemblato sul lato anteriore del circuito stampato e quindi sigillato dalla resina di stampaggio o dall'imbottitura. Conosciuto anche come Bump Display Carrier (PAC). Il perno può superare 200, che è un pacchetto per LSI multi-pin. Il corpo del pacchetto può anche essere reso più piccolo di QFP (Quad Flat Package). Ad esempio, un BGA a 360 pin con una distanza del centro del perno di 1.5mm è solo 31mm quadrato, mentre un QFP a 304 pin con una distanza del centro del perno di 0.5mm è 40mm quadrato. E BGA non deve preoccuparsi di deformazione del perno come QFP.
Questo pacchetto è stato sviluppato dalla Motorola Company degli Stati Uniti, ed è stato inizialmente adottato nei telefoni portatili e altri dispositivi, e poi reso popolare nei personal computer. Inizialmente, la distanza centrale del perno BGA (bump) era di 1,5 mm e il numero di pin era di 225. Ci sono anche alcuni produttori di LSI che stanno sviluppando BGA a 500 pin. Il problema con BGA è l'ispezione visiva dopo la saldatura a riflusso. American Motorola Company si riferisce al pacchetto sigillato con resina stampata come OMPAC, mentre il pacchetto sigillato con metodo di potting è chiamato GPAC.
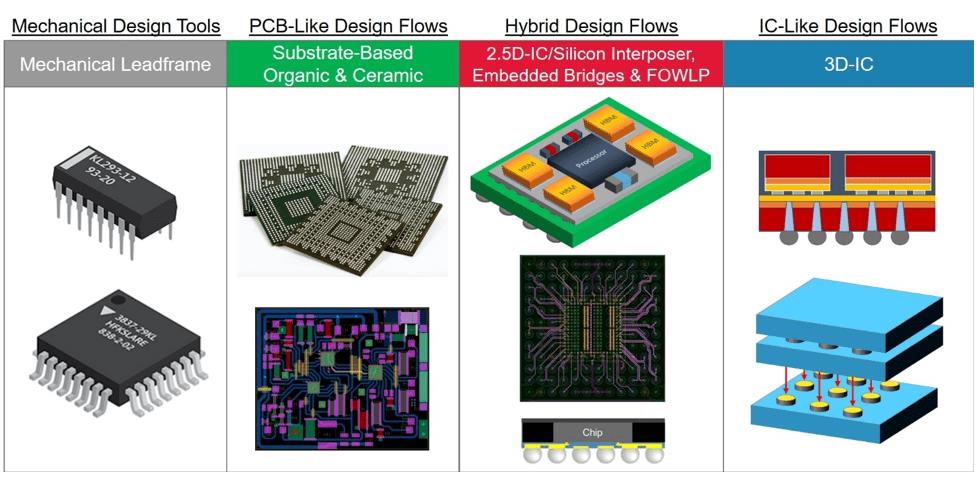
2.Cï¼ (ceramica) rappresenta il marchio del pacchetto ceramico. Ad esempio, CDIP sta per ceramica DIP. È un marchio che viene spesso utilizzato nella pratica.
3.COB (chip on board) chip on board packaging è una delle tecnologie di montaggio del chip nudo. Il chip a semiconduttore viene consegnato e montato sul circuito stampato. Il collegamento elettrico tra il chip e il substrato è realizzato mediante cuciture a filo e rivestito con resina per garantire affidabilità. Sebbene COB sia la più semplice tecnologia di montaggio a chip nudo, la sua densità di imballaggio è molto inferiore alla tecnologia di incollaggio TAB e flip-chip.
4.DIP (pacchetto doppio in linea) pacchetto doppio in linea. Uno dei pacchetti plug-in, i perni sono disegnati da entrambi i lati della confezione e i materiali della confezione sono plastica e ceramica. I produttori europei di semiconduttori utilizzano principalmente DIL. DIP è il pacchetto plug-in più popolare e la sua gamma di applicazioni include IC logici standard, LSI di memoria e circuiti microcomputer. La distanza del centro del perno è di 2,54 mm e il numero di pin è da 6 a 64. La larghezza del pacchetto è solitamente 15.2mm. Alcuni pacchetti con larghezze di 7,52 mm e 10,16 mm sono chiamati SK-DIP (skinny dual in-line package) e SL-DIP (slim dual in-line package) small-body DIP rispettivamente. Ma nella maggior parte dei casi, non viene fatta alcuna distinzione, e sono semplicemente indicati collettivamente come DIP. Inoltre, il DIP ceramico sigillato con vetro a bassa fusione è chiamato anche Cerdip (vedere 4.2).
4.1DIC (doppio pacchetto ceramico in linea) Un altro nome per DIP (compresa la guarnizione di vetro) del pacchetto ceramico.
4.2Cerdip: Pacchetto ceramico dual-in-line sigillato con vetro, utilizzato per ECL RAM, DSP (processore di segnale digitale) e altri circuiti. Cerdip con finestra di vetro è utilizzato per EPROM cancellabile ultravioletto e circuito del microcomputer con EPROM all'interno. La distanza del centro del perno è di 2,54 mm e il numero di pin è da 8 a 42. In Giappone, questo pacchetto è espresso come DIP-G (G significa guarnizione di vetro).
4.3SDIP (Shrink dual in-line package) Shrink DIP. Uno dei pacchetti plug-in, la forma è la stessa del DIP, ma la distanza del centro del perno (1.778 mm) è più piccola del DIP (2.54mm), quindi si chiama questo. Il numero di pin varia da 14 a 90. Ci sono due tipi di ceramica e plastica. Conosciuto anche come SH-DIP (shrink dual in-line package)
5.flip-chipFlip-saldare il chip. Una delle tecnologie di imballaggio del chip nudo è quella di fare urti metallici nell'area dell'elettrodo del chip LSI e quindi collegare gli urti metallici all'area dell'elettrodo sul substrato stampato mediante saldatura a pressione. L'impronta del pacchetto è fondamentalmente la stessa della dimensione del chip. È la più piccola e sottile di tutte le tecnologie di imballaggio. Tuttavia, se il coefficiente di espansione termica del substrato è diverso da quello del chip LSI, si verificherà una reazione al giunto, che influenzerà l'affidabilità della connessione. Pertanto, è necessario utilizzare resina per rafforzare il chip LSI e utilizzare un materiale di substrato con sostanzialmente lo stesso coefficiente di espansione termica.
6.FP (pacchetto piatto) Pacchetto piatto. Uno dei pacchetti di montaggio superficiale. Un altro nome per QFP o SOP (vedere QFP e SOP). Alcuni produttori di semiconduttori usano questo nome.
7.H-(con dissipatore di calore) Indica un segno con un radiatore. Ad esempio, HSOP significa SOP con dissipatore di calore.
8.MCM (modulo multi-chip) componenti multi-chip. Un pacchetto in cui più chip nudi a semiconduttore sono assemblati su un substrato di cablaggio. Secondo il materiale del substrato, può essere diviso in tre categorie: MCM-L, MCM-C e MCM-D. MCM-L è un componente che utilizza un circuito stampato multistrato epossidico di vetro comune. La densità di cablaggio non è molto alta e il costo è basso. MCM-C utilizza la tecnologia a pellicola spessa per formare il cablaggio multistrato e utilizza ceramica (allumina o ceramica di vetro) come componente del substrato, che è simile a un IC ibrido a pellicola spessa utilizzando un substrato ceramico multistrato. Non c'è differenza evidente tra i due. La densità di cablaggio è superiore a MCM-L.MCM-D è l'uso della tecnologia a film sottile per formare cavi multistrato, con ceramica (ossido di alluminio o nitruro di alluminio) o Si, Al come componente del substrato. Lo schema di cablaggio è il più alto tra i tre componenti,ma il costo è anche alto.