Принципы упаковки и применения трехмерных интегральных схем
2.5D диэлектрический слой представляет собой конфигурацию, в которой сердечники труб устанавливаются бок о бок на кремниевом, стеклянном или органическом диэлектрическом слое с использованием кремниевого сквозного отверстия (TSV), проходящего через диэлектрический слой. (При использовании стеклянных или органических пластин в качестве основания для среднего слоя они называются пробивающими стеклянными отверстиями (TGV) и фундаментными отверстиями (TSV) соответственно.) Связь между ядрами осуществляется с помощью цепей, изготовленных на промежуточном уровне.
Датчик изображения CMOS (CIS) имеет TSV в качестве заднего отверстия для формирования межсоединений, устраняя слияние выводов, тем самым уменьшая размер и увеличивая плотность. Во всех типах 3D - инкапсуляции чипы в упаковке используют внешние сигналы чипа для связи, как если бы они были установлены в отдельной упаковке на обычной плате.
3D IC можно разделить на 3D - sic (3D - sic), что означает, что чипы IC и TSV складываются и соединяются друг с другом; Реальный 3D IC использует FAB - процесс для укладки нескольких слоев устройства на один чип и может использовать или не использовать TSVS с очень тонкими интервалами для создания соединений.
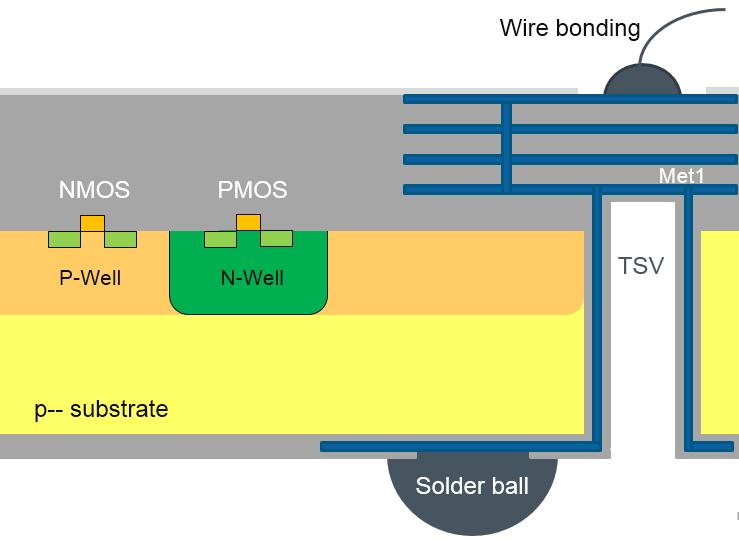
Силиконовые отверстия (TSV) представляют собой отверстия, образующиеся на кремниевых пластинах с использованием процесса травления. Взаимосвязь образуется путем заполнения TSV проводящими материалами, такими как медь, вольфрам или поликристаллический кремний (рисунок 2). Основным преимуществом соединений TSV является то, что они сокращают путь передачи сигнала от одного чипа к другому или от одного слоя цепи к другому. Это позволяет снизить мощность и увеличить плотность соединения, тем самым улучшая функциональность и производительность. Сам по себе TSV не 3D IC. Вместо этого они являются основой для включения трехмерных интегральных схем. Задние сквозные отверстия также используются в других устройствах, таких как датчики изображения, микроэлектромеханические системы (MEMS) и полупроводники соединений.
Что такое 3D IC?
Моноличный 3D - IC - это не укладка чипов или модулей для создания 3D - IC, а начало с базового чипа, который использует традиционные устройства FAB для добавления дополнительных слоев, таких как кристаллический кремний, металлический слой и активные и пассивные схемы (рисунок 2). Использование сквозных отверстий нанометрового, а не микронного диапазона для создания вертикальных связей между слоями, а не между чипами; То же самое с TSV. В настоящее время разрабатывается несколько различных методов, в основном для приложений памяти. Иногда Integral 3D называют sequential 3D.
Что такое 3D память?
Было разработано множество методов для вертикальной компоновки памяти на двух устройствах, которые не являются уязвимыми (флэш - память NAND) и уязвимыми (DRAM). Метод DRAM включает высокополосную память (HBM), гибридный куб памяти Micron и интегрированную оперативную память (DiRAM) Tezzaron. Все они основаны на 3D IC с использованием TSV (рисунок 3). Samsung, Toshiba и многие другие компании разрабатывают флэш - память 3D NAND на основе целостного 3D - подхода.
В чем преимущества технологии 2.5D - вставки?
Технология 2.5D, первоначально разработанная как технология моста для 3D - интегральных схем, теперь превратилась в платформу инкапсуляции, которая, как ожидается, будет сосуществовать с 3D - интегральными схемами. В отличие от 3D - IC, только промежуточный слой (а не само ядро) требует TSV для подключения активного ядра к подложке упаковки. Это позволяет использовать существующий дизайн формы.
Каковы основные технологические факторы 3D - интеграции?
На узлах следующего поколения чипов увеличение стоимости таких фотолитографических шагов и обработки чипов побудило отрасль искать альтернативы для повышения производительности и функциональности наших электронных устройств и снижения затрат. Кроме того, спрос на небольшие интегрированные различные технологии (логика, память, RF, датчики и т. Д.) подталкивает индустрию к 3D - интеграции как решению.
Каковы движущие силы рынка 3D - интеграции?
Рыночные движущие силы 3D - интеграции (3D - интеграции) начинаются с высокопроизводительных вычислений, серверов и центров обработки данных, военной и аэрокосмической техники и медицинского оборудования, поскольку они пользуются наибольшим спросом и могут позволить себе современные технологии 3D - интеграции. Планшеты, смартфоны и игровые устройства также способствуют развитию этой технологии.
С какими проблемами сталкиваются трехмерные интегральные схемы?
Несмотря на то, что многие утверждают, что нет оставшихся технических проблем и что оставшиеся проблемы могут быть легко решены, некоторые технологические шаги по - прежнему требуют лучших решений, таких как проектные инструменты для планирования, внедрения и проверки 2,5D и 3D - интегральных схем, обработки чипов, теплового управления и тестирования. Основные проблемы связаны с текущими удельными затратами, низкими объемами и рисками осуществления, связанными со зрелостью экосистем. Предпринимаются усилия по сокращению затрат на процессы и упрощению сотрудничества в рамках всей отрасли. Увеличение производства поможет снизить затраты. Тем не менее, многие 3D - эксперты считают, что реализация 3D - интегральных схем значительно снизит стоимость системы, и остальная проблема заключается в обучении системных инженеров преимуществам проектирования 3D - интегральных схем в их системах.
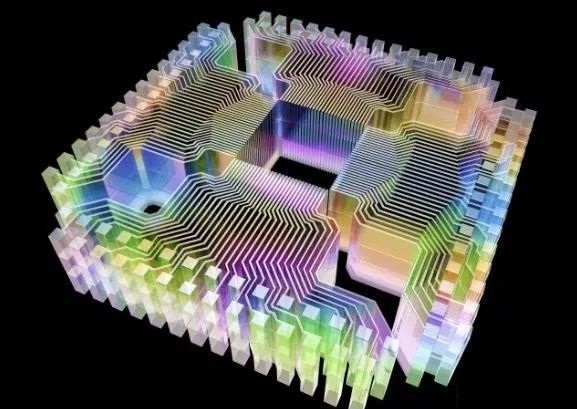
Датчик изображения CMOS (CIS) был одним из первых устройств, которые реализовали большое количество отверстий через отверстие. CIS (BSI) с задним освещением в настоящее время находится в производстве, и поскольку CIS стекается в верхней части IC, это устройство 3D IC (рисунок 2). В 2011 году Xilinx выпустила 2.5D - плагины для всех программируемых FPgas серии Virtex - 7. За последние несколько лет Tezzaron поставила небольшое количество DiRAM.
В конце 2014 года Micron и Samsung начнут производить гибридные кубики хранения (HMCS), стек 3D DRAM, расположенный над логическими устройствами. SK Hynix будет поставлять как HMC, так и высокочастотную память (HBM). Эти 3D - интегрированные устройства хранения данных были массово выпущены в 2014 / 15 году и продолжали использовать логические стеки и изомерные устройства в последующие годы.
Компания iPCB поделится с вами всей информацией!