основа интегральной схемыопределение: база для упаковки чипов голых IC.
функция:
(1) Переносные полупроводники IC Чипсы фри.
(2)Внутренние схемы используются для соединения между чипом и платой.
(3) Защита, фиксация, является промежуточным продуктом коммуникационных чипов и печатных плат.
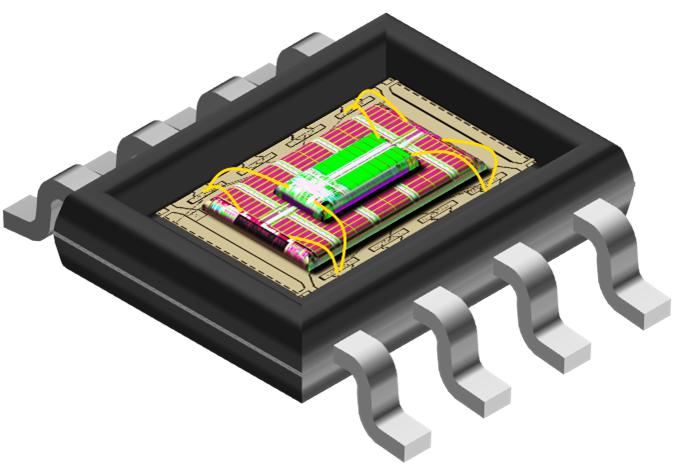
IC Packaging
Родился в середине 1990 - х годов. Появление новых форм инкапсуляции высокой плотности интегральных схем (IC), таких как BGA (инкапсуляция решетчатой решетки) и CSP (инкапсуляция размеров чипа), для упаковки принес необходимый новый носитель - IC упаковочная плита.
Разработка полупроводников: транзистор клапана инкапсулируется системой (SIP) путем сборки поверхностного инкапсуляции (SMT) чип - класса (CSP, BGA)
ПХБ и полупроводниковые технологии взаимозависимы и тесно взаимосвязаны,пробивная сила, Тесная координация, PCB может создать несколько чипов, Электрическая изоляция и электрические соединения, предоставлять необходимые электрические характеристики.
Уровень технических параметров:2 - 10 этажей;
Толщина пластины PCB: обычно 0,1 ~ 1,5 мм;
Допуск минимальной толщины пластины PCB * 0 микрон;
Минимальная апертура, сквозное отверстие.1mm, микропористость.03mm;
Минимальная ширина рисунка / интервал, 10 - 80 микрон;
Минимальная ширина кольца, 50 микрон;
Контурный допуск, 0 - 50 микрон;
Погруженные слепые отверстия, сопротивление, емкость погребенного сопротивления;
Поверхностное покрытие,никель/Au, мягкое золото, Прочный золото, никель/палладий/Цзинь, Шорт.
Размер пластины, 150 * 50 мм (один носитель IC);
То есть, THE основа интегральной схемынужно больше штрафов, Высокая плотность, число пяток, Небольшая емкость, Дырка, Диск, чуть - чуть, ultra-тонкий слой активной зоны. поэтому, Необходима точная технология межуровневого наведения, метод формирования образов, гальваническая техника, Технология бурения и обработки поверхностей. предъявлять более высокие требования к надежности продукции, Оборудование и приборы, управление материальными средствами и производством.поэтому, Технический порог базовой платы IC и НИОКР.
технические трудности по сравнению с традиционным производством PCB, технические трудности, которые необходимо преодолеть основа интегральной схемы Как показано ниже:
(1) Техническая таблетка для изготовления стержней, деформация, Особенно, если толщина плиты составляет 0,2 мм, вспучивание листов, Параметры ламинарного потока, Такие технологии, как межпластовая система позиционирования, Таким образом, осуществляется эффективное управление толщиной листов сверхтонких сердечников.
(2)Технология микропористости
*Включает: процесс открытия сварочной маски, лазерная перфорация, Процесс заполнения слепым отверстием.
* Технология Conformalmask (Conformask) используется для разумной компенсации лазерных слепых отверстий и прямого определения отверстия и положения слепых отверстий с помощью открытых медных колец..
* Индикатор, связанный с лазерным сверлением микроотверстий: форма отверстия, соотношение между верхним и нижним отверстиями, Боковая эрозия, выпуклое стекловолокно,Клей на дне отверстия.
* Показатели, связанные с покрытием слепым отверстием медью, включают: способность наполнять, глухой полость, sag, надёжность омеднения, Подожди.
* В настоящее время, размер микропористости 50 ~ 100 микрон, И количество пористостей достигает 3, заказ №№ 4 и 5.
(3) Графическое образование и медное покрытие
Модель компенсации технологий и контроля; Технология производства тонких узоров; Методы контроля равномерности толщины покрытия медью; Методы борьбы с микроэрозией тонких узоров.
* В настоящее время ширина рисунка требует от 20 до 50 микрон. Для равномерности толщины медного покрытия требуется 18 * микрон, однородность травления 90%.
(4) Процесс сварного сопротивления * включает в себя процесс пробок, метод печати сварных сопротивлений и т.д.
* Разница в высоте между поверхностями сварного сопротивления основа интегральной схемыменее 10 микрон, Кроме того, разница в высоте между сопротивлением сварного материала и поверхностью диска составляет менее 15 микрон.
(5) Технология обработки поверхностей
* однородность толщины никелирования / золочения; Процесс мягкого и твердого золочения на одной и той же пластине; Nickel/палладий/Процесс золочения.
* Покрытие внутренней поверхности, технология селективной обработки поверхности.
(6) Способность к тестированию и надежность продукции
* Оснащен несколькими испытательными аппаратами/оборудование, отличное от традиционного завода PCB.
* Технология проверки надежности отличается от традиционной.
(7) В общем основа интегральной схемы В связи Десять аспектов технологии:
Динамическая компенсация графиков; Графическое гальваническое покрытие, чтобы толщина покрытия была равномерной; Контроль полного расширения и усадки материала; Технология обработки поверхностей,избирательное гальваническое мягким и твёрдым золотом, Процесс никелирования / палладия / золочения;
* Производство пластинчатых пластин;
*Высокая надежность технологий обнаружения; микропористая обработка;
* Если сложить миниатюры 3, 4, 5, производственный процесс;
* Многослойное давление; Ламинирование 4 раза; Бурение скважин 5 раз; Электричество 5 раз.
* Формирование и травление рисунков;
* высокоточная система наведения;
* Процесс сварных пробок, гальваническое заполнение микроотверстий;
IC Substrateклассификация
Через форму упаковки
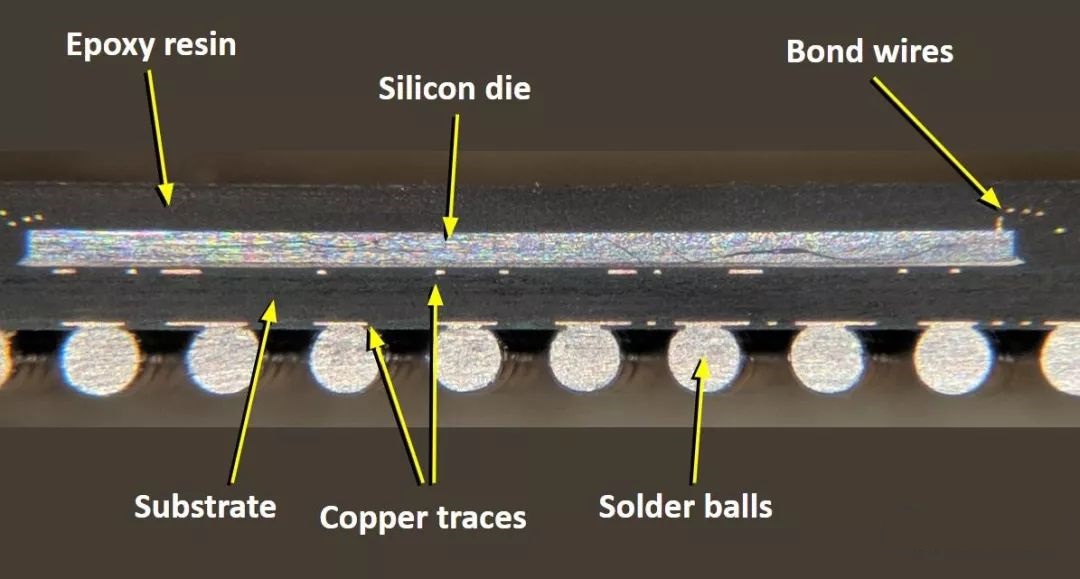
тенденция упаковки
(1) BGA
*BallGridAiry, BGA, Пакет сферических массивов.
*Такой посылка Теплоотвод и электрические свойства пластины хорошие,вывод чипа можно существенно увеличить Количество выводов 300 (pincount) для верхней части упаковки IC.
(2) CSP
*CSP, упаковка кристаллов, Упаковка размеров чипсета.
* Это одночиповый пакет, легкомысленный, Маленький, размер и размер упаковки Размер самой IC почти такой же или немного больше, хранить продукцию, communication products, электронный продукт с низким пин - кодом.
(3) Покрытый кристалл PCB
*Перевернутый чип (FC) - это тип упаковки, в котором передний поворот чипа (Flip), выпуклый блок подключается напрямую доходить pcb.
Эта подложка имеет преимущество малой помехи сигнала, коаксиальный ультра - высокой частоты УВЧ типа бабочка низкой потери соединения, хорошее электрическое свойство, Эффективное охлаждение и т.д..
(4) Многочиповый модуль
* Многочиповый (MCM) модуль с несколькими чипами с различными функциями в одном и том же пакете.
* Это лучшее решение для легкой, тонкой и короткой электроники, радиостанция с низкой скоростью. Электронные продукты для больших ЭВМ высшего класса или специальных характеристик.
* Поскольку в одной упаковке несколько чипов, помехи от сигнала, heat dissipation, тонкое проектирование, Постой, Нет более полного решения, Активное развитие продукции.
По характеристикам материала
(1) Твердый PCB- панель. Загрузка PCB
* Жесткие органические вещества упаковочная плита Изготовлен из эпоксидной смолы, телесвязь Великобритании, ABF Смола. ее продукция составляет подавляющее большинство ВВП. IC Упакованная подложка. CTE (Коэффициент теплового расширения) от 13 до 17ppm/полоть крест.
(2)Загрузка PCB - уплотнения с мягкой пластиной панель.
* Упакованная подложка из гибких пластин PI (полиамид), PE (полиэфирная) смолы, коэффициент теплового расширения от 13 до 27 ppm.
(3) Керамический фундамент
* Оксид алюминия, нитрид алюминия,керамический материал, например карборунд. CTE очень маленький, 6 ~ 8ppm.
известный техникой связи
(1) Режим зазора для соединения несущей пластины
* Золотой провод соединяет ИС с печатная плата
(2) TAB PCB
*TAB -- Автопривязка ленты
*Внутренний вывод чипа соединен с чипом, внешний - с панелью упаковки.
3) прикрепление кристаллов к пластинам PCB.
*Filpchip, чип является выпуклой точкой Filp, непосредственно связанной с PCB - панель.